
方案摘要
方案下载| 应用领域 | 材料 |
| 检测样本 | 薄膜材料 |
| 检测项目 | |
| 参考标准 | / |
薄膜材料就是厚度介于一个纳米到几个微米之间的单层或者多层材料。
薄膜材料就是厚度介于一个纳米到几个微米之间的单层或者多层材料。由于厚度比较薄,薄膜材通常依附于一定的衬底材料之上。常规XRD测试,X射线的穿透深度一般在几个微米到几十个微米,这远远大于薄膜的厚度,导致薄膜的信号会受到衬底的影响(图1)。另外,随着衍射角度的增加,X射线在样品上的照射面积逐渐减小,X射线只能辐射到部分样品,无法利用整个样品的体积,衍射信号弱。薄膜掠入射衍射(GID:Grazing Incidence X-RayDiffffraction)很好的解绝了以上问题。所谓掠入射是指使X射线以非常小的入射角(<5°)照射到薄膜上,小的入射角较大减小了在薄膜中的穿透深度 。同时低入射角较大增加了X射线在样品上的照射面积,增加了样品参与衍射的体积。这里有两点说明:GID需要专门的硬件配置;常规GID只适合多晶薄膜和非晶薄膜,不适合单晶外延膜。本文介绍了GID在薄膜结构分析中的作用,文中GID数据是在布鲁克D8 ADVANCE X射线衍射仪上完成的。
实例一 单层薄膜GID测试
本例中样品是在(100)单晶硅衬底上制备的14nm RuO2多晶薄膜。如图1所以,常规XRD图谱中薄膜样品的信号被Si单晶的信号掩盖。放大图虽然能看到薄膜衍射峰,但信号非常弱。图2中给出了入射角0.3度时,样品的GID图谱。图中没有Si单晶衬底的信号,且薄膜信号明显。利用全谱拟合得到了薄膜的晶胞参数、晶粒大小以及微观应变。

图1 RuO2薄膜常规XRD测试图谱。
左图:单晶硅衬底的很强信号;
右下图:RuO2薄膜的微弱信号;右上图:RuO2薄膜结构示意图。

图2 蓝色实线:RuO2薄膜掠入射衍射图谱,入射角ω=0.3°。红色实线:全谱拟合计算图谱,得到结构参数在右上角。
实例二 多层薄膜GID测试
当样品为多层薄膜时,通过设置不同的入射角度,进而控制X射线在薄膜中的穿透深度,GID可以被用来确定薄膜材料的结构随深度变化的信息。本例中的样品为45nm NiO/355nm SnO2/玻璃 。
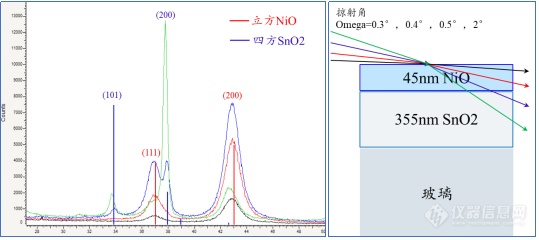
图3 左图:不同入射角时,薄膜的GID图谱。右图:薄膜结构示意图及掠入射角度。
当以低角度omega=0.3°入射时,看到薄膜上层的立方NiO。当入射角omega=0.5°时,有四方SnO2的衍射峰出现,随着入射角进一步增加,SnO2的信号逐渐加强,说明有更多的X射线照射到SnO2薄膜上。同时,两物相衍射峰的相对强度与卡片对比(左图)可以知道,NiO和SnO2均有一定程度的取向。其中SnO2的强度差别更大,说明取向更强。


晶体日记(二十)- 有效的数据收集是较省时间的方式据- X射线衍射XRD
晶体日记(十九)- 给使用OMIT完整的证据链- X射线衍射XRD
应用分享 | 反光电子能谱IPES专辑之应用案例(一)-XPS
相关产品

关注

拨打电话

留言咨询