
方案摘要
方案下载| 应用领域 | 半导体 |
| 检测样本 | 其他 |
| 检测项目 | |
| 参考标准 | 其他 |
聚焦离子束(Focused Ion beam,简称FIB)技术是利用静电透镜将离子束聚焦成非常小尺寸的显微切割技术。离子束轰击样品时,其动能会传递给样品中的原子/分子,产生溅射效应,从而达到不断蚀刻,进而切割样品的效果。
聚焦离子束(Focused Ion beam,简称FIB)技术是利用静电透镜将离子束聚焦成非常小尺寸的显微切割技术。离子束轰击样品时,其动能会传递给样品中的原子/分子,产生溅射效应,从而达到不断蚀刻,进而切割样品的效果。FIB对固体局部区域内进行高精度的切割和加工后,借助飞行时间二次离子质谱仪(Time-of-Flight Secondary Ion Mass Spectrometry,简称TOF-SIMS),就能实现对该区域的原位、高灵敏度的化学成分分析,从而获取样品“由表及里”的丰富的化学信息。
FIB-TOF功能介绍
PHI nanoTOF仪器可以通过FIB-TOF来实现截面样品的制备和化学分析,有以下两种方法:
方法一:PHI nanoTOF仪器利用配备的Ga源FIB配件进行FIB处理。经过Ga源进行精确的FIB加工后,随后直接进行TOF-SIMS分析(见图1a)。值得一提的是,在Ga源进行FIB加工时,还能获取FIB加工区域的3D影像;此外,Ga源还可以作为TOF-SIMS分析源(即一次离子源)进行TOF-SIMS分析。
方法二:对于新的型号的PHI nanoTOF3+仪器,作为初级离子源的液态金属离子源,还可兼具FIB功能,利用同一离子源就能够完成对样品进行截面加工和横截面的TOF-SIMS分析。如图1b和1c所示,通过PC端控制,用户可以轻松、快速地完成从FIB处理到TOF-SIMS分析的全过程。此外,PHI nanoTOF3+还支持在冷却条件下进行FIB加工。

图1. FIB-TOF工作的示意图
FIB-TOF的应用
FIB-TOF技术适用于对具有三维结构或组分复杂(如合金)样品的深度分析。如图2a和2b所示,首先利用FIB准确切割样品,然后采集断面上的TOF-SIMS二维图像,实现直观且迅速地获取样品“由表及里”深度方向上的组分的分布情况。表格中对比了Bi离子和Ga离子对几种典型材料的磨削速率(Milling Rate)(见2c)。实验结果表明,无论是无机非金属材料还是硬度较高的合金,
FIB加工均展现出良好的适用性;另一方面也表明了同样大小的离子束条件下,Bi离子的磨削速率高于Ga离子。
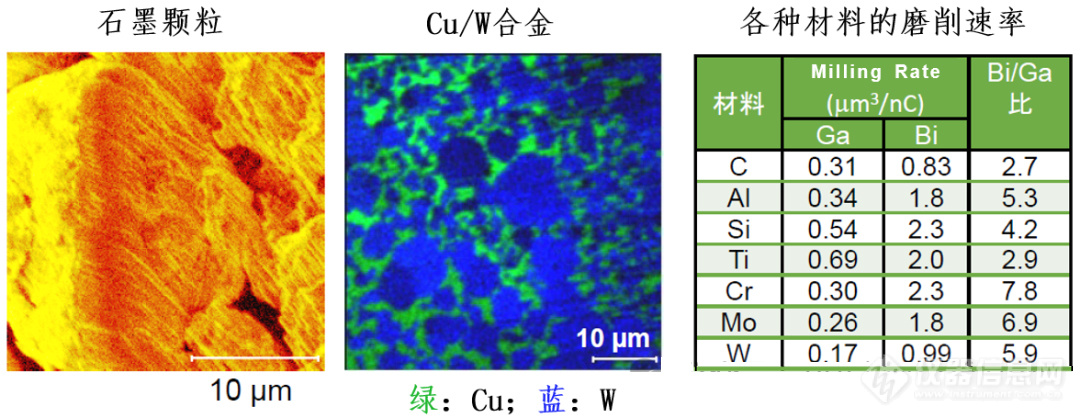
图2. 石墨a)、Cu-W合金b)的FIB-TOF图像;c) Bi和Ga离子对各种材料的Milling Rate对照表。
全新升级的PHI nanoTOF3+配备了先进的液态金属离子设备以及特有的TRIFT分析器,性能得到大力提升!它具备优于50 nm的空间分辨率,能够实现宽带通能量和宽立体接受角的高灵敏度质谱分析。此外,液态金属离子设备还可选配FIB功能,使得原位FIB-TOF技术成为研究复杂结构以及微区特征样品的强大工具。PHI nanoTOF3+可被广泛应用于材料科学、生物医学、新能源、半导体、电子器件制造等领域,为科研和工业界带来前所未有的分析体验。


晶体日记(二十)- 有效的数据收集是较省时间的方式据- X射线衍射XRD
晶体日记(十九)- 给使用OMIT完整的证据链- X射线衍射XRD
应用分享 | 反光电子能谱IPES专辑之应用案例(一)-XPS
相关产品

关注

拨打电话

留言咨询