高分辨XRD(HR-XRD)是一种常见的测量化合物半导体(如SiGe,AlGaAs,InGaAs等)的成分和厚度的方法。
当掺杂剂或杂质以置换的方式添加到单晶晶格中时,晶格将因掺杂原子的存在而发生应变。例如,在Si晶格中,Ge原子的存在会导致压缩应变,因为Ge原子体积大于晶格中的Si原子。该应变改变了Si晶格的间距,而这种间距差异可以被HR-XRD检测到。

图1:压缩应变下通用结构的理论HR-XRD扫描,例如在Si衬底上的10nm SiGe层。0度处的尖峰来自衬底中的Si晶格。
较大的Ge原子的存在导致SiGe层中的Si原子间隔更远,使衍射峰移动到较低的角度(在衬底峰的左侧)。由于10nm SiGe层较薄,SiGe层的衍射峰比Si衬底的衍射峰宽得多。
在这种薄膜中,只有几行具有一定排列的原子可用于产生衍射信号,与来自Si衬底的衍射相比,X射线衍射峰较宽,因为衬底中有数千行可用于产生衍射信号的原子序列。如果结构处于拉伸应变下,则Si原子的间距将比衬底中的Si原子更紧密,并且对应的衍射峰将向衬底峰的右侧移动。谱图中额外的峰,称为“厚度条纹”,来自被SiGe层和Si基底之间界面所反射的X射线的增强干涉。这与用于X射线反射率(XRR)分析的信号相同,可用于确定应变层的厚度。
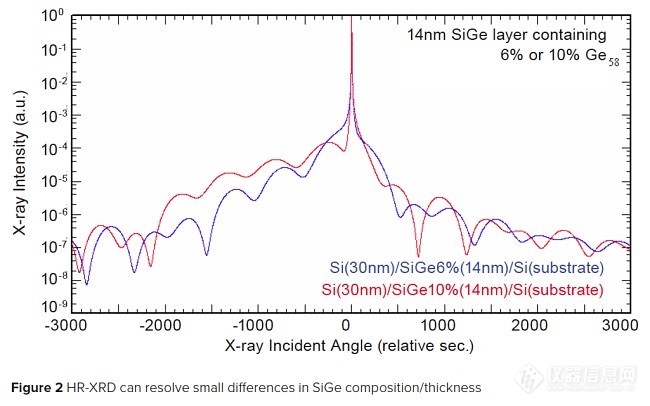
该方法可用于确定应变层的成分组成。图2显示了两个样品的理论HR-XRD扫描,在Si衬底上由30nm的Si生长在14nm的SiGe上。在第一种情况下,晶格中有6%的Ge,而在另一种情况下,有10%的Ge。HR-XRD可以轻松分辨这两种结构之间的差异,并根据厚度条纹确定层的厚度。
此外,先进的建模技术可以对结构特征进行准确描述,例如具有渐变结构的SiGe层。HR-XRD可以测量多种外延材料,例如AlGaAs,InGaAs,InGaN等。通常,XRD测定这些薄膜层组成的精度可以在1%以内。但是,应该注意的是,HR-XRD假设所有掺杂原子都存在于晶格中。
如果掺杂剂或杂质存在于晶格外,那么HR-XRD将无法检测到它们,因为它们对晶格间距没有影响。此外,HR-XRD并不能识别掺杂剂的具体元素成分,因此仅用于测量已知结构,而不能识别这些结构中的未知成分。
(文章来源于网络)
国科仪器聘任吴东教授为科学专家顾问
国科仪器小角X射线散射仪荣获合肥市新产品认定
国科仪器荣获“2023年度合肥市高新区瞪羚培育企业”荣誉称号
国科仪器荣获合肥市企业技术中心认定
相关产品

关注

拨打电话

留言咨询