来自半导体实验室专家的报告回顾
随着摩尔定律的发展逼近极限,3D封装技术对于半导体器件性能的提高越来越重要。3D封装器件失效分析面临的挑战是如何暴露出深埋的内部连接、倒装芯片和焊点等结构。
TESCAN将高通量 i-FIB+TMXe等离子FIB镜筒与 TriglavTMUHR 电子镜筒配对,以扩展 FIB 在物理失效分析的极限,实现了超大宽度和深度横截面加工的技术突破。Xe 等离子FIB充分满足了3D封装物理失效分析的无机械应力,定点加工和快速制备大尺寸截面等要求。
TESCAN失效分析实验室的专家前不久进行了一场在线报告直播,介绍了氙离子FIB在半导体领域如何助力先进封装、微机电器件和光电集成产品的分析检测工作。
通过观看本次《更高效的工具来增加半导体失效分析任务中的通量和灵活性》报告,您将了解氙离子FIB在半导体行业以下几方面的应用介绍:
无Ga 污染TEM样品制备
高质量逐层剥离实时监控
6/8/12寸不破片晶圆导航观测
在大体积深度截面上更高效的无窗帘效应加工
·精彩看点·
更高效的无窗帘效应加工
这是一个锂电材料样品使用等离子FIB大束流进行加工后因为没有用摇摆方式在左图能看到明显窗帘效应影响。当我们用±5°摇摆样品台加工后发现窗帘效应被有效地消除,获得非常平整干净的截面。
· 半导体领域,TESCAN一直在创新 ·
TESCAN 是全球首家将等离子 FIB 集成到扫描电子显微镜(SEM)中的制造商,早在2011年就推出了FERA,并于2019年底推出了新一代的 AMBER X 和 SOLARIS X。其中 AMBER X 将可用于样品精细加工的氙等离子体 FIB 和无漏磁的超高分辨成像的 SEM完美地结合,应用于各类材料的显微结构表征,尤其是讲究效率的半导体领域。
大家都在用的:高效聚焦离子束扫描电镜


( * 只展示部分可公开客户logo)
·更快速的反切·
在制备逻辑和存储器件的TEM薄片样品中,越来越精细的尺寸导致必须使用反切TEM薄片的方式才能获得10纳米以下的样品厚度。由于缺陷大小往往已达到纳米级别,就需要使用STEM(扫描透射电子探测器)从平面方向上对TEM薄片进行观测。因此,TEM薄片提取过程可能需要多个操作步骤,甚至需要将样品室泄真空后再倒置或平面放置样品。TESCAN SOLARIS通过一种专利设置解决了这些问题,只需一步,结合AUTO SLICING就可完成倒切。
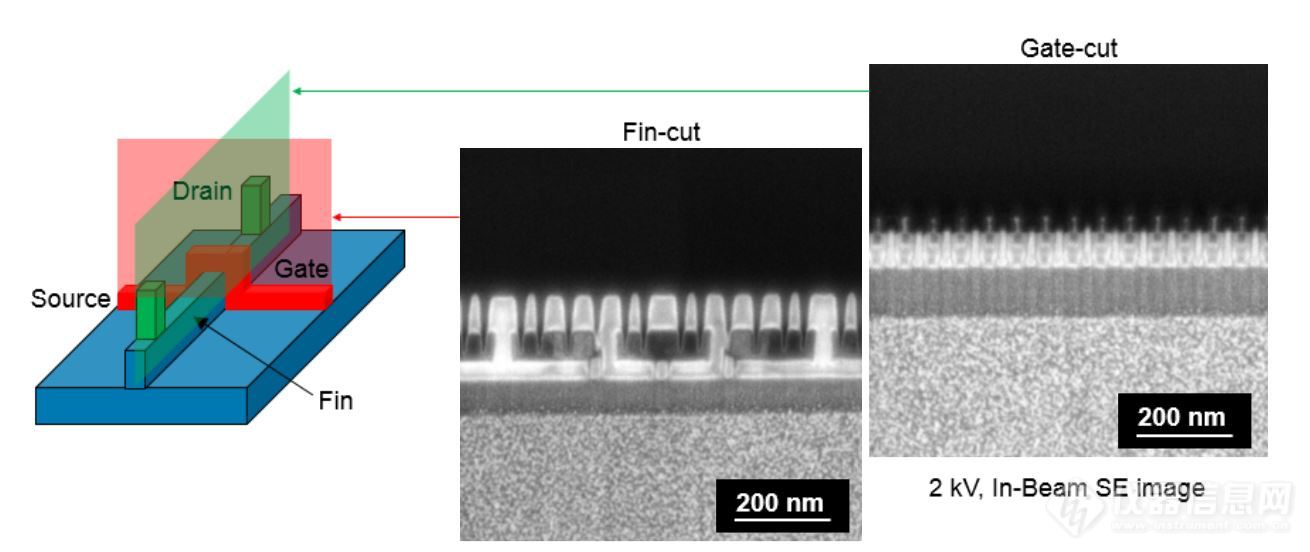
· <1小时 ·
针对14nm制成节点的芯片在1H内可制备一颗高质量的TEM观测样品。
· 亚微米分辨率的4D原位动态技术 ·
除了高效聚焦离子束扫描电镜之外,2021年,TESCAN发布最新款革命性X射线显微CT产品-UniTOM HR,是目前唯一具有亚微米分辨率和实时真4D原位动态技术的micro-CT。它可以帮助半导体工程师们:无损、快速的获得球栅阵列封装BGA的三维分析,并清晰的得到里面的焊球和内部孔隙分布、统计信息,为下一步高分辨的FIB分析提供更有效的指导。
- 更多报告 -
TESCAN春季研讨会,可以帮助您深入了解TESCAN SOLARIS及其辅助系统如何在半导体失效分析实验室环境中半自动化、高质量、低束流损伤地完成样品制备,以及不同尺寸、要求苛刻的样品进行演示,样品包括复杂器件和不导电硬质材料。
春季研讨会一:《如何结合等离子FIB刻蚀和激光烧蚀,更高效完成毫米级半导体失效分析》
春季研讨会二:《如何更快的使用正切、反切和平面切割方式制备逻辑和存储器件的TEM薄片样品》
如果你是失效分析实验室工程师、第三代半导体产线研发工程师、设计工程师,或者正在学习相关专业课程,都欢迎您登陆“中国电镜用户之家”,获得报告的回放链接,及最新应用。
·TESCAN介绍·

服务引领
Service Driven
深耕显微制造70年 | 服务80+国家
全球12家子公司 | 完善的中国售后体系
全球支持
Global Support

专注研发
Research Focus
5家研发中心 | 2个生产基地
来源于:泰思肯(中国)有限公司
热门评论
最新资讯
厂商动态
新闻专题
更多推荐
















