日本电子发布高精度-高分辨率FIB-SEM系统:JIB-PS500i
导读:日本电子推出的JIB-PS500i便是通过由高精度加工的聚焦离子束(FIB)系统和高分辨率的扫描电子显微镜(SEM)相结合的系统JIB-PS500i。
仪器信息网讯 2023年2月1日,日本电子株式会社(JEOL Ltd.,)总裁兼首席执行官Izumi Oi宣布推出FIB-SEM系统"JIB-PS500i”【产品链接】。
随着先进材料结构的精细化和工艺复杂性的提高,对形貌观察和元素分析等评价技术提出了更高的分辨率和精度要求。在半导体行业、电池和材料领域的透射电子显微镜(TEM)样品制备过程中,需要 “更高的精度”和“更薄的样品”。
此背景下,日本电子此次推出的JIB-PS500i便是通过由高精度加工的聚焦离子束(FIB)系统和高分辨率的扫描电子显微镜(SEM)相结合的系统,来满足以上需求。

高精度、高分辨率的FIB-SEM系统“JIB-PS500i"【产品链接】
JIB-PS500i主要特点
1. FIB镜筒可以使用高达100nA的大束流Ga离子束进行处理。大束流处理在制备用于大面积成像和分析的横截面样品方面特别有效。此外,FIB镜筒的工作距离也缩短了。与新开发的电源一起,帮助低加速电压下处理性能大大改善。
2. 新开发的超锥形透镜系统应用于扫描电镜镜筒中,在低加速电压下大大提高了图像的分辨率。这种极好的成像对于利用扫描电镜检查薄片试样的端点铣削状态非常有用。
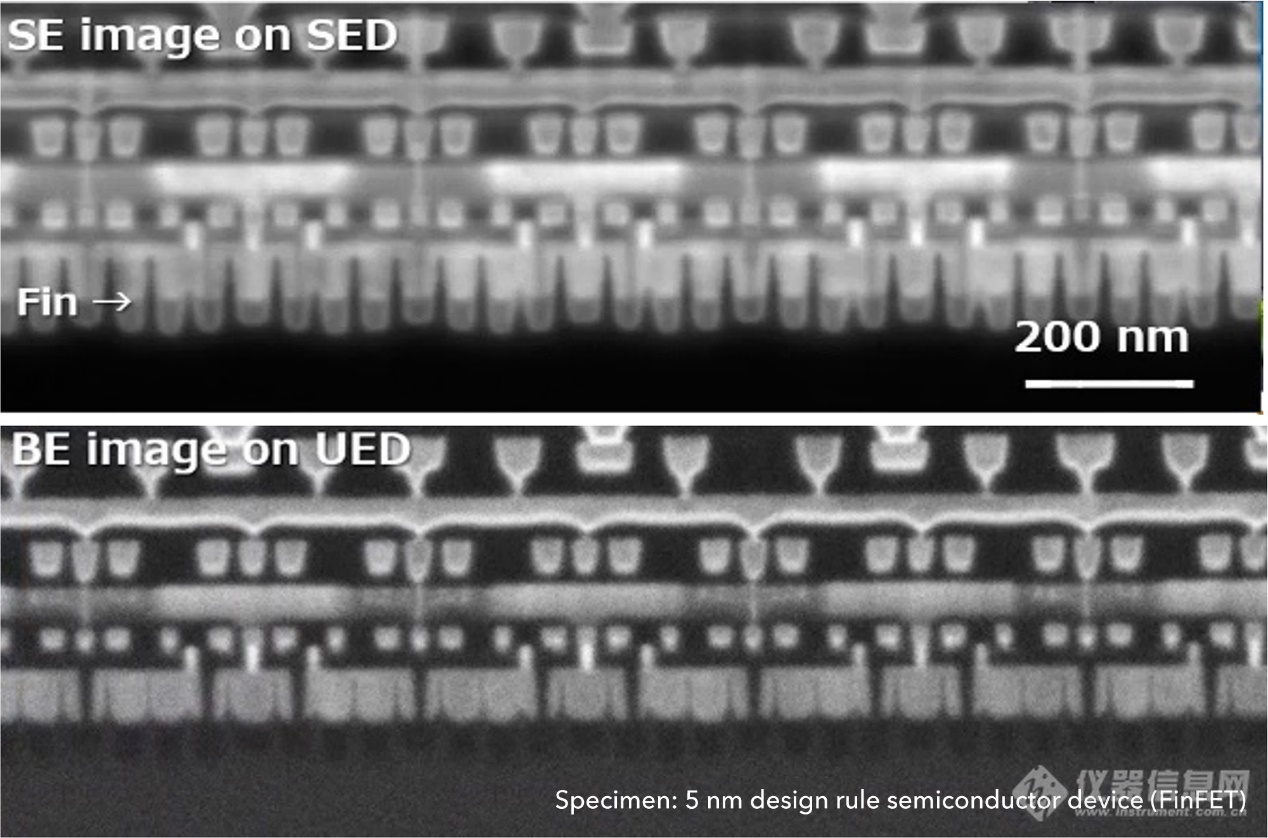
3. JIB-PS500i采用了大型样品仓和新开发的样品台,增加了的移动范围,从而可容纳大型样品。此外,新开发的STEM检测器,可以在90度倾斜下使用,并可以实现从TEM标本制备到STEM观察的无缝过渡。
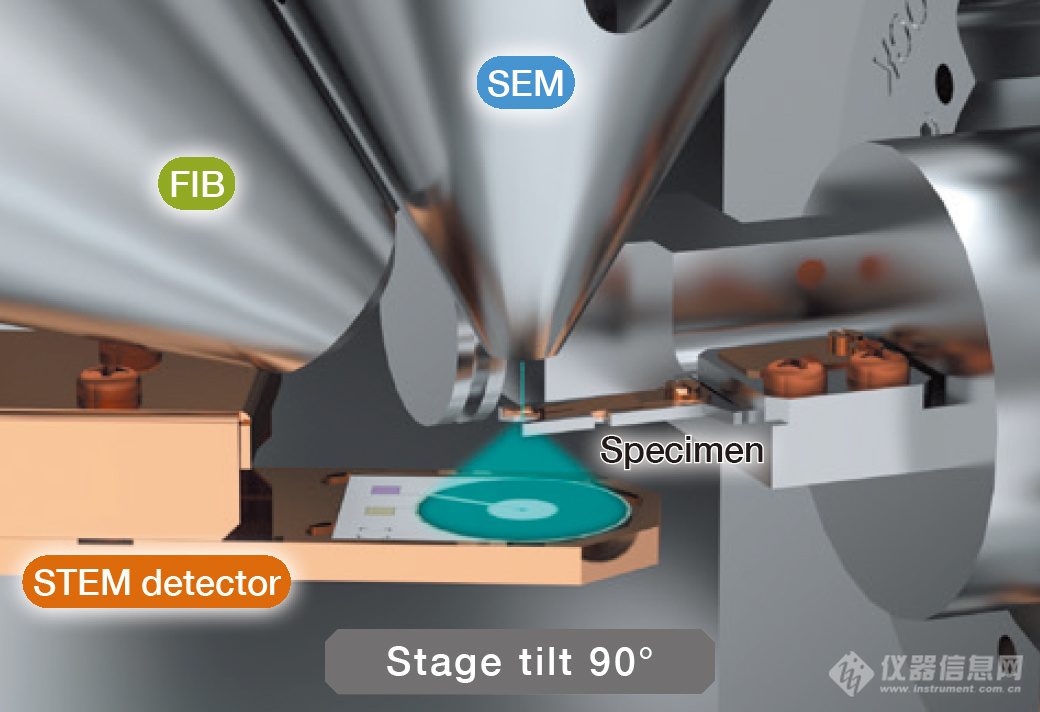
4. 操作界面采用了在JSM-T800系列高分辨率扫描电子显微镜中广受好评的"SEM中心",实现了EDS分析的完全集成。
5.专用TEM样品杆和夹具等可实现更精确的对准,同时使TEM和FIB之间的样品转移更容易。

使用双倾斜样品杆的样品转移工作流程
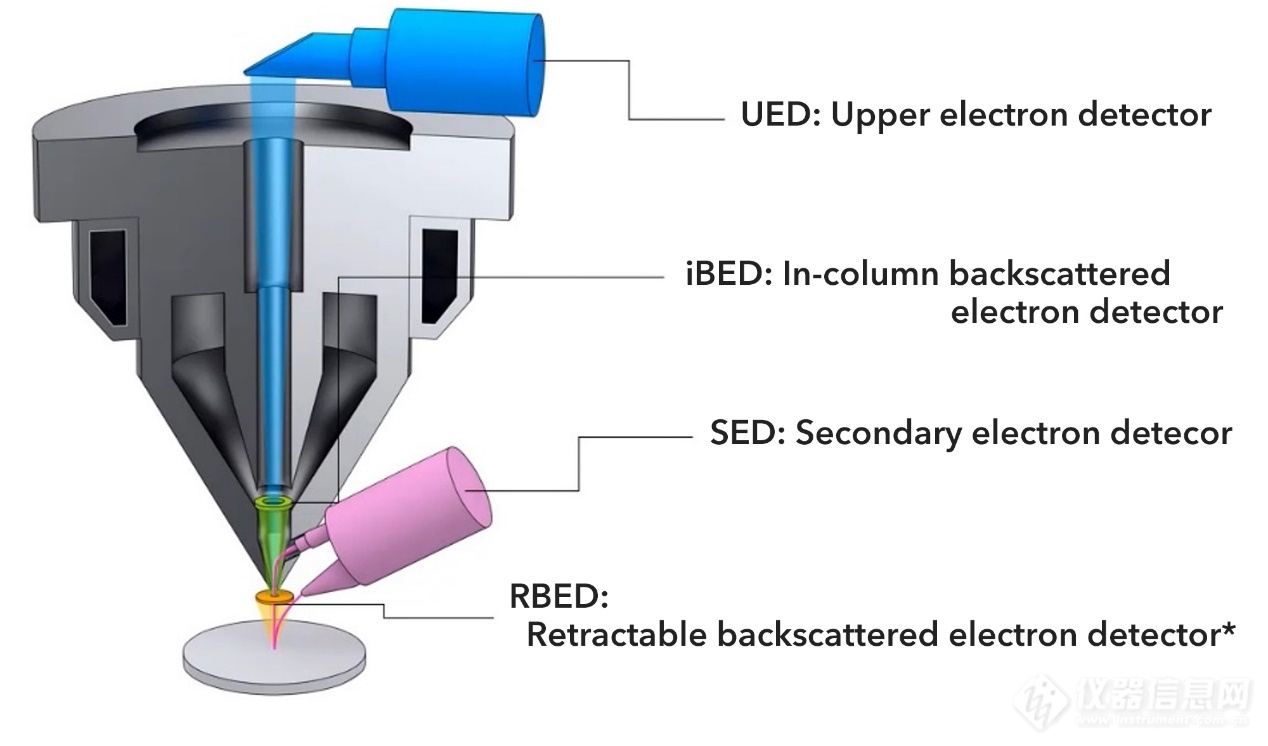
多种探测器可供选择

样品:5nm设计规则半导体器件(FinFET);(左)加速电压2kV,探测器SED二次电子图像;(中右)加速电压200kV,TEM图像,电镜型号:JEM-ARM200F

样品:半导体器件;加速电压3KV,探测器SED二次电子图像标本块(200X4X15pm);用OmniProbe 400拾取标本块
FIB主要规格参数
图像分辨率 | 3 nm (30 kV) |
放大倍率 | ×50 to ×300,000 |
加速电压 | 0.5 to 30 kV |
束流 | 1.0 pA to 100 nA |
离子源 | Ga liquid metal ion source |
铣削加工形状 | Rectangle, Circle, Polygon, Spot, Line, BMP |
SEM主要规格参数
图像分辨率 | 0.7 nm (15 kV), 1.4 nm (1 kV) |
放大倍率 | ×10 to ×1,000,000 |
加速电压 | 0.01 to 30 kV |
束流 | Approx. 1 pA to 500 nA or more |
电子枪 | In-lens Schottky Plus field emission electron gun |
物镜 | Super conical lens |
标准检测器 | Secondary electron detector (SED) |
样品台主要规格参数
样品台移动范围 | X:130 mm |
Y:130 mm | |
Z:1.0 mm to 40 mm | |
T:- 40.0 to 93.0° | |
R:360° |
来源于:仪器信息网
热门评论
最新资讯
新闻专题
更多推荐















