进口
NPGS纳米图像电子束曝光系统
NPGS电子束曝光系统是利用计算机控制电子束成像电镜及偏转系统,聚焦形成高能电子束流,轰击照射涂有高分辨率和高灵敏度化学抗蚀剂的晶片直接描画或投影复印图形的技术。NPGS的特点是分辨率高、图形产生和修改容易、制作周期短。
由于SEM、STEM及FIB的工作方式与电子束曝光机十分相近,美国JC Nabity Lithography Systems公司成功研发了基于改造商品SEM、STEM或FIB的NPGS电子束曝光装置(Nanometer Pattern Generation System纳米图形发生系统,简称NPGS)。NPGS为电子束直写光刻图形发生系统,改造现有SEM等,外加电子束控制系统,将会聚的电子束斑逐点地在样品台上移动,直接辐照电子抗蚀剂上或刻蚀基片形成图形。相对于购买昂贵的专用电子束曝光机,以既有的SEM等为基础,可大幅节省造价,且兼具原SEM 的观测功能,在功能与价格方面均有优势。NPGS由于具有高分辨率及低成本等特点,在北美研究机构中,NPGS是最畅销的与扫描电镜配套的电子束曝光系统,并且它的应用在世界各地也越来越广泛。NPGS的技术目标是提供一个功能强大的多样化简易操作系统,结合市面上已有的扫描电镜、扫描透射电镜或聚焦离子束装置,实现高级的电子束或离子束光刻技术。当前众多用户的一致肯定和推荐足以证明NPGS实现了自己的目标,满足了用户对纳米级光刻加工技术的需求。
应用简述
NPGS电镜改装系统所具有的超高分辨率,无需投影光学系统和费时的掩模制备过程,计算机产生图形并控制电子束直接将图形扫描到光刻胶上的特点,使它在纳米加工方面有着巨大的优势。NPGS系统能够制备出具有高深宽比的微细结构纳米线条,从而为微电子领域如掩模板制造、微电子器件制造、全息图形制作、电子束诱导表面沉淀等微/纳加工相关技术提供了新的方法。
NPGS系统刻画图案的大小从纳米级到显微镜能达到的最大尺度,即最大可到10毫米。然而,对任何SEM电子束曝光系统,刻画精度将随着图案大小的增加而降低。
主要特点:
为满足纳米级电子束曝光要求,JC Nabity出品的NPGS系统设计了一个纳米图形发生器和数模转换电路,并采用电脑控制。电脑通过图形发生器和数模转换电路驱动SEM等仪器的扫描线圈,从而使电子束偏转并控制束闸的开关。通过NPGS可以对标准样片进行图像采集及扫描场的校正。配合精密定位的工件台,还可以实现曝光场的拼接和套刻。利用配套软件也可以新建或导入多种通用格式的曝光图形。
系统参数:
最细线宽(μm):根据SEM
最小束斑(μm):根据SEM
扫描场:可调
加速电压:根据SEM,一般为0-40kV
速度:5MHz(可选6MHz)
A. 硬件:
微影控制介面卡:NPGS PCI-516A High Speed Lithography Board,16 Bit,high resolution (0.25%)
控制电脑:Pentium IV 3.0 GHz computer (or better) with 512 Mb RAM, 80G硬盘, CDRW Drive,17"液晶显示器.
皮可安培计:Keithley 6485 Picoammeter
B. 软件:
微影控制软件NPGS V9.0
DesignCAD Express v16.2 或更高版本
NPGS纳米图形电子束曝光系统-关于电镜
NPGS技术以电子显微镜为基础,提供了一个功能强大且操作简便的电子束曝光系统。事实上,NPGS可以应用到任何SEM, STEM或FIB以实现电子束光刻技术作为基础研究及技术开发。市场上还没有其他扫描电镜电子束曝光系统可以像NPGS一样提供既快速且高精度的电子束光刻技术,并且使用成本有了很大程度的降低。
以下列表是已成功应用NPGS技术的电镜型号。需注意的是,某些电镜型号要求额外的外部输入装置。通常,同一个厂家的不同电镜型号有相同的XY接口。因此,某些在此未列明型号的电镜同样可安装NPGS。如有疑问,可来电或邮件咨询。- Amray 1200, 1400, 1830 SEMs
- Amray 1845 FE-SEM
- Camscan Series 4 SEM
- Elionix ERA-8800
- FEI XL30 LaB6 SEM
- FEI XL30 FEG & XL30 SFEG FE-SEMs
- FEI XL30 ESEM FEG FE-SEM
- FEI Inspect S & Quanta SEMs
- FEI Inspect F, Quanta FEG, & FEG ESEM FE-SEMs
- FEI Sirion, NanoSEM, & Magellan FE-SEM
- FEI Quanta 3D Dual W & Ion Beam Microscope
- FEI Strata 235/237/620/810/820, Quanta 3D, Nova Nanolab , & Helios Dual FE & Ion Beam Microscope
- Hitachi S510, S570 SEMs
- Hitachi S2460N SEM
- Hitachi S2300, S2400, S2500 Delta, S2700 SEMs
- Hitachi S3000H, S3000N, S3400, S3500N SEMs
- Hitachi S4000, S4100, S4200, S4700, S4800 cFE-SEMs
- Hitachi S4300SE FE-SEM
- Hitachi SU-6600 &SU-70 FE-SEMs
- Hitachi FB2000A FIB
- ISI 60 SEM
NPGS纳米图形电子束曝光系统的配置考虑因素
- 电子束流稳定性:电子束流稳定性取决于图形的线宽和曝光时间。曝光时间从几秒钟到几小时不等。六硼化镧及钨灯丝电镜的效果较好,而冷场发电镜容易出现漂移且噪音较大。当冷场发电镜要安装NPGS,需提供“电子束电流VS时间图”帮助我们评价可能存在的问题。有NPGS的用户反映,冷场发电镜至少有+/-3%的噪音及通常每小时+/-15%的漂移。相比之下,热场发电镜的电子束流更稳定且噪音小。例如,有热场发NPGS用户12个小时内电子束流最大到最小的变化小于1pA,而通常的变化值为129.5pA,因此该用户的偏移率每小时仅为0.1%。97%的数据(每5s钟读取)没有噪音(0.1pA分辨率),剩下的3%数据在0.4pA平均值。这样的稳定电流是SEM电子束曝光系统的理想工作条件。
- 最大电子束电流:钨丝及六硼化镧丝电镜可以提供大多数SEM电子束曝光系统需要的电子束流条件,老款热场发电镜要差一些,但是其最大电流可以满足大多数SEM电子束曝光系统的条件。冷场发电镜比热场发的提供的电流小,当运用较大电子束电流刻画大面积图形时可能会受到一定影响。
- 分辨率:一般来说,高分辨率电镜通常意味着高性能,然而电镜最终的分辨率对电子束曝光系统却不是最重要的考虑。能够持续的降低像散性(astigmatism)对大多数电子束曝光系统来说才是最重要的问题。
- 放大倍数:放大倍数将决定图形的视野大小及最小线宽。通常,刻画精致图形(< 0.1 um)需要放大约100um2的视野。
- 工作台稳定性:需要考虑的是后座及漂移。例如,一个图形由0.1um的直线组成需刻画1分钟,工作台的偏移为每分钟20nm是可以接受的。当工作台有偏移问题,在刻画前校正写场对准可减少影响。
- 磁场屏蔽:工作环境受到磁场影响的电镜需要做磁场屏蔽。(消磁产品Spicer可见我司产品介绍。)
- 法拉第杯:曝光之前需用安培计测量电流大小。
- 电子束匝:大多数应用也可不使用减速电子挡板或不使用电子束匝。如果要买新电镜,最好考虑一起购买电子束匝。
- X&Y外部控制:电子束移动由外部电压控制。大多数电镜有内置的外部接口或可供选择的接口。
- 相关资料
-

-
 NPGS电子束曝光系统相关知识
NPGS电子束曝光系统相关知识2011-12-22
-

NPGS纳米图像电子束曝光系统/纳米图形发生器/电子束光刻信息由理化(香港)有限公司为您提供,如您想了解更多关于NPGS纳米图像电子束曝光系统/纳米图形发生器/电子束光刻报价、型号、参数等信息,欢迎来电或留言咨询。
相关产品

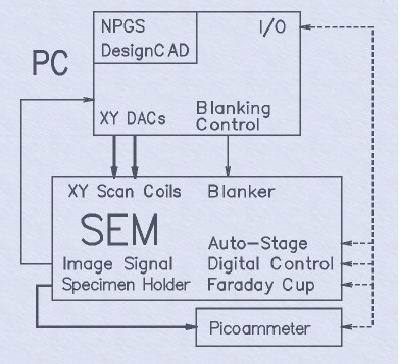


 仪器对比
仪器对比




 关注
关注


