Fusion and Hybrid Bonding Systems 融合和混合键
报价 面议
Fusion and Hybrid Bonding Systems
融合和混合键合系统
融合或直接晶圆键合可通过每个晶圆表面上的介电层永久连接,该介电层用于工程衬底或层转移应用,例如背面照明的CMOS图像传感器。
混合键合扩展了与键合界面中嵌入的金属焊盘的熔融键合,从而允许晶片面对面连接。 混合绑定的主要应用是高级3D设备堆叠。
EVG®301 单晶圆清洗系统
研发型单晶圆清洗系统。
EVG®320 自动化单晶圆清洗系统
自动化的单晶片清洗系统,可有效去除颗粒。
EVG®810LT 低温™等离子体激活系统
适用于SOI,MEMS,化合物半导体和先进基板键合的低温等离子体活化系统。
EVG®850LT SOI和直接晶圆键合的自动化生产键合系统
自动化生产粘合系统,适用于各种融合/分子薄片粘合应用。
EVG®850 SOI和直接晶圆键合的自动化生产键合系统
自动化生产粘合系统,适用于各种融合/分子薄片粘合应用。
NI®FB 自动化生产晶圆键合系统
为精细对准和熔融粘合的集成平台。
BONDSCALE™ 自动化生产熔合系统
启用3D集成可持续更多收益。
EVG®301 Single Wafer Cleaning System
EVG®301 单晶圆清洗系统
研发型单晶圆清洗系统
EVG301半自动化单晶片清洗系统采用一个清洗站,该清洗站使用标准的去离子水冲洗以及超音速,毛刷和稀释化学药品作为附加清洗选项来清洗晶片。
EVG301具有手动加载和预对准功能,是一种多功能的R&D型系统,适用于灵活的清洁程序和300 mm的能力。
EVG301系统可与EVG的晶圆对准和键合系统结合使用,以消除晶圆键合之前的任何颗粒。旋转夹头可用于不同的晶圆和基板尺寸,从而可以轻松设置不同的工艺。
选件
带有红外检查的预粘接台
非SEMI标准基材的工具
技术数据
晶圆直径(基板尺寸)200、100-300毫米
清洁系统:开室,旋转器和清洁臂
兆声区域传感器:频率:1 MHz(3 MHz选件)
输出功率:最大 2.5 W /cm2有效面积(最大输出200 W)
去离子水流量:最高1.5升/分钟
有效的清洁区域:三角形,确保每次旋转时整个晶片的辐射均匀性
材质:不锈钢和蓝宝石;刷;材质:PVA
可编程参数:刷子和晶圆速度(rpm);可调参数(刷压缩,介质分配)
EVG®320 Automated Single Wafer Cleaning System
EVG®320 自动化单晶圆清洗系统
自动单晶片清洗系统,可有效去除颗粒
EVG320自动化单晶圆清洗系统可在处理站之间自动处理晶圆和基板。 机械手处理系统可确保在盒到盒或FOUP到FOUP操作中自动预对准和装载晶圆。 除了使用去离子水冲洗外,配置选项还包括兆频,刷子和稀释的化学药品清洗。
特征
完全由软件控制的清洁过程
EVG320技术数据
晶圆直径(基板尺寸)200、100-300毫米
清洁系统
开室,旋转器和清洁臂
腔室:由PP或PFA制成(可选)
清洁介质:去离子水(标准),其他清洁介质(可选)
旋转卡盘:真空卡盘(标准)和边缘处理卡盘(选件),由不含金属离子的清洁材料制成
旋转:最高3000 rpm(5秒内)
超音速喷嘴:频率:1 MHz(3 MHz选件);输出功率:30-60 W;
去离子水流量:最高1.5升/分钟;有效清洁区域:?4.0 mm;材质:聚四氟乙烯
兆声区域传感器:可选的;
频率:1 MHz(3 MHz选件)
输出功率:最大2.5 W /cm2有效面积(最大输出200 W)
EVG®810 LT LowTemp™ Plasma Activation System
EVG®810LT LowTemp™等离子激活系统
适用于SOI,MEMS,化合物半导体和先进基板键合的低温等离子体活化系统
技术数据
EVG810 LT LowTemp™等离子活化系统是具有手动操作的单腔独立单元。 处理室允许进行异位处理(晶圆被一一激活并结合在等离子体激活室外部)。
特征
表面等离子体活化,用于低温粘结(熔融/分子和中间层粘结)
晶圆键合机制中最快的动力学
无需湿工艺
真空系统:9x10-2 mbar
腔室的打开/关闭:自动化
腔室的加载/卸载:手动(将晶圆/基板放置在加载销上)
可选功能
卡盘适用于不同的晶圆尺寸
无金属离子活化
Si:Si / Si,Si / Si(热氧化,Si(热氧化)/ Si(热氧化)
TEOS / TEOS(热氧化)
绝缘体锗(GeOI)的Si / Ge
硅/氮化硅
玻璃(无碱浮法):硅/玻璃,玻璃/玻璃
化合物半导体:GaAs,GaP,InP
聚合物:PMMA,环烯烃聚合物
用户可以使用上述和其他材料的“最佳已知方法”配方(可根据要求提供完整列表)
EVG®850 LT
Automated Production Bonding System for SOI and Direct Wafer Bonding
EVG®850LT SOI和直接晶圆键合的自动化生产键合系统
自动化生产键合系统,适用于多种融合/分子晶圆键合应用
晶圆键合是SOI晶圆制造工艺以及晶圆级3D集成的一项关键技术。借助用于机械对准SOI的EVG850 LT自动化生产键合系统和具有LowTemp™等离子活化的直接晶圆键合,融合了熔合的所有基本步骤-从清洁,等离子活化和对准到预键合和IR检查-。因此,经过实践检验的行业标准EVG850 LT确保了高达300 mm尺寸的无空隙SOI晶片的高通量,高产量生产工艺。
特征
利用EVG的LowTemp™等离子激活技术进行SOI和直接晶圆键合
适用于各种融合/分子晶圆键合应用 ;
预粘接室
对齐类型:平面到平面或凹口到凹口
对准精度:X和Y:±50 μm,θ:±0.1°
结合力:最高5 N
键合波起始位置:从晶圆边缘到中心灵活
真空系统:9x10-2 mbar(标准)和9x10-3 mbar(涡轮泵选件)
LowTemp™等离子激活模块
EVG®850 Automated Production Bonding System for SOI
EVG®850 SOI的自动化生产粘合系统
自动化生产键合系统,适用于多种融合/分子晶圆键合应用
技术数据
SOI晶片是微电子行业有望生产出更快,性能更高的微电子设备的有希望的新基础材料。晶圆键合技术是SOI晶圆制造工艺的一项关键技术,可在绝缘基板上实现高质量的单晶硅膜。借助EVG850 SOI生产粘合系统,SOI粘合的所有基本步骤-从清洁和对准到预粘合和红外检查-都结合了起来。因此,EVG850确保了高达300 mm尺寸的无空隙SOI晶片的高产量生产工艺。 EVG850是唯一在高通量,高产量环境下运行的生产系统,已被确立为SOI晶圆市场的行业标准。
特征
生产系统可在高通量,高产量环境中运行;
全自动盒带到盒带操作
GEMINI® FB Automated Production Wafer Bonding System
GEMINI®FB 自动化生产晶圆键合系统
集成平台可实现高精度对准和熔合
技术数据
半导体器件的垂直堆叠已经成为使器件密度和性能不断提高的日益可行的方法。晶圆间键合是实现3D堆叠设备的重要工艺步骤。
EVG的GEMINI FB XT集成熔合系统扩展了当前标准,并结合了更高的生产率,更高的对准度和覆盖精度,适用于诸如存储器堆叠,3D片上系统(SoC),背面照明CMOS图像传感器堆叠和芯片分割等应用。该系统具有新的SmartView NT3键合对准器,该键合对准器是专门为<50 nm的熔融和混合晶片键合对准要求而开发的。
ONDSCALE™ Automated Production Fusion Bonding System
BONDSCALE™ 自动化生产熔合系统
启用3D集成以获得更多收益
技术数据
EVG BONDSCALE旨在满足广泛的融合/分子晶圆键合应用,包括工程化的基板制造和使用层转移处理的3D集成方法,例如单片3D(M3D)。借助BONDSCALE,EVG将晶片键合应用于前端半导体处理中,并帮助解决国际设备和系统路线图(IRDS)中确定的“更多摩尔”逻辑器件扩展的长期挑战。结合增强的边缘对齐技术,与现有的熔融粘合平台相比,BONDSCALE大大提高了晶圆粘合生产率,并降低了拥有成本(CoO)。
BONDSCALE与EVG的行业基准GEMINI FB XT自动融合系统一起出售,每个平台针对不同的应用。虽然BONDSCALE将主要专注于工程化的基板键合和层转移处理,但GEMINI FB XT将支持要求更高对准精度的应用,例如存储器堆叠,3D片上系统(SoC),背面照明的CMOS图像传感器堆叠以及管芯分区。
特征
在单个平台上的200 mm和300 mm基板上的全自动熔融/分子晶圆键合应用
通过等离子活化的直接晶圆键合,可实现不同材料,高质量工程衬底以及薄硅层转移应用的异质集成
支持逻辑缩放,3D集成(例如M3),3D VLSI(包括背面电源分配),N&P堆栈,内存逻辑,集群功能堆栈以及超越CMOS的采用的层转移工艺和工程衬底
1年
是
有
技术人员现场培训
2个月1次
软件免费重装,硬件维修
24小时到达
相关产品

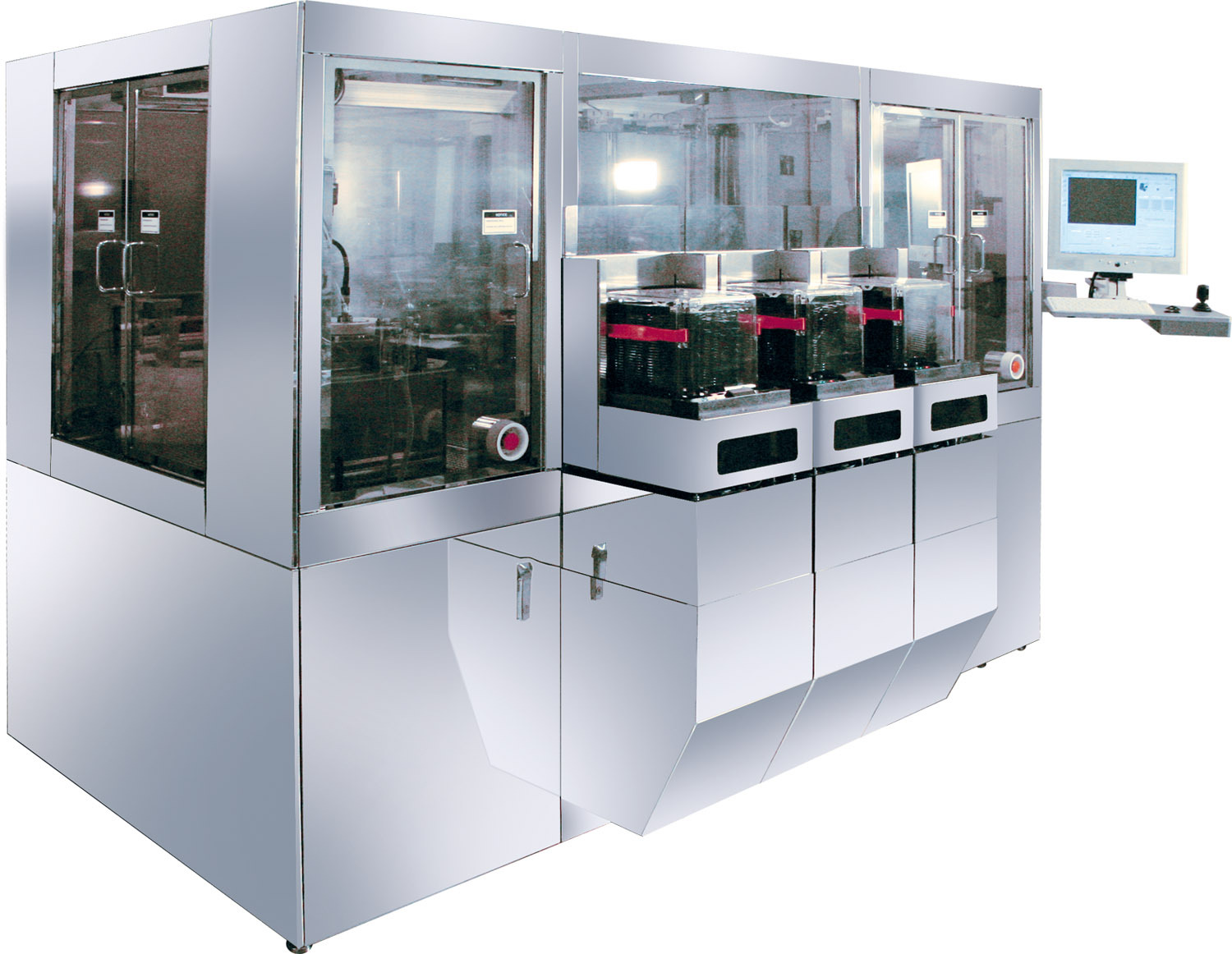


 仪器对比
仪器对比



 关注
关注






