Metrology Systems 计量系统
计量对于控制,优化并确保半导体制造过程中的最高产量至关重要。 通过实施反馈循环,可以启用过程控制和过程参数校正,从而可以满足更严格的过程要求。
EVG的度量衡解决方案针对光刻和所有类型的粘合应用进行了优化,并使用无损测量方法。 客户可以选择将计量技术集成到全自动过程设备中,也可以选择服务于多个过程步骤的独立计量系统。
EVG®20
红外线检查系统
快速检查键合晶圆叠层的空隙。
EVG®40NT
自动化测量系统
适用于键合和光刻的多功能,高精度度量衡。
EVG®50
自动化计量系统
适用于键合叠层和单晶片的高通量,高分辨率度量衡。
EVG®20 IR Inspection System
EVG®20 红外线检查系统
快速检查键合晶圆叠层的空隙
特征
EVG20提供了一种快速检查方法,尤其是对于熔融粘合晶圆。 整个晶片的实时图像通过IR传输支持半径小于0.5 mm的空隙检测。 红外检测系统非常适合作为单独的EVG20工具或作为EVG集成粘合系统中的工作站的熔合工艺。
特征
实时成像
 一次性检查整个晶圆
一次性检查整个晶圆
可选的粘结销,用于实时可视化直接粘结
Maszara测试兼容
空隙尺寸检测小至0.5 mm半径
EVG®40 NT Automated Measurement System
EVG®40NT 自动化测量系统
适用于键合和光刻的多功能,高精度计量
特征
EVG40 NT(独立工具)和AVM(集成了HVM的模块)能够测量与光刻相关的参数,例如临界尺寸以及键合对准精度。由于系统具有很高的测量精度,因此可以验证是否符合严格的工艺规范并立即优化集成的工艺参数。
凭借其多种测量方法,EVG40 NT可以同时适应多种制造工艺,例如纳米压印光刻或晶圆间键合。
作为一个应用实例,EVG40 NT完善了EVG的产品范围,以实现高精度对准晶圆键合,作为记录工具,可以可靠地验证EVG的GEMINI FB自动熔合的100 nm键合覆盖精度。
特征
光刻和键合计量的多功能测量选项
粘接和光刻应用的对准验证
上下显微镜用于多种测量方法
临界尺寸(CD)测量
芯片对芯片对准验证
多层厚度测量
垂直和水平方向的测量精度高
专门的校准程序可实现高通量
基于PC的测量和模式识别软件可实现最高可靠性
EVG®50 Automated Metrology System
EVG®50 自动化计量系统
适用于键合叠层和单晶片的高通量,高分辨率计量
特征
EVG50(全自动独立工具)和在线计量模块(集成在EVG的大批量生产系统中)可在各种应用中采用不同的测量方法,从而实现高速,高精度的测量。
该工具的应用范围包括用于确定中间层的总厚度变化(TTV)的多层厚度测量,键合界面的检查以及抗蚀剂厚度的测量,并满足了良率驱动的半导体行业的最苛刻要求。
特征
具有业界领先的吞吐量和分辨率的多层计量
多层厚度映射
绑定界面检查
低接触边缘处理
无颗粒
全区域可访问的正面和背面
自校准可提高系统重现性并延长生产时间
 多种输出格式
多种输出格式
100%生产检验
1年
是
有
技术人员现场培训
2个月1次
软件免费重装,硬件维修
24小时到达
相关产品


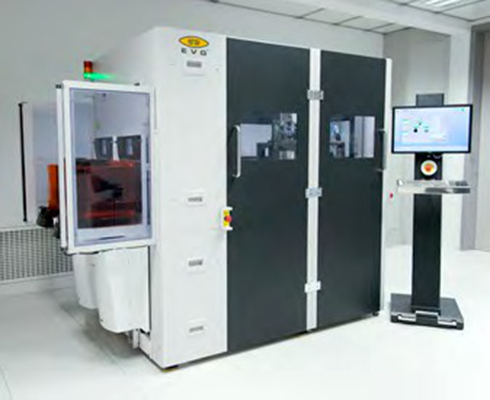


 仪器对比
仪器对比



 关注
关注






