
方案摘要
方案下载| 应用领域 | 其他 |
| 检测样本 | 其他 |
| 检测项目 | |
| 参考标准 | 无 |
上海伯东美国 KRi 考夫曼品牌 RF 射频离子源, 无需灯丝提供高能量, 低浓度的宽束离子束, 离子束轰击溅射目标, 溅射的原子(分子)沉积在衬底上形成薄膜, IBSD 离子束溅射沉积 和 IBD 离子束沉积是其典型的应用.
‍‍
上海伯东美国 KRi 射频离子源 IBSD 离子束溅射沉积应用
上海伯东美国 KRi 考夫曼品牌 RF 射频离子源, 无需灯丝提供高能量, 低浓度的宽束离子束, 离子束轰击溅射目标, 溅射的原子(分子)沉积在衬底上形成薄膜, IBSD 离子束溅射沉积 和 IBD 离子束沉积是其典型的应用.
KRi 离子源在 IBSD 离子束溅射沉积应用
通常安装两个离子源
主要溅射沉积源和二次预清洁 / 离子辅助源
一次气源为惰性气体, 二次气源为惰性或反应性气体
基板远离溅射目标
工艺压力在小于× 10-4 torr‍‍‍‍‍‍
‍‍
离子源在离子束溅射沉积工艺过程: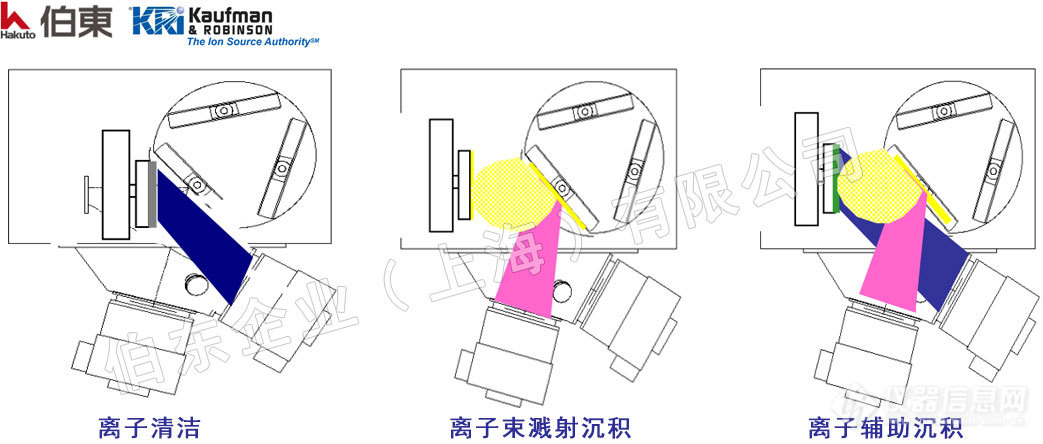
上海伯东美国 KRi 射频离子源优势
提供致密, 光滑, 无针孔, 耐用的薄膜
远离等离子体: 低基材温度
不需要偏压衬底
溅射任何材料, 不需要射频溅射电源
非常适用于复杂, 精密的多层薄膜制备
清洁, 低污染工艺
沉积原子为坚硬, 耐用的薄膜保留溅射能量
离子能量, 离子电流密度的控制
优良的反应沉积工艺
美国 KRi RFICP 射频离子源技术参数:
型号 | RFICP 40 | RFICP 100 | RFICP 140 | RFICP 220 | RFICP 380 |
Discharge 阳极 | RF 射频 | RF 射频 | RF 射频 | RF 射频 | RF 射频 |
离子束流 | >100 mA | >350 mA | >600 mA | >800 mA | >1500 mA |
离子动能 | 100-1200 V | 100-1200 V | 100-1200 V | 100-1200 V | 100-1200 V |
栅极直径 | 4 cm Φ | 10 cm Φ | 14 cm Φ | 20 cm Φ | 30 cm Φ |
离子束 | 聚焦, 平行, 散射 | ||||
流量 | 3-10 sccm | 5-30 sccm | 5-30 sccm | 10-40 sccm | 15-50 sccm |
通气 | Ar, Kr, Xe, O2, N2, H2, 其他 | ||||
典型压力 | < 0.5m Torr | < 0.5m Torr | < 0.5m Torr | < 0.5m Torr | < 0.5m Torr |
长度 | 12.7 cm | 23.5 cm | 24.6 cm | 30 cm | 39 cm |
直径 | 13.5 cm | 19.1 cm | 24.6 cm | 41 cm | 59 cm |
中和器 | LFN 2000 | ||||
‍‍
上海伯东美国 KRi 射频离子源 RFICP 系列, 无需灯丝提供高能量, 低浓度的离子束, 通过栅极控制离子束的能量和方向, 单次工艺时间更长! 射频离子源适合多层膜的制备, 离子溅镀镀膜和离子蚀刻, 改善靶材的致密性, 光透射, 均匀性, 附着力等. 上海伯东是美国 KRi 离子源中国总代理.
上海伯东同时提供溅射沉积系统所需的涡轮分子泵, 真空规, 高真空插板阀等产品, 协助客户生产研发高质量的真空系统.
1978 年 Dr. Kaufman 博士在美国创立 Kaufman & Robinson, Inc 公司, 研发生产考夫曼离子源, 霍尔离子源和射频离子源. 美国考夫曼离子源历经 40 年改良及发展已取得多项专利. 离子源广泛用于离子清洗 PC, 离子蚀刻 IBE, 辅助镀膜 IBAD, 离子溅射镀膜 IBSD 领域.
若您需要进一步的了解 KRi 射频离子源, 请联络上海伯东叶女士
上海伯东版权所有, 翻拷必究!‍‍
‍‍

上海伯东 Europlasma 等离子表面处理设备在医疗器械行业的应用
上海伯东 Europlasma 纳米亲水涂层在氢燃料电池外壳中的应用
上海伯东 Europlasma 低压等离子设备在气体和液体过滤介质中的应用
相关产品
inTEST 热流仪 5G 通讯模块高低温冲击测试
聚丙烯 PP膜等离子表面亲水改性设备
气体和液体过滤介质用低压等离子表面处理设备
微控制器 MCU 芯片高低温测试机,美国 inTEST 热流仪
美国 inTEST 汽车芯片用高低温测试机,热流仪
功率器件高低温冲击测试机,美国 inTEST 热流仪
PMMA 亚克力板等离子表面活化机
IBF 离子束抛光工艺用考夫曼离子源
IBAD 辅助镀膜用考夫曼离子源
LED-DBR 辅助镀膜用离子源
上海伯东美国 KRi 大面积射频离子源 RFICP 380
上海伯东美国 KRi 霍尔离子源 eH 3000
上海伯东美国 KRI 霍尔离子源 ,霍尔源eH 2000
上海伯东美国 KRI 霍尔离子源 eH 1000
KRI 霍尔离子源, 霍尔源,eH 400

关注

拨打电话

留言咨询