推荐厂家
暂无
暂无
 留言咨询
留言咨询
 400-895-0897
400-895-0897
 留言咨询
留言咨询
 留言咨询
留言咨询

 400-666-7037
400-666-7037
 留言咨询
留言咨询

 留言咨询
留言咨询
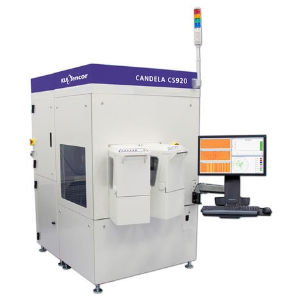
 400-860-5168转4306
400-860-5168转4306
 留言咨询
留言咨询






我现在使用的薄膜,可以渗透水蒸气,但是不能透过液态水。所以想找相关得仪器测试测试一下薄膜表面能够穿透薄膜的孔的大小,做过扫面电镜和比表面积及孔径分析仪的检测,扫面电镜只能看到薄膜表面的凹坑,不能确定这个凹坑是否穿透薄膜。孔径分析也是这样,测得都是凹坑的孔径分布。但我现在想做穿透孔的测试,望大神们给予建议,谢谢!
我现在使用的薄膜,可以渗透水蒸气,但是不能透过液态水。所以想找相关得仪器测试测试一下薄膜表面能够穿透薄膜的孔的大小,做过扫面电镜和比表面积及孔径分析仪的检测,扫面电镜只能看到薄膜表面的凹坑,不能确定这个凹坑是否穿透薄膜。孔径分析也是这样,测得都是凹坑的孔径分布。但我现在想做穿透孔的测试,望大神们给予建议,谢谢!
[b][font=宋体][color=black]【序号】:1[/color][/font][font='微软雅黑',sans-serif][color=black][/color][/font]【作者】:[size=16px][b]王悦[/b][/size][/b][font=&]【题名】:[b][b][b]光学元件亚表面缺陷检测自动调平与对焦研究[/b][/b][/b][/font][font=&]【期刊】:cnki[/font][b][color=#545454]【链接]: [url=https://kns.cnki.net/kcms/detail/detail.aspx?dbcode=CMFD&dbname=CMFD202101&filename=1021001205.nh&uniplatform=NZKPT&v=xYGHSdLttNdKdrQ4eSEtVhLFx0cYpkq8yjYDo-JSapNdufFHtF5fAnmFys_fHVpk]光学元件亚表面缺陷检测自动调平与对焦研究 - 中国知网 (cnki.net)[/url][/color][/b]


