优势特点1)样品处理开始后样品池中真空度可达到10-3 Pa;2)样品测量过程中各样品可同时或分别进行预处理、吸附、脱附探针分子;3)测量所需探针分子为酸性或碱性分子,高硼硅玻璃材质避免了各类气体的相互污染;4)真空处理系统由机械泵与玻璃四级扩散泵串联组成,可满足样品测试所需的高真空度的要求,具有抽速快、体积小、噪音低、操作简单、使用方便等特点;5)低真空部分主要是抽除系统中的高浓度气体或吸附的残余气体;6)各部分节门选用高硼硅玻璃节门,满足系统高真空的要求,透明性操作,便于调试;7)真空测量仪使用数显高精密真空计;8)本系统所配透过式石英红外吸收池,可对样品进行陪烧、流动氧化还原、抽空脱气、吸附反应等处理过程,可随时移入或移出到红外光谱仪的光路中进行实验,对样品的加热温度可达450度;9)波纹管更换方便。10)高真空系统和原位红外吸收池可按客户要求进行更改和定制。产品应用1 吸附态研究和催化剂红外光谱表征红外光谱已经广泛应用于催化剂表面性质的研究,其中有效和广泛应用的是研究吸附在催化剂表面的所谓“探针分子”的红外光谱,如:NO、CO、CO2、NH3、C3H5N等,红外光谱表征可以提供催化剂表面尤其是原位反应条件下催化剂表面存在的“活性中心”和表面吸附物种的信息,因此对于揭示催化反应机理十分重要。1.1 CO吸附态研究CO具有很高的红外消光系数,其未充满的空轨道很容易同过渡金属相互作用,同时许多重要的催化反应如羰基合成、水煤气合成、费托合成等均与CO密切相关,因此,研究CO在过渡金属表面的吸附态是一项十分广泛的研究课题。1.2催化剂表面组成测定合金催化剂表面组成与体相组成的差异会导致催化剂的性能显著不同,因此,测定催化剂的表面组成对理解反应的活性位相当重要。利用两种气体混合物在双组份过渡金属催化剂表面上的竞争吸附,并通过红外光谱测定其强度,可以方便地测定双金属负载催化剂的表面组成。典型的例子是CO和NO在Pt-Ru双金属催化剂上共吸附的红外光谱。1.3几何效应和电子效应研究在高分散金属催化剂中引入第二金属组元,由于金属间的几何效应和电子效应可显著改变催化剂的吸附性能从而改变催化活性。如在Pd-Ag/SiO2催化剂体系中,Ag对Pd起稀释作用,当Ag含量增加,成双存在的Pd浓度减少,因而桥式CO减少,线式CO增加,说明几何效应改变了CO在Pd-Ag/SiO2体系中的吸附性能,同时,随Ag含量的增加,CO吸附谱带红移加大,说明Pd-Ag之间存在电子效应。1.4吸附分子相互作用研究CO吸附在过渡金属表面时存在d-π反馈,nco同d-π反馈程度有有关,而d-π反馈程度与金属本身的d轨道情况有关,因此,通过CO吸附态的红外吸收光谱的化学位移,可以考察其它分子与CO共同吸附时导致的分子与金属组元之间的电子转移过程。如:当能够给出电子的Lewis碱与CO共吸附在Pt上时,根据d-π反馈原理,吸附在Pt上的CO伸缩振动向低波数位移,而当能够接受电子的受体与CO共吸附在Pt上时,根据d-π反馈原理,吸附在Pt上的CO伸缩振动向高波数位移。2 氧化物、分子筛催化剂的红外光谱表征2.1 固体表面酸性测定固体表面酸性位一般可看作是氧化物催化剂表面的活性位。在众多催化反应如催化裂化、异构化、聚合等反应中烃类分子与表面酸性位相互作用形成正碳离子,该正碳离子是反应的中间物种。正碳离子理论可以成功解释烃类在酸性表面上的反应,也对酸性位的存在提供了有力证明。为了表征固体酸催化剂的性质,需要测定表面酸性位的类型(Lewis酸,Bronsted酸)、强度和酸量。测定表面酸性的方法很多,如碱滴定法、碱性气体吸附法、热差法等,但这些方法都不能区分L酸和B酸部位。红外光谱法则广泛用来研究固体催化剂表面酸性,它可以有效区分L酸和B酸,在该方法中,常用碱性吸附质如氨、吡啶、三甲基胺、正丁胺等来表征酸性位,其中应用比较广泛的是吡啶和氨。2.2 氧化物表面羟基的研究氧化物尤其是大比表面的氧化物的表面结构羟基同许多催化反应如脱水反应、甲酸分解反应等有关,而表面结构羟基的性质又同表面酸性有密切的关系,多年来,人们对氧化物表面羟基进行了大量的研究,其中大部分研究着眼于氧化物表面羟基的结构、性质以及同酸性中心的关系,进而同催化剂的反应性能相关联。研究催化剂表面结构羟基的方法很多,但卓有成效的是红外光谱法。2.3 氧化物表面氧物种研究甲烷是烃类分子中结构简单、对称、化学惰性的分子,从基础研究角度认识以甲烷为代表的低碳烃类活化机理具有极大的学术意义。但是,甲烷分子很难吸附在催化剂表面上,因此很难直接观察到它在氧化物表面的活化过程。而氧化物表面(尤其碱性氧化物表面)的氧物种研究由于表面存在一层稳定的碳酸盐使得对其研究十分困难。鉴于上述原因,氧化物表面氧物种的研究一直没有取得重大进展。近年来采用了“化学捕集”技术、同位素交换技术和低温原位红外光谱方法相结合应用于上述研究取得了一些关于表面氧物种和甲烷活化的重要信息。3 原位红外光谱应用于反应机理研究长期以来人们研究了各种分子在催化剂表面的吸附态并获得了许多重要的信息,但是这些信息都是在反应没有发生时测得的。而反应条件下的吸附物种的类型、结构、性能与吸附条件下的吸附物种的类型、结构、性能有很大差别,因此,仅利用吸附条件下分别测得的吸附物种信息无法准确阐明反应机理,为此,进行反应条件下吸附物种的研究十分必要。而在反应条件下催化剂表面吸附的物种并未都参与反应,因此如何在多种吸附物种中识别出参与反应的“中间物种”是非常重要的课题。原位红外光谱可以测量催化剂在反应状态下吸附物种的动态行为,因此可以获得催化剂表面物种的动态信息,并可据此推断反应机理。详细介绍原位红外光谱表征高真空系统是用于测定催化剂表面组成、吸附、酸性、物种、表面羟基及反应机理的专用设备,包括高真空系统和原位红外吸收池两部分,可以配合Bruker布鲁克等主要红外光谱仪进行氨、吡啶、一氧化碳、一氧化氮、甲醇、乙醇等化合物的化学吸附测定及反应机理研究。催化剂表征对于了解催化剂结构和组成在预处理、诱导期和反应条件下以及再生过程中所发生的变化是至关重要的。催化反应机理的知识、特别是结构、动态学和沿催化反应途径中生成的反应中间物的能量学可为开发新催化剂和改良现有催化剂提供更深刻的认识。原位谱学观察又是阐明反应机理、分子与催化剂相互作用的动态学和中间物结构的有效技术。这些研究还可以提供有关催化剂和底物相互作用及有关活化势垒的热力学方面信息。反应机理和动力学的研究,特别是对催化反应中间物的原位观察,对发展催化科学是非常必要的。因为这样的研究结果提供了催化作用的全面知识,并有助于阐明催化剂结构和功能的关系。高真空系统由玻璃四级扩散泵、真空泵、精密真空表、电离规、集气瓶、球形安瓶、制备瓶、可伐、真空活塞等组成。该系统的高真空是通过一台优质低噪声的机械泵和一台玻璃四级扩散泵组成的机组而获得。原位红外吸收池由石英制成,分样品台和真空密封窗口两部分。样品台带有加热组件、热电偶、冷却系统和气体引入系统;真空密封窗口由冷却系统和CaF2窗片组成。该吸收池采用透射模式进行红外光谱表征,可对样品进行焙烧、流动氧化还原、抽空脱气、吸附反应等处理过程,可随时移入或移出到红外光谱仪的光路中,也可利用配备的延长管路进行原位表征实验。样品的加热采用程序升温方法控制温度,温度可达450℃。标准配置的吸收池窗口材料为CaF2,工作区间为4000—1000cm-1,也可按用户需要配置其他窗口材料。表1 红外窗口材料的性质材料使用范围cm-1反射损失*(1000cm-1)溶解度 g/100ml@20oC相对价格物理性质NaCl5000至6257.5%401.0溶于水,硬但易抛光和切割,潮解慢KBr5000至4008.5%701.2溶于水,较软但易抛光和切割,潮解慢,价格高,范围宽CsI5000至18011.5%807.8溶于水,软且易划伤,不能切割,潮解慢CaF25000至10005.5%难溶3.5难溶于水,耐酸碱,不潮解,忌用于铵盐溶液BaF25000至7507.5%不溶6.2类似于CaF2,对热和机械振动敏感SrF25000至8506%不溶5.1类似于CaF2,对热和机械振动敏感AgCl5000至45019.5%不溶6.6不溶于水但溶于酸和NH4Cl溶液,可延展,长期暴露于紫外光变暗,腐蚀金属及合金AgBr5000至28025%难溶难溶于水,软且易划伤,冷变形长期暴露于紫外光变暗KRS-55000至25028%0.19.1微溶水,溶于碱但不溶于酸, 软且易划伤,冷变形,剧毒Infrasil(SiO2)5000至2850NA不溶不溶于水,溶于HF溶液,微溶于碱难切割Poly-ethylene625至10NA不溶1.6不溶于水,耐溶剂,软易溶胀,难清洗,可压片*两个面上的反射损失, NA 不透明. 玻璃高真空系统部分组成及说明请参阅图1所示,本玻璃高真空实验测试系统,主要应用红外光谱催化剂原位表征、催化剂表面吸附物种和催化剂表征方面(探针分子的红外光谱)以及反应动态学方面的研究。该系统包括由机械真空泵A,真空波纹管B,可伐KF接头C,缓冲球D,组成一级真空泵,用于抽取低真空段,该部分真空可以抽取到1.0Pa;玻璃扩散泵E,用于提升真空度,提升真空度到10-2-10-3Pa,此为二级真空泵,液氮冷阱F,用于冷却系统中杂质气体,也有利于帮助提高真空度;真空规管G和精密真空表J,分别用于测量系统的高真空度及低真空度;玻璃球瓶H、I为储气瓶,用于储存备用纯化好的气体;玻璃管P为高真空部,为工作玻璃管,为该系统的核心部分;玻璃管Q为低真空部,用于连接测试样品池M,进气接口L,为工作管P服务,并实现高低真空的转换;玻璃制备瓶K,用于气体的纯化与制备;制备安瓶N,用于液体的纯化与制备;该系统全部采用玻璃真空阀门,更好的保证了气密性,02,03为三通玻璃真空阀门(详图2),01、04、05、06、07、08、09、10、11为二通玻璃真空阀门(详图3)。本实用新型中所采用的管路均为玻璃管路,所采用的阀门均为玻璃高真空阀门,真空阀门可以保证系统使用过程中不会产生漏气或缓慢渗漏的情形。图1-C中不锈钢管与玻璃管路采用可伐(Kovar)连接。
 留言咨询
留言咨询
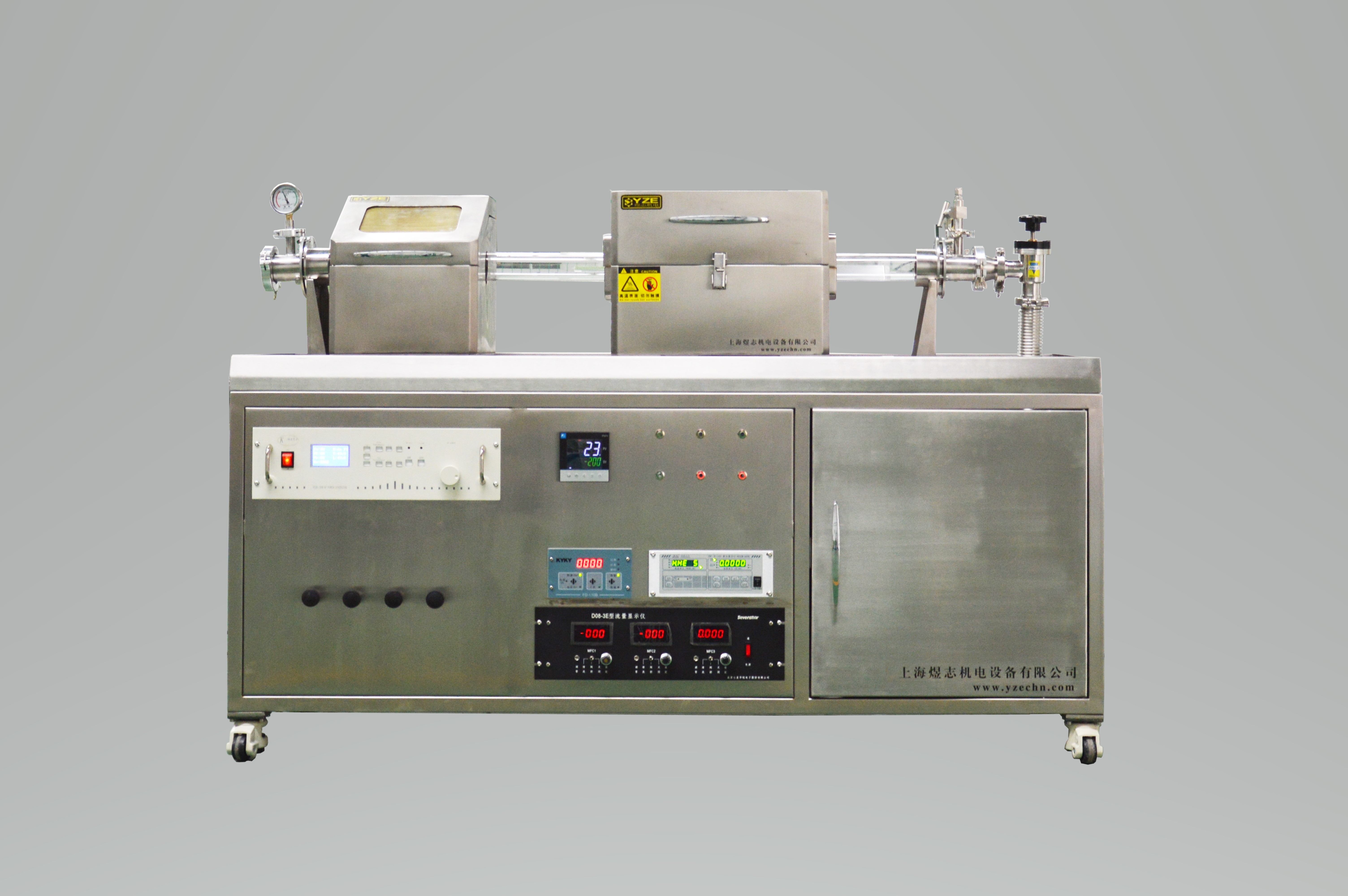
 400-860-5168转4224
400-860-5168转4224
 留言咨询
留言咨询

 400-860-5168转1978
400-860-5168转1978
 留言咨询
留言咨询

 留言咨询
留言咨询

 留言咨询
留言咨询

 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询

 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询

 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询

 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询

 400-860-5168转1988
400-860-5168转1988
 留言咨询
留言咨询

 400-860-5168转1374
400-860-5168转1374
 留言咨询
留言咨询

 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询

 400-860-5168转1978
400-860-5168转1978
 留言咨询
留言咨询

 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询
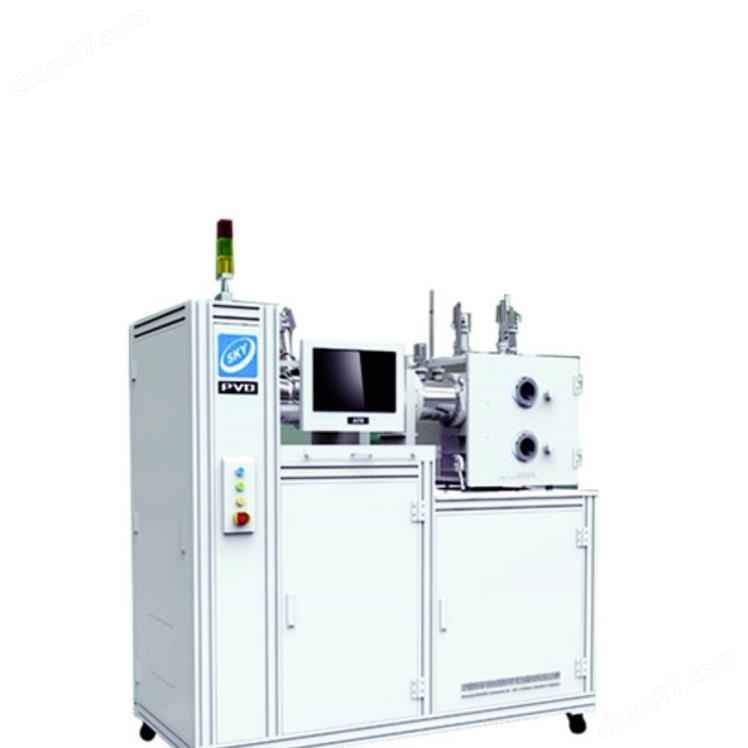
 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询
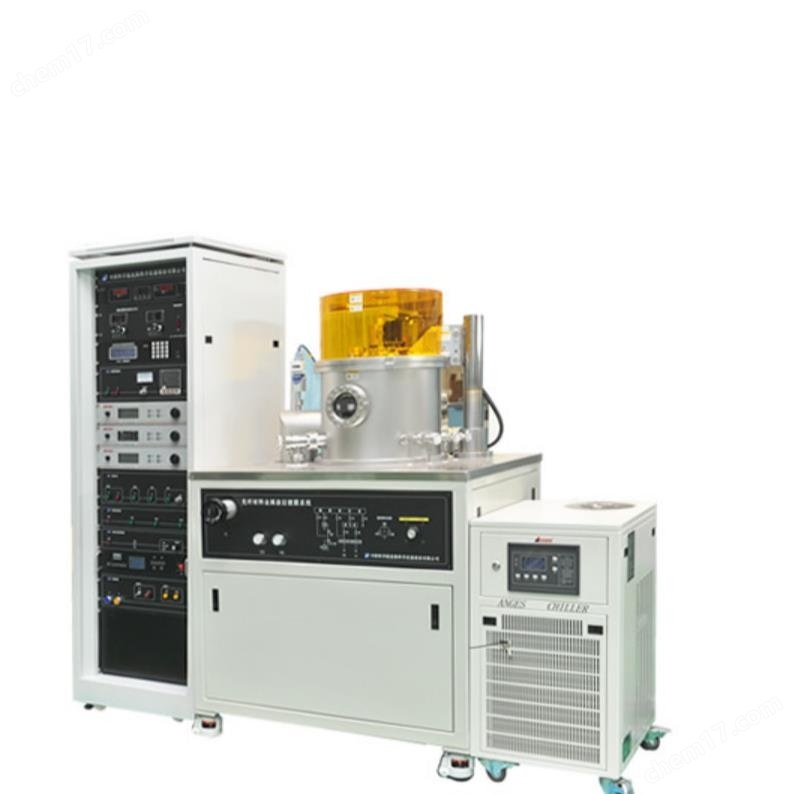
 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询

 400-860-5168转1374
400-860-5168转1374
 留言咨询
留言咨询
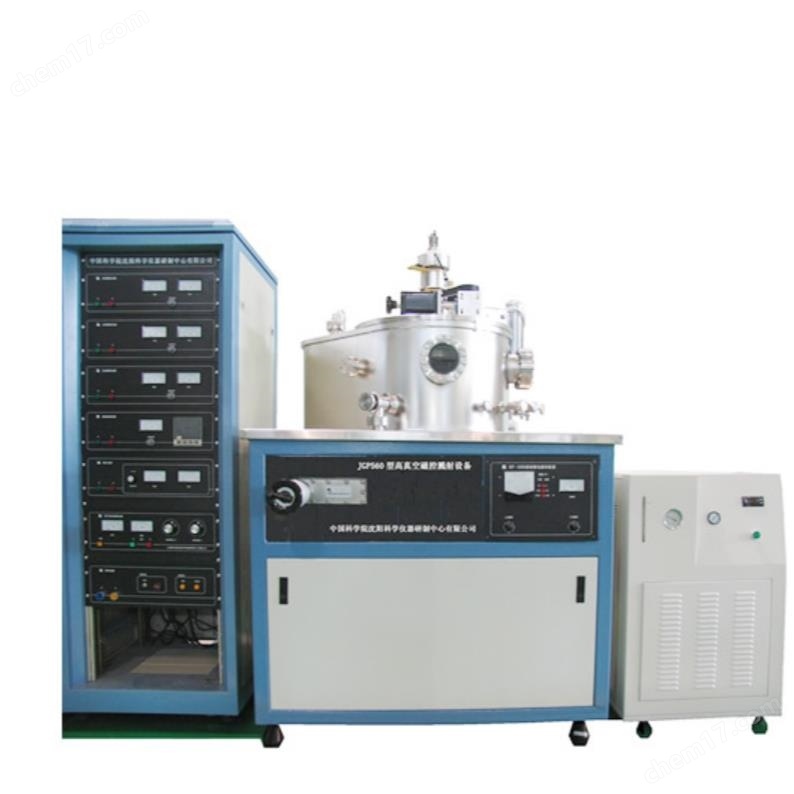
 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询

 400-860-5168转1374
400-860-5168转1374
 留言咨询
留言咨询

 400-860-5168转4994
400-860-5168转4994
 留言咨询
留言咨询

 400-860-5168转4994
400-860-5168转4994
 留言咨询
留言咨询

 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询
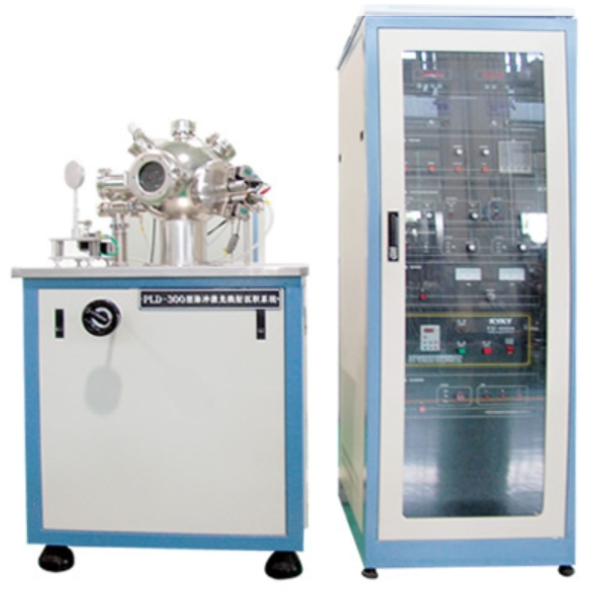
 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询
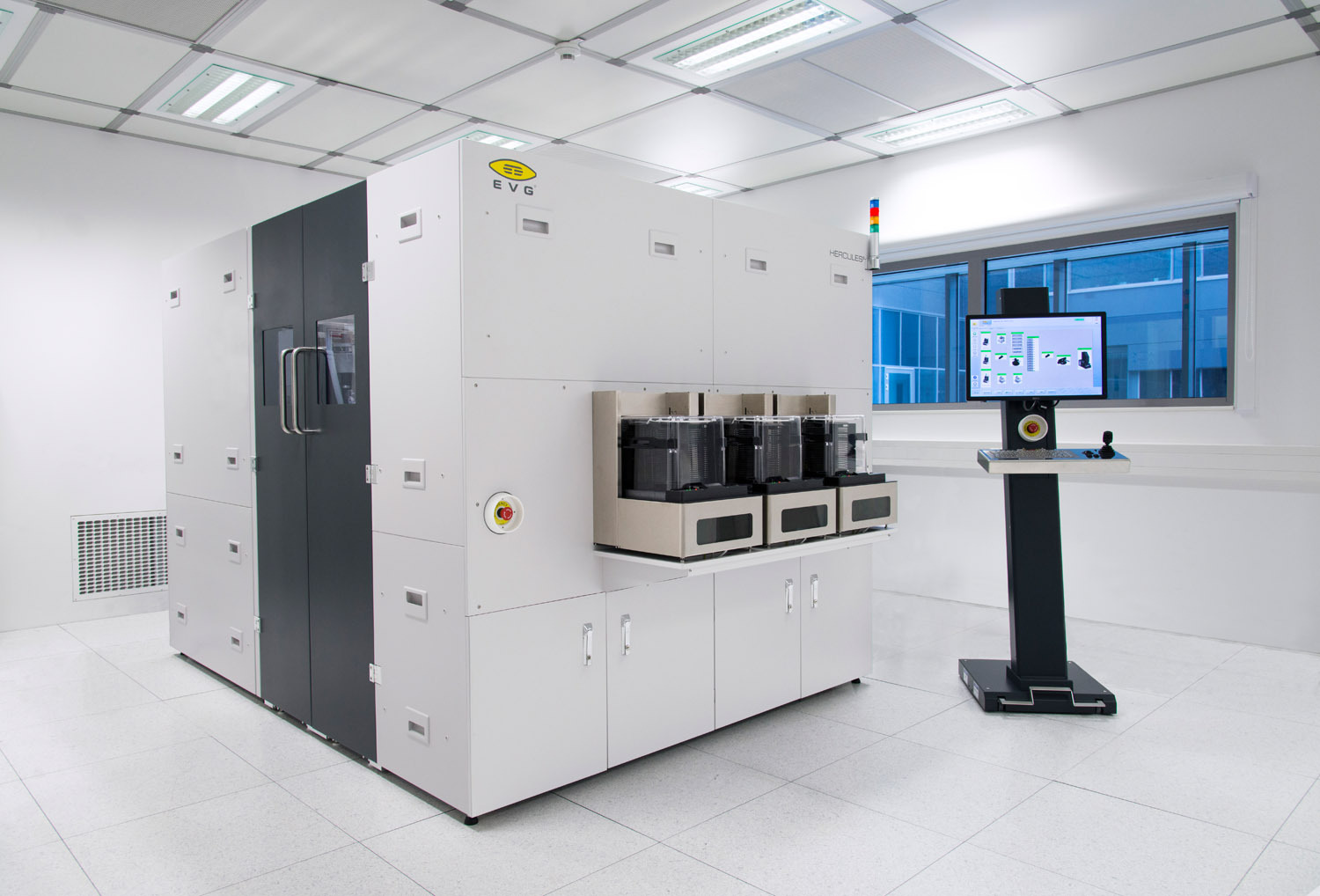
 400-860-5168转4552
400-860-5168转4552
 留言咨询
留言咨询

 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询

 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询
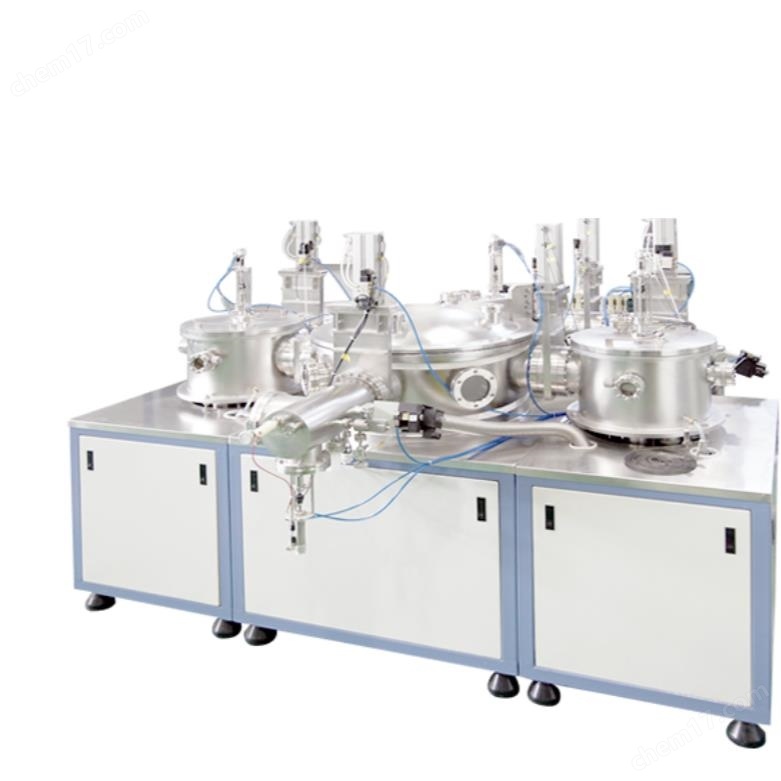
 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询

 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询
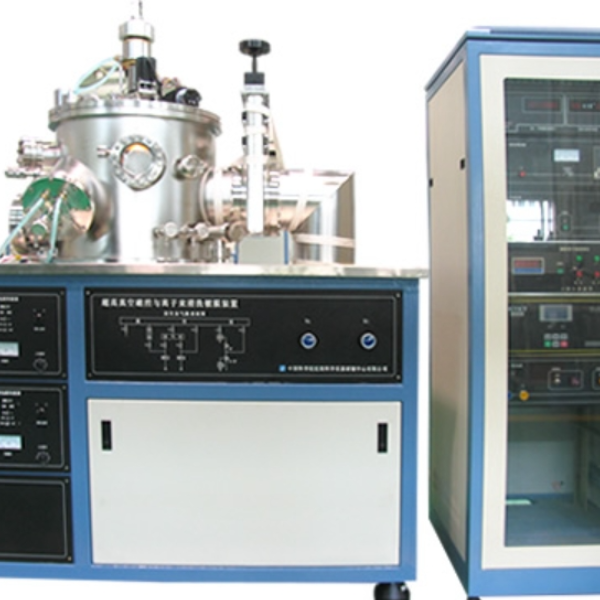
 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询

 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询

 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询