NEW !!Table Top Shadow Moiré (TTSM)For fast, room temperature warpage metrologyShadow Moiré 技术Shadow Moiré 是一种非接触式,全视野的光学技术,它用样品上的参考光栅和它的影子之间的几何干扰产生摩尔云纹分布图(Moiré Pattern),进而计算出各像素位置中的相对垂直位移。它需要一个伦奇刻划光栅(Ronchi-ruled grating),一条大约45度角的光源和一个垂直于光栅的相机。Shadow Moiré的Phase stepping技术来增加测量分辨率,右图中示出其光学集成的图像与加热腔室。新一代表面测量和分析技术Akrometrix 的ZGTherMoiré技术是行业领xian的热变形翘曲分析技术。自一九九八年以来,TherMoiré产品作为翘曲管理解决方案,服务于全球企业。TherMoiré技术可以模拟回流焊工艺和操作环境条件、同时捕捉一个完整的历史翘曲位移表现。运用这一重要的信息,获得元器件/基板翘曲度的一致性来直接影响一级和二级装配产量和提高产品的可靠性。可应用于研发/诊断/生产监控,测试结果符合国际标准(JEDEC, JEITA等),测试精度为微米级,极大的满足了高端客户对翘曲测试监控的要求,是国际主流并被JEDEC, JEITA等标准推荐的测试方法,主要的参数有 Coplanarity, JEITA ED7306 (Normalized Diagonals Signed Warpage), JEDEC 22B112 (Full Field Signed Warpage), IPC TM-650(Twist & Bow), IPC 9641 (BGA vs PCB Gap Analysis), CTE 等。TherMoiré AXP 产品特性● 最大样品尺寸: 400mm x 400mm● 最小样品尺寸: 0.5mm x 0.5mm (如配备DFP功能时)● 在2秒内获得140万个数据点● 最高每秒加热1.5oC摄氏度● 红外线加热和对流冷却来控制温度● 高分辨率测量小型样品● XY 轴应变STRAIN和热膨胀系数CTE 计算● 运用QL冷却系统提高实验能力● 支持从室温到300oC以下的回流炉温度模拟,以及-50oC至300oC度可靠性测试选项● 软件成熟,可独立PC运行做进一步离线分析● 样品追踪功能支持多样品同时测试,提高产量 针对细小样品也能测量热变形印刷电路板 插座QFN (3mm x 3mm)Akrometrix DFP(Digital Fringe Projection) 解决方案新的独立产品提供纯对流加热组装回流模拟方式!能有效测量带台阶的样品及保留钖球的测量!● 启用台阶高度和间断表面测量● FOV 可以移动到样品上的任何位置(Gantry fixture)● 改进的顶部/底部的温度均匀性 – 无光栅● 应用于锡球的共面性测量,非连续面和插座测量● 高锡球的共面性测量X / Y分辨率● 最大 FOV : 48mm x 64mm● 最大样品尺寸: 300mm x 300mm● 最小样品尺寸: 5mm x 5mm● Z-轴分辨率 : 5 microns● Z-轴准确性 : 5 micronsCXP放映机/相机门口GantryBGA 高锡球测量启用台阶高度和间断表面测量FOWLP 的翘曲解决方案 - AKM600P FOWLP Akrometrix AKM600P是专为FOWLP市场设计的翘曲量测解决方案● 利用影子摩尔shadow moiré 技术进行翘曲量测, Z轴分辨率可达1.25μm● 可进行晶圆与平板大面积的翘曲量测● 全视场FOV成像, 不论晶圆大小都可"单次捕获"整个晶圆/平板, 捕捉时间少于2秒● 测量面积: 600mm x 600mm● 采用NIST标准进行标定● 如需使用26°C ~ 300°C的热变形测量, 可选配加热装置 Fan Out Wafer Level Processing (FOWLP)扇出晶圆加工Digital Image Correlation - DIC (2.0) 模组● Add-on 模组: AXP & PS200S● Strain和CTE 测量模组● 资料获取时间: 1 second● In-Plane 应变分辨率: 1.0 μm● Strain 分辨率: 150 microstrain (Δ L/L x 10-6)● 温度范围: 26°C to 300°C● 视线范围: 75 mm x 75 mmDIC 2.0 模组装配在TherMoiré AXP内Strain measurement can be critical for components, PBCs, and material layersMean strain values usedfor CTE calculation Akrometrix Studio 软件包Akrometrix Studio 8.2 是一套先进的集成软件模块, 提供了一套最全面的表面表征和分析能力提供一起运作。 当用到 TherMoiré AXP 表面量测系统十, Studio 6.0 可组成一套测量解决方案, 产生快速,全面表征了广泛的微电子部件和组件的表面信息。Studio 8.2 使用不同种类的强大图形和分析功能为用户得出结论,并作出决定 。Studio 8.2 Die/Package Tilt样品追踪:自动智能追踪,实现批量测试功能 Interface Analysis软件实时监测回流过程中PCB及元器件变形情况3D图形分析软件* HNP/H0P(头枕效应)* 短路* 断路 三维图形分析 -在回流过程中的组件之间的间隙通过/警告/失败图形Pass/Warning/Fail Maps SMT Assembly解决方案 AXP CRE 模组 (Convention Reflow Emulation 模组)它结合了最大分辨能力的AXP与测量间断表面的能力!● 对流加热和冷却● 生产/装配对流回流炉的温度均匀一致● 亚微米分辨率的功能/多部分测试● 最大 FOV : 70mm 圆形CRE 模块的样品台Studio软件的实时分析功能 (Real-time Analaysis)它結合了高批量的測試 “Go/No Go” 準則!● 量测后即时看到“通过/失败”指标● 应用于测量结果时,用户可自行定制● “合格/不合格”的标准● 与样品跟踪多个样品测试一起运作● 在室温下和在热外貌下工作
 留言咨询
留言咨询

 400-860-5168转6117
400-860-5168转6117
 留言咨询
留言咨询
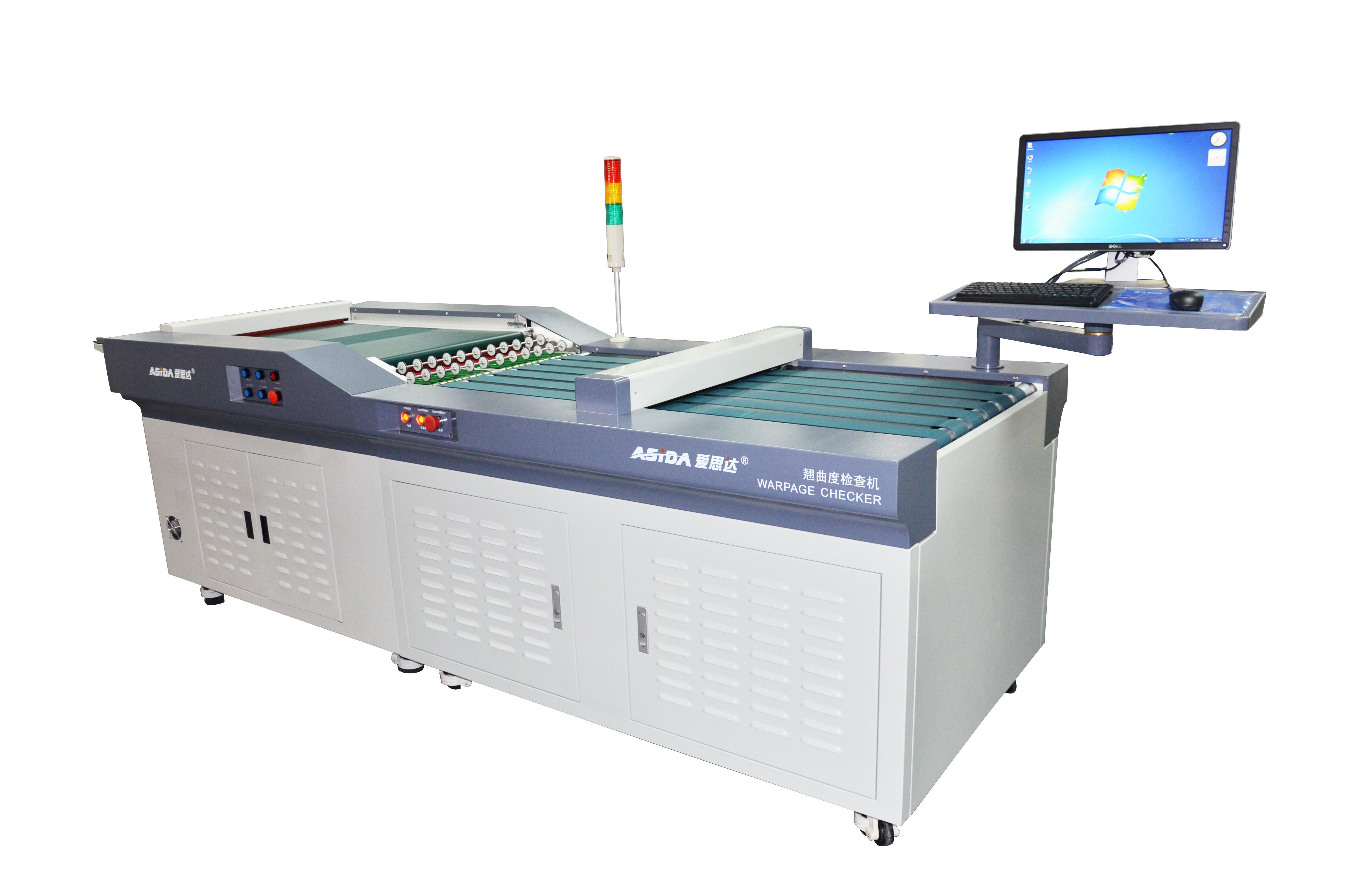
 400-860-5168转2189
400-860-5168转2189
 留言咨询
留言咨询
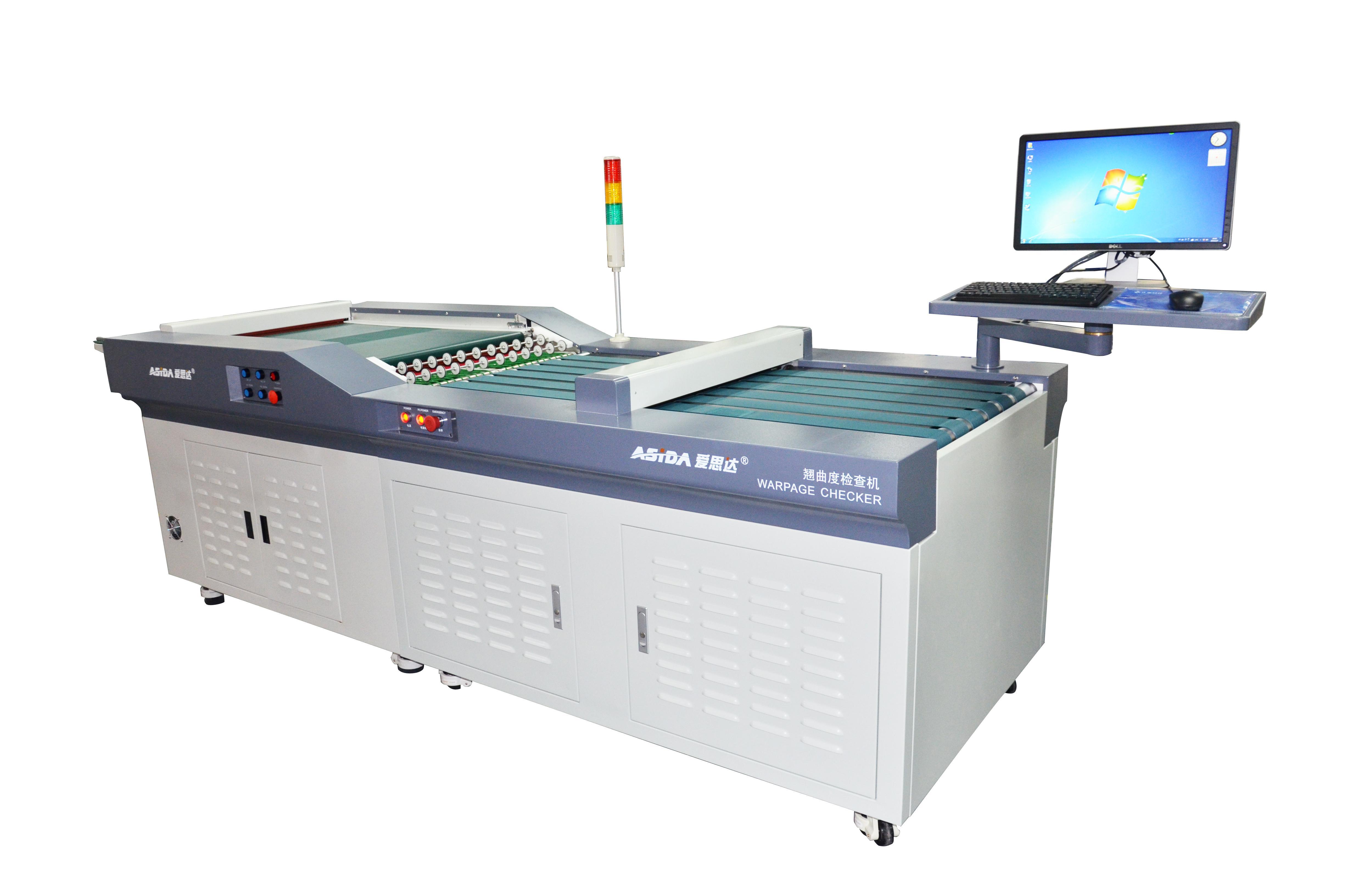
 400-860-5168转2189
400-860-5168转2189
 留言咨询
留言咨询

 400-860-5168转6117
400-860-5168转6117
 留言咨询
留言咨询

 400-860-5168转6117
400-860-5168转6117
 留言咨询
留言咨询

 400-860-5168转2189
400-860-5168转2189
 留言咨询
留言咨询

 400-860-5168转6117
400-860-5168转6117
 留言咨询
留言咨询

 400-860-5168转6117
400-860-5168转6117
 留言咨询
留言咨询

 400-860-5168转6117
400-860-5168转6117
 留言咨询
留言咨询

 400-860-5168转6117
400-860-5168转6117
 留言咨询
留言咨询

 400-860-5168转3282
400-860-5168转3282
 留言咨询
留言咨询

 400-860-5168转4452
400-860-5168转4452
 留言咨询
留言咨询
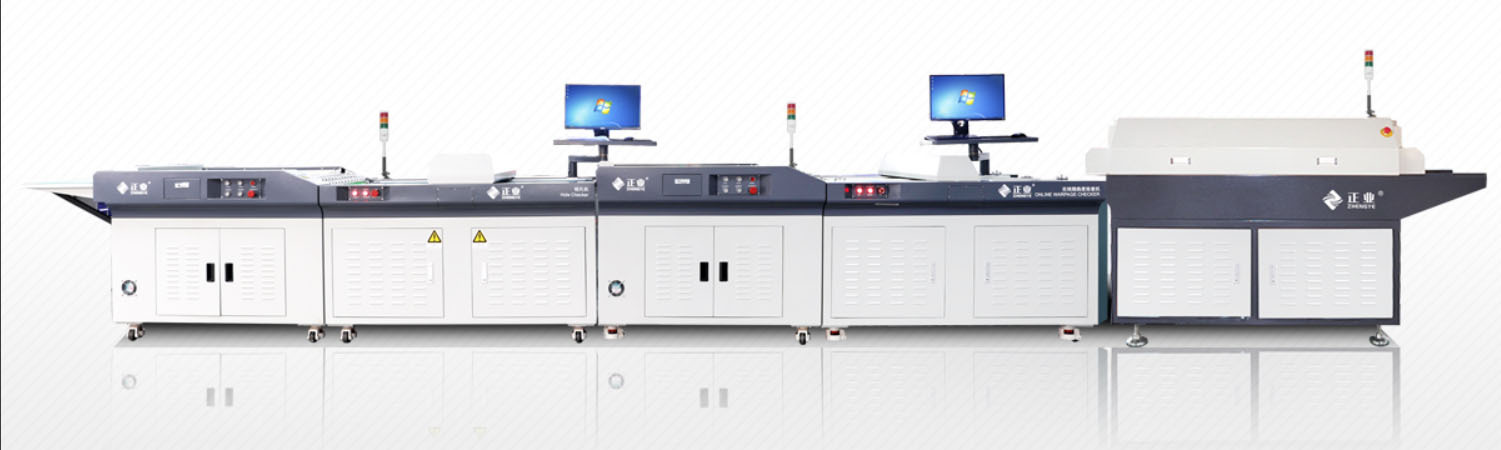
 400-860-5168转2189
400-860-5168转2189
 留言咨询
留言咨询

 400-860-5168转2189
400-860-5168转2189
 留言咨询
留言咨询

 400-860-5168转2189
400-860-5168转2189
 留言咨询
留言咨询
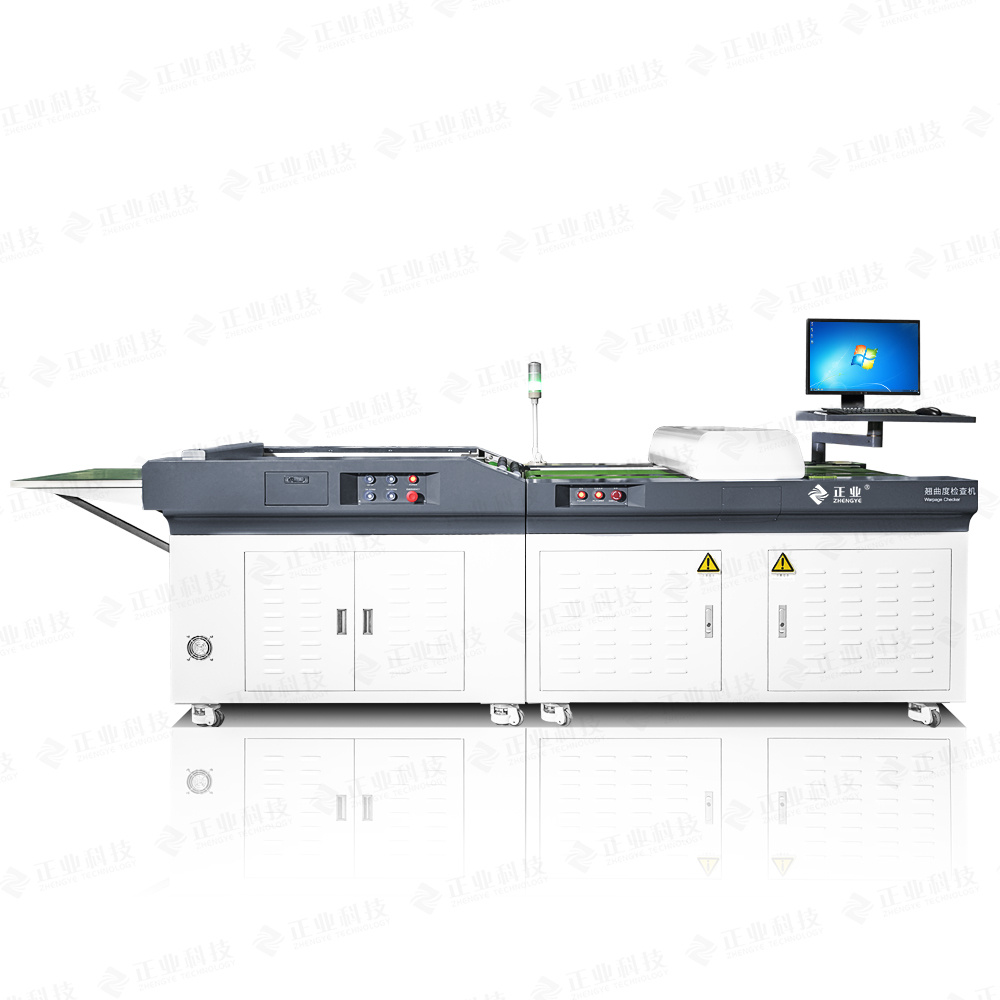
 400-860-5168转2189
400-860-5168转2189
 留言咨询
留言咨询
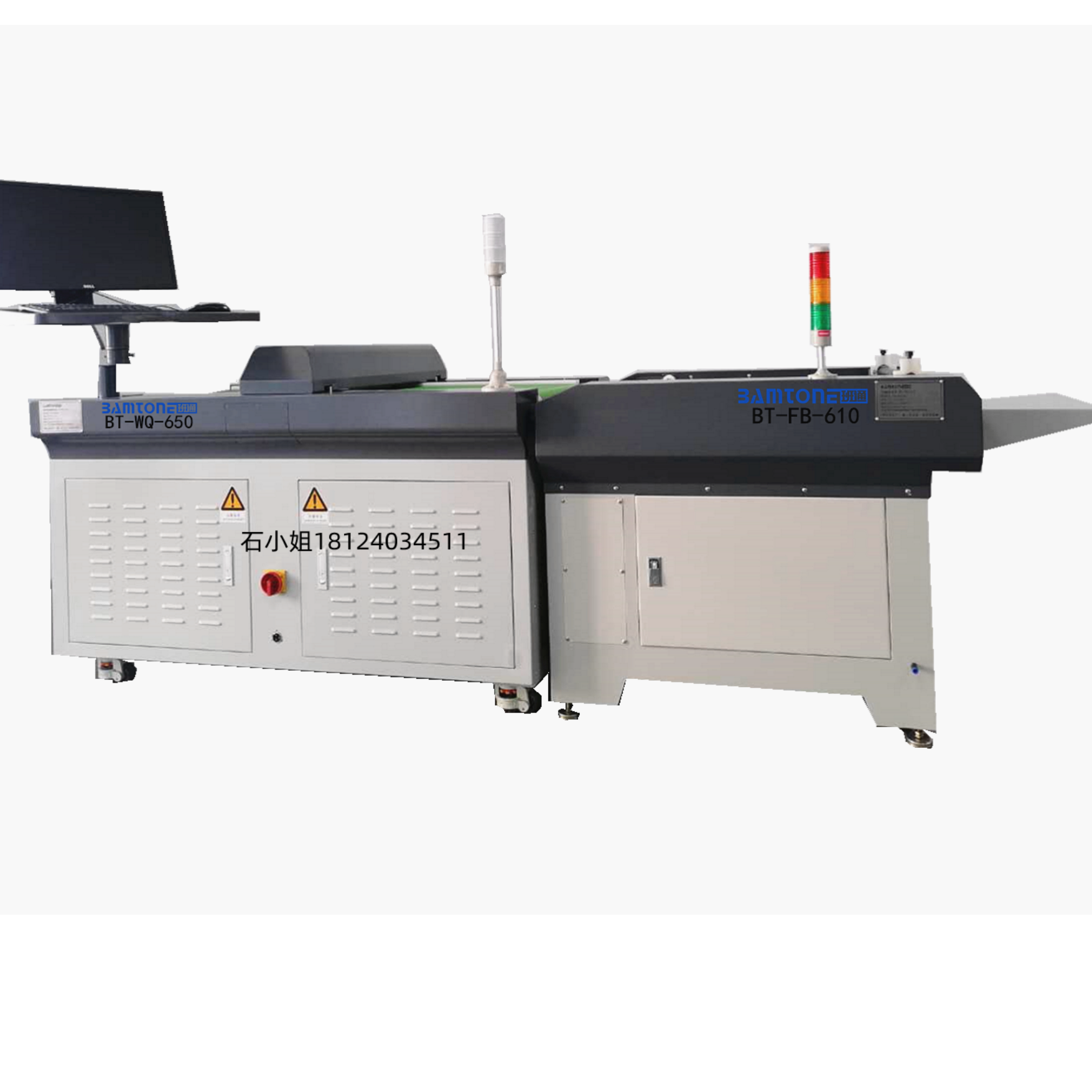
 留言咨询
留言咨询

 400-860-5168转0960
400-860-5168转0960
 留言咨询
留言咨询
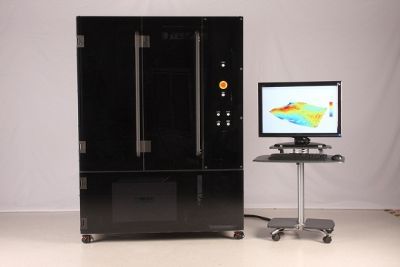
 400-860-5168转2459
400-860-5168转2459
 留言咨询
留言咨询

 留言咨询
留言咨询

 400-860-5168转6117
400-860-5168转6117
 留言咨询
留言咨询

 留言咨询
留言咨询

 留言咨询
留言咨询

 400-860-5168转5976
400-860-5168转5976
 留言咨询
留言咨询

 400-860-5168转6117
400-860-5168转6117
 留言咨询
留言咨询

 400-860-5168转6117
400-860-5168转6117
 留言咨询
留言咨询

 400-860-5168转3282
400-860-5168转3282
 留言咨询
留言咨询
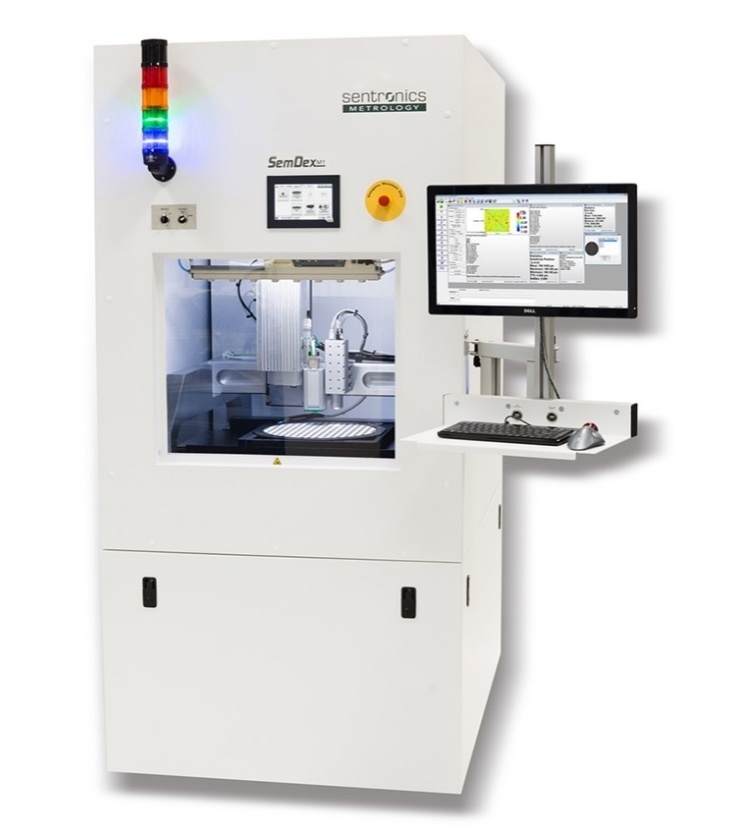
 400-860-5168转3282
400-860-5168转3282
 留言咨询
留言咨询

 400-860-5168转6117
400-860-5168转6117
 留言咨询
留言咨询

 留言咨询
留言咨询