
 400-803-2799
400-803-2799
 留言咨询
留言咨询

 400-633-0963
400-633-0963
 留言咨询
留言咨询
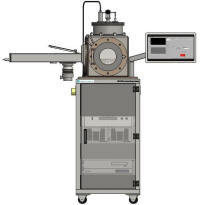
 400-860-5168转3569
400-860-5168转3569
 留言咨询
留言咨询

 400-860-5168转3569
400-860-5168转3569
 留言咨询
留言咨询

 400-860-5168转3569
400-860-5168转3569
 留言咨询
留言咨询
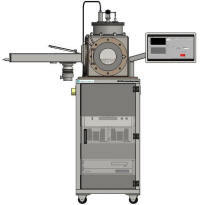
 400-860-5168转3569
400-860-5168转3569
 留言咨询
留言咨询
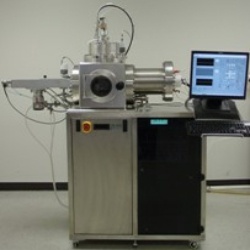
 400-860-5168转3569
400-860-5168转3569
 留言咨询
留言咨询
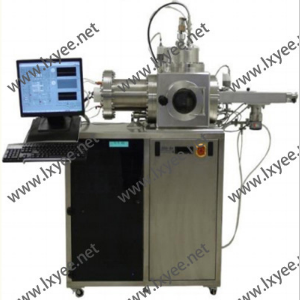
 400-860-5168转4527
400-860-5168转4527
 留言咨询
留言咨询

 400-860-5168转2826
400-860-5168转2826
 留言咨询
留言咨询
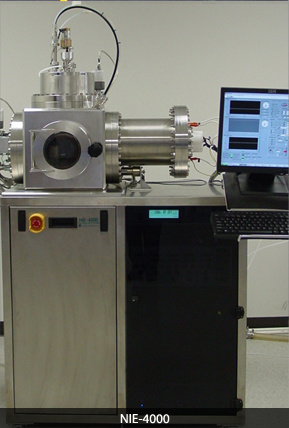
 400-860-5168转3569
400-860-5168转3569
 留言咨询
留言咨询

 400-860-5168转3569
400-860-5168转3569
 留言咨询
留言咨询

 400-860-5168转4552
400-860-5168转4552
 留言咨询
留言咨询

 400-860-5168转4552
400-860-5168转4552
 留言咨询
留言咨询
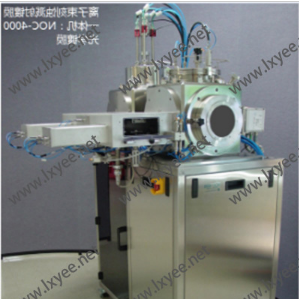
 400-860-5168转4527
400-860-5168转4527
 留言咨询
留言咨询
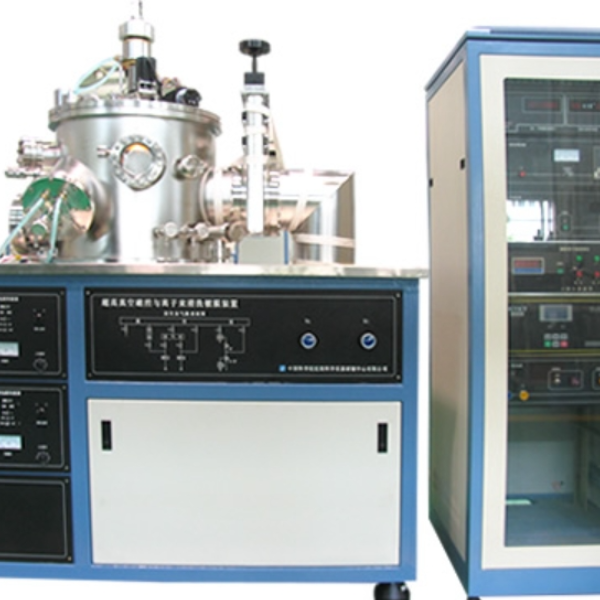
 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询

 400-860-5168转1679
400-860-5168转1679
 留言咨询
留言咨询
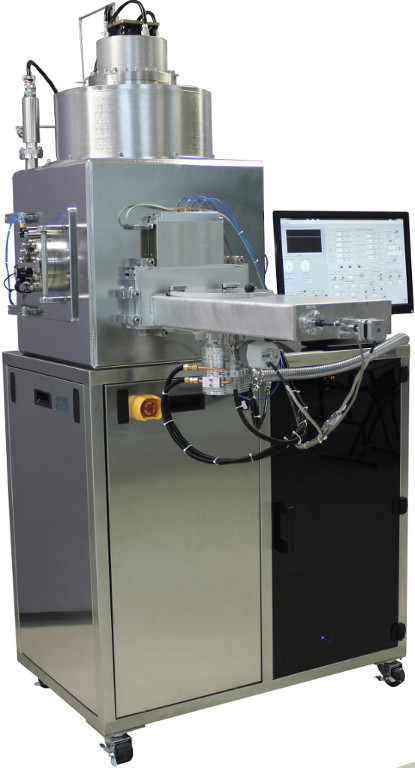
 400-860-5168转3569
400-860-5168转3569
 留言咨询
留言咨询

 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询

 400-860-5168转3827
400-860-5168转3827
 留言咨询
留言咨询
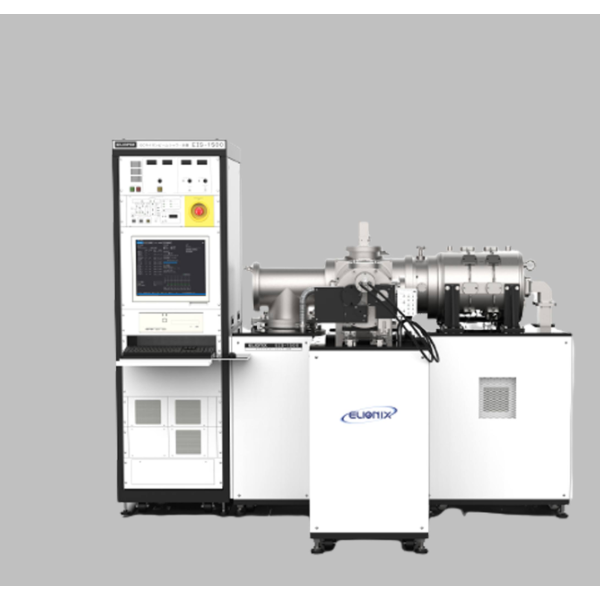
 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询
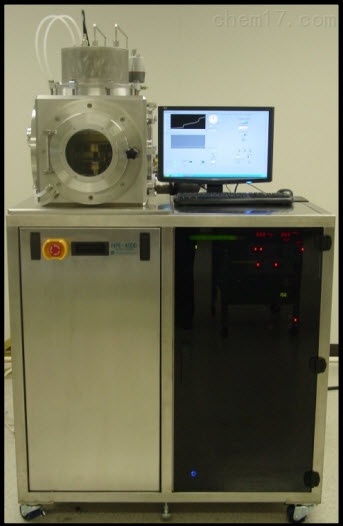
 400-860-5168转3569
400-860-5168转3569
 留言咨询
留言咨询
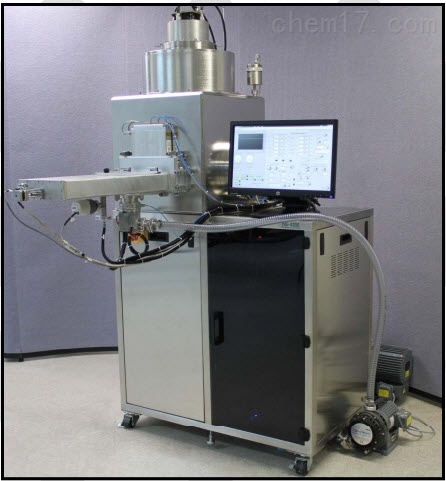
 400-860-5168转3569
400-860-5168转3569
 留言咨询
留言咨询

 400-860-5168转3569
400-860-5168转3569
 留言咨询
留言咨询

 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询
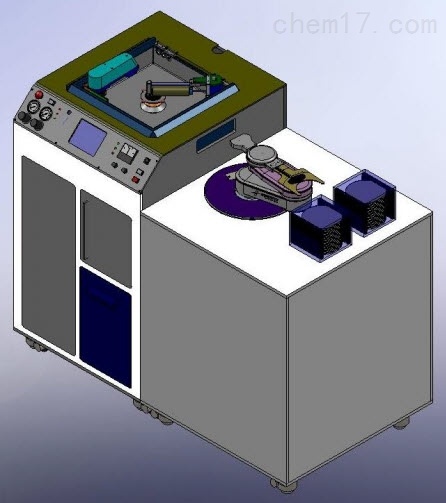
 400-860-5168转3569
400-860-5168转3569
 留言咨询
留言咨询

 400-860-5168转0727
400-860-5168转0727
 留言咨询
留言咨询

 400-860-5168转2556
400-860-5168转2556
 留言咨询
留言咨询

 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询

 400-860-5168转2623
400-860-5168转2623
 留言咨询
留言咨询
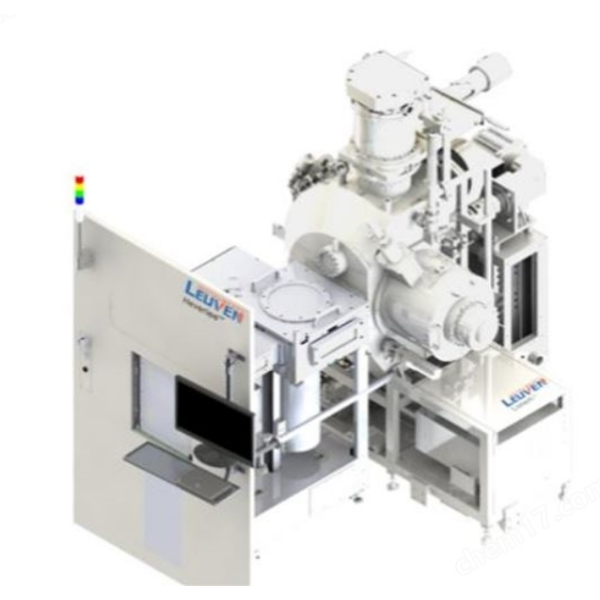
 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询