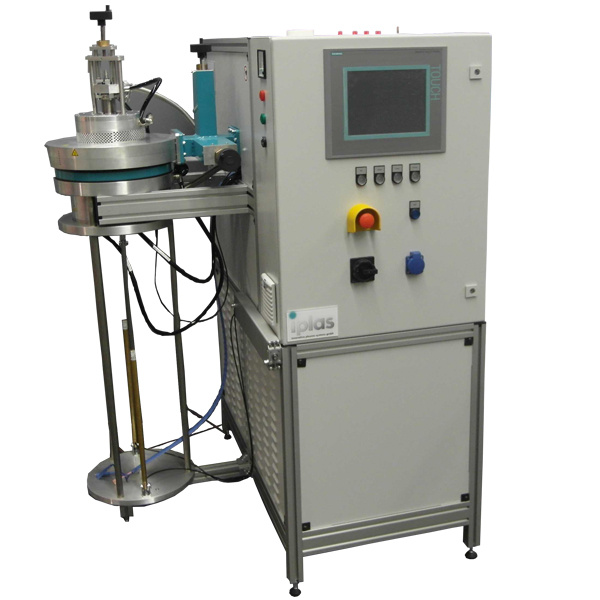
 400-860-5168转0980
400-860-5168转0980
 留言咨询
留言咨询

 400-860-5168转3549
400-860-5168转3549
 留言咨询
留言咨询

 400-860-5168转4527
400-860-5168转4527
 留言咨询
留言咨询
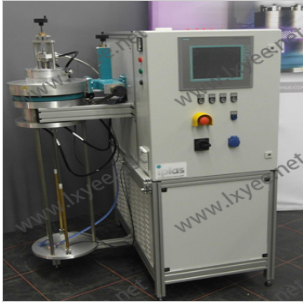
 400-860-5168转4527
400-860-5168转4527
 留言咨询
留言咨询
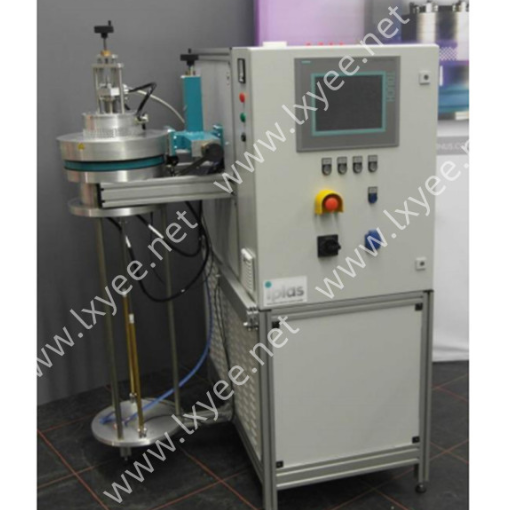
 400-860-5168转4527
400-860-5168转4527
 留言咨询
留言咨询
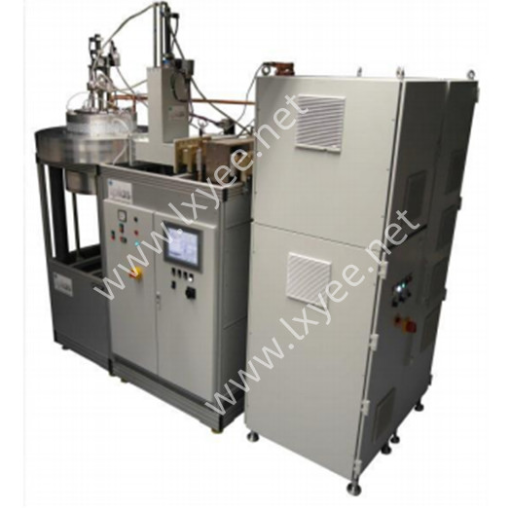
 400-860-5168转4527
400-860-5168转4527
 留言咨询
留言咨询
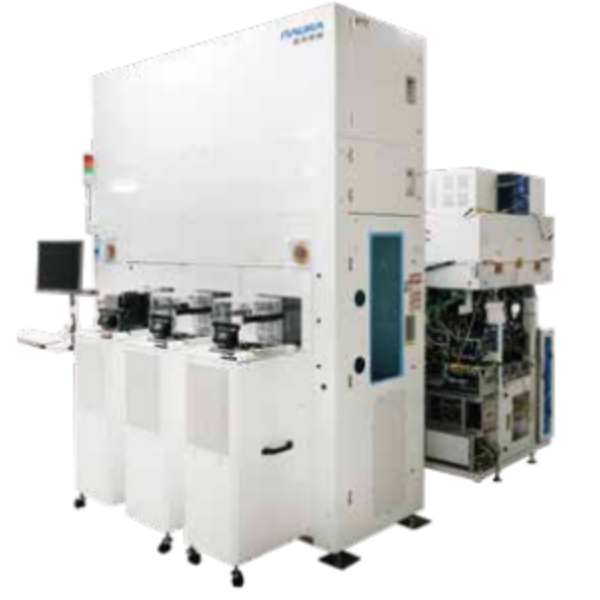
 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询

 400-860-5168转4527
400-860-5168转4527
 留言咨询
留言咨询
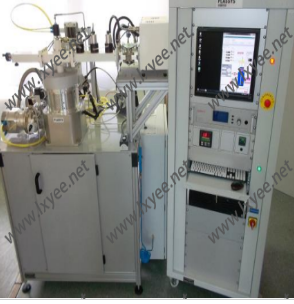
 400-860-5168转4527
400-860-5168转4527
 留言咨询
留言咨询
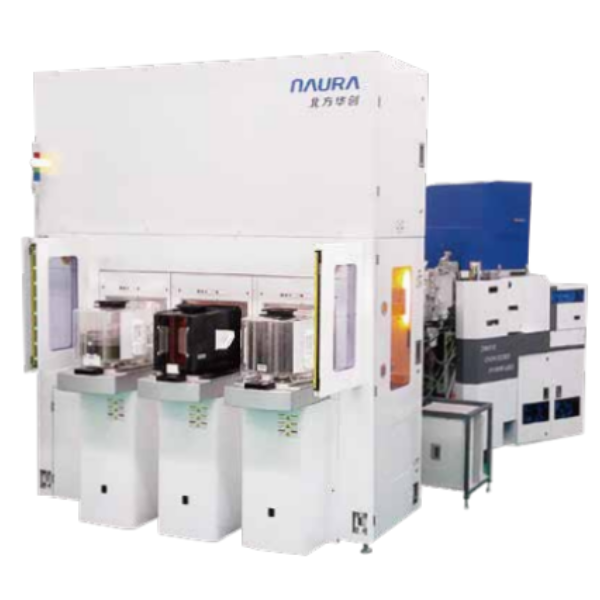
 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询

 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询
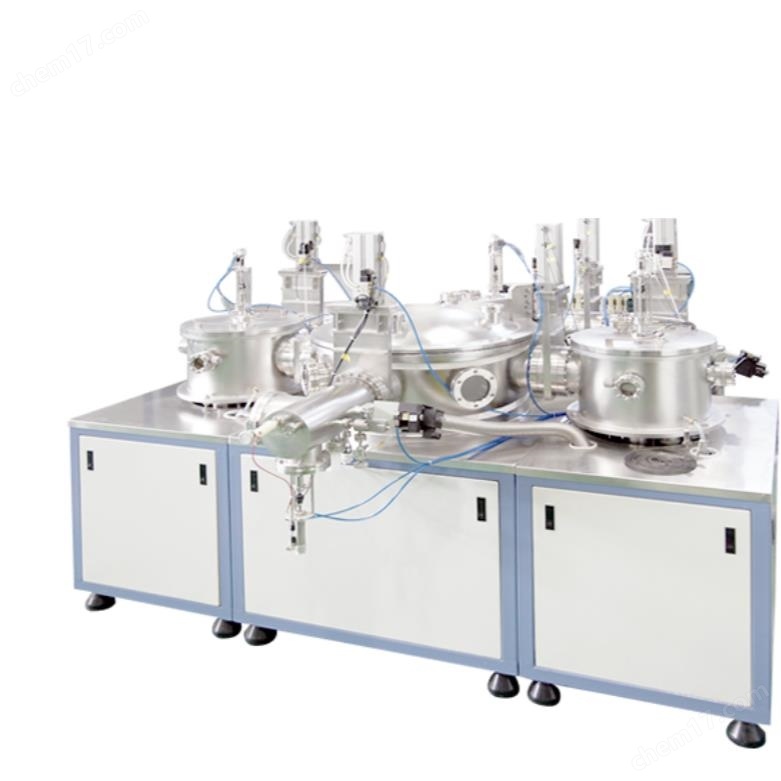
 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询
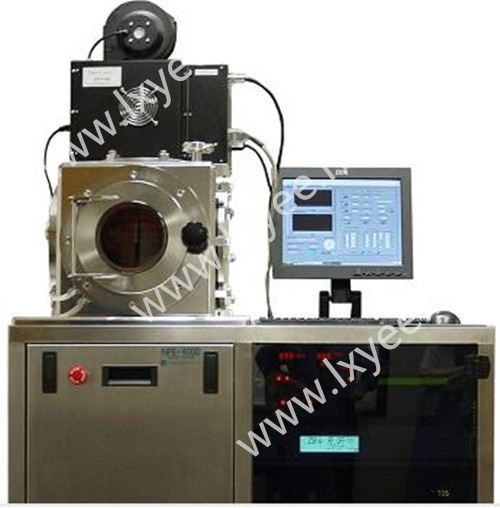
 400-860-5168转4527
400-860-5168转4527
 留言咨询
留言咨询
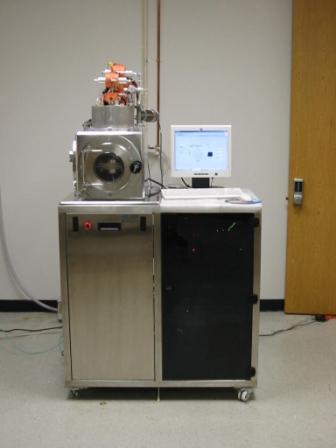
 400-860-5168转3569
400-860-5168转3569
 留言咨询
留言咨询

 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询
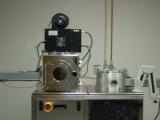
 400-860-5168转3569
400-860-5168转3569
 留言咨询
留言咨询

 400-860-5168转3569
400-860-5168转3569
 留言咨询
留言咨询
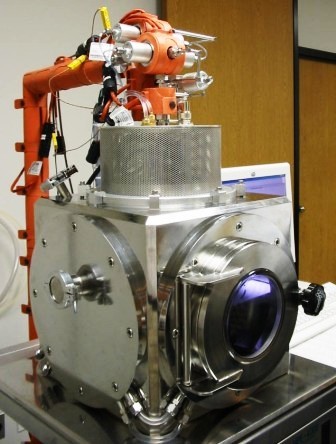
 400-860-5168转3569
400-860-5168转3569
 留言咨询
留言咨询

 400-860-5168转4967
400-860-5168转4967
 留言咨询
留言咨询
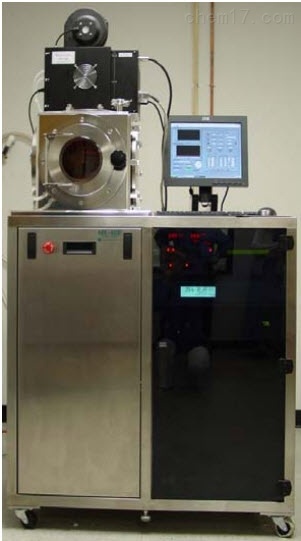
 400-860-5168转3569
400-860-5168转3569
 留言咨询
留言咨询
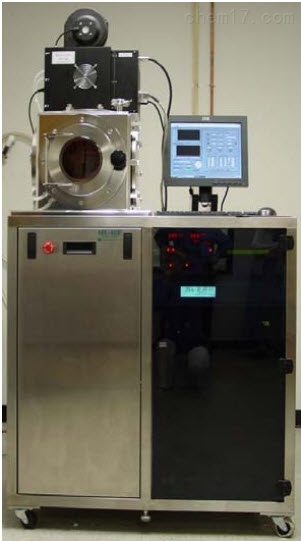
 400-860-5168转3569
400-860-5168转3569
 留言咨询
留言咨询

 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询

 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询
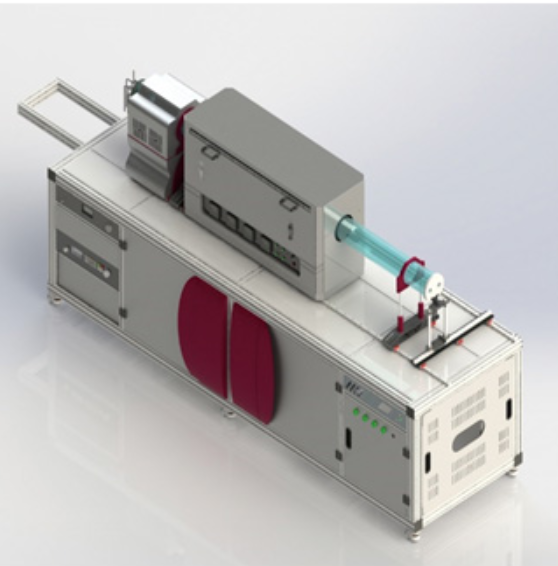
 400-860-5168转5011
400-860-5168转5011
 留言咨询
留言咨询

 400-860-5168转4527
400-860-5168转4527
 留言咨询
留言咨询

 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询
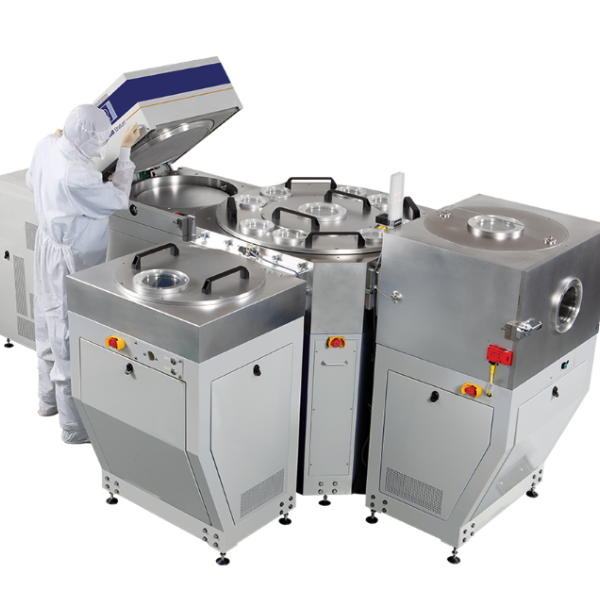
 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询
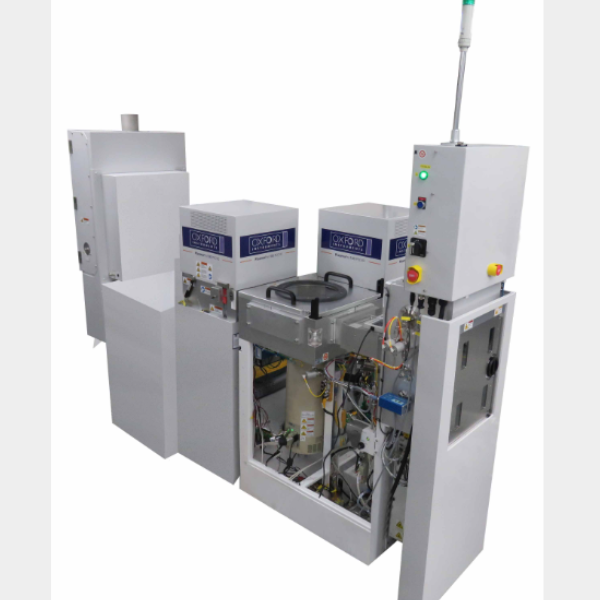
 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询

 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询

 400-860-5168转0758
400-860-5168转0758
 留言咨询
留言咨询