一, 1.3µ m SOA(半导体光学放大器)模块SOA(半导体光放大器)是放大光信号的半导体元件。 在半导体激光器的两个面上都进行了抗反射处理,以消除谐振器结构。 当光从半导体外部进入时,光被受激发射放大。SOA用于放大光信号。 SOA安装在用于数据中心之间通信的光收发器模块中,以放大用于以太网通信的1.3 um波长的光信号,以补偿传输损耗。SOA模块具有15 dB或更高的高光学增益,以及7 dB或更低的低噪声系数。 偏振相关增益也为1.5 dB或更小,这使得信号放大几乎没有问题。 该模块是6针紧凑型封装,带有隔离器和TEC(热电冷却器),可以安装在CFP / CFP2上。1.3µ m SOA(半导体光学放大器)模块,1.3µ m SOA(半导体光学放大器)模块产品特点● 光学增益:≧15dB● 偏振相关增益(PDG):≦1.5dB● 内置光隔离器((input side)● 低功耗1.0W typ.(TC=75℃) 产品应用● 数据通信100GBASE-ER4● 前置放大器技术参数光电参数参数符号测试条件最小值典型值最大值单位光学增益GIF=120mA, *1, *2, *315dB偏振相关增益PDG IF=120mA, *1, *2, *31.5dB正向电流IF100150mA正向电压VFIF=120mA2.0V波长范围λIF=120mA12941311nm饱和功率PSIF=120mA *47dBm噪声系数NFIF=120mA, *1, *2, *3,*57dBTEC电流ICG=(BOL), TC=75℃0.6ATEC电压VCG=(BOL), TC=75℃2.2v热敏电阻RthTSOA=25℃, B=3435±105K9.51010.5KΩ*1:光输入信号条件:连续波(CW)*2:光输入信号为以下4个波长范围。对每个波长范围的特性进行测量,光输入信号的波长范围如下:λ 0 : 1294.5~1296.6nm λ 2 : 1303.5~1305.7nmλ 1 : 1299.0~1301.1nm λ 3 : 1308.0~1310.2nm*3: 光输入信号功率(Pin)=-25dBm*4:饱和功率在1310nm单波长条件下测量值*5:没有偏振调节绝对最大值参数符号数值单位SOA正向电流IF150mASOA反向电压VR2V操作温度TC-5 to +75℃存储温度Tstg-40 to +85℃TEC电流IC1.0ATEC电压VC2.5V注意:超过绝对最大值可能导致损坏特征曲线二, C/O波段 SOA 非线性半导体光放大器 1550nm 14dBm / 1310nm 7dBmL波段 SOA非线性半导体光放大器是一种偏振不敏感光学放大器,具有先进的外延晶片生长和光电封装技术,可在宽光谱带宽上实现高输出饱和功率、低噪声系数和大增益。L波段 SOA非线性半导体光放大器 1610nm 13dBm,L波段 SOA非线性半导体光放大器 1610nm 13dBm通用参数产品特点:宽带光高输出功率低偏振灵敏度多量子阱或体结构产品应用:助推光光放大器 电信与数据通信损失补偿型号指南:PL-SOA-☆-A8▽-W□□□□-XX☆ :Output PowerA: 13dbmB: 20dbm▽: Bandwidth1: 60-70nm2: 30-40nm□□□□:Wavelength680: 680nm850: 850nm*****1550: 1550nm1650: 1650nmXX: Fiber and Connector TypeSASA=(SMF-28E+ FC/APC)+(SMF-28E+ FC/APC)SPSP=(SMF-28E+ FC/PC)+(SMF-28E+ FC/PC)PAPA=(PM Fiber+ FC/APC)+(PM Fiber+ FC/APC)PPPP=(PM Fiber+ FC/PC)+(PM Fiber+ FC/PC)PAPA=(PM Fiber+ FC/APC)+(PM Fiber+ FC/APC)技术参数特征宽带光高输出功率低偏振灵敏度多量子阱或体结构应用助推光光放大器电信与数据通信损失补偿电/光学特性(Tsub=25°C,CW,)参数符号PL-SOA-A-A81-W1610-PAPA最小典型最大工作电流IOP-120 mA150 mA正向电压VF-1.2V2.0V中心波长λC1600nm1610nm1620nm信号增益 (@ Pin = -20 dBm)G15dB--3dB带宽BW40nm--ASE波纹(RMS)δG--0.5dB饱和输出功率 (@ -3 dB)PSAT7dBm--偏振相关增益PDG--1.5dB噪声系数NF--7dB热敏电阻(@ 25℃)RTH9.5KΩ10KΩ10.5KΩTEC电压VTEC2.3VTEC电流ITEC0.9A 绝对最大值参数参数符号PL-SOA-A-A81-W1610-PAPA最小最大最大操作电流(CW)IOP max200mA反向电压VR2V芯片操作温度(CW)TSOA25℃30℃外壳温度(CW)TC0℃70℃TEC 电压VTEC-4.0VTEC电流ITEC-1.8A存储温度TSTG-40℃85℃存储湿度5%RH85%RH 典型特征曲线ASE 光谱图SOA放大器光谱图(Pin=0dBm,I=200mA)
 留言咨询
留言咨询

 400-628-5299
400-628-5299
 留言咨询
留言咨询

 400-628-5299
400-628-5299
 留言咨询
留言咨询

 留言咨询
留言咨询

 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询

 留言咨询
留言咨询
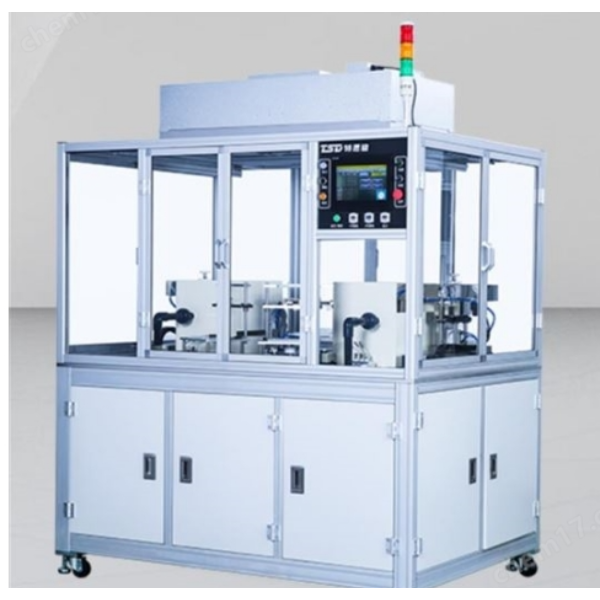
 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询
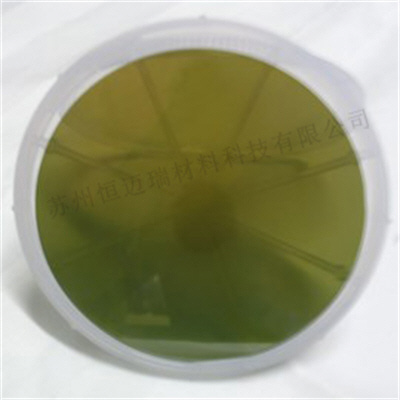
 留言咨询
留言咨询

 400-860-5168转5943
400-860-5168转5943
 留言咨询
留言咨询

 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询

 留言咨询
留言咨询

 留言咨询
留言咨询

 留言咨询
留言咨询

 留言咨询
留言咨询

 留言咨询
留言咨询
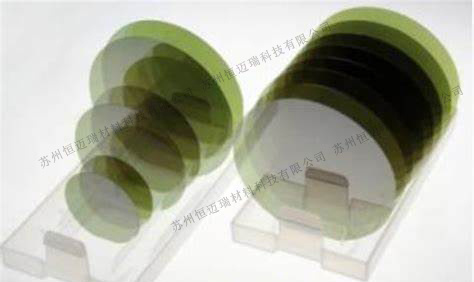
 留言咨询
留言咨询
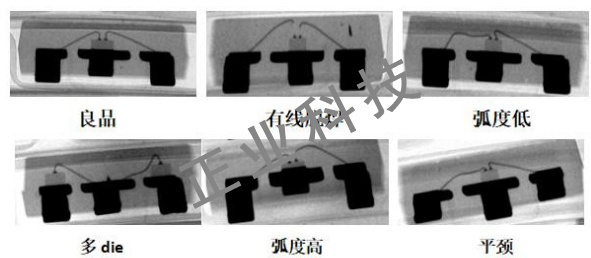
 400-860-5168转2189
400-860-5168转2189
 留言咨询
留言咨询
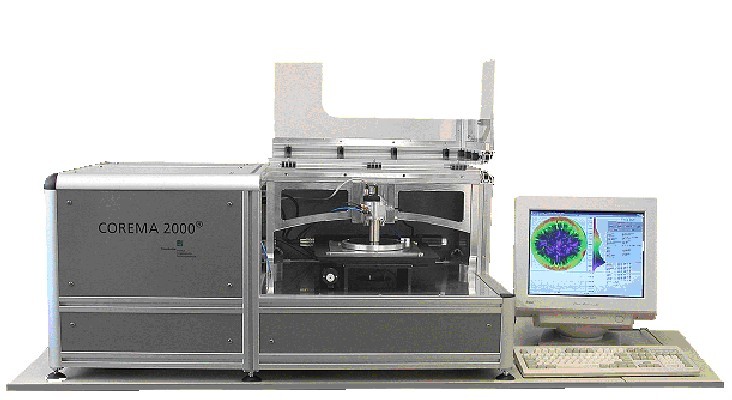
 400-860-5168转2024
400-860-5168转2024
 留言咨询
留言咨询

 留言咨询
留言咨询

 400-860-5168转4682
400-860-5168转4682
 留言咨询
留言咨询

 400-860-5168转0727
400-860-5168转0727
 留言咨询
留言咨询

 400-860-5168转6117
400-860-5168转6117
 留言咨询
留言咨询
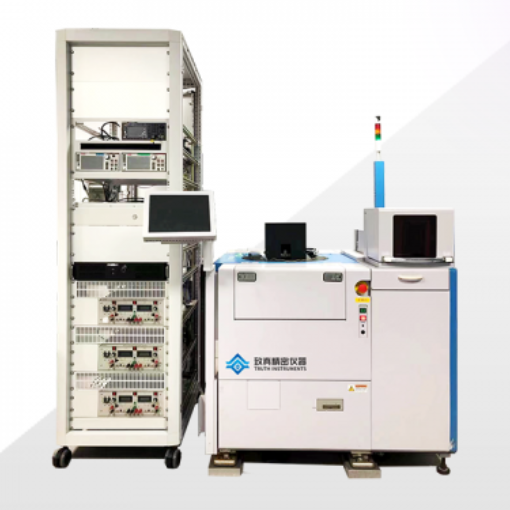
 400-860-5168转6169
400-860-5168转6169
 留言咨询
留言咨询

 400-801-0263
400-801-0263
 留言咨询
留言咨询

 400-860-5168转6117
400-860-5168转6117
 留言咨询
留言咨询

 400-860-5168转6117
400-860-5168转6117
 留言咨询
留言咨询

 400-860-5168转6117
400-860-5168转6117
 留言咨询
留言咨询

 400-860-5168转6117
400-860-5168转6117
 留言咨询
留言咨询

 400-860-5168转3429
400-860-5168转3429
 留言咨询
留言咨询
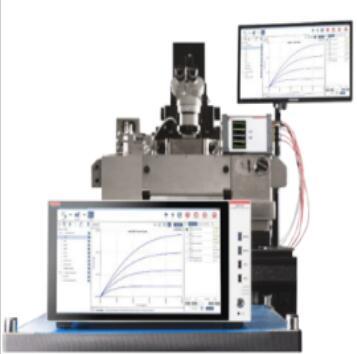
 400-860-5168转4527
400-860-5168转4527
 留言咨询
留言咨询

 400-860-5168转1936
400-860-5168转1936
 留言咨询
留言咨询