我有两个问题想麻烦各位解答一下,1,为什么二次电子显微图像具有很好的立体感?2,为什么气孔边缘的二次电子产额比较大?谢谢大家!!
Leo 1530VP场发射扫描电镜,2001年安装投入使用,现二次电子检测器SE1不能使用了,据说是闪烁体时间长了,现在只能使用In Lens检测器,有时候感觉会不大方便,大家有碰到这种问题吗?能否修复二次电子检测器呀。
各位大大,新人求教:1、SEM中形成图像的话电子枪是一次击打完毕还是多次击打?比如我要调整分倍率或者移动的时候电子枪还需不需要再发射电子一次呢?2、二次电子是否是有限的?是不是SEM照片只能拍有限次呢?3、拍SEM的话不导电物质可以拍么?不导电物质也应该存在二次电子吧、谢谢!
现在低真空(包括环境真空)电镜很时髦。本人想了解一下:1、在低真空时,二次电子是如何检测的;2、低真空二次电子探测器由哪些类型及其各自的特点。3、低真空下二次电子像分辨率到底有多高?能和高真空一样吗?我想很多同仁也都会对此感兴趣。望资深大侠不吝传教。
二次电子逸出是因为入射电子能量交换获得高于逸出功,这个交换过程是碰撞吗?能量是怎么交换的呢?
我们通常认为二次电子(SE)与原子序数之间没有关系,而背散射电子(BSE)产额则随原子序数的增大而增大。事实上,SE也和原子序数之间有一定的关系。二次电子产额在总体上随着原子序数的增大而增加。在原子序数Z 小于20时,δ 随着原子序数Z 的增加也有所增加;当原子序数Z 大于20时,二次电子产额基本上不随原子序数变化,只有Z 小的元素的二次电子产额与试样的组分有关。所以二次电子通常情况下用于观察表面形貌,而不用于观察成分分布;不过在原子序数较低或差异较大的时候,二次电子也能看出原子序数衬度。欢迎版内的各位老师上传电镜照片来验证这个理论。对这个理论我自己有一个想法:根据SE的类型,其中有背散射电子激发的二次电子信号(SE3),那么这种SE是否可以说就和原子序数有一定的关系呢?是否这是导致上述理论成立的原因呢???
![【求助】[TEM]电子衍射中二次电子判断??](https://ng1.17img.cn/bbsfiles/images/2008/11/200811251049_120294_1639619_3.jpg)
从包含的元素来看,有Si和Te,查资料后可知这两元素的化合物都是菱方(用六方表示),从主斑点看到,周围有次斑点,次斑点周围也还有。现在认为,周围的小斑点是多次电子衍射,但又不是很明白多次电子的意思,想知道这是不是二次电子衍射的结果,判断二次电子衍射的方法有哪些?谢谢。。。[img]http://ng1.17img.cn/bbsfiles/images/2008/11/200811251049_120294_1639619_3.jpg[/img]
请教:怎样理解二次电子,背反射电子,对其中的概念不理解,谢谢了!![em0707] [em0707] [em0707]

请教各位电镜专家一个问题:最近在观察钢中非金属夹杂时,成分上看很像夹杂,但是在二次电子像下观察时其呈现白亮色(和钢基体比)且感觉悬浮在基体表面上。而一般情况下夹杂物的二次电子像都比钢基体衬度深,发黑且边界清晰。请问导致这种情况发生的可能原因是什么,是这些夹杂物的导电性不好,还是因为这些夹杂物的化学成分特殊(均含Na、Li的氧化物,普通的夹杂物一般为Al、Ca的氧化物)?或者帮我普及一下二次电子像衬度(和基体相相比亮或暗)与哪些因素相关http://ng1.17img.cn/bbsfiles/images/2016/05/201605311533_595490_1613632_3.jpg
弱问,重元素有较大的反射率,样品表面镀金会使背散射电子产额增加;但如何让二次电子产额增加?如果不增加,怎么提高二次电子成像的?呼唤高人赐教,谢谢!
单位的SEM使用二次电子成像怎么照的图片都一样呢?样品是TiAl合金的铸锭
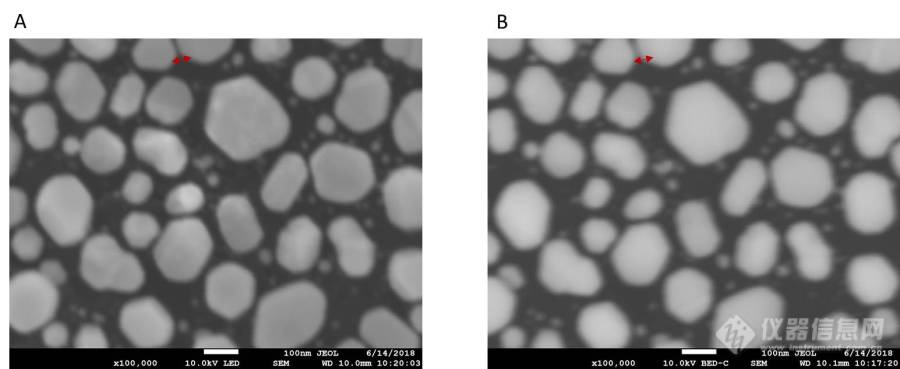
[align=center][b]二次电子与背散射电子成像区别[/b][/align] 二次电子检测器和背散射电子检测器是扫描电子显微镜常用检测器。二次电子检测器成像速度快,在快速扫描时很容易对焦,图像立体感强,背散射电子检测器在快速扫描时图像有带状条纹,对焦成像条件一般依赖二次电子检测器(即在调整好二次电子像参数后启动背散射电子检测器成像)。 散射电子检测器一般是被嫌弃的,因为它成像分辨率低(图1)。造成分辨率不同的原因是二者检测的信号源不同。二次电子(SE)的能量小于50ev,二次电子信号主要来自试样表层,深度大约5~10 nm,反映试样表面的形貌。背散射电子(BSE)是受到试样原子核的弹性和非弹性散射而被反射回的一部分入射电子,能量大于二次电子(SE)(图2)[sup][/sup]。一般来说,背散射电子的能量大于50ev,背散射电子反映试样表面50~200 nm深度的信息,激发区域大于二次电子。[img=,690,282]http://ng1.17img.cn/bbsfiles/images/2018/07/201807261522354238_7646_2265735_3.jpg!w690x282.jpg[/img][b]图1 金纳米粒子二次电子图像(A)和背散射电子图像(B)。[/b]背散射电子图像分辨率低于二次电子图像(图中红色箭头指示处)。JEOL-7800F扫描电子显微镜,工作距离10mm。[img=,690,518]http://ng1.17img.cn/bbsfiles/images/2018/07/201807261523412701_7969_2265735_3.png!w690x518.jpg[/img][b]图2 当加速电子轰击分析物激发的各种信号[sup][/sup][/b]。二次电子(SE)和背散射电子(BSE)是扫描电镜成像的基础信号。 二次电子和背散射电子有一定的方向性,背散射电子更加靠近入射法线。一般二次电子的探测器装在电镜样品仓侧面(在物镜内部,小工作距离的高分辨二次电子探头不在这里讨论),背散射探头的探测晶体直接安装在物镜下面,中心与物镜光学中心重合。探测器的安装位置和电子不同的反射角度会影响图像的明暗。图3是硅球的扫描电镜图。二次电子图像的有较大阴影,球的中心位置阴影最明显,与之相反背散射电子图像球的中心位置最亮。[img=,690,266]http://ng1.17img.cn/bbsfiles/images/2018/07/201807261527144207_5694_2265735_3.png!w690x266.jpg[/img][b]图3 硅球的二次电子图像(A)和背散射电子图像(B)[/b]。JEOL-7800F扫描电子显微镜,工作距离10mm。 背散射电子检测器也有自己的独特之处,有的时候可以成功逆袭二次电子探测器。背散射电子图像具有一定的Z轴衬度,与晶体取向有关,电子强度与物质组成有关,可以显示样品内部结构,也就是说背散射电子图像可以用来分析复合材料。在试验条件相同的情况下,背散射电子信号的强度随分析物[b]平均原子序数[/b]增大而增强,在样品表层平均原子序数较大 的区域,产生的背散射信号强度较高[sup][/sup]。目前商品化的背散射电子检测器可以区分元素周期表相邻的两个元素。图4显示在基底上镀镍(28号元素)和铜(29号元素),在二次电子图像上几乎看不出是两个不同的镀层,能谱分析显示两个镀层有明显的界限,背散射电子图像不仅可以完美区分两个镀层,对镀层的缺陷也比背散射电子图像更加明确的呈现出来。[img=,690,349]http://ng1.17img.cn/bbsfiles/images/2018/07/201807261530426736_7830_2265735_3.png!w690x349.jpg[/img][b][b]图4 不同镀层的扫描电子显微镜分析[/b]。A,二次电子图像;B,EDS能谱图像;C,背散射电子图像。JEOL-7800F扫描电子显微镜,工作距离10mm。牛津(oxford)能谱仪。[/b] 目前扫描电镜分析已经逐渐脱离单纯的形貌分析,组成和相分析更加有助于我们深刻理解材料的构成和性质。我们在常规扫描电镜实验中,调用一下常常被忽略的背散射电子检测器,在几乎不增加工作量的情况下也许会有意外的收获。[b]参考文献[/b] 1.JEOL指导手册,A Guide to Scanning Microscope Observation 2.Bozzola, J.J., Russell, L.D., 1999.Electron Microscopy: Principles and Techniques for Biologists, 2nd ed. Jonesand Bartlett Publishers, Boston, NY.
蔡司电镜 二次电子图像调好对比度和亮度之后,放几分钟,图像有时会变的很亮,有时会变的很暗,知道是什么原因吗?大侠帮忙分析一下。
n=(k*t*i)/q k=0.25二次电子检出率,每100个入射电子检出25个二次电子t :每帧时间100秒i :电子束电流,取为10^-11安培q:一个电子的电量1.6*10^-19库伦代入公式计算得:n=1.56*10^9 16亿个二次电子取i=10^-10 n=160亿

一个表面抛光的金属样品,采用背散射电子像可以看到不同的成分分布,而采用二次电子像时也能同意观察到几乎完全相同的图像,应该说二次电子像中也包含部分元素成分的衬度信息,值得大家注意。[img]http://ng1.17img.cn/bbsfiles/images/2010/10/201010112130_250975_1872735_3.jpg[/img][img]http://ng1.17img.cn/bbsfiles/images/2010/10/201010112131_250976_1872735_3.jpg[/img]
一、聚光镜电流越小,二次电子产额越高,是聚光镜电流对二次电子有排斥?二、灯丝电流应是越大,二次电子产额越高吧?三、聚光镜电流越小,像颗粒越细?。四、聚光镜电流越小,信号越强?。五、聚光镜电流越小,电子束流越大?。六、一个最基本的问题:聚光镜电流在电镜上如何调节?我们平时调节的只有灯丝的电流,好象没调节过聚光镜电流啊?谢谢您的指导!
sem中二次电子成像观察到晶粒的最小取向差是多少?电子通道衬度成像呢?非常感谢!
请问高手们,晶体结构,晶粒取向是否影响二次电子激发率?
请问大家一下,扫描电镜是通过二次电子信息显示表面形貌。弱弱的问,二次电子有没有可能被吸收,而显示不了膜表面的信息?再问一下,二次电子的最小穿透深度是多少?谢谢大家了。
看过论坛上的一些资料,初步了解BSE信号分辨金属分布区域应该效果更好,但此图片(请见附件)是SEM-SEI,二次电子像。[b][i]讨论开始:[/i][/b]图中有些圆孔顶端(黄箭头所指处)比其他区域衬度更亮,当然二次电子像受表面形貌影响甚大,原来怀疑是由此引起,但请看图中红箭头所指的管,其高度应明显高于周围,但周围有几个圆孔顶端却更亮;另外,请看兰色箭头所指的两根管子,上边的一个景深方向明显暗于顶口(好象有一层东西的感觉),而下边这个管延景深方向却是一直很亮。管的材料是钛(原子序数22),表面做过修饰,为金(原子序数79)。[b][i]请问我能否初步判断:[/i][/b]那些特别亮的管顶口有金的存在?我是初学者,请多指教,谢谢!
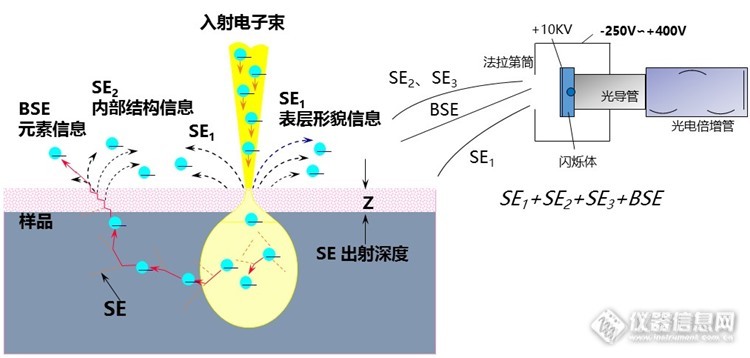
材料显微分析工作不仅限于通过显微镜等设备对材料的微观形貌进行拍摄,还包括了对所拍摄到的微观图像进行分析。对这些数据的分析工作要求我们一定要考虑到:对样品自身背景、取样方法、制样工艺、拍摄条件以及接收信号种类对测试结果的影响。对电镜原理及分析技术的理解不仅可以让我们得到漂亮美观的显微图像数据,可以帮助我们挖掘到很多关于材料本身的信息。我们知道扫描电镜对样品的微观信息进行分析,有各种个样的成分信息。比如背散射电子、二次电子、背散射电子衍射花样、阴极荧光、特征X射线、韧致辐射X射线等等。[align=center][img=,690,329]http://ng1.17img.cn/bbsfiles/images/2017/07/201707310824_01_1735_3.jpg[/img][/align][align=center]图1、 不同二次电子的特征及产生机理示意图[/align]拿二次电子衬度形貌的分析来举例如图1所示,二次电子在扫描电子显微镜中主要分三大类:第一类是一次二次电子SE1,主要是由入射电子与样品极表面(几纳米的深度)相互作用而产生的,它的产率受入射电子束方向与样品表面夹角的影响,因此体现的是样品的形貌衬度;第二类是二次二次电子SE2,主要是由入射电子束在材料机体内发生弹射后又从电子束进入材料的入射点周围及附近弹出时,与材料表面相互作用而引起的,它的产率受材料主体成分及材料晶体取向的影响,因此体现的是材料成分信息及材料晶体取向信息(一般情况下SE1信号在材料的观测中为主要衬度,只有在SE1衬度极弱的条件下,SE2信号的衬度才可以被我们观察到);第三类是三次二次电子SE3,主要是由电镜样品舱内或物镜极靴或样品台与弹射出样品的背散射电子作用而产生的,它一般是作为噪音来被二次电子探测器接收到的,这类信号越多,电镜拍摄到的图像衬度越差。[align=left][b]SE2二次电子的应用[/b][/align]我们都知道一般SE1二次电子用来观测图像的形貌衬度,而把SE2或SE3当做噪音来看待,但是随着制样工艺及电镜表征技术的发展,SE2二次电子信号也可以被我们用来分析材料的微观结构信息,如下图粉末颗粒截面:[align=center][img=,690,518]http://ng1.17img.cn/bbsfiles/images/2017/07/201707310824_02_1735_3.jpg[/img][/align][align=center]图2 电极材料截面形貌观测[/align][align=center][/align][align=left]我们可以观测,当通过氩离子束抛光把样品表面抛的绝对平的时候,SE1的形貌衬度在图中样品的平面部位的衬度就很弱,因此反应晶体取向衬度的SE2信号就被我们观察到了,图像中颗粒截面的这种亮暗不同是由不同 取向的晶粒造成的,通过它我们可以很直观的看到样品的晶粒度(亮暗区域的大小)、晶体取向差(亮暗灰度绝对值)。对我们研究新材料的性能及合成工艺有很大的帮助。[/align][align=center][/align]
在做价带谱的实验研究中,通常会非常关心二次电子边的位置和强度。但在我的仪器上(VG ARUPS10),时常会出现二次电子边起不来的现象,也有同行反映了类似问题,多认为是由于样品接触不好所导致,但我一直觉得还有别的某种未知因素。因为我的仪器有时候会出现连续好几天二次边都起不来的情况,无论我怎么加强样品的接触,消除外电磁场干扰等等。很是不解。不知道大家有没有遇到过类似的问题,如何解决的?欢迎email写信讨论。我的email:zhangwh@ustc.edu.cn
各位大虾: 金属二次电子发射系数和相应的金属氧化物相比,哪一个的二次电子发射系数高些?(如Ti和TiO2相比)谢谢
弱弱的问下:一般二次电子探测器加载电压250 V,根据相关原理,请问:能否通过改变二次电子探测器电压采集背散射电子像?
有个概念性的问题,比较弱哈扫描电镜中二次电子主要来自表面原子的价电子而特征X射线是原子的内层电子受到激发后,在能级跃迁过程中直接释放的具有特征能量和特征波长的一种电磁波辐射以前一直以为与x射线相关的这部分被激发出去的电子就是二次电子,现在看来二次电子来自不同的地方,那么这部分内层电子激发以后去了哪里?谢谢啊
最近打算购买扫描电镜,FEI Apreo C可以装几个二次电子探头,Apreo S可以装几个二次电子探头?感谢支持
我最近遇见一个案子,经典老电镜剑桥仪器S360,二次电子检测器的闪烁体的12KV供电单元坏了,还有检测器的偏压400V也坏了,可是二次电子像几乎还是和以前什么都好用的时候一样清晰,开始我也很糊涂,后来听高手解释才恍然大悟,请问各位为什么呢?
样品碰到了二次电子探头一下,现在要在很高对比度下才能看到图象,而且效果很不好,是不是探头坏了,好修吗?谢谢
SEM一般用二次电子成像,但有时看到也用背散射电子成像。我想问:什么时候用背散射电子成像更合理?两者的区别有哪些啊。新手!不懂!前来求教!
【作者按】上一篇详细介绍了物质的组成以及高能电子束轰击样品产生二次电子和背散射电子的过程。并对与扫描电镜成像有关的各种衬度信息做了较为详细的阐述。【[color=#00b0f0][b]延伸阅读:[/b][/color][url=https://www.instrument.com.cn/news/20200114/520618.shtml][b]二次电子和背散射电子的疑问(上)[/b][/url]】 二次电子和背散射电子都呈现出怎样的样品信息?如何利用这些信息对样品进行分析?在表面形貌像的形成过程中起怎样的作用?对表面形貌像的细节分辨有何影响?是否存在假象?这些问题都将在本文加以详细的探讨。[align=center][b]二次电子与背散射电子成像[/b][/align]传统观点认为:二次电子带有样品的表面形貌信息,形成样品的表面形貌像;背散射电子给出样品的成分信息,是形成样品成分像的主要信号源。这种观点是否片面?会不会产生假象?下面将围绕这些问题展开讨论。[align=center][b]一、二次电子[/b][/align]二次电子源自高能电子束对样品原子核外的介电子激发。能量低(50ev)、溢出深度浅(10nm)、溢出样品表面的分布不均。与样品表面夹角较大的二次电子(高角度二次电子),在样品中行走的自由程较短,溢出几率高,溢出量也较多。与样品表面夹角较小的二次电子(低角度二次电子),由于在样品中的自由程较长,因此损耗大、溢出几率较低、溢出量也较少。[align=center][img=1.png]https://img1.17img.cn/17img/images/202002/uepic/408e3c43-65b2-463f-9615-0a91b6981fd2.jpg[/img][/align]一直以来对于二次电子的认识存在很多问题,下面将选取以下几个问题来进行详细的探讨:二次电子主要来自核外的那一层电子激发?是形成表面形貌像的最佳选择吗?为啥易受荷电影响?会产生假象吗?有无Z衬度信息?SE1\SE2\SE3\SE4指的是啥?电位衬度和二次电子有什么关联?[b]1.1二次电子主要来自原子核外那一层?[/b]传统观念认为介电子(最外层)最容易被激发,所以二次电子主要来自最外层。那么一个疑问是:如果最外层电子是二次电子的主要来源,那么大量的特征X射线来自那里?我们先看一个加速电压的变化对能谱谱线强度影响的实例。[align=center][img=2.png]https://img1.17img.cn/17img/images/202002/uepic/599eb752-6862-4d29-b3ad-0000bf07d804.jpg[/img][/align]能谱谱线的峰位对应着电子结合能,结合能对应电子层。那一层电子激发多,对应峰位的谱峰就高。从上面两张谱图可以看到,加速电压的增加,铜和锌的K线占比也增大。这说明加速电压增加,结合能高的K层电子,激发量的占比也增加。 因此从能谱看,似乎二次电子主要源于核外那一层电子并不固定,而是与加速电压和轨道电子激发能(结合能)的比值(过压比)有关。但是有充分的事例表明,特征X射线与二次电子在激发量上存在巨大的差距,这意味着内层电子的激发量极少。因此推测内层电子的激发与最外层电子的溢出可能并不是一个体系,即与特征X射线激发有关的内层电子,是以光电子形式溢出样品。故二次电子可能只能来自最外层轨道也就是介电子层。所谓光电子就是指由光电效应产生的电子。即轨道电子全面接收入射电子的能量,克服轨道结合能的影响而溢出。光电子的最大初动能与光的频率(能量)有关。[b]Ek=hv-A h是普朗克常数,v是频率,A是逸出功[/b]主流观念认为内层电子的激发在过压比为3-4时达最佳。个人观点:不同元素这个值也不同,10左右都存在最佳激发的可能。充分认识到这一点,将有利于能谱测试时,对加速电压的选择。[b]1.2二次电子是否是形成样品表面形貌像的最佳信息源?[/b]传统理念认为二次电子是形成样品表面形貌像信息源的最佳选择。这个观点基于以下两点:1. 二次电子能量弱,在样品中自由程短,浅表层溢出,横向扩散极小,因此对表面细节的影响小,含有表面信息多。2. 二次电子的溢出量随平面斜率变化较大,边缘处溢出最多,由此形成二次电子衬度及边缘效应。样品的表面形貌可看成不同斜率的平面组合,因此二次电子衬度就带有大量形貌信息。[img=3.png]https://img1.17img.cn/17img/images/202002/uepic/9bc7d100-8ccc-4ea6-bceb-992f0df9311d.jpg[/img]二次电子衬度是否是形成样品表面形貌像的主导因素?二次电子形成的表面形貌像细节是否就一定最丰富?[b]1.2.1 样品表面形貌像是否取决于二次电子衬度?[/b]先看一个实例:用日立regulus8230的样品仓探头(L)和镜筒内探头(U)分别对硅片上刻蚀的倒金字塔图形进行观察。由于EXB系统的分离,使探头(U)接收的信息为较纯的二次电子。样品仓探头(L)因位置原因含有大量背散射电子。结果如下:[align=center][img=1.png]https://img1.17img.cn/17img/images/202008/uepic/171072a0-5b72-45d7-9e7b-562a06ac0a5a.jpg[/img][/align]由上例可见,图像中二次电子衬度充足但表面形貌像并不好, 形貌衬度(参见上篇)充足形成表面形貌像才十分的优异。因此形貌衬度才是形成形貌像的基础。形貌衬度的主要形成因素,依所观察样品的特性及所需获取的样品信息不同,分为两个层面:层面一:样品做低倍观察或样品表面起伏较大。探头、样品、电子束三者夹角将是影响形貌衬度的主导因素。大工作距离下使用侧向的样品仓探头获得表面形貌像,细节更丰富。[align=center][img=5.png]https://img1.17img.cn/17img/images/202002/uepic/dadb4366-061a-4b04-939b-6071ade9322b.jpg[/img][/align]层面二:高倍观察样品的几纳米细节。这些细节起伏小,采用不同角度的电子信息形成的形貌衬度即满足要求。小工作距离下选择镜筒探头从顶部获取较多的二次电子信息,减少信息扩散对细节的影响,是形成形貌像的关键。此时测试条件的选择,应当以尽可能多的获取低角度信息为目标。[align=center][img=2.png]https://img1.17img.cn/17img/images/202008/uepic/024fc5d0-42ae-4342-9376-1f2c0d6614cc.jpg[/img][/align]镜筒探头(U),利用不同角度的信息形成形貌衬度,只能面向起伏较小的样品细节,对较大细节的观察效果差。[align=center][img=3.png]https://img1.17img.cn/17img/images/202008/uepic/4b96227b-8219-4354-9919-c6063716e8dc.jpg[/img][/align][b][/b]探头(U)位于顶部,造成形貌衬度不足,无法分辨亮、暗衬度的空间形态。探头接收的二次电子占主导地位,二次电子衬度的影响使得斜面与平面有明显的亮、暗差异。亮部易被误认为是另一种物质所形成的Z衬度。采用探头(L)进行观察,情况刚好相反,故真实的孔洞信息表现充分。[align=center][b]B)二次电子的边缘效应也会对某些样品的细节分辨提供帮助[/b][/align][align=center]两张不同材料的多层膜照片,各膜层的材料相近,Z衬度较差。[/align][align=center][img=4.png]https://img1.17img.cn/17img/images/202008/uepic/30cfea12-6d69-4487-b960-7ebe49305d3a.jpg[/img][/align]以上几个实例表明:形成样品表面形貌像的基础是形貌衬度,而非二次电子衬度。二次电子衬度会带来形貌假象,但也会帮助我们观察并区分一些特殊的样品信息。不同的样品信息适合用不同的衬度信息来表现,故辩证的关系无处不在。[b]1.2.2二次电子对图像细节分辨能力的影响[/b]形貌衬度是形成扫描电镜表面形貌像的基础,其他的各种衬度信息叠加在形貌衬度上,才能形成完整的表面形貌像。无论表面形貌像是如何构成的,信息源都是二次电子和背散射电子。其在样品表面的溢出区大小,必然会对表面形貌像的细节分辨产生影响。电子信息的能量越大、影响也越大。二次电子能量弱,对样品表面细节影响小,是对松散样品(如介孔、气凝胶)的几纳米细节观察的首选信息。它的含量越大这类信息表现得就越充分。[align=center][img=5.png]https://img1.17img.cn/17img/images/202008/uepic/31aa0262-e51d-443f-a364-08789d18ec66.jpg[/img][/align]低倍下,观察细节受信号扩散的影响减弱,充足的形貌衬度将成为主体。此时选择样品仓探头从侧面观察,结果更佳。[align=center][img=6.png]https://img1.17img.cn/17img/images/202008/uepic/a3eed5c6-6b8c-406f-841c-5d6e833fe40b.jpg[/img][/align]以上多个实例表明,形成样品表面形貌像的基础在于形貌衬度。其余的各种衬度信息叠加在形貌衬度之上共同形成完整的表面形貌像。不同的信息需求必须采用不同的应对方案,才能获取最佳的测试结果,这是一个辨证的关系。[b]1.3 荷电现象与二次电子[/b]样品表面因电荷累积形成静电场,影响电场及周边电子信息的正常溢出,产生所谓的荷电现象(这一现象今后将有专文探讨)。二次电子由于能量弱因此更容易被该静电场所影响。[align=center][img=6.png]https://img1.17img.cn/17img/images/202002/uepic/f0392819-a938-40e5-8c23-1632be9b39e1.jpg[/img][/align]荷电场对高角度二次电子的溢出影响更为明显,因此样品信息中高角度二次电子含量越多,图像的荷电现象会更严重。下面以介孔硅KIT-6图像为例来说明。[align=center][img=7.png]https://img1.17img.cn/17img/images/202008/uepic/e8c31c1e-1dfe-47c7-9c45-6cbc63323c92.jpg[/img][/align]采用样品仓探头接收样品信息,工作距离也会影响荷电现象。[align=center][img=8.png]https://img1.17img.cn/17img/images/202008/uepic/3ee8d1e3-a752-4eb9-ab69-a1abc9e4de99.jpg[/img][/align][b]1.4二次电子是否拥有Z衬度信息?[/b]同一个加速电压下,样品的不同密度及原子序数,二次电子的激发量还是存在衬度差异,但该衬度差异不如背散射电子强烈。[align=center][img=9.png]https://img1.17img.cn/17img/images/202008/uepic/ade275e0-9420-49b5-8370-039102e48b70.jpg[/img][/align][b]1.5 SE1\SE2\SE3\SE4指的是啥?对测试结果有啥影响?[/b]依据目前各电镜厂家的描述:SE1指的是电子束直接激发并溢出样品表面的二次电子,SE2是样品内部各种散射电子激发并溢出样品表面的二次电子,SE3\SE4是散射电子、入射电子所激发的样品仓内的各种二次电子信息。 SE1是形成高分辨表面形貌像的关键信息。其扩散范围小,基本在电子束直径的周边,对样品表面形貌细节影响也最小。同等条件下该信息含量越充足,图像清晰度及细节分辨力越优异。 SE2离散度较高,加速电压越高其产额和离散度也会越大。当SE2成为样品表面形貌像的主导信息时,表面形貌像的图像分辨力会大大降低。这是过高加速电压图像分辨能力差的主要缘由。 SE3\SE4是杂散信息,产额越多对结果影响越大。电镜厂家在镜筒设计过程中都会将这一因素的影响压倒最低。选择加速电压时要充分考虑其对SE1\SE2产额的影响。在满足测试所需的电子束发射亮度的情况下,加速电压越低越好。要获得这样的结果,扫描电镜的本证亮度就要大。(可参看经验谈1)[b]1.6二次电子与电位衬度[/b]样品表面的少量静电场会引发该处信号异常溢出,当静电场弱小到不对图像的形态产生影响时,就形成了所谓的电位衬度。电位衬度主要影响的是能量较弱的二次电子,对背散射电子的溢出量影响较小。电位衬度可以在材料缺陷的分析上提供帮助。下面是我在为某单位进行样品测试时遇到的两个实例。[align=center][img=10.png]https://img1.17img.cn/17img/images/202008/uepic/4ac1d2e5-0460-4c65-8665-53c12c818eeb.jpg[/img][/align]从左至右,探头选择依次是U\UL\L,背散射电子含量依次增多。但图像Z衬度却反常的依次减弱,直至消失。因此考虑这是否是少量有机物形成轻微荷电场所产生的电位衬度,并不是我们日常所见到的Z衬度信息。放大后看到有亮点经电子束轰击后消失,图像缩小可看到明显碳污染的存在,故可判断该现象是有机物污染所形成。[align=center][img=11.png]https://img1.17img.cn/17img/images/202008/uepic/1b672cd4-42ee-463f-83bd-eba4761cab2f.jpg[/img][/align]上述现象如同上例所存在的探头切换时Z衬度的异常变化,只是高倍轰击并没有出现碳沉积现象。说明此处异常亮并非有机物附着形成,可能已经被有机物氧化,能谱分析此处氧含量偏多。用户对设备清洗后这些现象都消失。[align=center][b]二、背散射电子[/b][/align]与入射电子束方向相反的散射电子,称为背散射电子。其能量与入射电子相当,在样品中扩散范围较大,加速电压越大扩散体也越大,对图像细节影响也越大。背散射电子在样品表面溢出范围也不均衡。由于高角度背散射电子形成几率小,因此溢出量少,低角度背散射电子产生的几率较高,因此溢出量较多。[align=center][img=12.png]https://img1.17img.cn/17img/images/202002/uepic/dd47d4a8-592f-477d-8a4c-2dec993cd022.jpg[/img][/align]背散射电子图像拥有如下特点:Z衬度与晶粒取向衬度好、受荷电影响小、信号扩散区大、极表层信息缺乏、电位衬度较差。[b]2.1背散射电子和二次电子的图像对比:[/b][align=center][img=13.png]https://img1.17img.cn/17img/images/202002/uepic/c95317fd-f9ce-4958-8c78-563d172684fa.jpg[/img][/align][b]2.2背散射电子进行的晶粒结构及取向分析[/b][align=center][img=14.png]https://img1.17img.cn/17img/images/202002/uepic/7aeb4551-2ef4-47d5-91fb-99fc1df796e7.jpg[/img][/align]背散射电子的溢出量不仅受到样品原子序数及密度的影响,晶体材料的晶体结构及取向也会对背散射电子的溢出量及溢出方向产生影响,形成的晶粒取向衬度(电子通道衬度)更明析。但是要形成足够的衬度差异,需要晶粒存在较大的取向差、足够的体积、密度及整体平整度。要获取该种类的样品信息,样品平整度处理十分重要。切割、抛光处理是常备的制样方式。利用背散射电子衍射(EBSD)所形成的菊池花样对晶粒取向及构造进行分析,所获得的取向精度得到极大的提升,达到0.1°,分析内容也更为充分。是目前利用扫描电镜进行晶粒结构和取向分析最权威、最充分且是最常用的技术手段。[align=center][img=15.png]https://img1.17img.cn/17img/images/202002/uepic/5e34d2af-f814-40d7-9c7a-b8be561439d8.jpg[/img][/align]无论是直接利用背散射电子获取晶粒取向衬度还是通过EBSD来对晶粒进行观察和分析,信息源都是背散射电子。离开背散射电子,扫描电镜将无法充分的进行晶体材料结构及取向分析。[b]2.3背散射电子图像的分辨力[/b]加速电压、样品特性、信息需求、探头的性能和位置都影响着背散射电子图像的分辨力。在谈论图像分辨力时不能脱离条件的限制。比如观察样品的Z衬度信息,背散射电子形成的图像比二次电子形成的图像拥有更好的细节分辨;要观察样品内部的信息,加速电压低了是无法观察到的; YAG材质的探头比半导体材质的探头更适合低加速电压观察,样品表面信息分辨好。但总体来说背散射电子在样品中的扩散比二次电子来的大。对样品表面形貌像的细节干扰较强、较为明显。背散射电子含量越大,高倍率图像的清晰度也越差。[align=center][b]三、结束语[/b][/align]二次电子和背散射电子是扫描电镜形成样品表面形貌像的两个重要信息源。但形成表面形貌像的基础却是探头所获取的样品表面各种信息的衬度,而不是选用了那个信息源。如同用不同颜色的光去观察一个物体。无伦选用哪种颜色的光,形成物体图像形态的关键都是对物体的观察角度。不同的观察角度,图像的形态不同。而不同颜色的光只是给这个物体染上了颜色。不同亮度的光可以在一定程度上影响物体图像细节的辨晰度,却无法影响物体图像的形态。 图像上的明、暗差异被称为图像衬度,是形成图像的基础。噪点及亮度、对比度的调整也会对其产生影响,但与成像有关的是各种信息衬度。图像的衬度主要由各种信息的衬度所形成。 形貌衬度、Z衬度、晶粒取向衬度(电子通道衬度)、二次电子衬度、边缘效应、电位衬度是形成扫描电镜图像的几个主要衬度信息。其中形貌衬度是基础,其余的衬度信息叠加在该衬度之上,共同形成扫描电镜的各种图像。不同的样品表面信息需要用不同的衬度信息来表现,才能获得最佳的效果。 样品表面形貌的高低位置差异形成扫描电镜图像的形貌衬度。形貌衬度主要受探头接收样品信息的角度影响。对形貌衬度产生主要影响的因素分为两个层次:1.倍率越低,形貌的高低位置差异越大,要求的形貌衬度较大,探头、样品和电子束三者间形成一定的夹角才能满足形貌衬度的形成需求。此时这个夹角就是关键因素,对样品仓探头的充分运用才能保证我们获取更为丰富的表面形貌像。2.高倍下形貌高低位置差异减少。对形貌衬度的要求较小,样品信息的溢出角度所形成的形貌衬度即满足形貌像的需求,此时信息扩散对细节的影响成为主导因素。采用小工作距离、镜筒探头这一组合观察时,接收的二次电子较多,对形貌细节的影响较少,此时形成形貌衬度的主导因素是样品的低角度电子信息。 二次电子和背散射电子做为形成样品表面形貌像的信息源,必然会对表面形貌像形成影响,其影响主要表现在信号扩散对细节的掩盖,相对来说二次电子对样品表面细节的影响较小。二次电子和背散射电子形成的各种衬度信息(Z衬度、晶粒取向衬度、边缘效应、二次电子衬度电位衬度等)是我们进行样品表面形貌观察及分析的重要依托。二次电子有利于减少信号扩散的影响,其电位衬度、边缘效应、二次电子衬度极为充分,利于展示样品的某些特殊信息,但这些衬度也会带来一些假象。必须辩证的认识,合理的使用。二次电子的溢出量容易受到样品表面荷电场的影响,形成样品表面的荷电现象。高角度二次电子更加容易受到荷电场的影响,它的含量越大,样品表面的荷电现象越严重。背散射电子有利于表现Z衬度、晶粒取向衬度等信息。因其本身能量较大,溢出量不易受样品表面荷电场的影响,被视为应对样品荷电现象的有效方法之一。但也正是因为能量较大,在样品中扩散范围也相对较大,使得高倍时图像清晰度较差,不利于低于20纳米的样品细节的展现。我们在运用二次电子和背散射电子作为信号源来形成样品表面形貌像时,应当依据样品特性以及所需获取的信息特性,对症下药用辩证的思维方式来指导我们选择合适的测试条件。[b]参考书籍:[/b]《扫描电镜与能谱仪分析技术》张大同2009年2月1日华南理工出版社 《微分析物理及其应用》 丁泽军等 2009年1月中科大出版社 《自然辩证法》 恩格斯 于光远等译 1984年10月人民出版社《显微传》 章效峰 2015年10月 清华大学出版社日立S-4800冷场发射扫描电镜操作基础和应用介绍 北京天美高新科学仪器有限公司 高敞 2013年6月