方案详情文
智能文字提取功能测试中
广州科适特科学仪器有限公司kosterpub@163.comwww.kosterscience.com 扫描探针显微镜设计用于轻松集成到电子显微镜中 表面结构的三维可视化 复杂表面特征-形貌,粗糙度,磁性,电导率,电性能等 ·精确的SPM尖端导航到SEM感兴趣的区域 ·用户友好的操作,轻松集成到SEM ·广泛的SPM成像模式 探索各种应用 探索全新的相关探针和电子显微镜技术 SPM/FIB/SEM-集成电路失效分析 相关探针和电子显微镜(CPEM) 是一种结合扫描电子显微镜(SEM)和扫描探针显微镜 (SPM)的新技术。集成电路中的目标层可以通过SEM和SPM在同一地点,同时和相同的协调下进行分析系统。 CPEM图像包含表面形貌信息以及典型的SEM细节。 SPM / FIB / SEM技术的集成显着简化了用于故障分析,质量控制和集成电路研发的去层过程。 我们的解决方案 相关成像,表面表征 判定 深度剖析 通孔层的SEM, SPM 和CPEM图 像。 RMS粗糙度为3.3nm。 3D逐层重建 2.5纳米。 联系我们: SPM-FIB-SEM系统联用在集成电路失效分析中的应用相关探针和电子显微镜(CPEM)是一种结合扫描电子显微镜(SEM)和扫描探针显微镜(SPM)的新技术。 集成电路中的目标层可以通过SEM和SPM在同一地点,同时和相同的协调下进行分析系统。CPEM图像包含表面形貌信息以及典型的SEM细节,SPM / FIB / SEM技术的集成显着简化了用于故障分析,质量控制和集成电路研发的去层过程.质量控制,去层后的平面性,下图是晶体管接触层的SEM图像。判定表面粗糙度精确的SPM探针导航,深度剖析SPM探针接近晶体管接触层。晶体管接触层的SPM(AFM)图像,RMS粗糙度2.5纳米。深度剖析相关成像,表面表征通孔层的SEM,SPM(AFM)和CPEM图像,RMS粗糙度为3.3nm。3D逐层重建
关闭-
1/2
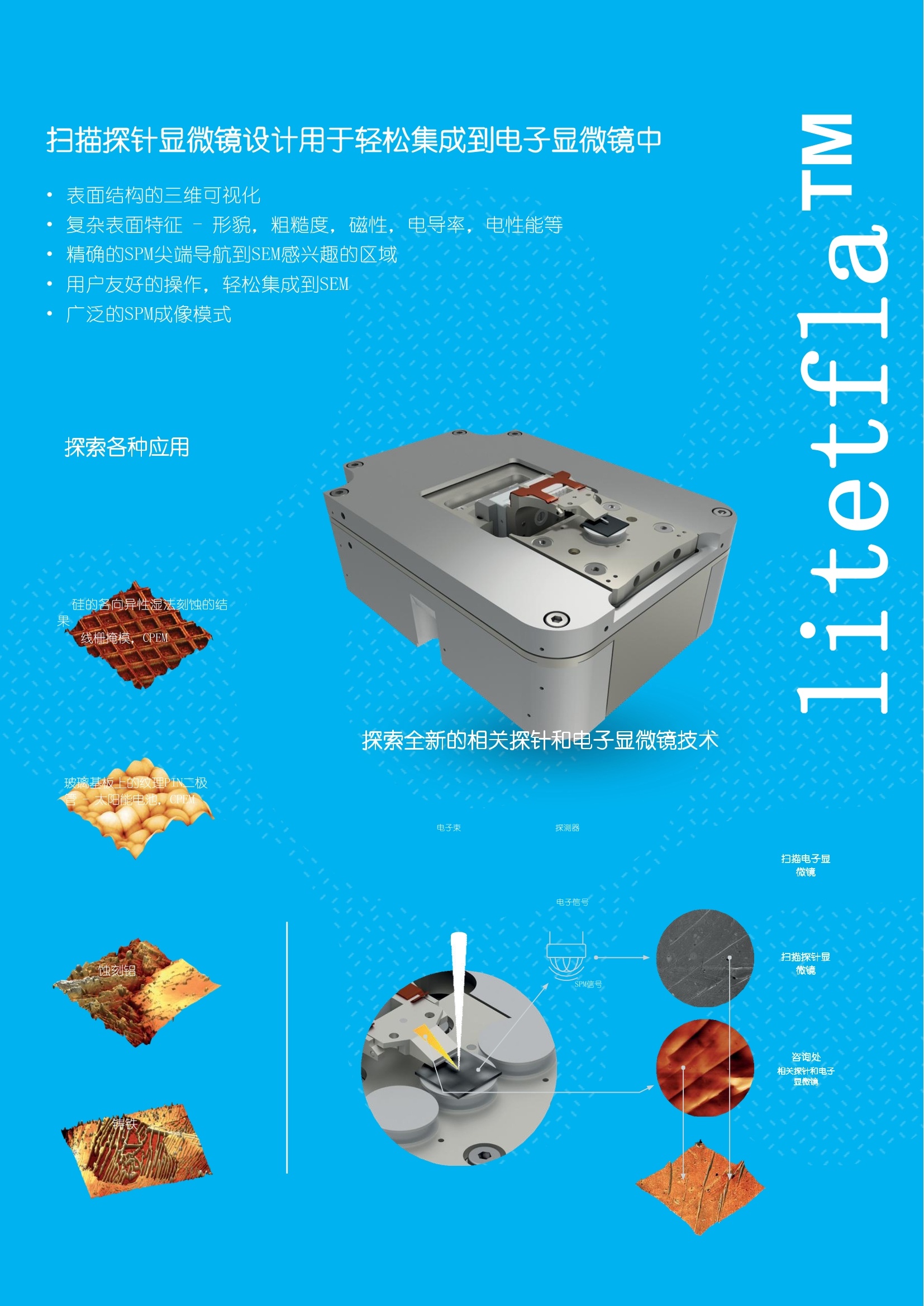
-
2/2

产品配置单
广州科适特科学仪器有限公司为您提供《集成电路中失效分析检测方案(扫描探针)》,该方案主要用于电子元器件产品中失效分析检测,参考标准《暂无》,《集成电路中失效分析检测方案(扫描探针)》用到的仪器有Nenovision原子力显微镜(电镜原子力关联)。
我要纠错
推荐专场
扫描探针显微镜SPM(原子力显微镜AFM、扫描隧道显微镜STM)
更多相关方案






 咨询
咨询





