
方案摘要
方案下载| 应用领域 | 电子/电气 |
| 检测样本 | 电子元器件产品 |
| 检测项目 | |
| 参考标准 | / |
自摩尔定律问世以来,微电子器件的特征尺寸一直在不断缩小,以提高集成电路的集成度和性能。由于短沟道效应的限制,鳍式场效应晶体管和环栅场效应晶体管等非平面型器件已逐渐被半导体行业所采用。为了满足制造具有这些复杂结构的芯片的要求,ALD因其可以在三维结构上生长高度均匀的保形薄膜的特点,已被广泛用于集成电路先进制程中的关键步骤。 ALD技术在很大程度上依赖于所涉及的表面化学,它可以显著影响沉积膜的特性,如膜厚、形貌、组分和保形性。此外,ALD前驱体对薄膜沉积也起着至关重要的作用。ALD前驱体通常为金属有机化合物,前驱体的挥发性、热稳定性和自限制反应性会显著影响薄膜的ALD生长行为。因此,全面了解ALD的表面化学机制和前驱体化学结构设计是进一步开发和利用ALD技术的关键。在本文中,作者等人对原子层沉积的最新进展进行了详细介绍。
自摩尔定律问世以来,微电子器件的特征尺寸一直在不断缩小,以提高集成电路的集成度和性能。由于短沟道效应的限制,鳍式场效应晶体管和环栅场效应晶体管等非平面型器件已逐渐被半导体行业所采用。为了满足制造具有这些复杂结构的芯片的要求,ALD因其可以在三维结构上生长高度均匀的保形薄膜的特点,已被广泛用于集成电路先进制程中的关键步骤。
ALD技术在很大程度上依赖于所涉及的表面化学,它可以显著影响沉积膜的特性,如膜厚、形貌、组分和保形性。此外,ALD前驱体对薄膜沉积也起着至关重要的作用。ALD前驱体通常为金属有机化合物,前驱体的挥发性、热稳定性和自限制反应性会显著影响薄膜的ALD生长行为。因此,全面了解ALD的表面化学机制和前驱体化学结构设计是进一步开发和利用ALD技术的关键。在本文中,作者等人对原子层沉积的最新进展进行了详细介绍。
a、ALD表面化学机制:ALD是化学气相沉积(CVD)的一类变种,其基本原理是将气相前驱体以脉冲的形式交替通入反应腔体中,气相前驱体在基底表面发生化学吸附并进行自限制的表面化学反应,从而实现薄膜的原子层级别的生长(图1 a)。由于表面反应的自限制性,当前驱体的暴露量足够使其完成与基底表面所有活性位点的化学反应后,多余的前驱体分子将不会化学吸附在反应表面,因此每个ALD循环只沿着整个基底表面的形貌均匀地生长单个原子层,即具有良好的保形性和厚度均匀性(图1 b)。此外,ALD的表面反应和沉积温度密切相关,在ALD温度窗口内,表面反应具有自限性,ALD在该温度范围内以几乎恒定的生长速率沉积薄膜;当沉积温度在ALD温度窗口外时,多种非理想因素可能出现并使其偏离理想生长,如前驱体的冷凝或分解、不完全的表面反应以及前驱体脱附(图1 c)。

图1 原子层沉积的基本特性。(a)表面化学反应示意图;(b)饱和生长特性;(c)温度窗口。
目前,许多材料的ALD制备已经实现,其中涉及表面化学机制可以归纳为四类:(1)配体交换;(2)解离吸附和非解离吸附;(3)氧化机制;(4)还原机制。这些机制并不是完全独立的,在很多情况下,ALD表面反应可能涉及到其中多种反应机制。
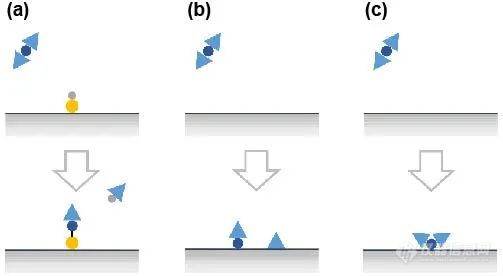
图2 化学吸附机制示意图。(a)配体交换;(b)解离吸附;(c)非解离吸附。
尽管ALD在沉积高质量薄膜方面有许多优点,但ALD工艺中仍存在非理想因素,深入研究非理想因素对于更好的薄膜质量控制至关重要。为此,作者详细阐述了ALD中一些典型的非理想因素,包括成核延迟、副产物吸附、配体分解、团聚、离子扩散和刻蚀效应(图3)。
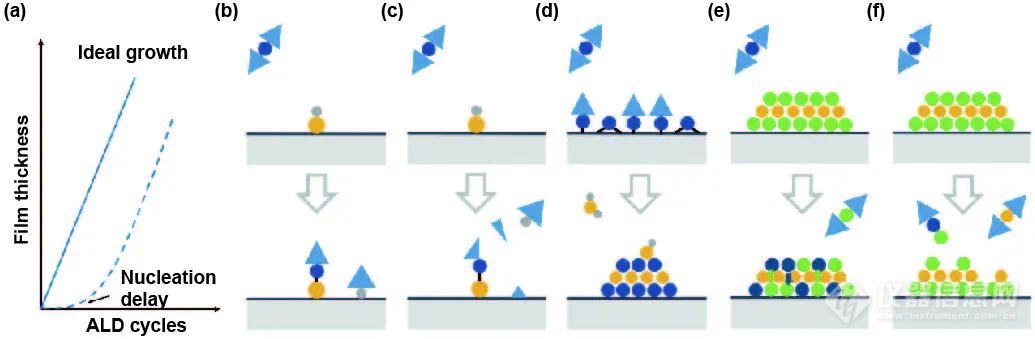
图3 ALD非理想因素。(a)成核延迟;(b)副产物吸附;(c)配体分解;(d)团聚;(e)离子扩散;(f)刻蚀效应。
b、ALD前驱体化学:ALD前驱体对薄膜沉积也起着至关重要的作用。通常,ALD前驱体应具有足够的挥发性、热稳定性和自限制反应性。挥发性是所有气相薄膜沉积技术的先决条件;良好的热稳定性对于避免前驱体在加热时或在衬底表面分解十分重要;前驱体的自限制反应性是保证原子层级别生长的前提。因此多年来,研究者一直致力于前驱体分子结构设计,以实现ALD应用所需的特性。例如,为了提高前驱体的挥发性,其通常采用具有烷基末端的有机配体来减少分子间的相互作用;而螯合结构可以被引入以提高前驱体的热稳定性。在本文中,作者对目前常用的几类ALD前驱体进行了详细介绍,包括金属卤化物、金属烷基化合物、金属醇盐、β 金属酮盐化合物、金属茂基化合物、金属胺基化合物以及金属脒基化合物(图4)。此外,通过合理的结构设计,在分子中引入不同类型的配体,可以将这几类ALD前驱体各自的优势结合起来,为前驱体的发展带来新的可能。

图4 ALD前驱体。
c、ALD的微电子领域应用:自从在DRAM中采用高k氧化锆以及45nm CMOS技术节点中采用氧化铪栅介质以来,ALD已经在半导体行业中被广泛使用。作者在文中列举了微电子领域的一些极具前景的新兴应用,包括基于氧化物的薄膜晶体管、铁电介电层以及金属互连(图5)。

图5 ALD在微电子领域的应用:(a)氧化物薄膜晶体管;(b)铁电介电层;(c)金属互连。
ALD作为一种可实现原子层级别的生长与调控的薄膜沉积技术,在微纳制造领域将发挥越来越重要的作用。尽管ALD技术在过去几十年得到了长足发展,但仍存在许多问题尚未解决:对于多元化合物的ALD制备,由于成核延迟在不同材料的切换生长中被显著放大,其组分通常难以调控;选择性ALD技术可以在不同材料的表面实现选择性生长,在降低集成电路制造中的光刻套刻误差方面有巨大的应用潜力,然而其工艺可靠性仍有待提高;空间ALD技术相比较传统的ALD技术,可以显著提升工业生产线的吞吐量,然而该技术更容易受表面化学反应动力学影响。为了进一步发展和利用ALD技术,解决上述难题,深入了解ALD表面化学机制和前驱体化学具有重要意义。随着ALD化学机制研究的不断深入,ALD技术的工业应用也将被大大促进。


分子相互作用相互仪(MP-SPR)在小分子药物与人血清白蛋白的相互作用方面的应用
分子相互作用仪(MP-SPR)在活细胞中小化合物对G蛋白偶联受体(GPCR)刺激分析中的应用
分子相互作用相互仪(MP-SPR)在奶粉细菌检测方面的应用
相关产品
铝离子检测仪 MIPS
氟离子检测仪 MIPS
内毒素检测仪 MIPS
农药检测仪 MIPS
石英晶体微天平 MIPS
纳米等离子体传感分析仪 S2
纳米等离子体传感分析仪 M8
全晶圆工业阴极荧光CL-SEM系统 Santis 300
皮秒时间分辨阴极荧光 CL-SEM系统 Chronos
磁场成像显微镜系统 Magma EFI HiRes
磁场成像显微镜系统 Magma EFI
多参数表面等离子体共振分析仪(分子互作分析仪) MP-SPR 410A
离子辅助脉冲激光沉积系统 Ion-Assisted PLD System
大尺寸脉冲激光沉积系统 Large-Area PLD Systems
组合型脉冲激光沉积系统 Combinatorial PLD System

关注

拨打电话

留言咨询