

本文介绍了一种配备自动化和可重复的 DIC(微分干涉对比)成像的 6 英寸晶圆检测显微镜,无论用户的技能水平如何。制造集成电路(IC)芯片和半导体组件需要进行晶圆检测,以验证是否存在影响性能的缺陷。这种检测通常使用光学显微镜进行质量控制、故障分析和研发。为了有效地可视化晶圆上结构之间的细微高度差异,可以使用 DIC 。
在半导体器件生产过程中,晶圆检验对于识别和减少可能影响器件性能的缺陷至关重要。为了提高检验的精确性和效率,光学显微镜方案应结合不同的对比方法,提供关于图案化晶圆上可能存在的任何缺陷的准确可靠信息。其中,在晶圆检验中起重要作用的一种对比方法是微分干涉对比(DIC)。
什么是 DIC 以及为什么要使用它?
微分干涉对比(DIC) ,也被称为诺马斯基对比,有助于可视化样品表面的高度差异[1,2]。DIC 使用沃拉斯顿棱镜、起偏器和检偏器(参见图1A)。起偏器和检偏器的偏振面相互垂直(交叉于 90° ) 。通过棱镜的偏振光被分割成两束具有 90° 偏振差异的广播。在离开棱镜后,这两束光波从样品表面反射,并朝着物镜返回。由于样品表面形态或光学性质的差异,光线可能经历不同的光学路径长度,导致一束光与另一束光相比发生相移。经过物镜棱镜和分析器的再次通过后,光线重新合并成一束,然后它们之间可以发生干涉。DIC 图像显示出强度和颜色的变化,从而呈现出纹理的外观。DIC 使得通常使用明场或暗场等其他类型的照明无法轻易观察到的高度差异变得明显可见。有关 DIC 的更多信息,请参考参考文献1和2。
下图是一个使用微分干涉对比(DIC)与明场和暗场照明相比,增强样品表面高度差异的示例(见图1)。DIC 被用来拍摄一 个图案化的晶圆样品。在 DIC 下,特征之间的高度差异更加明显可见。
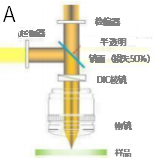



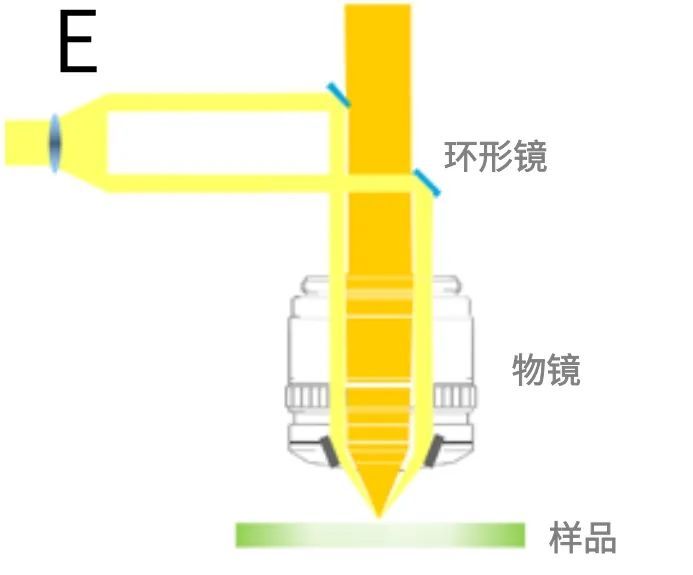

图1:用 DIC、明场和暗场照明成像的图案化晶圆样品图像:A) 显微镜光学中的入射光路径用于 DIC 和B) 样品图像;C) 明场的入射光路径和D) 样品图像;以及E) 暗场的入射光路径和F) 样品图像。
使用 DIC 时的挑战:
DIC 能够让使用者观察到晶圆上结构之间的微小高度差异,但对许多用户来说,使用起来可能相当复杂。正确调整 DIC 棱镜对于实现最佳对比度和准确、可重复的结果至关重要。例如,在 DIC 图像中,样品结构的垂直方向(进入或离开样品的水平面)在很大程度上取决于棱镜对光波的剪切。因此,剪切影响观察到的结构之间的任何高度差异,即图像中的一个结构是否看起来比另一个更高或更低。剪切通常表示为具有正向或负向的偏差(参见下文图2) ,但偏差通常不与实际的高度差异相关。对于大多数光学显微镜,除了起偏器和检偏器的交叉之外,还需要手动调整 DIC 棱镜。然而,用户应该具有高水平的经验才能获得可比较、一致的 DIC 结果。获得具有非常好 DIC 对比度的图像可能需要用户花费大量的时间和精力进行手动调整。

图2:使用 DIC 拍摄的图案化晶圆区域的图像,具有:A) 负偏差,B) 无偏差,和 C) 正偏差。加号和正方形形状的边框在负偏差时看起来像是从表面升起,在正偏差时则 像是陷入表面。
自动化和可重复的 DIC 成像的优势
对于手动 DIC 操作,显微镜的照明和对比度设置必须始终由用户直接进行调整。图像结果在很大程度上取决于用户的经验和技能水平。然而,通过提供自动化 DIC 操作的显微镜,可以高效地实现用于质量控制(QC)、失效分析和研发(R&D)的晶圆检查工作流程。即使是经验较少的用户也可以轻松地进行可重复的 DIC 成像,只需进行最少的设置更改。只需按下按钮,就可以选择适当的棱镜并调整其位置以实现所需的入射光波的剪切,此外,设置会自动存储并易于调用。当使用 DIC 时,这一特性对于可靠的文档记录也是必不可少的。
徕卡的可重复 DIC 解决方案
使用 DM6 M 显微镜(参见图3) ,可以快速可靠地检查6英寸晶圆。由于以下特点,它提供了晶圆和半导体组件的自动化和 可重复的 DIC 成像:
在工作区域节省空间方面还有额外的好处,因为 DM6 M 的占地面积比通常用于晶圆检查的显微镜要小。

图3:使用安装了 6 英寸晶片平台的 DM6 M 显微镜进行晶片检测的示例。
图4展示了使用 DM6 M 显微镜和可重复 DIC 技术拍摄的图案化晶圆图像。为了比较的目的,图5也展示了同一晶圆在明场和暗场照明下记录的图像。




图4:使用 DM6 M 显微镜,采用具有负偏移(A和C)和正偏移(B和D)的光波剪切的差分干涉对比(DIC)技术,对图 案化晶圆的不同区域进行成像。
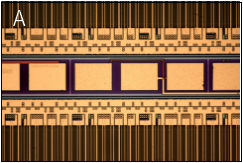
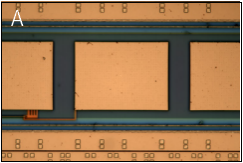
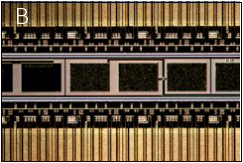
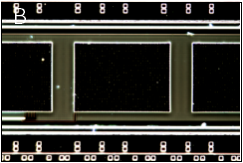
图5: 图4中显示的图案化晶圆的相同区域,但这次是使用DM6 M显微镜在A)明场和B)暗场照明下成像。
总结和结论
描述了一种带有自动化和可重复的微分干涉对比(DIC)技术的 6 英寸晶圆检查显微镜,即带有晶圆载物台的 DM6 M。在半导体行业中,晶圆检查用于质量控制(QC)、失效分析和研发(R&D) ,通常需要使用各种对比方法的光学显微镜。DIC 技术能够高效地可视化图案化晶圆上结构之间的微小高度差异。即使是经验较少的用户,使用自动化和可重复的 DIC 也能在检查期间高效地进行 DIC 成像。
参考文献:
1. D. Diez, J. DeRose,《超越明场》章节,《金相学 - 简介:如何揭示金属和合金的微观结构特征》, Science Lab (2020 年)徕卡显微系统。
2. J. DeRose, D.R. Barbero,《使用显微镜对比方法进行快速半导体检测:通过光学显微镜揭示关键细节,在电子行业 中高效可靠地进行半导体质量控制》, Science Lab(2023 年)徕卡显微系统。

徕卡显微咨询电话:400-877-0075





关于徕卡显微系统

显微图库 | THUNDER技术图库 第三弹
月满中秋 | 海上观月影,心向未“徕”
【案例分享】脑部手术中的最佳可视化
类器官研究利器-MICA
相关产品
德国徕卡 体视显微镜-数码显微镜 DVM6
德国徕卡 倒置荧光金相显微镜 Leica DMi8 M
MICA 全场景显微成像分析平台
ARveo 8数字化手术显微镜
德国徕卡 MICA宽焦全场景显微成像分析平台
德国徕卡 MICA宽场活细胞全场景显微成像分析平台
德国徕卡手术显微镜系统 Leica M525 F20
德国徕卡眼科手术显微镜徕卡M620 F20
德国徕卡桌面眼科手术显微镜 Leica M620 TTS
德国徕卡红光反射手术显微镜 M822
德国徕卡眼科手术显微镜M844 F40 / F20
德国徕卡眼科手术显微镜 Proveo 8
德国徕卡眼科手术显微镜 Leica ToricEyePiece
德国徕卡视网膜正像观察镜 Leica RUV800
德国徕卡摆臂式旋转分光器Leica Rotatable Beamsplitt

关注

拨打电话

留言咨询