常规椭偏仪通常只能对一点进行膜厚测量,而且单点测量也需要耗费时间,虽然也有可以做到自动扫描检测整个样品膜厚状况的手段,但是点数和时间以及精度往往无法满足工业客户的需求;
对客户的这一痛点日本Photonic lattic 通过以自研的偏振传感器为核心的新一代全检膜厚测量椭偏仪,可以做到1000点/分钟,6寸产品最快可以在3分钟内完成,不仅如此,ME-210-T针对透明基板也可测量。
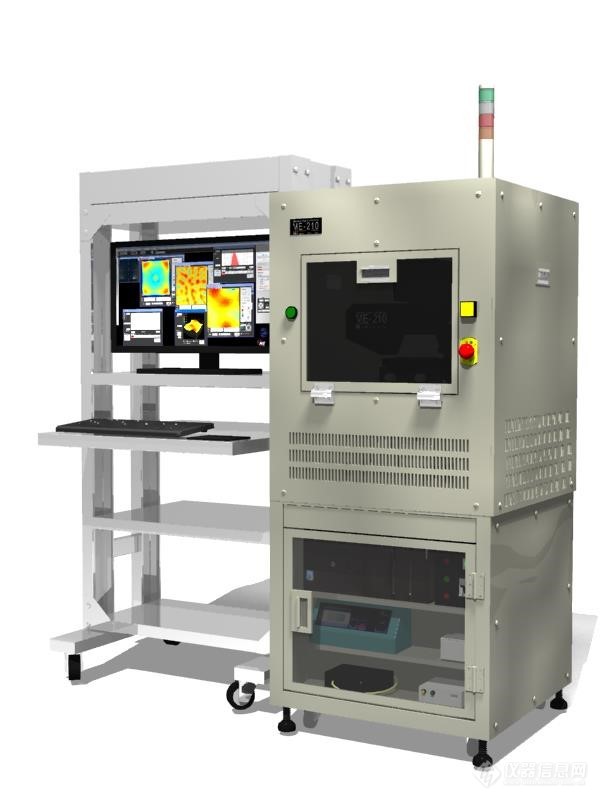
新品发布-VR镜头专用应力双折射测量设备
光博会延期通告
lasertec共聚焦显微镜的白光共聚焦功能介绍
中秋节放假通知-欧屹科技
相关产品
PHL应力双折射测试仪
PHL双折射应力仪WPA-Micro
PHL显微型应力双折射仪
应力双折射测试仪器WPA-200,WPA-200-L
PHL应力双折射仪 PA-200
PHL偏振相机 PI-110
PL光子晶体波片
PHL膜厚测试仪/椭偏仪SE-101
Adamand Namiki 光干涉内周面测量仪 NMH-01
Lasertec激光白光混合共聚焦显微镜系统HYBRIO
蓝宝石专用双折射测量仪
球坑测厚仪
Photonic Lattice显微应力双折射分析仪 PA-Micro
Micro Support微区取样器AXIS Pro
ARMS SYSTEM无掩模光刻机/直写光刻机UTA-IA

关注

拨打电话

留言咨询