
方案摘要
方案下载| 应用领域 | 电子/电气 |
| 检测样本 | 电子元器件产品 |
| 检测项目 | |
| 参考标准 | 2.5nm |
相关探针和电子显微镜(CPEM)是一种结合扫描电子显微镜(SEM)和扫描探针显微镜(SPM)的新技术。 集成电路中的目标层可以通过SEM和SPM在同一地点,同时和相同的协调下进行分析系统。CPEM图像包含表面形貌信息以及典型的SEM细节,SPM / FIB / SEM技术的集成显着简化了用于故障分析,质量控制和集成电路研发的去层过程.
SPM-FIB-SEM系统联用在集成电路失效分析中的应用
相关探针和电子显微镜(CPEM)是一种结合扫描电子显微镜(SEM)和扫描探针显微镜(SPM)的新技术。 集成电路中的目标层可以通过SEM和SPM在同一地点,同时和相同的协调下进行分析系统。CPEM图像包含表面形貌信息以及典型的SEM细节,SPM / FIB / SEM技术的集成显着简化了用于故障分析,质量控制和集成电路研发的去层过程.
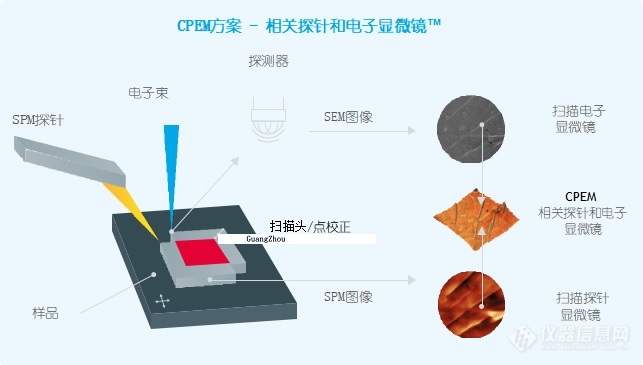
质量控制,去层后的平面性,下图是晶体管接触层的SEM图像。

判定表面粗糙度
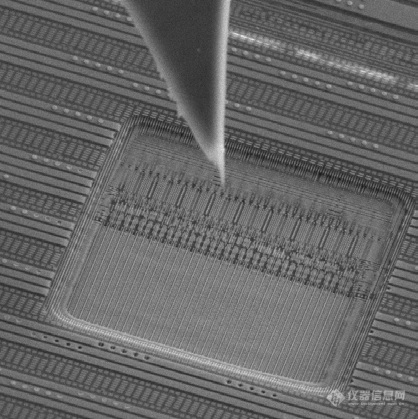
精确的SPM探针导航,深度剖析
SPM探针接近晶体管接触层。
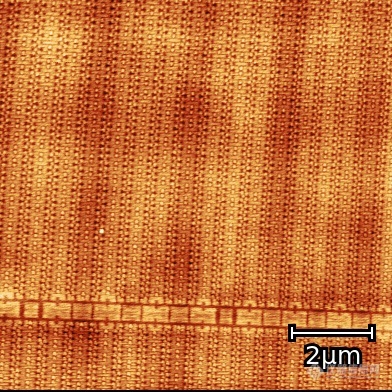
晶体管接触层的SPM(AFM)图像,RMS粗糙度2.5纳米。
深度剖析
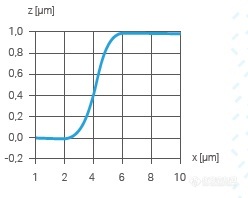
相关成像,表面表征
通孔层的SEM,SPM(AFM)和CPEM图像,RMS粗糙度为3.3nm。
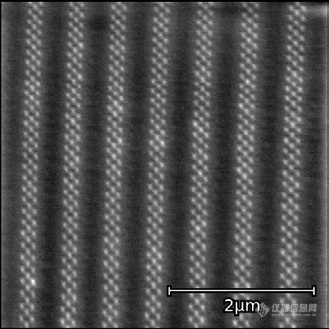
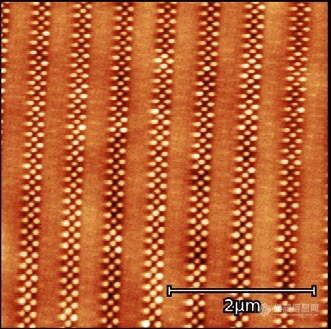
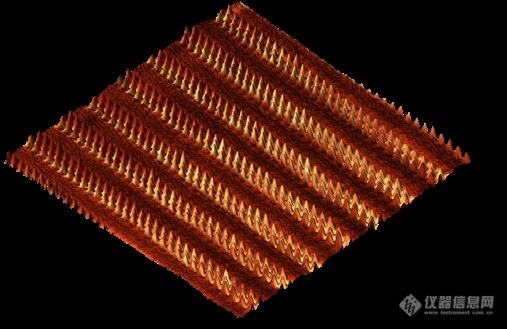
3D逐层重建
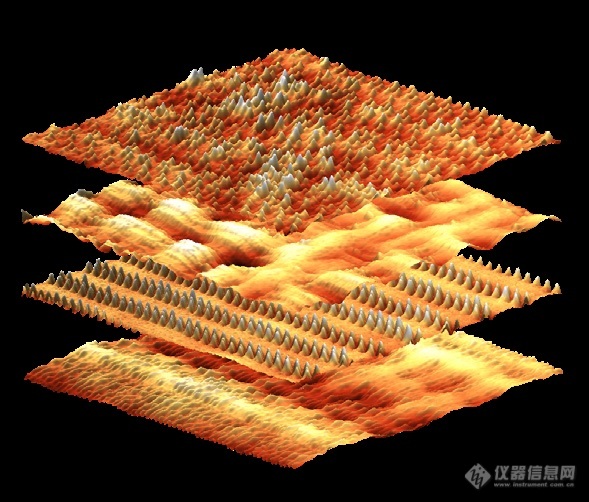


3D细胞培养模型 – 概述
相机触发LED光源实现活细胞自动多色成像方案
CoolLED pE-4000用于体外电生理学的落射荧光成像与光遗传学刺激
相关产品

关注

拨打电话

留言咨询