
方案摘要
方案下载| 应用领域 | 半导体 |
| 检测样本 | 其他 |
| 检测项目 | |
| 参考标准 | 无 |
共聚焦显微镜和干涉仪是常用的表面形状测量仪器,具有无损,高精度等特点。 然而对于基板上的透明薄膜的凹凸形状,对于较薄的膜(1um上下),测量是受到基板反射光的影响,会导致测量失败。 如,在测量Si晶圆上的光刻胶的形状时。 为解决上述问题,我们推荐反射分光法,测量光刻胶的膜厚,从而得到表面形状信息。
概要
共聚焦显微镜和干涉仪是常用的表面形状测量仪器,具有无损,高精度等特点。
对于基板上的透明薄膜的凹凸形状,对于较薄的膜(1um上下),测量是受到基板反射光的影响,会导致测量失败。
如,在测量Si晶圆上的光刻胶的形状时。
为解决上述问题,我们推荐反射分光法,测量光刻胶的膜厚,从而得到表面形状信息。
对于金属、塑料制品等,其加工面上的即使是几十微米的凹凸、台阶,用共聚焦显微镜可以进行测量。然而如下图所示的,硅晶圆上的光刻胶样品的形状测量,则不再适用。
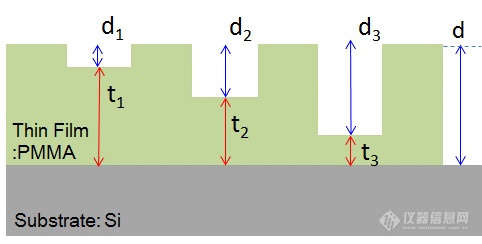
为何测不出?
共聚焦显微镜的测量原理是通过接收样品表面的反射光,得到反射面的高度信息。
当样品是Si-光刻胶 两层结构时,两个表面均会反射。两个反射面的距离小于几微米时,反射光难以完全分离,导致测量失败。
解决方案来了!反射分光膜厚法——
对于硅晶圆,可认为其表面为平面,那么,上层光刻胶的膜厚分布信息即可作为表面高度信息。
那么,如何测量膜厚呢?
我们来了解一下原理——
共聚焦显微镜拍摄得到的图像如下,根据光刻胶深度的不同,各位置呈现不同颜色。
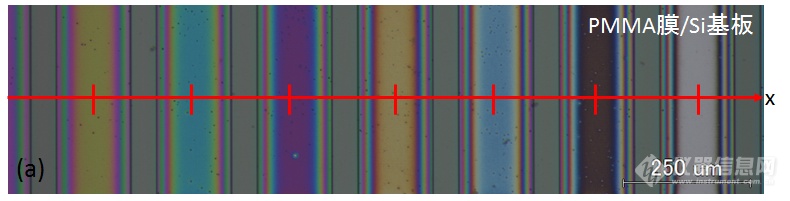
透明材料制成的薄膜,随膜厚颜色不同,是由于1)薄膜的上下表面的反射光发生干涉;2)不同波长,即不同颜色的光,干涉效果不同(叠加后后强度不同),于是呈现出与原材料不同的颜色。
对于特定波长()的光,其反射率(R)由透明膜的厚度(t)造成的相位差()决定。具体来说如以下公式:
 (1)
(1)
 (2)
(2)
于是,测量得到各波长光的反射率,即可通过拟合计算得到透明膜的膜厚了。

对于上图种的样品,可测得各条形图案处的膜厚,如下表:

共聚焦显微镜+反射分光膜厚测量的 独特优势!——
与市场上常见的反射分光膜厚仪相比,在共聚焦显微镜上搭载反射分光功能,其最大优势是:XY方向的高分辨率!
通常的膜厚仪的测量光斑,大小为几十到几百um。即只能测得该区域的平均厚度。
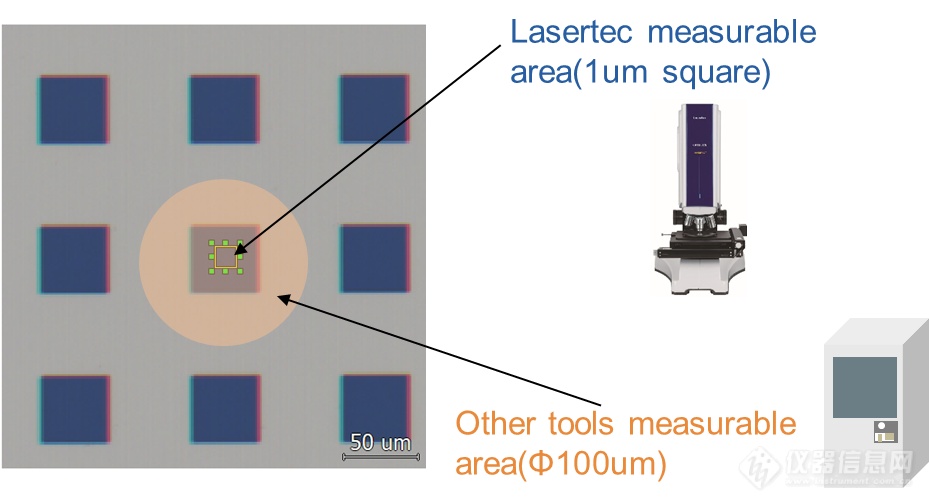
而对于硅晶圆上光刻胶图案的膜厚测量,由于图案非常精细,大光斑的膜厚仪无法正确测出厚度,也无法体现厚度是否均匀。
利用共聚焦显微镜中的膜厚测量功能,不仅得到每条光刻胶“沟”的深度,还可以得到沟的深度分布,即沟的具体形状。(最小XY分辨率可达0.15um。)

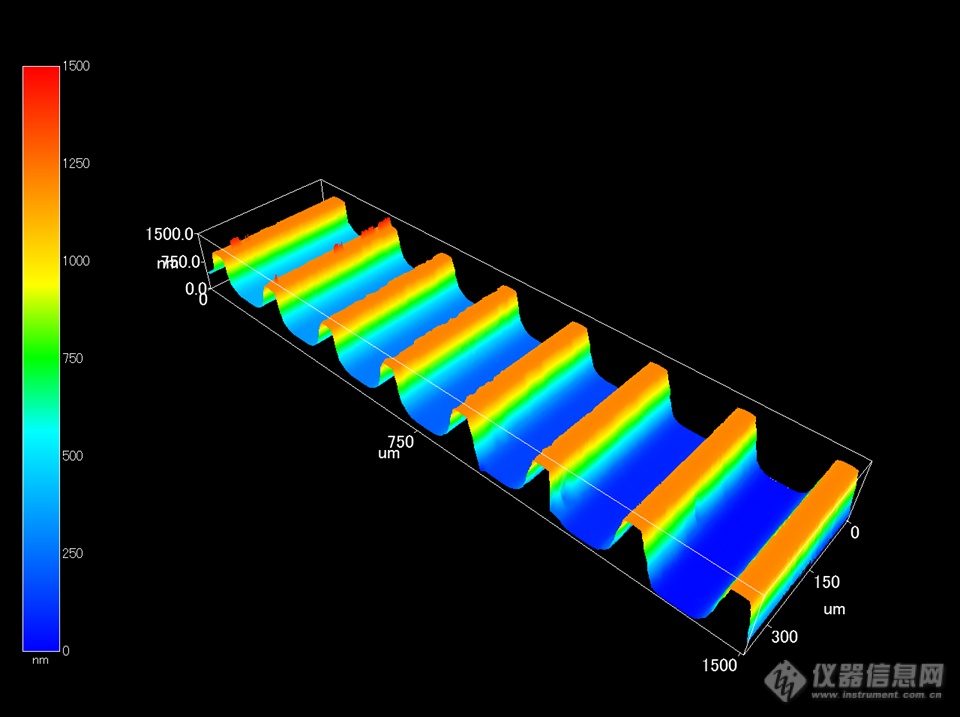
总结
本文介绍了,对于基板上的nm级透明膜,如何准确测量其表面形状。
感谢大家的关注,有任何疑问请留言,期待多多讨论沟通!


共聚焦显微镜 方解石解理面溶解过程观察
共聚焦显微镜+SAW滤波器+晶圆缺陷 IDT形状
共聚焦显微镜+透明基板上金属膜+膜厚
相关产品

关注

拨打电话

留言咨询