超高灵敏度芯片半导体器件失效分析显微镜
新一代超高灵敏度半导体芯片失效分析热成像显微镜日前在美国问世,于2014年3月18日慕尼黑上海电子展上在大中华区发布并在中国大陆,台湾和香港同步上市,由孚光精仪公司负责该区域销售和售后服务。
新一代热发射显微镜采用锁相热成型技术,可探测到1mK (0.001°C) 的器件温度变化,可探测到 100 μW 的功率变化。
据悉,这种热发射显微镜可快速定位半导体器件的温度异常点,从而找到漏电等失效点位置。这种热发射显微镜不需要对器件表面处理,可对裸器件和封装器件失效分析,也可定位SMD器件的低功率位置,比如电容泄露测试。除了失效分析之外,这套热发射显微镜还具有器件的真实温度测量功能,以及结点温度,热阻和芯片黏着 Die Attach分析功能。

详情浏览:http://www.f-opt.cn/rechengxiang/hongwaixianweijing.html
应用领域:
器件漏电分析
栅极和漏极之间的电阻短路分析
封装器件的复合模具短路分析
Latch-up点定位
金属性短路分析
缺陷晶体管和二极管定位分析
氧化层击穿
SMD元件漏电分析
特色和功能
超高灵敏度失效点定位
堆叠芯片的缺陷深度分析
真实温度测量
结点温度测量
封装和裸露器件分析
正面和背面分析
检测芯片粘接问题
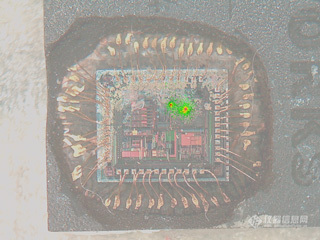
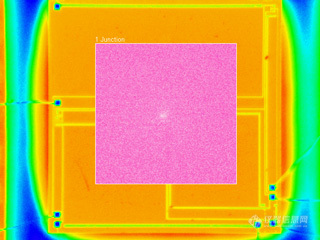
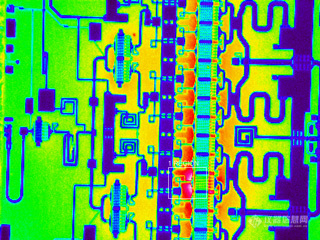
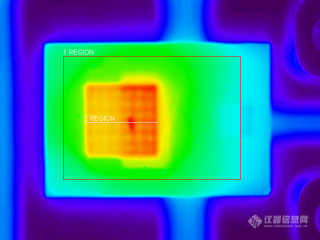
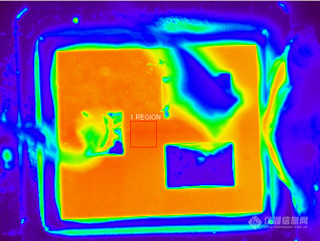
来源于:孚光精仪有限公司
热门评论
最新资讯
厂商动态
新闻专题
更多推荐
写评论…
0














