微电子所在二硫化钼负电容场效应晶体管上取得进展
导读:近日,2020国际电子器件大会(IEDM)以视频会议的形式召开。会上,微电子所刘明院士科研团队展示了二硫化钼负电容场效应晶体管的最新研究成果。
近日,2020国际电子器件大会(IEDM)以视频会议的形式召开。会上,微电子所刘明院士科研团队展示了二硫化钼负电容场效应晶体管的最新研究成果。
功耗是制约未来集成电路发展的瓶颈问题。在栅极中引入铁电新材料的“负电容晶体管”(NCFET)可突破传统场效应晶体管的亚阈值摆幅开关极限,有望在极低电源电压下工作,从而降低功耗并保持高性能。同时,原子层厚度的二硫化钼(MoS2)免疫于短沟道效应,具有较高的迁移率、极低的关态电流和CMOS兼容的制造工艺等优势,是面向先进晶体管的可选沟道材料之一。近期的一些实验显示,MoS2 NCFET能实现低于60mV/dec的亚阈值摆幅。但这些研究仅实现了较长沟道(>500 纳米)的器件,没有完全发掘和利用负电容效应在短沟道晶体管中的优势。
 针对该问题,刘明院士团队通过对器件参数以及制造工艺的设计与优化,首次把MoS2 NCFET的沟道长度微缩至83 纳米,并实现了超低的亚阈值摆幅(SSmin=17.23 mV/dec 和 SSave=39 mV/dec)、较低回滞和较高的开态电流密度。相比基准器件,平均亚阈值摆幅从220 mV/dec提高至39 mV/dec,沟道电流在VGS=0 V和1.5 V下分别提高了346倍和26倍。这项工作推动了MoS2 NCFET尺寸持续微缩,对此类器件面向低功耗应用有一定意义。
针对该问题,刘明院士团队通过对器件参数以及制造工艺的设计与优化,首次把MoS2 NCFET的沟道长度微缩至83 纳米,并实现了超低的亚阈值摆幅(SSmin=17.23 mV/dec 和 SSave=39 mV/dec)、较低回滞和较高的开态电流密度。相比基准器件,平均亚阈值摆幅从220 mV/dec提高至39 mV/dec,沟道电流在VGS=0 V和1.5 V下分别提高了346倍和26倍。这项工作推动了MoS2 NCFET尺寸持续微缩,对此类器件面向低功耗应用有一定意义。
基于上述研究成果的论文“Scaling MoS2 NCFET to 83 nm with Record-low Ratio of SSave/SSRef.=0.177 and Minimum 20 mV Hysteresis”入选2020 IEDM。微电子所杨冠华博士为第一作者。
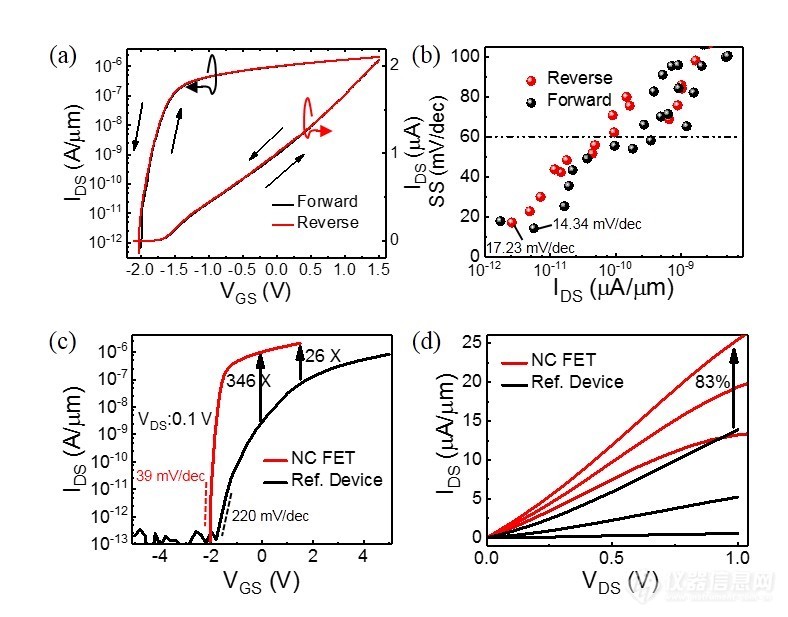
图(a) MoS2 NCFET转移曲线。(b)亚阈值摆幅~沟道电流关系。MoS2 NCFET与MoS2 FET对比数据:(c)转移曲线和(d)输出曲线
来源于:中科院微电子所
热门评论
最新资讯
新闻专题
更多推荐













