提升芯片制造SEM测量水平,NIST联合KLA开发电子束倾斜测量技术
导读:美国国家标准与技术研究院 (NIST) 和半导体及相关行业检测和测量系统提供商 KLA Corporation 的研究人员提高了扫描电子显微镜 (SEM) 测量的准确性。
美国国家标准与技术研究院 (NIST) 和半导体及相关行业检测和测量系统提供商 KLA Corporation 的研究人员提高了扫描电子显微镜 (SEM) 测量的准确性。SEM用于半导体制造中的过程控制应用,有助于确保高产量生产功能性高性能芯片。
SEM使用聚焦电子束对小至1纳米的特征进行成像,使其成为表征半导体器件结构的重要仪器。在芯片制造过程中,高分辨率 SEM 用于许多检测和计量应用,包括检测非常小的缺陷、识别和分类光学检测员发现的缺陷、图案特征的关键尺寸测量、覆盖测量等。这些信息有助于芯片工程师表征和微调其制造工艺。
当电子束通过SEM时,它会受到仔细控制。电子束与理想路径的轻微偏差或电子束撞击芯片表面的角度的微小错位都会使生成的 SEM 图像失真并歪曲器件的结构。NIST和KLA通过考虑电子束的这些角度错位,提高了SEM的精度。该联合研究项目测量光束倾斜的精度小于一毫弧度,即百分之五度,这需要在角分辨率和测量验证方面取得进步。
为了测量光束倾斜,NIST和KLA创建了电子显微镜的原型标准,并以一种新的方式分析了所得的电子显微照片。原型标准由一系列锥形硅柱组成,称为锥形视锥体,形成对光束倾斜高度敏感的图像。倾斜表现为视锥体顶部边缘和底部边缘图像中心之间的偏移。利用他们在模拟电子-物质相互作用方面的专业知识,研究人员使用模拟来展示亚毫弧度精度的潜力,指导他们正在进行的标准工件的设计和制造。
已知位置的锥形视锥体阵列有可能测量 SEM 扫描和成像的区域内光束倾斜的任何变化。这些测量可以进一步校准电子显微镜的放大倍率和畸变。此外,新标准还适用于芯片制造中使用的其他显微镜方法,包括原子力和超分辨率光学显微镜。比较不同显微镜方法结果的能力有助于在不同方法之间可靠且可重复地传输信息,并提高测量模型的准确性。
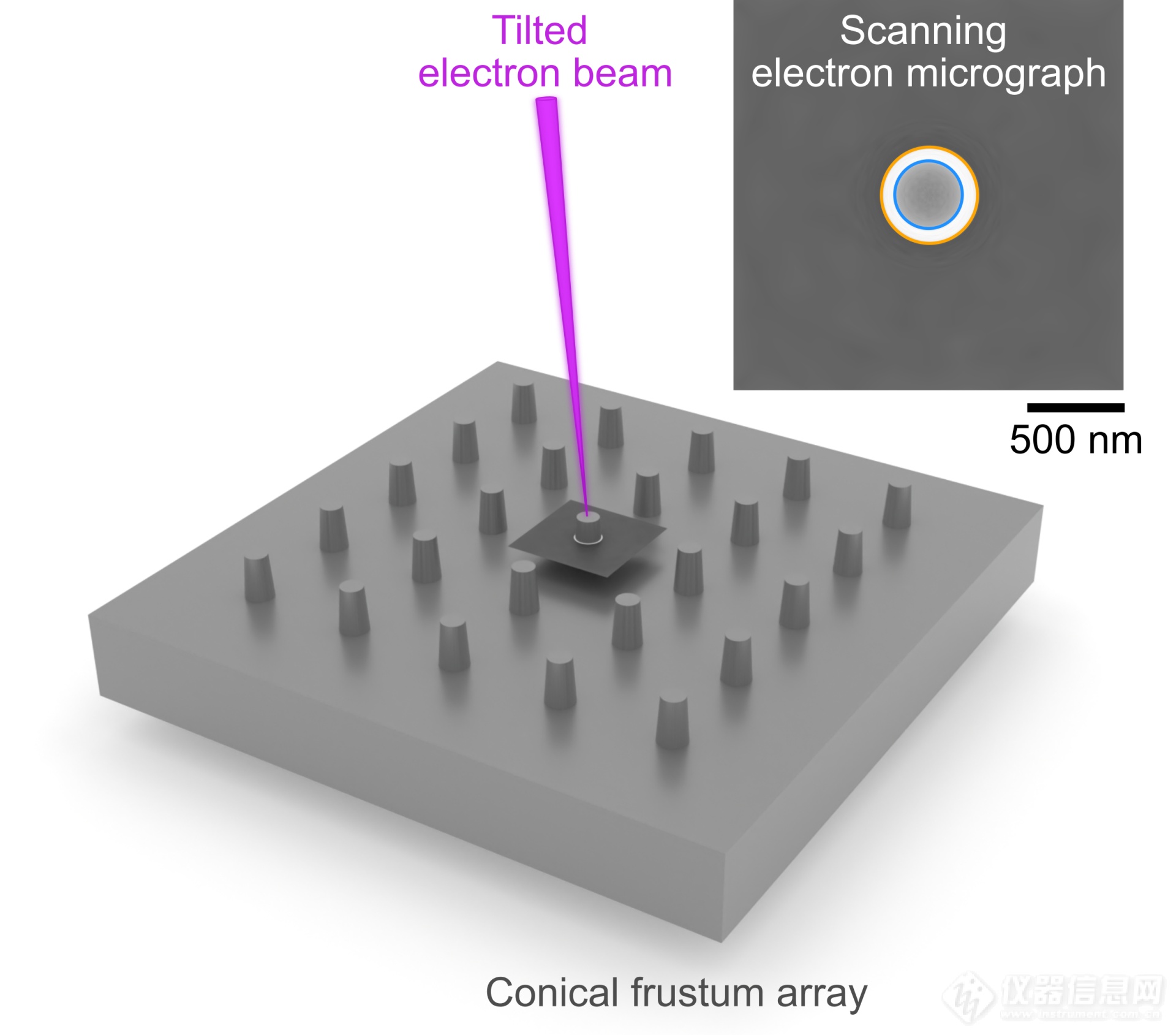
锥形视锥体阵列的模型
“电子束倾斜会改变器件特征的表观位置,降低SEM测量的准确性,”NIST研究员兼涵盖这项研究的行业论文的第一作者Andrew C. Madison说。“我们的新标准和分析方法可以检测电子束位移,因为它在整个成像场中变化。
“有了这些数据,SEM制造商可以实施校准和校正,以提高图像质量和测量精度,”NIST研究员兼首席研究员Samuel M. Stavis说。
“作为半导体检测和计量领域的专家,我们不断探索可以扩展当前测量极限的新技术,”KLA公司高级副总裁兼总经理Yalin Xiong说。“与研究机构的合作在发现有助于推进芯片行业过程控制的创新方面发挥着重要作用。我们与NIST的联合研究旨在提高用于表征芯片制造工艺的基本测量的准确性。
来源于:仪器信息网译
热门评论
最新资讯
新闻专题
更多推荐