芯联集成“键合结构及其制备方法”专利公布
导读:芯联集成电路制造股份有限公司研发的“键合结构及其制备方法”专利,通过创新设计减少键合对准偏差对密封环尺寸的影响,实现更高效、低成本的晶圆级键合工艺。
天眼查显示,芯联集成电路制造股份有限公司“键合结构及其制备方法”专利公布,申请公布日为2024年7月23日,申请公布号为CN118380407A。
背景技术
晶圆级键合是半导体制造技术中重要的一个工艺步骤,共晶晶圆键合技术是使两表面间的键合能(Bonding Energy)达到一定强度和密封性,而使这两晶圆片结为一体。晶圆级键合主要的作用是机械保护和一定的气体氛围或真空度要求下的密封,为了保证机械强度和密封性,一般密封环占用了大量的芯片面积,尤其是考虑到键合的对准偏差,密封环还要增加面积,图1示意出现有技术中常见的一种密封环的结构,该密封环包括第一键合层100、第二键合层200和位于两侧的阻挡件300,考虑到键合的对准偏差,第二键合层200比第一键合层100单侧宽10um,密封环单侧宽度达到120μm,如图2中所示,密封环两侧宽度之和为240μm,而芯片宽度为1mm,由此两侧的密封环占据了芯片约25%的尺寸,密封环会导致单个晶圆上的芯片数目减小,不利于降低成本。
发明内容
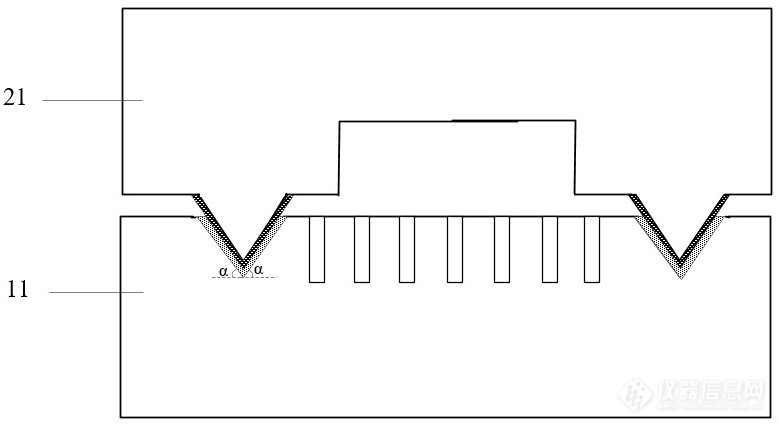
本发明提供一种键合结构及其制备方法,所述键合结构包括:第一晶圆和第二晶圆;所述第一晶圆具有环形凹槽,所述第二晶圆具有环形凸起部,所述环形凹槽具有V型纵截面,所述环形凸起部具有三角状纵截面,所述三角状纵截面的顶角角度与所述V型纵截面的夹角相等;所述环形凹槽的表面覆盖有第一键合层,所述环形凸起部的表面覆盖有第二键合层,所述环形凸起部部分嵌入所述环形凹槽内,使得所述第一键合层和所述第二键合层彼此相键合。本发明所形成的键合结构,键合层不必为了减小对准偏差而增加尺寸,从而密封环可采用更小尺寸的设计。
来源于:仪器信息网
热门评论
最新资讯
新闻专题
更多推荐