推荐厂家
暂无
暂无
 金牌15年
金牌15年
 400-860-5168转1777
400-860-5168转1777
 留言咨询
留言咨询
 铜牌14年
铜牌14年
 400-860-5168转2244
400-860-5168转2244
 留言咨询
留言咨询
 400-860-5168转5050
400-860-5168转5050
 留言咨询
留言咨询

 400-860-5168转4058
400-860-5168转4058
 留言咨询
留言咨询
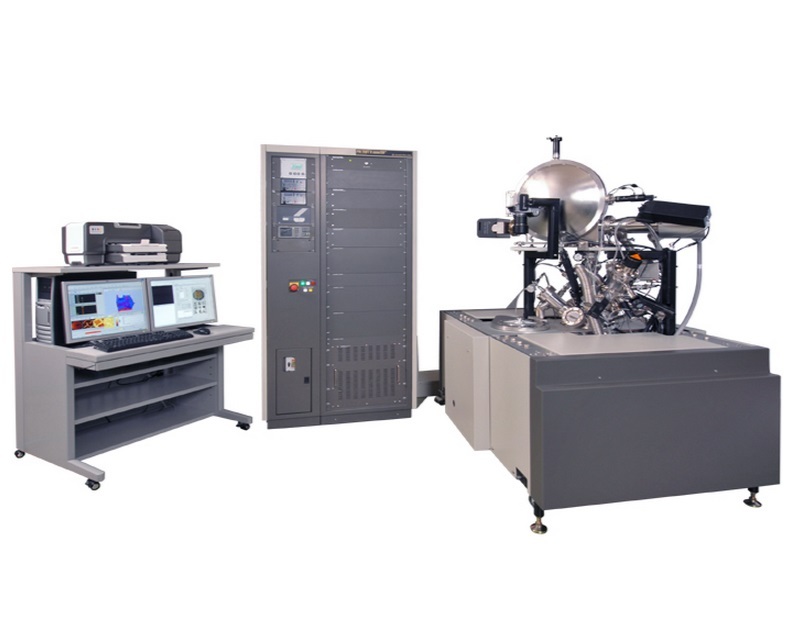
 400-860-5168转3774
400-860-5168转3774
 留言咨询
留言咨询

 400-860-5168转3314
400-860-5168转3314
 留言咨询
留言咨询






飞行时间-二次离子质谱仪,TOF-SIMS, 是一种既能测试有机物,又能测试无机物的一种检测仪器,其质谱的基本原理:使用一次的离子源(Ga,Cs, O2, etc)轰击样品,产生二次离子,激发的二次离子被引入一个无场区(drift tube),自由飞行,飞行时间的长短,与离子的mass-to-charge ratio的二分之一此方成正比;也就是说,质量数越小的离子飞得越快,到达检测器的时间越短,反之,质量数越大的离子飞得越慢,到达检测器的时间越长,这样就可以实现质谱的分离。(未完待续)
半导体生产:在晶圆的制备过程中,由于生产流程长,工序繁多,不可避免的会遇到污染,那么该如何分析检测这些濡染物呢?如何评价清洗工序的清洗的效果呢?可以考虑采用飞行时间-二次离子质谱仪来检测。样品制备:飞行时间-二次离子质谱仪作为一种表面分析工具,对样品制备要求非常严格。样品分析的表面绝对不能接触任何包装物,尤其是防静电袋,双面胶等等,这些都会对样品进行污染,常见的污染特征峰,防静电剂:阴离子:311,325,339等,对于双面胶其常见的污染物峰为(硅氧烷):阳离子:28,43,73,143,281 等等,另外,样品也不能在空气或者办公室内放置过长时间,要不同样会测到大量污染物,而测不到污染物下面的成分,因为,其分析深度只有3~6nm。例如,在晶圆的表面上永远都可以测到大量的CH峰,其本质原因就是生产工艺或者空气中的CH化合物吸附在其表面。众所周知,其分析的检测限为ppm~ppb,相当高。所以,样品制备要极其严格。数据处理:一般上分析过程中要考虑,组合峰的出现,比如我们在分析单晶硅得时候,样品表面会不可避免地出现(正离子)14,27,28,45,等等一系列的峰,首先要学会辨认他们。比如28,它可能是Si28,也可能是c2h428,如何区分他们,这就需要经验。欢迎大家分享自己的经验,如需详细讨论,可加入二次离子质谱QQ群:100364310
tof-sims (time-of-flight Secondary ion mass spectrometer)是飞行时间-二次离子质谱仪,它可以进行全元素分析,包括H,同时还可以分析元素的全部同位素。对有机物,无机物都能进行分析,而且对样品导电性能无任何要求,仪器的灵敏度高,可以检测出ppb~ppt量级的杂质。其基本的原理,采用脉冲粒子束轰击样品表面使其产生二次离子(正离子,负离子),产生的二次离子经过一个漂移管到达检测器。根据不同离子的荷质比不同,所以在漂移管中的飞行时间也不相同,质量数小的离子先到达检测器,质量大的后到达检测器,这样就实现了质谱的分离。1 基本原理:入射粒子束的能量为E0,根据能量守恒原理E0=1/2 mv^2t=L/V所以,离子在漂移管中的飞行时间与其质量的1/2成正比,所以,质量越大,飞行时间越长。2 分析模式两种工作模式:正离子谱模式和负离子谱模式我们知道不同元素的电负性不同,所以得失电子的能力也不同,有的元素易于形成负离子(如第七主族的卤素元素),有的易于形成正离子(如第一主族的碱金属元素)。所以,分析的过程可根据实际需要选择正离子或者是负离子的工作模式。3 样品要求:一般可以分析固体样品,液体样品也可,但是液体要求黏度要大,真空中不挥发。由于仪器的灵敏度高,所以样品制备过程要防止其受到污染。欢迎大家讨论。


