推荐厂家
暂无
暂无
[color=#231815]《剃须刀片刃口镀复氮化铬硬质薄膜》[/color][color=#7c7c7c]孙洪斌,[/color][color=#7c7c7c]上海市机械制造工艺研究所[/color][color=#231815][/color]
HGT 4103-2009 化学试剂 有机氮化合物测定通用
概述 芳香族伯胺和亚硝酸作用生成重氮盐的反应标为重氮化,芳伯胺常称重氮组分,亚硝酸为重氮化剂,因为亚硝酸不稳定,通常使用亚硝酸钠和盐酸或硫酸使反应时生成的亚硝酸立即与芳伯胺反应,避免亚硝酸的分解,重氮化反应后生成重氮盐。 重氮化反应可用反应式表示为: Ar-NH2 + 2HX + NaNO2--—Ar-N2X + NaX + 2H20重氮化反应进行时要考虑下列三个因素:一、酸的用量 从反应式可知酸的理论用量为2mol,在反应中无机酸的作用是,首先使芳胺溶解,其次与亚硝酸销生成亚硝酸,最后生成重氮盐。重氮盐一般是容易分解的,只有在过量的酸液中才比较稳定,所以重氮化时实际上用酸量过量很多,常达3mol,反应完毕时介质应呈强酸性(pH值为3),对刚果红试纸呈蓝色.重氮过程中经常检查介质的pH值是十分必要的。 反应时若酸用量不足,生成的重氮盐容易和未反应的芳胺偶合,生成重氮氨基化合物: Ar-N2Cl + ArNH2——Ar-N=N—NHAr + HCl 这是一种自我偶合反应,是不可逆的, 一旦重氮氨基物生成,即使补加酸液也无法使重氮氨基物转变为重氮盐,因此使重氮盐的质量变坏,产率降低。在酸量不足的情况下,重氮盐容易分解,温度越高,分解越快。二、亚硝酸的用量 重氮化反应进行时自始至终必须保持亚硝酸稍过量,否则也会引起自我偶合反应。重氮化反应速度是由加入亚硝酸钠溶液加速度来控制的,必须保持一定的加料速度,过慢则来不及作用的芳胺会和重氮盐作用生成自我偶合反应。亚硝酸钠溶液常配成30%的浓度使用.因为在这种浓度下即使在-15℃也不会结冰。 反应时检定亚硝酸过量的方法是用碘化钾淀粉试纸试验,一滴过量亚硝酸液的存在可使碘化钾淀粉试纸变蓝色。由于空气在酸性条件下也可位碘化钾淀粉试纸氧化变色,所以试验的时间以0.5-2s内显色为准。 亚硝酸过量对下一步偶合反应不利,所以过量的亚硝酸常加入尿素或氨基磺酸以消耗过量亚硝酸。 亚硝酸过量时,也可以加入少量原料芳伯胺,使和过量的亚础酸作用而除去。三、反应温度 重氯化反应一般在0-5℃进行,这是因为大部分重氮盐在低温下较稳定,在较高温度下重氮盐分解速度加快的结果。另外亚硝酸在较高温度下也容易分解。重氮化反应温度常取决于重氮盐的稳定性,对-氨基苯磺酸重氮盐稳定性高,重氮化温度可在10-15℃进行;1-氨基萘-4-磺酸重氮盐稳定性更高,重氮化温度可在35℃进行。重氮化反应一般在较低温度下进行这一原则不是绝对的,在间歇反应锅中重氮反应时间长,保持较低的反应温度是正确的,但在管道中进行重氮化时,反应中生成的重氮盐会很快转化,因此重氮化反应可在较高温度下进行。




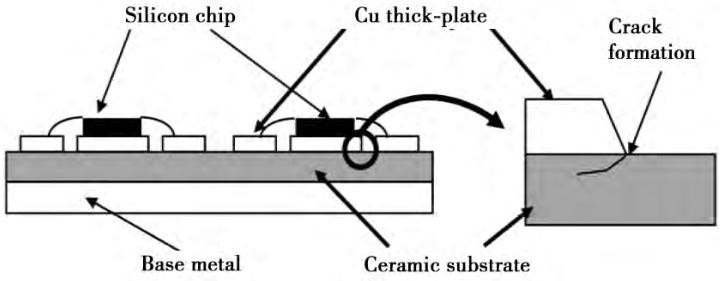
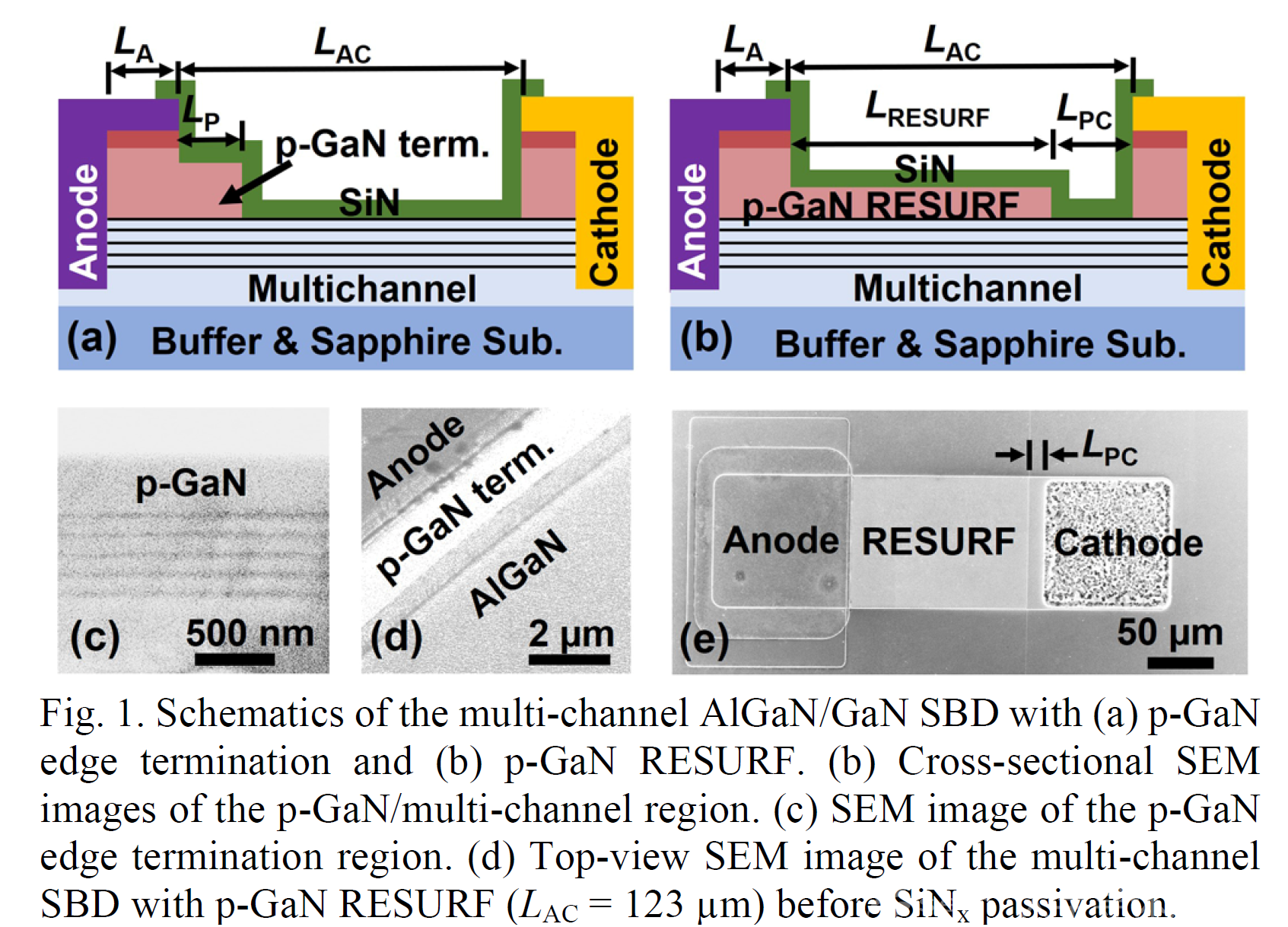

 400-629-8889
400-629-8889
 留言咨询
留言咨询

 400-860-5168转1679
400-860-5168转1679
 留言咨询
留言咨询
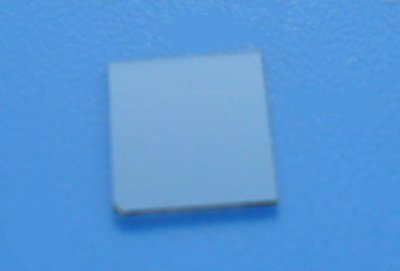
 400-860-5168转2205
400-860-5168转2205
 留言咨询
留言咨询