1-11月进口额已达318亿元:化学气相沉积设备进口数据盘点
化学气相沉积(Chemical Vapor Deposition 简称CVD) 是利用气态或蒸汽态的物质在气相或气固界面上发生反应生成固态沉积物的过程。化学气相沉积过程分为三个重要阶段:反应气体向基体表面扩散、反应气体吸附于基体表面、在基体表面上发生化学反应形成固态沉积物及产生的气相副产物脱离基体表面。最常见的化学气相沉积反应有:热分解反应、化学合成反应和化学传输反应等。通常沉积TiC或TiN,是向850~1100℃的反应室通入TiCl4,H2,CH4等气体,经化学反应,在基体表面形成覆层。如今,化学气相沉积被大量应用于半导体领域中。2021年是“十四五”开局之年,中国政府也推出了一系列激励政策来鼓励半导体产业发展,明确了半导体产业在产业升级中的重要地位,同时全球自2020年爆发的“芯片荒”在全球范围内愈演愈烈,却迟迟得不到缓解,各行各业都受到了一定的影响,受此影响包括仪器产业、新能源产业等在内的诸多产业都面临产品涨价、缺货的危机。危中有机,全球半导体行业的巨震却是中国半导体产业的发展契机。通过分析海关化学气相沉积设备的进口情况,可以从一个侧面反映出中国化学气相沉积设备市场的一些情况,进而了解到中国半导体产业的一些情况。海关统计中,根据化学气相沉积设备的应用领域将其分为制造半导体器件或IC的化学气相沉积装置 (84862021)和制造平板显示器用的化学气相沉积设备(CVD)(84863021)。 为了解2021年化学气相沉积设备的进出口情况,仪器信息网特别对2021年1-11月,化学气相沉积设备(商品编码84862021、84863021)进口数据进行了分析汇总,为大家了解中国目前化学气相沉积设备市场做一个参考。2021年1-11月化学气相沉积设备进口额变化(人民币/万元)2021年1-11月化学气相沉积设备进口数据商品名称进口额/元数量/台均价制造半导体器件或IC的化学气相沉积装置25,588,916,599181914067574制造平板显示器用的化学气相沉积设备(CVD)6,182,288,9799664398844总计31,771,205,57819152021年1-11月,中国进口化学气相沉积设备总额约318亿元,总台数达1915台,其中绝大部分用于制造半导体器件和集成电路,此类设备多达1819台,总额达256亿元,占比高达81%。可以看出,目前影响CVD设备进口的主要取决于半导体器件与集成电路制造。从此前统计的【进口数量同比增长68%:2021上半年CVD设备海关进口数据盘点】可以看出,2020年1-12月,我国共进口化学气相沉积设备1150台,进口额约为186亿元,而今年仅前十一个月就已远超去年全年的进口额。这表明,今年我国晶圆代工厂的建设热度不减,这也和如今的半导体投资热、芯片荒有关。2021年1-11月进口化学气相沉积设备贸易伙伴变化(人民币/万元)从进口CVD设备的贸易伙伴分布可以看出,主要进口的贸易伙伴为新加坡、中国台湾和韩国。新加坡处在马六甲海峡,扼太平洋及印度洋之间的航运要道,是全球海运的几大必经路线之一,战略地位十分重要——早在新加坡建国之前,“新加坡港”已发展成为国际著名的转口港。世界各国的将需要出口的货物运输到新加坡港,存放几天或几十天(其中20%的堆存时间仅为1天),然后再转运到进口国。由于新加坡的自由贸易港,通过新加坡的“转口贸易”可变成躲避贸易制裁的有效方式之一。从新加坡进口CVD可能是为了规避以美国为首的西方集团对我国日益收紧的高端装备进口限制。而从台湾进口的CVD主要用于制造平板显示器,从图中可以看出,中国台湾在平板显示器用CVD进口占比高达95%,而在集成电路或半导体器件制造中,仅占2%。用于半导体器件和集成电路制造的CVD中,主要来源为新加坡、韩国、美国和日本。 2021年1-11月化学气相沉积设备各注册地进口数据变化(单位/万元)那么这些化学气相沉积设备主要销往何处?通过对进口数据的注册地进行分析发现,陕西省、上海市、湖北省、江苏省和安徽省进口额最多,分列前五名。这些地区的化学气相沉积主要用于集成电路或半导体器件生产中,这表明这些地区在新建或改造集成电路生产线上投入较大,对半导体设备的需求也在激增。实际上,我国在1-11月从韩国进口的化学气相沉积设备主要的注册地就是陕西省,这可能和三星等韩国企业在西安的半导体生产线有关。而在平板显示器用CVD的注册地分布中可以看出,重庆市独占鳌头,这可能和京东方在重庆的生产线有关,京东方是我国面板产业的龙头企业,其对进口额影响较大。而福建省进口平板显示器用CVD仅次于重庆,这可能与位于厦门的天马微电子有关。重点商品化学气相沉积有哪些重点商品呢?对此,笔者查阅了海关总署,发现重点商品主要有4款,都属于84862021编号。商品1:K465i金属有机物化学气相淀积设备该商品由手套箱系统、反应腔、气体系统、电源及控制系统、真空系统、冷却水和气动系统、安全控制系统等组成。功能是在衬底表面生长一层或多层半导体薄膜。工作原理是通过控制通入反应腔气体的种类、流量和反应腔内的温度、压力,从而在衬底表面生长出不同工艺要求的半导体薄膜。进口后用于LED制造的外延片加工工序。该产品是由Veeco推出的TurboDisc.K465i,是一款用于生产高亮度LED(HB LED)的氮化镓(GaN) 金属有机化学气相沉淀(MOCVD)设备,2016年经过LED产业内的Veeco 用户试用后, K465i很快获得量产认可。商品2:|Oerlikon Solar|KAI MT 化学气相沉积装置该化学气相沉积装置主要用于太阳能电池组件导电层的镀膜。工作原理:该装置内部的传输机械手将玻璃基板传送到薄膜沉积模块中,在一定的温度、压强下,等离子体发生器在反应室内产生射频电压,将工艺气体电离成原子、分子、原子团形式的带电荷粒子混合状态,经过离子碰撞后使之发生化学反应,沉积成一层非晶硅或者微晶硅薄膜在玻璃基板表面。商品3:|CENTROTHERM|E2000-HT 410-4等离子化学气相沉积装置该产品是太阳能电池生产线用|在半导体表层沉积氮化硅膜。商品4:铂阳|无型号|PECVD化学气相沉积设备PECVD化学气相沉积设备:离解化学气体,在玻璃基板上产生化学反应,生长薄膜/ 250MW硅基薄膜太阳能自动化生产线。



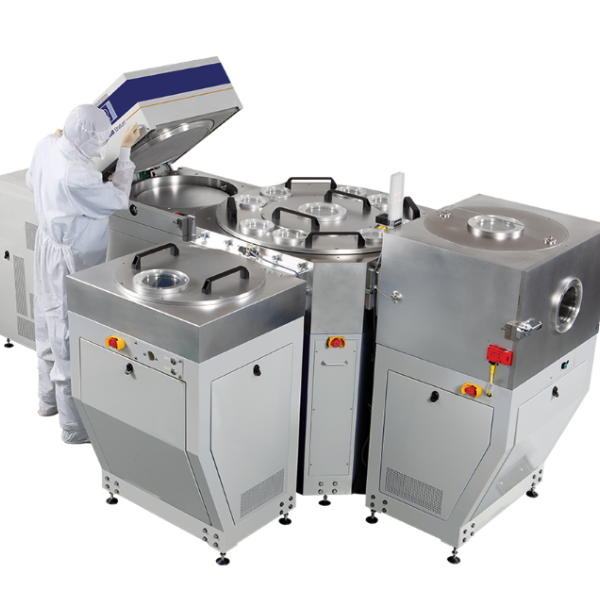
 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询

 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询
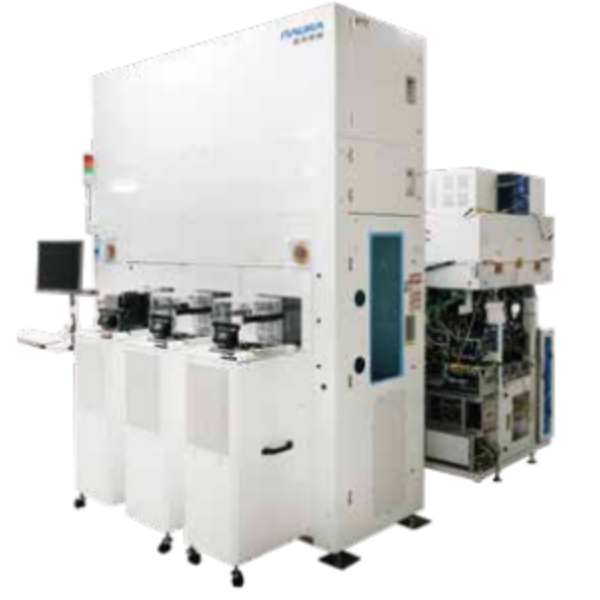
 400-860-5168转5919
400-860-5168转5919
 留言咨询
留言咨询





