推荐厂家
暂无
暂无
 银牌9年
银牌9年
 400-860-5168转2464
400-860-5168转2464
 留言咨询
留言咨询
 金牌1年
金牌1年
 400-860-5168转6165
400-860-5168转6165
 留言咨询
留言咨询
 留言咨询
留言咨询

 400-860-5168转1516
400-860-5168转1516
 留言咨询
留言咨询

 400-860-5168转4019
400-860-5168转4019
 留言咨询
留言咨询

 400-860-5168转1021
400-860-5168转1021
 留言咨询
留言咨询






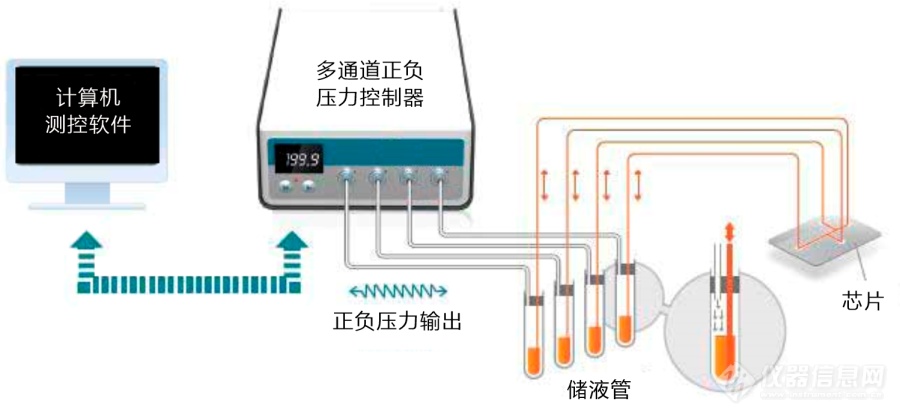
[color=#000099]摘要:在微流控芯片进样、化学反应进样和长时间药物注射领域,都需要能提供正负气压可精密控制的压力控制器。本文特别针对微流控芯片进样对多通道压力控制器的技术要求,提出了相应的解决方案,并详细介绍了方案中多通道气路结构、控制方法、气体流量调节阀、压力传感器和PID控制器等内容和技术指标。通过此解决方案,完全能够满足各种微流体控制对多通道压力控制器的要求。[/color][align=center]~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~[/align] [size=18px][color=#000099]一、背景介绍[/color][/size]在微流控芯片进样、化学反应进样和长时间药物注射领域,都需要能提供正负气压可精密控制的多通道压力控制器,并且通过气体压力来控制流体的流量或流速。图1所示为这种压力控制器在微流控芯片进样中的典型应用。[align=center][img=微流控芯片用压力控制器,690,318]https://ng1.17img.cn/bbsfiles/images/2022/06/202206271559098143_8354_3384_3.png!w690x318.jpg[/img][/align][align=center]图1 多通道压力控制器在微流控芯片进样中的典型应用[/align]在微流控芯片进样中,要求压力控制器需具备以下几方面的功能:(1)多通道,每个通道可独立控制和操作。(2)每个通道都可按照编程设定输出相应的正负压力。(3)正负压力控制范围:绝对压力1Pa~0.5MPa(表压-101kPa~0.6MPa)。(4)压力控制精度:0.1%~1%。 针对上述微流控芯片进样对压力控制器要求,本文提出了相应的解决方案,并详细介绍了方案中多通道气路结构、控制方法、气体流量调节阀、压力传感器和PID控制器等内容和技术指标。通过此解决方案,完全能够满足各种微流体控制对多通道压力控制器的要求。[size=18px][color=#000099]二、解决方案[/color][/size]本文所提出的解决方案是实现在1Pa~0.7MPa绝对压力范围内的精密控制,控制精度极限可达到0.1%。即提供一个可控气压源解决方案,采用双向控制模式的动态平衡法,结合高精度步进电机和微小流量电动针阀、高精度压力传感器和多通道PID控制器,气压源可进行高精度的各种真空压力的可编程输出,同时也可用于控制不同的流体流量。本文所涉及的解决方案,主要针对用于微流控芯片进样用多通道正负压力控制器,这主要是因为微流控芯片所用压力基本在一个标准大气压附近变化,相应的多通道压力控制器相对比较简单。而对于更低压力,如气压小于1kPa绝对压力的多通道控制,要实现精密控制则整个压力控制器将十分复杂。微流控芯片进样用多通道压力控制器工作原理如图2所示。[align=center][img=微流控芯片用压力控制器,690,350]https://ng1.17img.cn/bbsfiles/images/2022/06/202206271559436818_6219_3384_3.png!w690x350.jpg[/img][/align][align=center]图2 微流控芯片进样用多通道压力控制器工作原理图[/align]微流控芯片进样用多通道压力控制器的工作原理为:(1)多通道压力控制包括多个控制通道,每个控制通道包括正压气源、进气调节阀、出气调节阀、抽气泵和PID控制器单元。其中的正压气源和抽气泵提供足够的负压和正压能力,并且可以多通道公用。同样,多通道压力控制器也公用一个进气调节阀。需要注意的是,由于微流控进样所需的负压气压值较大并接近一个标准大气压,对于微流控芯片进样的压力控制,只需固定进气调节阀的开度,近靠调节出气阀开度极可实现正负压的精密控制,因此可以公用一个进气调节阀。如果要进行较低负压气压值(较高真空度)的精密控制,配置恰恰相反,每一通道配置的进气阀进行调节,但可以公用一个抽气阀。(2)精密压力控制原理基于密闭空腔进气和出气的动态平衡法。多通道压力控制器的每一个通道都是典型闭环控制回路,其中PID控制器的每一通道采集相应通道的真空压力传感器信号并与此通道的设定值进行比较,然后调节相应通道的进气和抽气调节阀开度,最终使此通道传感器测量值与设定值相等而实现该通道真空压力的准确控制。(3)为了覆盖负压到正压的所要求的真空压力范围,需要配置一个测试量程覆盖要求范围内的高精度绝对压力传感器,如果一个压力传感器无法覆盖全量程,则需要增加压力传感器数量来分段覆盖。采用绝对压力传感器的优势是不受各地大气气压变化的影响,无需采取气压修正,更能保证测试的准确性和重复性。(4)绝对压力传感器对应所覆盖的真空压力范围输出数值从小到大变化的直流模拟信号(如0~10VDC)。此模拟信号输入给PID控制器,由PID控制器调节进气阀和排气阀的开度而实现压力精确控制。(5)当控制是从负压到正压进行变化时,一开始的进气调节阀开度(进气流量)要远小于抽气调节阀开度(抽气流量),通过自动调节进出气流量达到不同的平衡状态来实现不同的负压控制,最终进气调节阀开度逐渐要远大于抽气调节阀开度,由此实现负压到正压范围内一系列设定点或斜线的连续精密控制。对于从正压到负压压的变化控制,上述过程正好相反。[size=18px][color=#000099]三、方案具体内容[/color][/size]解决方案中所涉及的正负压力控制器的具体结构如图3所示,主要包括正压气源、电动针阀、密闭空腔、压力传感器、高精度PID控制器和抽气泵。[align=center][img=微流控芯片用压力控制器,690,393]https://ng1.17img.cn/bbsfiles/images/2022/06/202206271602023624_9954_3384_3.png!w690x393.jpg[/img][/align][align=center]图3 微流控芯片进样用多通道正负压力控制器结构示意图[/align]在图3所示的正负压力控制器中,每个通道都对应一密闭空腔,每个密闭空腔上的外接接口作为此通道的压力输出口。密闭空腔左右安装两个NCNV系列的步进电机驱动的微型电动针阀,电动针阀本身就是正负压两用调节阀,其绝对真空压力范围为0.0001mbar~7bar,最大流量为40mL/min,步进电机单步长为12.7微米,完全能满足小空腔的正负压精密控制。由此,压力控制器中的每个通道可实现正负压任意设定点的精确控制,也可以从正压到负压的压力线性变化控制,也可以从负压到正压的压力线性变化控制。微流控芯片进样过程中一般要求微小正负压控制,要求是在标准大气压附近的真空压力精确控制,如控制精度为±0.5%甚至更小,一般都需要采用调节抽气阀的双向动态模式,即通过控制器使得进气口处电动针阀的开度基本不变,同时根据PID算法来调节排气口处的电动针阀开度。由于进气阀的开度基本处于固定状态,使得微流控芯片进样所用的多通道压力控制器可以公用一个调节进气流量的电动针阀。另外,所有通道都需要具备抽气功能,抽速也是一固定值,因此多通道压力控制器也可以公用一个抽气泵。在微流控芯片进样过程中压力控制,除了上述恒定进气流量调节抽气流量的控制方法之外,决定压力控制精度的因素还有压力传感器、PID控制器和电动针阀的精度。本方案中的PID控制器采用的是24位AD和16位的DA,电动针阀则是高精度步进电机,因此本解决方案的测试精度主要取决于压力传感器精度,一般至少要选择0.1%精度的压力传感器。在微流控芯片进样过程中,往往会要求密闭容器在正负压范围内进行多次往复变化和按照设定曲线进行控制,因此本方案采用了可存储多个编辑程序的PID控制器,每个设定程度是一条多个折线段构成的曲线,由此可实现正负压往复变化的自动程序控制。在本文所述的解决方案中,为实现正负压的精密控制,如图3所示,针对负压的形成配置了抽气泵。抽气泵相当于一个负压源,但采用真空发生器同样可以达到负压源的效果,负压源采用真空发生器的优点是整个系统只需配备一个正压气源,减少了整个系统的造价、体积和重量,真空发生器连接正压气源即可达到相同的抽气效果。[size=18px][color=#000099]四、总结[/color][/size]本文所述解决方案,完全可以实现微流控芯片进样系统中压力的任意设定点和连续程序形式的精密控制,并且可以达到很高的控制精度和速度,全程自动化。本方案除了自动精密控制之外,另外一个特点是系统简单,正负压控制范围也可以比较宽泛,整个系统小巧和集成化,便于形成小型化的检测仪器。本文解决方案的技术成熟度很高,方案中所涉及的电动针阀和PID控制器,都是目前特有的标准产品,其他的压力传感器、抽气泵、真空发生器和正压气源等也是目前市场上常见的标准产品。[align=center]~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~[/align]

[size=14px][color=#ff0000]摘要:本文将针对CVD和MPCVD工艺设备中存在的问题,介绍一种国产的两通道24位高精度多变量PID控制器,此一台控制器可对温度和真空度同时进行控制,大大缩小了仪表占用空间和造价。两通道可一次共接入4个传感器,每个通道可以连接备用的温度和真空度传感器,由此可保障长时间钻石生长的安全性又可满足宽量程测控的需要,同时还可用来进行差值和平均值监测。[/color][/size][align=center][size=14px][color=#ff0000][img=CVD工艺生长宝石,450,295]https://ng1.17img.cn/bbsfiles/images/2021/07/202107291558344977_8369_3384_3.png!w690x453.jpg[/img][/color][/size][/align][align=center]~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~~[/align][size=18px][color=#ff0000]1. 问题的提出[/color][/size][size=14px] 目前,高等级钻石生长的首选工艺是采用化学[url=https://insevent.instrument.com.cn/t/Mp]气相[/url]沉积(CVD)和微波等离子体CVD(MPCVD)技术,另外CVD和MPCVD工艺还可用于在钻石以外的基材上进行钻石沉积,这为许多行业带来了技术上的进步,如光学、计算机科学和工具生产。在CVD工艺中,通过采用气体原料(氢气、甲烷)在低于1个大气压和800~1200℃的温度下,采用外延生长的方式获得完全透明无色大尺寸金刚石单晶,其成分、硬度和密度等与天然钻石基本一致,而价格远远低于天然钻石。[/size][size=14px] 在采用CVD和MPCVD工艺进行钻石生长过程中,需要严格调节和控制CVD工艺的温度、真空压力和气体成分,这三个变量中的任何一个变化或波动都会影响钻石的生长速度、纯度和颜色。这三个变量在实际工艺中分别代表了温度、真空压力和工作气体的质量流量,即在CVD工艺中一般是在进气口处采用气体质量流量计控制氢气和甲烷以达到设定的混合气体成分,通过温度传感器和加热装置来调节和控制工作腔室内的温度,最后在出气口处通过真空计和电动阀门来调节和控制工作腔室内的真空压力。[/size][size=14px] 目前这三个变量的同时控制,在国内的CVD工艺设备上还存在以下几方面问题:[/size][size=14px] (1)在气体质量流量和温度这两个变量的测控方面,国内仪表已经非常成熟和可靠,但在真空压力的测控方面,普遍还在使用测量精度较差的皮拉尼真空计及相应的控制器,这会严重影响腔室内工作气压的测控精度,而对钻石质量带来影响。[/size][size=14px] (2)在CVD工艺设备中,上述三个变量都需要独立的传感器和控制器进行独立操作和控制,由此造成一方面的所占空间比较大,另一方面是设计操作复杂且成本无法进一步降低。[/size][size=14px] (3)部分CVD工艺设备在真空度测控中采用了成熟的国外产品,但价格昂贵且功能单一,只能进行真空度的测控,同时还需要准确的控制算法来适应温度突变情况下的真空度稳定控制,而且还需配套国产的气体质量流量计和温度控制仪表。[/size][size=14px] 总之,国内的钻石生长市场在近几年发展快速,据统计,2018年,国内自主生产供应的宝石级培育钻石约37.5亿元,相比2016年的0.4亿元,呈现了几何级的增长。然而国内掌握CVD技术,特别是MPCVD技术的厂家并不多,目前依旧是欧美厂家占主导,国内很多大厂家都已经涉足该领域,但量产一直是难点,而量产这一难点的根源在于CVD和MPCVD在真空环境下的控制很难。[/size][size=14px] 本文将针对CVD和MPCVD工艺设备中存在的问题,介绍一种国产的2通道24位高精度多变量PID控制器,此一台控制器可对温度和真空度同时进行控制,大大缩小了所占空间和造价。2通道可一次共接入4个传感器,每个通道可以连接备份用的温度和真空度传感器,由此可保障长时间钻石生长的安全性又可满足宽量程测控的需要,同时还可用来进行差值和平均值监测。[/size][size=18px][color=#ff0000]2. 真空压力上游和下游控制模式的选择[/color][/size][size=14px] 在如图2-1所示的工作腔体内部真空压力控制过程中,一般有上游和下游两种控制模式。上游控制是一中保持下游真空泵抽速恒定而调节上游进气流量的方式,下游控制是一种保持上游进气流量恒定而调节下游真空泵抽速的方式。[/size][align=center][img=典型CVD工艺设备框图,690,366]https://ng1.17img.cn/bbsfiles/images/2021/07/202107291600257733_6411_3384_3.png!w690x366.jpg[/img][/align][size=14px][/size][align=center][color=#ff0000]图2-1 CVD工艺设备典型结构示意图[/color][/align][size=14px] 针对CVD和MPCVD工艺设备中的真空压力控制,国内外普遍都采用下游控制模式,也有个别国外公司推荐使用上游控制模式,这里将详细分析上下游两种控制模式的特点和选择依据:[/size][size=16px][color=#ff0000]2.1. 下游控制模式[/color][/size][size=14px] (1)在采用CVD和MPCVD工艺进行宝石生长过程中,对气体成分有严格的规定并需要精确控制。因此在CVD和MPCVD工艺设备中,通常会在工作腔体进气端采用气体质量流量控制器对充入腔体内的每种工作气体流量进行准确控制,也就是说对进气端调节控制的是气体流量,而且至少是两种工作气体。[/size][size=14px] (2)在进气端实现对工作气体成分准确控制后,还需要对工作腔体内的真空压力进行控制。下游控制可通过调节真空泵的抽速快速实现真空压力的准确控制,而且在控制过程中并不会影响工作腔室内的气体成分比例。[/size][size=14px] (3)在CVD和MPCVD工艺过程中,温度变化会对腔体内的真空压力会给真空压力带来很大影响,由此要求真空压力控制具有较快的响应速度,使腔体内的真空压力随温度变化始终恒定控制在设定值上,因此采用下游控制模式会快速消除温度变化对真空压力恒定控制的影响。[/size][size=14px] (4)在CVD和MPCVD工艺过程中,工作腔体内的真空压力一般在几千帕左右这样低真空的范围内进行定点控制。对于这种低真空(接近一个大气压)范围内的真空压力控制,较快速有效和经济环保的控制方式是下游控制,在进气流量恒定的前提下,只需较小的抽速就能快速实现真空压力的准确控制,排出的工作气体较少。[/size][size=16px][color=#ff0000]2.2. 上游控制模式[/color][/size][size=14px] (1)上游控制模式普遍适用于高真空(真空压力小于100Pa)控制,即真空泵需要全速抽气,通过调节上游进气的微小变化,即可实现高真空准确控制。[/size][size=14px] (2)采用上游控制模式对低真空进行控制,在真空泵全速抽气条件下,就需要增大上游进气量,增大进气量一方面会造成恒定控制精度差和响应速度慢之外,另一方面会带来大量的废气排出。因此,在这种低真空的上游控制模式中,一般还需在下游端增加手动节流阀来减小真空泵的抽速。[/size][size=14px] (3)在真空压力控制中,一般在流量和压力之间选择其中一个参量进行独立控制,也就是说控制了流量则不能保证压力恒定,而控制了压力则不能保证流量恒定,因此在一般真空压力控制中,上游控制模式在一定范围内比较适用。但在CVD和MPCVD工艺过程中,如果在进气端进行流量调节来实现进气成分比例和真空压力的同时恒定,而且还要针对温度变化做出相应的调整,这种上游控制方式的难度非常大,如果不在下游增加节流阀调节,这种上游控制方式几乎完全不能满足工艺过程要求。[/size][size=14px] (4)有些国外机构推荐在CVD和MPCVD工艺设备中使用上游控制模式,一方面是这些机构本身就是气体质量流量控制器生产厂家,并不生产下游控制的各种电动阀门,因此他们在气体质量流量控制器中集成了真空传感器,这种集成真空计的气体质量流量控制器确实是能够用来独立控制进气流量或腔室内的真空压力,但要同时控制流量和压力则几乎不太可能,还需下游节流阀的配合才行。另一方面,这些生产气体质量流量控制器的机构,选择使用上游控制模式的重要理由是下游控制模式中采用电动阀门的成本较高,情况也确实如此,国外主要电动阀门的成本几乎是气体质量流量控制器的好几倍,但目前国产的电动阀门的价格已经只是气体质量流量控制器的四分之一左右。[/size][size=18px][color=#ff0000]3. 成分、温度和真空压力三参量同时控制方案[/color][/size][size=14px] 在宝石生长专用的CVD和MPCVD工艺设备中,针对气体成分、温度和真空压力这三个控制参数,本文推荐一种全新的控制方案,方案如图3-1所示。[/size][align=center][img=双通道控制器同时控制温度和真空压力示意图,690,348]https://ng1.17img.cn/bbsfiles/images/2021/07/202107291601353557_9929_3384_3.png!w690x348.jpg[/img][/align][size=14px][/size][align=center][color=#ff0000]图3-1 CVD工艺设备中三变量控制结构示意图[/color][/align][size=14px] 控制方案主要包括以下几方面的内容:[/size][size=14px] (1)进气端采用气体质量流量控制器进行控制,每一路进气配备一个质量流量控制器,由此实现进气成分的精确控制。[/size][size=14px] (2)采用双通道24位高精度PID控制器对温度和真空压力控制进行同步控制,其中一个通道用于温度控制,另一个通道用于真空压力控制,由此在保证精度的前提下,可大幅度减小控制装置的空间占用和降低成本。[/size][size=14px] (3)温度控制通道连接温度传感器输入信号和固态继电器或可控硅执行机构,可按照设定点或设定程序曲线进行温度控制,PID控制参数可通过自整定方式进行优化。[/size][size=14px] (4)真空压力控制通道连接真空计输入信号和电动阀门,同样可按照设定点或设定程序曲线进行真空压力控制,PID控制参数可通过自整定方式进行优化。为了保证真空度测控的准确性,强烈建议采用薄膜电容式真空计,其精度一般为0.25%,远高于皮拉尼计。最重要的是薄膜电容式真空计内部不带电加热装置,在氢气环境下更具有安全性。[/size][size=14px] (5)双通道控制器除了具有两路控制信号主输入端之外,还有两路配套的辅助输入端,这两路配套的辅助输入端可用来连接温度或真空压力测控的备用传感器,在主输入端传感器发生故障时能自动切换到辅助输入端传感器继续进行测量和控制,这对较长时间的CVD和MPCVD工艺过程尤为重要。[/size][size=14px] (6)双通道控制器可连接4个外部信号源,在进行两路独立变量的控制过程中,4个外部信号源的组态形式可为控制和监测带来极大的便利,除上述备用传感器功能之外,还可以用来进行差值和平均值的监测等。[/size][align=center]=======================================================================[/align] [align=center][img=CVD和MPCVD工艺生长钻石,690,269]https://ng1.17img.cn/bbsfiles/images/2021/07/202107291602272138_6714_3384_3.jpg!w690x269.jpg[/img][/align]
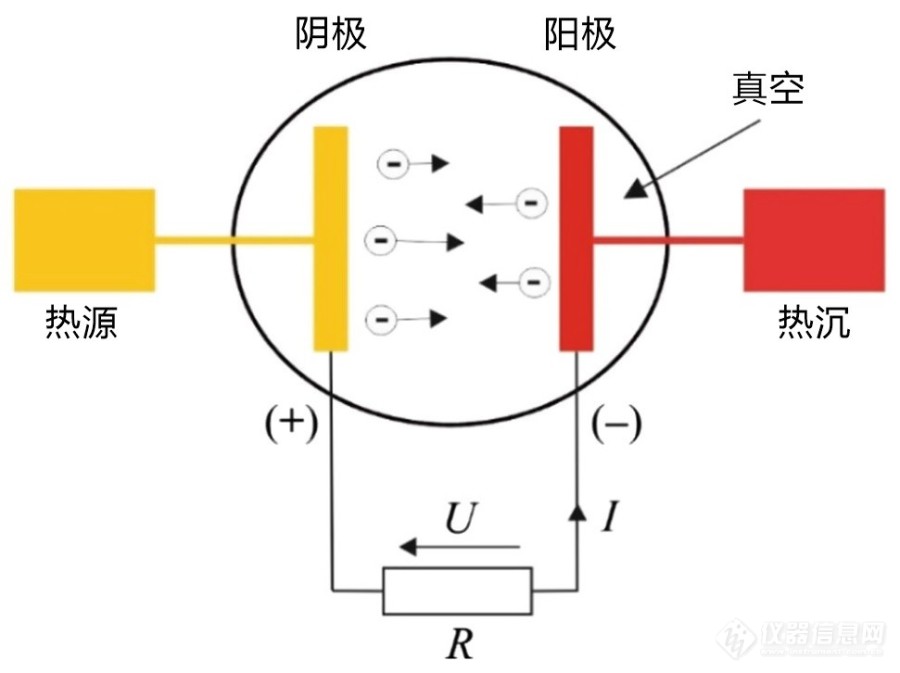
[size=14px][color=#ff0000]摘要:本文针对真空型热离子能量转换器(发电装置)中真空压力和温度的关联性复杂控制,提出一个简便的控制方式和控制系统的解决方案,控制系统仅采用一个双通道高精度PID调节器。方案的核心技术思路是将一个可调参量转换为两个,即将阴极加热电源替换为两个串联形式的小功率电源,分别调节这两个电源的功率即可实现真空室气压和阴极温度的同时控制,由此可大幅减小设备造价且无需使用任何软件。[/color][/size][size=14px][/size][align=center]~~~~~~~~~~~~~~~~~~[/align][size=18px][color=#ff0000][b]一、问题的提出[/b][/color][/size][size=14px] 热离子能量转换器(TEC)是一种将热能直接转化为电能的静态装置,是一种基于热离子发射的转换方法。TEC可分为真空、带有正离子的铯离子和由辅助放电产生的惰性气体(如氩气)等形式。[/size][size=14px] 真空型TEC的简化示意图如图1所示,电极被放置在高真空环境中。阴极与热源热连接,阳极与热沉连接。电极颜色反映了它们温度之间的关系。[/size][align=center][size=14px][color=#ff0000][img=01.真空热离子能量转换器结构示意图,500,373]https://ng1.17img.cn/bbsfiles/images/2022/11/202211230931128921_2824_3221506_3.jpg!w690x515.jpg[/img][/color][/size][/align][size=14px][/size][align=center][color=#ff0000]图1 真空热离子能量转换器结构示意图[/color][/align][size=14px] 一般情况下,最常见的商用温度控制器都能控制TEC阴极的温度,但如果使用了钡钨分压器阴极,因其氧化性问题则对加热过程有特殊的要求并不可忽视。在使用前,阴极必须烘烤并激活。为了保护阴极免受来自周围结构或焙烤过程中产品的氧化和污染,在真空室中必须保持必要的超高真空水平。此外,为了防止阴极可能被水分永久性污染而造成发射能力降低和钨阴极表面损伤,阴极必须允许浸泡在200~400℃足够长的时间,以允许完全的水蒸气出气。[/size][size=14px] 为了防止上述情况出现,最佳控制指标就是真空压力,即真空室中的压力必须始终小于1.33E-04Pa。因此,在TEC运行过程中,当给阴极加热器通电时,由于出气,温度会升高,真空室压力会增加。如果压力超过1.33E-04Pa,则需要关闭加热器电源,直到压力降到这个水平以下。真空室排气和焙烧后的活化是通过将钨基体中的氧化钡转化为阴极表面的游离钡来实现的。活化速率是真空室清洁度、阴极污染、时间和温度的函数。一般来说,阴极在工作温度或略高于工作温度时被激活。阴极温度不应超过1473K。[/size][size=14px][/size][size=14px] 由此可见,在TEC运行过程中,一个重要前提条件是供电加热和温度控制应确保整个过程的真空压力水平不应超过设定的超高真空度,即在运行过程中,除了温度控制之外,还需控制真空室内的真空度始终不超过额定值,但只有加热功率一个可调装置。[/size][size=14px] 从上述真空型TEC的运行要求可以看出,阴极的加热过程是通过调节一个可控变量(加热功率)来实现两个参数(气压和温度)的同时控制。[/size][size=14px] 为了实现这个特殊的控制过程,文献1采用一种复杂的控制机构,此控制机构基于类似的串级控制方法,使用了一个典型的PID控制器结合一个PXI单元,并编制了专用程序进行整体控制,其控制框图如图2所示。[/size][align=center][size=14px][color=#ff0000][img=02.文献1中使用的控制框图,600,356]https://ng1.17img.cn/bbsfiles/images/2022/11/202211230931510435_9811_3221506_3.jpg!w690x410.jpg[/img][/color][/size][/align][size=14px][/size][align=center][color=#ff0000]图2 文献1中使用的控制框图[/color][/align][size=14px] 从图2所示的控制框图可以看出,整个控制装置结构较复杂,还需编制控制软件,整体造价也高。为了实现更简便的控制,本文提出一个更简便的控制方式和控制系统的解决方案,控制系统中仅采用一个双通道高精度PID调节器。方案的核心技术思路是将一个调节参量转换为两个,即将阴极加热电源替换为两个串联形式的小功率电源,分别调节这两个调节小功率电源来实现真空室气压和阴极温度的控制。[/size][size=18px][color=#ff0000][b]二、解决方案[/b][/color][/size][size=14px] 由于在真空型TEC运行过程中只能调节阴极加热温度而同时不能使真空室内的气压超过设定值,这使得整个工作过程只有阴极加热功率一个可调节变量。为了实现阴极温度和腔室真空度的同时控制,解决方案采用了两个串联电源的新型结构,如图3所示。[/size][align=center][size=14px][color=#ff0000][img=03.新型真空压力和温度同时控制系统结构示意图,600,276]https://ng1.17img.cn/bbsfiles/images/2022/11/202211230932179007_2110_3221506_3.jpg!w690x318.jpg[/img][/color][/size][/align][size=14px][/size][align=center][color=#ff0000]图3 新型真空压力和温度同时控制系统结构示意图[/color][/align][size=14px] 如图3所示,解决方案中采用了一个高精度的两通道PID控制器,此控制器具有两个独立的PID控制通道。第一通道与真空计和电源1组成第一闭环控制回路,第二通道与安装在阴极上的热电偶温度传感器(TC)和电源2组成第二闭环控制回路。这里的第一控制回路提供阴极的基础温度,其主要用于较低温度段的烘烤,并同时起到控制腔室真空度的作用。第二控制回路是在阴极温度达到一定温度后(如600℃)才开始起作用,其主要作用是将阴极温度最终恒定控制在设定的高温温度上。整个过程的真空压力和温度的控制效果基本与文献1所述的图4和图5所示相同。[/size][align=center][color=#ff0000][size=14px][img=04.全温域的真空压力和阴极温度的变化,690,449]https://ng1.17img.cn/bbsfiles/images/2022/11/202211230932441901_8566_3221506_3.jpg!w690x449.jpg[/img][/size][/color][/align][color=#ff0000][/color][align=center]图4 全温域的真空压力和阴极温度的变化[/align][align=center][size=14px][/size][/align][align=center][size=14px][img=05.加热初期的真空压力和阴极温度的变化,690,449]https://ng1.17img.cn/bbsfiles/images/2022/11/202211230933014212_1816_3221506_3.jpg!w690x449.jpg[/img][/size][/align][size=14px][/size][align=center][color=#ff0000]图5 加热初期的真空压力和阴极温度的变化[/color][/align][size=14px] 在实际运行过程中的控制步骤如下:[/size][size=14px] (1)首先抽取腔室真空,使其达到2E-06Pa的超高真空水平。然后运行第一控制回路,真空计采集腔室压力,然后自动调节电源1的加热功率使得阴极温度从室温逐渐升高,其中的压力控制设定值为5E-06Pa。在此控制期间腔室压力始终不会超过设定值,但温度则会逐渐快速升高,且电源1始终有一定的输出功率。[/size][size=14px] (2)当第一控制回路控制中阴极温度达到初级设定温度(如600℃)后,第二控制回路自动开始运行,这使得电源2开始输出加热功率,此时电源1和电源2同时输出,使得阴极温度进一步升高,最终恒定在第二控制回路的温度设定值上。[/size][size=14px] (3)在第二回路工作期间,阴极温度进一步上升,势必会造成腔室气压升高而超出设定值5E-06Pa水平,此时第一回路会自动减小电源1的输出功率,使得阴极温度变化速度放缓。在第二回路运行过程中,第二回路相当于一个正向调节作用,第一回路实际上则是一个反向调节作用,这样既能保证腔室气压不会超出设定值,又能保证阴极温度逐步升高而达到设定的高温温度。[/size][size=14px] 总之,通过上述解决方案及其自动控制,可很便捷的实现热离子能量转换器中真空压力和温度的同时控制,压力水平和阴极恒定温度可根据阴极材料要求任意设定。而且整个控制装置得到了大幅度的简化,且无需进行采用任何软件。[/size][size=18px][b][color=#ff0000][/color][color=#ff0000]三、参考文献[/color][/b][/size][size=14px][1] Kania B, Ku? D, Warda P, et al. Intelligent Temperature and Vacuum Pressure Control System for a Thermionic Energy Converter[M]//Advanced, Contemporary Control. Springer, Cham, 2020: 253-263.[/size][size=14px][/size][align=center]~~~~~~~~~~~~~~~~~~~~~~~~~[/align][size=14px][/size][size=14px][/size][size=14px][/size]


