方案详情文
智能文字提取功能测试中
在半导体材料科学领域,碳化硅(SiC)作为一种宽带隙半导体材料,近年来因其高性能而备受关注。SiC以其高硬度、高抗压强度、高热稳定性和优异的半导体特性,在大功率器件、高温环境应用以及装甲陶瓷等领域展现出巨大的潜力。特别是在高压器件中,SiC已成为硅(Si)的有力竞争对手,其性能的提升对于推动相关技术的发展具有重要意义。然而,SiC材料的质量评估是确保其在实际应用中发挥高性能的关键环节。少数载流子寿命(Minority Carrier Lifetime),作为衡量半导体器件性能的基本参数之一,对于SiC材料的质量评估尤为重要。少数载流子寿命的长短直接影响到器件的效率和可靠性,特别是在高压、高温等极端工作条件下。为了准确评估SiC材料的质量,德国Freiberg Instruments公司开发了多种表征和测试方法。其中,微波检测光电导率(MDP,Microwave Detected Photoconductivity)作为一种无接触、无破坏的检测技术,在SiC材料的质量评估中展现出独特的优势。MDP技术通过测量材料在光激发下的光电导率变化,能够直接反映材料的载流子寿命,进而评估材料的缺陷情况和整体质量。碳化硅材料质量评估:通过少子寿命检测,可以评估碳化硅材料的整体质量,包括缺陷分布、杂质含量等。这有助于筛选出高质量的碳化硅材料,提高器件的成品率和性能。在4H-SiC外延生长过程中进行(Al + B)掺杂,研究了掺杂Al和(Al + B)的p型外延层中的少数载流子寿命,来获得品质优良的碳化硅(SiC)基功率器件。 (a) 不同Al浓度外延层中的少数载流子寿命, (b) 不同 B浓度的(Al + B)掺杂外延层中的少数载流子寿命。外延层的Al浓度为 ∼5 × 1017 cm−3。证明了具有Al和B掺杂可调节p型4H-SiC外延层中的少子寿命。并发现一种通过对4H-SiC基IGBTs采用微量掺杂Al来防止双极退化的方法1。 缺陷分析:通过少子寿命技术可以进行缺陷调查。这对于评估SiC材料的质量和稳定性具有重要意义利用微波检测光电导衰减(MDP)评估了厚的轻掺杂n型4H-SiC外延层的自由载流子寿命。从而获得和缺陷中心的相关性。测量的少子寿命与4H-SiC样品中的Z1/2缺陷中心和EH6/7中心浓度之间的关系。可以看到载流子寿命与Z1/2中心和EH6/7中心的相关性。有必要研究载流子寿命与外延层厚度、晶体缺陷和其他深能级(如空穴陷阱)的相关性2。相关应用未完待续~参考文献:[1] Murata, K. , et al. "Carrier lifetime control by intentional boron doping in aluminum doped p-type 4H-SiC epilayers." Journal of Applied Physics 129.2(2021):025702-.[2] Tawara, Takeshi, et al. "Evaluation of Free Carrier Lifetime and Deep Levels of the Thick 4H-SiC Epilayers." Materials Science Forum (2004).
关闭-
1/4

-
2/4

还剩2页未读,是否继续阅读?
继续免费阅读全文产品配置单
束蕴仪器(上海)有限公司为您提供《应用分享|少子寿命测试仪(MDP)在碳化硅材料质量评估中的应用》,该方案主要用于其他中碳化硅检测,参考标准《暂无》,《应用分享|少子寿命测试仪(MDP)在碳化硅材料质量评估中的应用》用到的仪器有MDPmap单晶和多晶硅片寿命测量仪。
我要纠错
相关方案





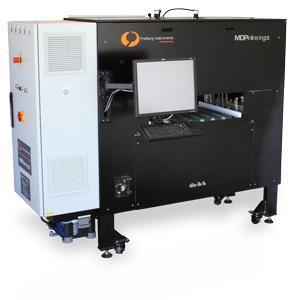
 咨询
咨询