TOF-SIMS在半导体领域有着广泛的应用,如表面痕量金属的检测和定量、工艺过程的有机污染、超浅层深度剖析、超薄介电层分析、界面/bond pad/test pad的分析等等。
TOF-SIMS技术的性能优势主要体现在高质量分辨率、高质量精度和良好的数据速率等方面。另外,低能量、小束斑、高电流的新型双束离子溅射源可以实现溅射快、精度高的深度分析,深度分辨<1nm。且TOF-SIMS技术无需复杂的样品前处理,可以对样品进行直接测试。
本文主要分享半导体器件的浅层、薄层、界面的深度分析的应用案例。(表面的痕量金属的检测和定量、表面污染检测等方面的分析测试案例请参考之前的推文。)
一、包埋500nm深度处的多膜层深度分析

Profiling Conditions: sputtering Cs 2 keV, 45°, analysis Bi 25 keV, 50 kHz interlaced
Speed: 2 µm in 1200 s, 3 datapoints per s, 1.7 nm/s (102 nm/min), 0.5 nm per datapoint
二、N, C, O, 和 Cl离子注入的深度分析

三、浅层注入的深度分析
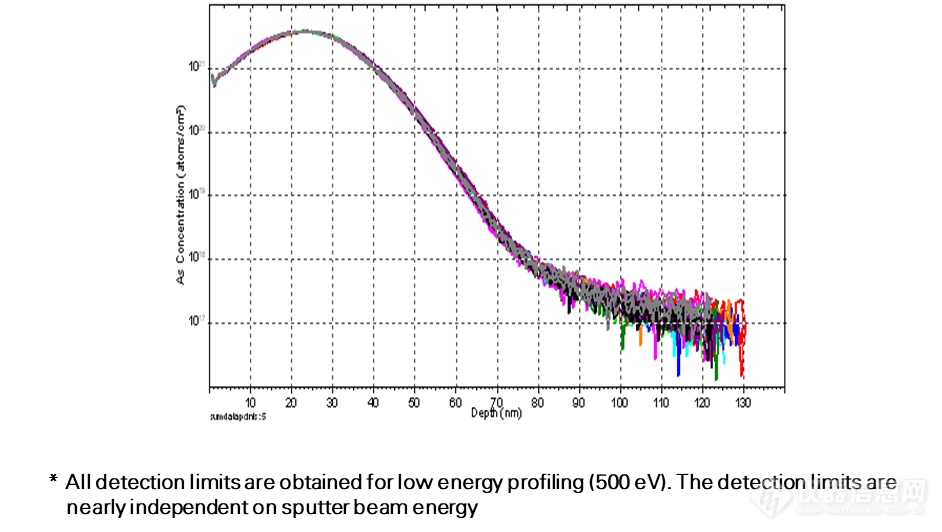
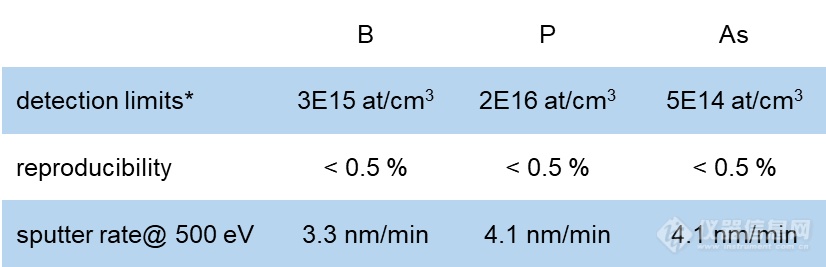
四、SiGe Testpad中B注入的深度分析

Analysis Beam:Bi1 @ 15 keV, 1 pA,35 x 35 µm2
Sputter Beam:O2 @ 500 eV, 90 nA,200 x 200 µm2
Total time for analysis including pad alignment: ≈15 min
五、SiCP Testsample的深度分析

Analysis Beam:Bi1 @ 15 keV, 8 pA,50 x 50 µm2
Sputter Beam:O2 @ 500 eV,80 nA,200 x 200 µm2
Total time for analysis: ≈10 min
六、GaAs/InGaP多膜层深度

Analysis Beam:Bi1 @ 15 keV, 7 pA,00 x 100 µm2
Sputter Beam:Cs @ 1000 eV,100 nA,300 x 300 µm2
Total time for analysis: ≈20 min
关注公众号“IONTOF-CHINA”,更多TOF-SIMS案例分享和实际应用技术解读。
Hybrid SIMS:超高质量分辨双分析器融合系统
TOF-SIMS在半导体器件分析方面的研究进展(一)
表面分析方法:EDX、AES、XPS、TOF-SIMS
第十届表面分析技术应用论坛暨表面化学分析国家标准宣贯会

相关产品

关注

拨打电话

留言咨询