imec 使用 ASML 最新High NA EUV 光刻机取得突破性进展
导读:IMEC与ASML合作,首次用High NA EUV光刻机成功曝光逻辑与DRAM图案,实现9.5nm密集金属线及20nm以下间距,展现新一代光刻技术潜力,对缩小技术尺寸、推进"埃米时代"具有重要意义。
比利时微电子研究中心 imec 当地时间昨日宣布,在其与 ASML 合作的 High NA EUV 光刻实验室首次成功利用 High NA EUV 光刻机曝光了逻辑和 DRAM 的图案结构。
在逻辑图案方面,imec 成功图案化了单次曝光随机逻辑机构,实现了 9.5nm 密集金属线(注:对应 19nm Pitch),将端到端间距尺寸降低至 20nm 以下。
不仅如此,imec 实现了中心间距 30nm 的随机通孔,展现了出色的图案保真度和临界尺寸一致性。
此外,imec 通过 High NA EUV 光刻机构建了 P22nm 间距的二维特征,显示了新一代光刻技术在二维布线方面的潜力。
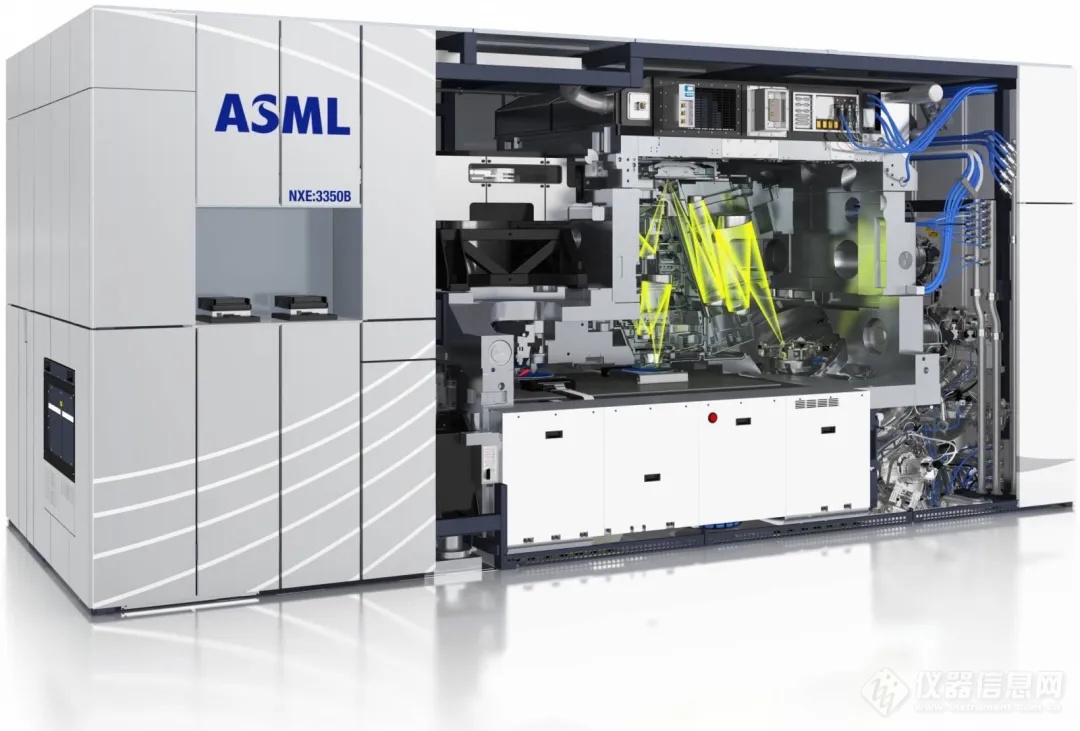
而在 DRAM 领域,imec 成功利用单次曝光图案化了集成 SNLP(Storage Node Landing Pad)和位线外围的 DRAM 设计,展现了 High NA EUV 减少曝光次数的能力。
imec 总裁兼首席执行官 Luc Van den hove 表示,这些结果证实了 High NA EUV 光刻技术长期以来所预测的分辨率能力,一次曝光即可实现 20nm 以下间距的金属层。因此 High NA EUV 将对逻辑和存储器技术的尺寸扩展起到重要作用,而这正是将路线图推向 "埃米时代" 的关键支柱之一。
来源于:微电子制造
热门评论
最新资讯
新闻专题
更多推荐
写评论…
0













