超薄!晶盛机电减薄机实现12英寸30μm晶圆稳定加工
进入 #半导体设备新品发布阅读更多话题内容
导读:晶盛机电成功研发新型WGP12T设备,实现稳定加工12英寸30μm超薄晶圆,标志着在半导体设备制造领域的重大进展。
超薄晶圆因其高集成度、低功耗和卓越性能,已成为当前半导体产业发展的关键材料之一。随着半导体工艺进入2.5D/3D时代,晶圆的厚度不断减薄,对设备精度和工艺控制的要求也越来越高。晶盛机电的研发团队迅速响应市场需求,于近日成功研发出新型WGP12T减薄抛光设备,实现了稳定加工12英寸30μm超薄晶圆的技术突破。这一成就标志着晶盛机电在半导体设备制造领域再次取得重要进展,为中国半导体产业的技术提升和自主可控提供了强有力的支撑。
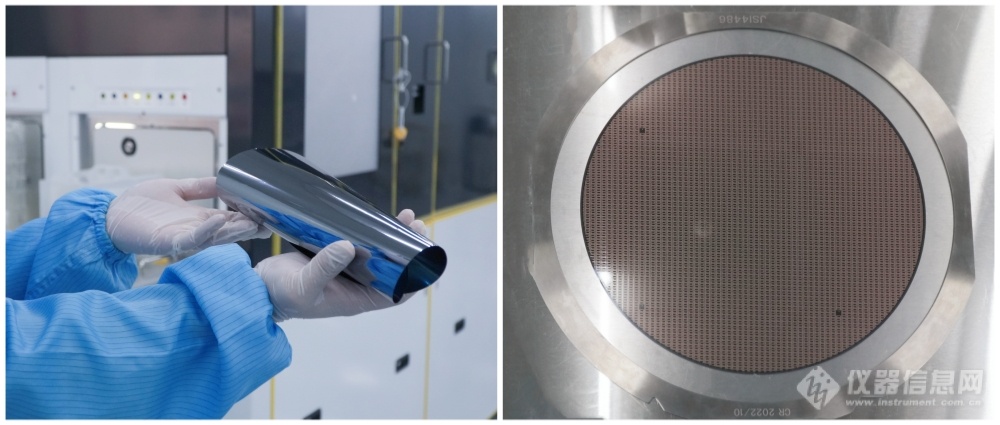
▲ 12英寸30μm超薄晶圆
据悉,新型WGP12T设备是在原有设备上进行了多项技术优化和工艺改进,成功使晶圆在设备上能稳定减薄至30μm以下,并确保晶圆表面平整度和粗糙度的高标准。在此过程中,团队成功解决了超薄晶圆减薄加工过程中出现的变形、裂纹和污染等难题,真正实现了30μm超薄晶圆的高效、稳定加工。这一技术突破为公司在全球半导体设备市场的竞争中增添了新的优势。

▲ 新型WGP12T减薄抛光设备
晶盛机电一直致力于半导体设备的研发与创新,此次行业领先的超薄晶圆加工技术突破,将为我国半导体行业提供更先进、更高效的晶圆加工解决方案。未来,晶盛机电将继续秉持“打造半导体材料装备领先企业,发展绿色智能高科技制造产业”的使命,持续深耕半导体设备领域,以技术创新为动力,不断突破技术壁垒,加速产品创新,为客户提供最前沿、最具竞争力的半导体解决方案,引领行业迈向新未来。
来源于:仪器信息网
热门评论
最新资讯
新闻专题
更多推荐
写评论…
0













