华虹宏力“半导体结构的形成方法”专利公布
导读:上海华虹宏力半导体制造有限公司研发的专利涉及一种提高快闪存储器性能的半导体结构形成方法,通过优化字线栅层和栅氧层的处理,解决过擦除问题,提升存储器性能。
天眼查显示,上海华虹宏力半导体制造有限公司“半导体结构的形成方法”专利公布,申请公布日为2024年7月23日,申请公布号为CN118382298A。
背景技术
在目前的半导体产业中,集成电路产品主要可分为三大类型:模拟电路、数字电路和数/模混合电路,其中,存储器是数字电路中的一个重要类型。而在存储器中,近年来快闪存储器(Flash Memory,简称闪存)的发展尤为迅速。闪存的主要特点是在不加电的情况下能长期保持存储信息,且具有集成度高、存储速度快、易于擦除和重写等优点,因此,在微机、自动化控制等多项领域得到了广泛的应用。
快闪存储器分为两种类型:叠栅(stack gate)快闪存储器和分栅(split gate)快闪存储器。叠栅快闪存储器具有浮栅和位于浮栅的上方的控制栅。叠栅快闪存储器存在过擦除的问题。与叠栅快闪存储器不同的是,分栅快闪存储器在浮栅的一侧形成作为擦除栅极的字线。分栅快闪存储器能有效的避免过擦除效应。
然而,现有的快闪存储器的性能较差。
发明内容
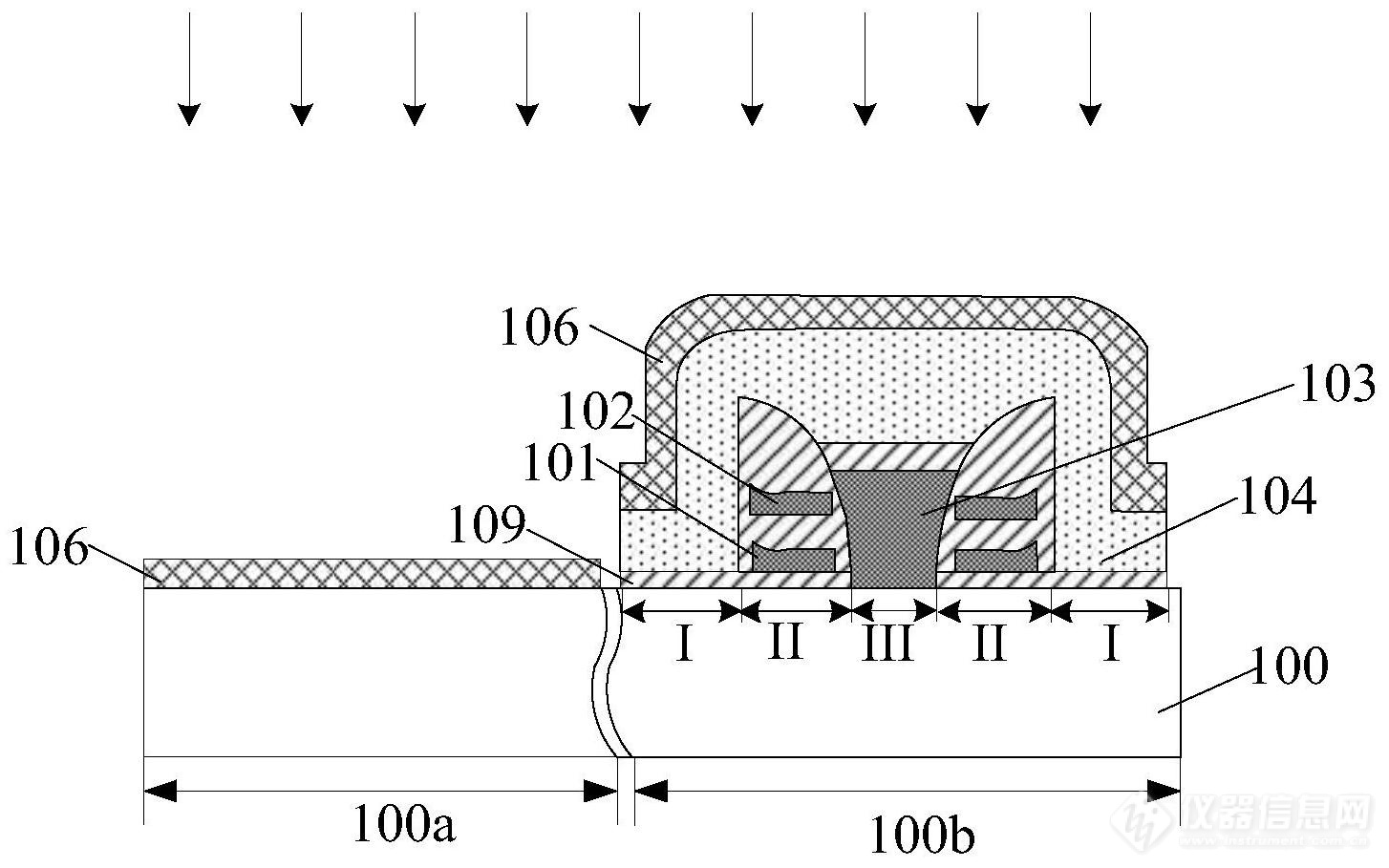
本发明提供一种半导体结构的形成方法,包括:提供衬底,所述衬底包括逻辑区和存储区,所述存储区包括字线区;在所述存储区上形成初始字线栅层;在所述初始字线栅层的顶部表面和所述逻辑区的所述衬底的表面形成初始栅氧层;对所述初始栅氧层进行热氧化处理,形成栅氧层,所述初始字线栅层表面的所述栅氧层的厚度大于所述逻辑区的所述衬底表面的所述栅氧层的厚度;在所述逻辑区的所述栅氧层的表面形成栅极层;刻蚀去除所述存储区的所述栅氧层以及所述栅氧层底部的部分所述初始字线栅层,在所述字线区的表面形成字线栅层,在形成字线栅层的过程中,栅氧层作为硬掩膜层,由于初始字线栅层表面的栅氧层的厚度变厚,从而在刻蚀的过程中能够表现出很好的阻挡性和稳定性,从而保证字线栅层的高度,提升字线栅层的高度均匀性,并且增加了字线区刻蚀的窗口,可以降低编程串扰失效,具有较广泛的使用范围。
来源于:仪器信息网
热门评论
最新资讯
新闻专题
更多推荐