推荐厂家
暂无
暂无
电子陶瓷(主要成分为氧化铝\碳化钛\氧化锆)的前处理方法,主要测铝\钛\锆含量,用碳酸钠+硼砂熔融可以吗?
[color=#DC143C][size=4][size=2]最近做了一些含糖量高的食品,碳化起来很慢,在坩埚中形成一层黑膜,里面很难碳化彻底。各位朋友有好办法吗?[/size][/size][/color][em09501][em09501][em09501]
小弟现做毕业设计,遇此困惑,希望各位老大给予帮助!!!在此小弟先谢谢各位了!! 高合金钢碳化物析出相萃取技术,主要是电解液与胶囊的问题:小弟希望在电解液中悬挂胶囊作为半透膜,但现查到的资料中胶囊与有机物溶解。特此向各位求教!!




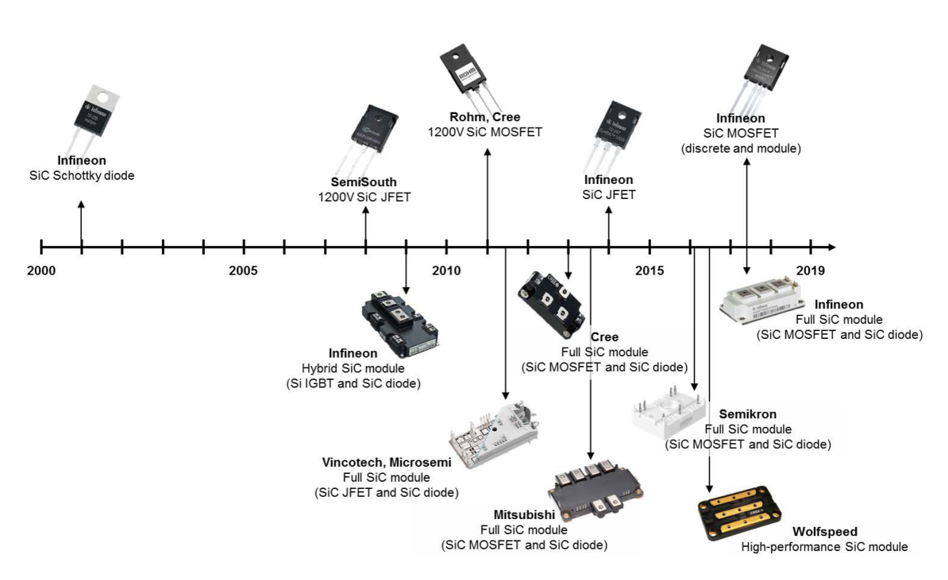


 400-628-5299
400-628-5299
 留言咨询
留言咨询

 400-860-5168转4852
400-860-5168转4852
 留言咨询
留言咨询

 400-860-5168转4852
400-860-5168转4852
 留言咨询
留言咨询


