方案详情文
智能文字提取功能测试中
Techcomp天美Application FIB-SEM-Ar‘“三束“系统 一般来说,用 FIB对样品进行 TEM 制样时,由于聚焦的 Ga+离子的能量过高,经常会使样品表面受到损伤,因而会严重影响 TEM 观察效果。为此,需要用低电压的 Ga+离子对样品进行加工。但是这就对操作者提出了更高的要求,而且由于 Ga+离子仍然是聚焦的,达不到最佳的加工效果。日立最新双束 FIB 系统NX2000(图1)可以通过对已经加工好的样品再用Ar+离子束进行加工,达到更好的加工效果。这样日立 NX2000 就变成了三束系统(FIB-SEM-Ar),大大拓展了FIB 的应用范围。 图1.日立双束 FIB 系统 NX2000 图2. FIB-SEM-Ar的结构示意图 图2是FIB-SEM-Ar的结构示意图。由于Ar+离子束是发散的,作用在样品上每一点点能量较低,对样品的损伤伤就较小。在TEM 观察过程中, 天美(中国)科学仪器有限公司 北京市朝阳区天畅园7号楼(100107) t 010-64010651 010-64060202 techcomp@techcomp.cn w www.techcomp.cn 图 3.NAND 闪存的 TEM薄片样品 图3是用 FIB所制备的 NAND 闪存的 TEM 薄片样品,(a)是用 FIB 30kV 精加工后的 TEM图片,几乎薄片整面都成了非晶,层间衬度很差;(b)是将(a)样品继续用 FIB 5kV精加工后的 TEM图片,层间衬度良好,但是 Si 层有很多损伤斑点;(c)是将(b)样品继续用 1kV的Ar离子束精加工后的 TEM 图片,层间衬度良好, Si 层无损伤整洁清晰。 日立最新双束FIB系统 NX2000(图1)可以通过对已经加工好的样品再用Ar+离子束进行加工,达到更好的加工效果 。
关闭-
1/2

-
2/2
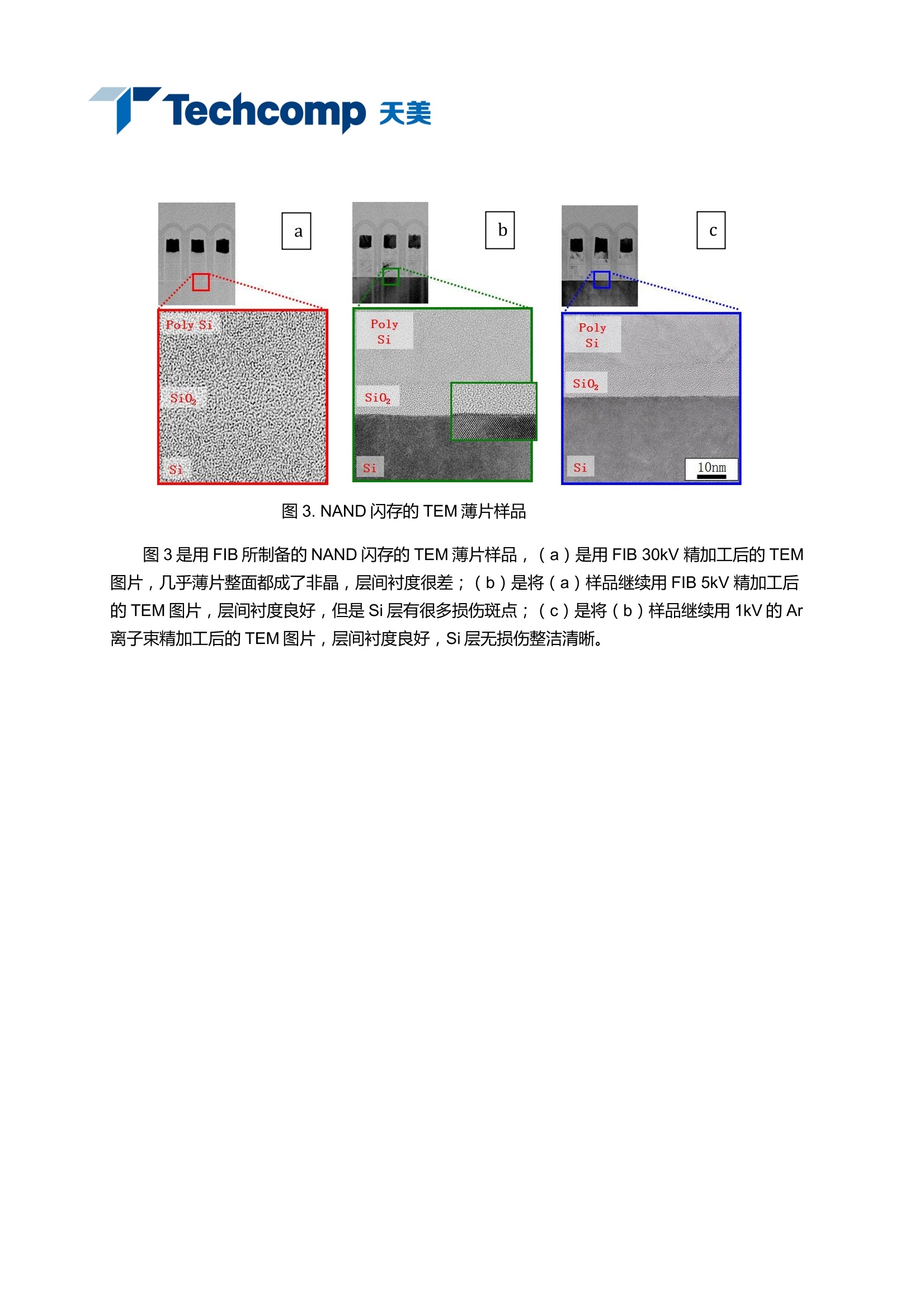
产品配置单
天美仪拓实验室设备(上海)有限公司为您提供《多种样品中表面形貌检测方案(其它相关仪表)》,该方案主要用于其他中表面形貌检测,参考标准《暂无》,《多种样品中表面形貌检测方案(其它相关仪表)》用到的仪器有null。
我要纠错
相关方案


 咨询
咨询