近 50 年来半导体工业的发展和增长始终遵循摩尔定律,可以说微型芯片中晶体管尺寸的不断缩小是由光刻技术的发展推动的。根据瑞利衍射的分辨率极限,与降低生产工艺参数 k 和提高数值孔径(NA)相比,缩短曝光波长(λ)是获得更小的光刻图特征的最容易的方法。
从汞灯的 G 线辐射(436nm)到激光等离子体产生的 13.5nm 波长的 EUV 辐射,曝光波长已经经过了五次迭代。目前荷兰已经推出的使用大规模生产的,第五代最新的 EUV 光刻机- NXE3600D,它可以支持 5 nm 和 3nm 逻辑节点和前沿 DRAM 节点的极紫外大规模生产。其使用了激光驱动锡基 EUV 等离子体源(IF点,250W),最大可曝光 300 毫米晶圆,最大曝光场尺寸为 26 毫米 x 33毫米。它配备了数值孔径(NA)为 0.33 的反射投影光学器件。每小时曝光晶圆数量在 160 片以上。
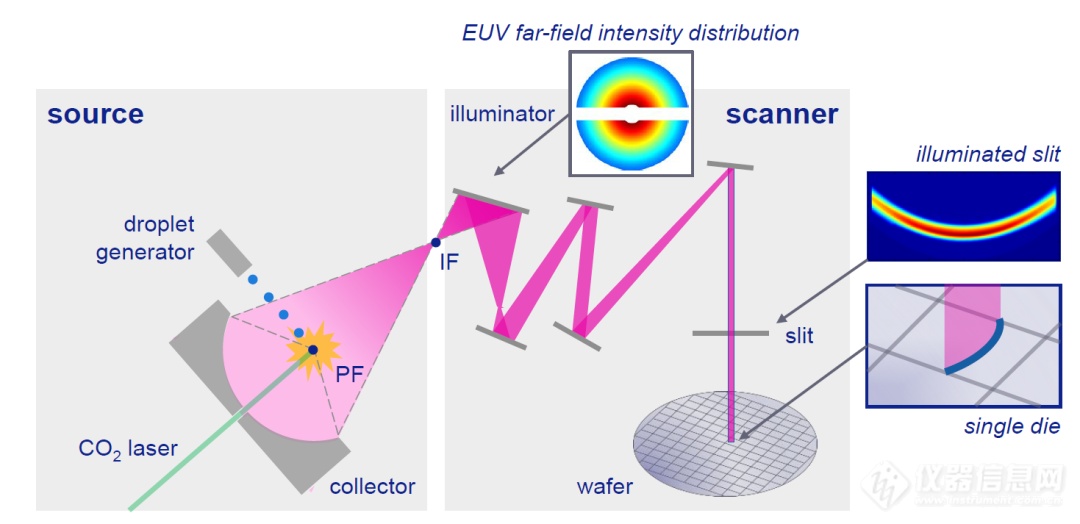
图1极紫外光刻机结构示意图
目前台积电和三星都从 ASML 订单数台光刻机,同时三星公司通过对比单次 EUV 曝光和 DUV 浸没式多次曝光发现,前者在成像质量、设计难度、良率和成本各方面均优于后者,这也标志着先进半导体制程正式进入 EUVL 时代。近期 ASML 透露有计划投资 70 亿在台湾新北修建厂区以扩大产能。极紫外光刻机被广泛、大批量用于批量芯片生产,对于极紫外计量设备的需求应运而生。如用于测量极紫外光刻机中所大量使用的极紫外多层膜反射镜反射率测量的极紫外反射率测量仪,用于极紫外光刻掩膜版缺陷检测的计量设备等。此类设备所搭载的极紫外光源,不要需要像光刻机中那么大功率的极紫外光源,反而小型化、紧凑型、高亮度的激光驱动等离子体极紫外光源是比较理想的选择。下面我们就着重介绍一下荷兰 ISTEQ 公司生产的紧凑型的激光驱动等离子体极紫外光源-TEUS 及其重要应用。
激光驱动等离子体极紫外光源-TEUS

荷兰 ISTEQ 公司是采用高重频、高能量的纳秒激光打高速转动中的液态 Sn/In 合金,来产生高亮、洁净的极紫外光,目前其得到的13.5nm±1%带宽内的能量约为2-8W@2π,光源亮度约为 80-280 W/mm2 sr。
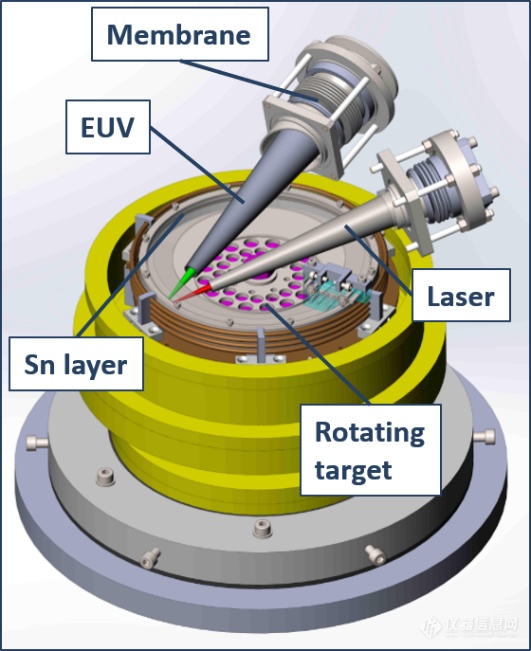
ISTEQ 生产的 TEUS光源靶室结构示意图
快速转动液态靶材设计及传统碎屑抑制技术
—获得洁净极紫外光源的终极方案
强激光与金属靶材的相互作用将会产生包括大颗粒、离子等多种碎屑污染物。当 Sn 等碎屑污染物在后端光路沉积的有效厚度达到 ~1.5nm 时,对 13.5nm 的 EUV 光的吸收率就已经高达 10%。因而,在光源、光路以及长期维护过程中,采取多种手段抑制碎屑的产生、沉积以及消除已沉积的污染物,对于科研以及大规模工业化生产中保持效率与稳定性尤为重要。
高速转动靶材的优势
高速旋转液态靶,保证 EUV 稳定输出的同时,使大颗粒污染物因惯性作用难以进入激光/ EUV 光路;激光调制降低产生的离子碎屑的能量;磁场偏离离子碎屑;对冲气流与 CNT 滤膜提供全方位保护。
(1)高速旋转液态靶重定向微滴碎片使其远离输入(激光)和输出(EUV)窗口
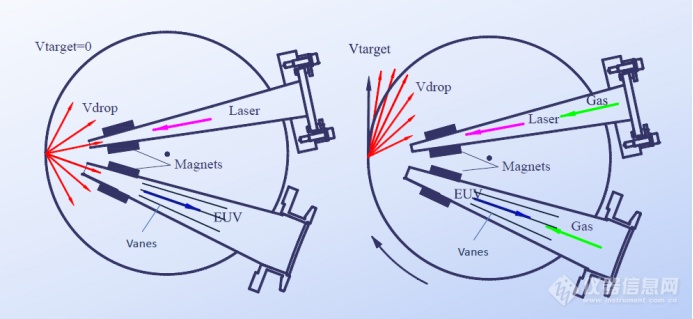
(2)200HZ 更高的装转速下的微滴抑制效果更明显
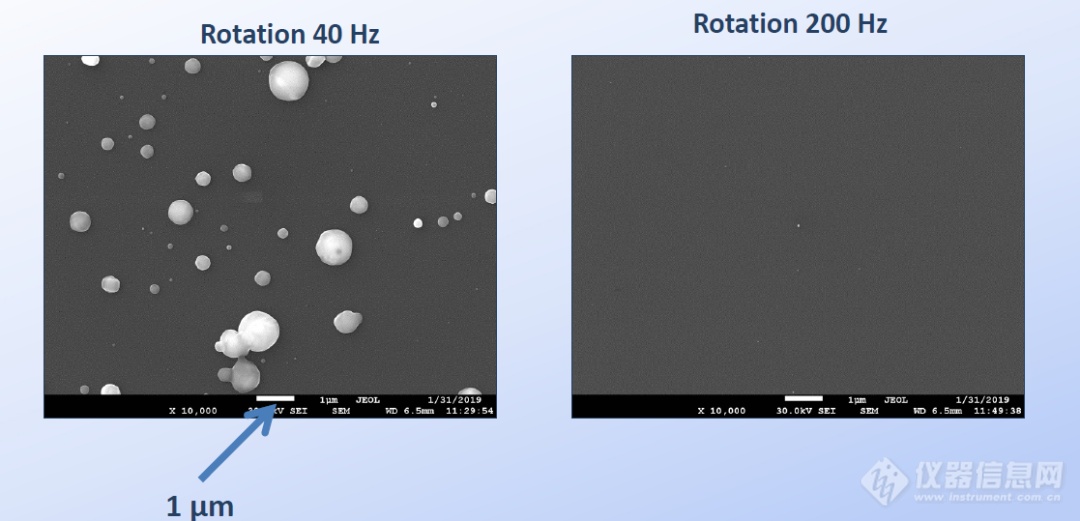
(3) 高速的转动使得每发激光都打在新的靶材上保证的 EUV 脉冲的能量稳定性
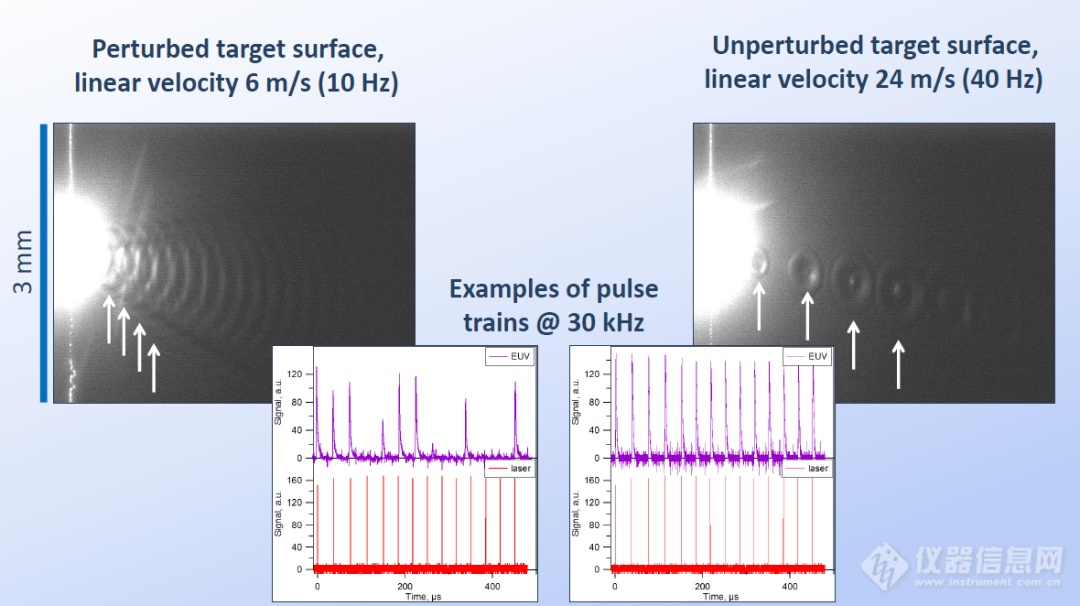
(4) 选取微滴碎屑的最小的极紫外出口方向

上图展示了三个极紫外出口位置的微滴碎屑分部,可以TEUS-S100出口位置的微滴碎屑已优化到最小。
传统碎屑(等离子体、蒸发碎屑)抑制技术
对冲气流——使 Sn/In 蒸汽减速
磁场——偏转带电粒子
激光脉冲轮廓优化——减小最大的离子能量以保证磁场偏转离子的有效性
碳纳米管(CNT)薄膜——保证极紫外高透的同时阻挡各类碎屑
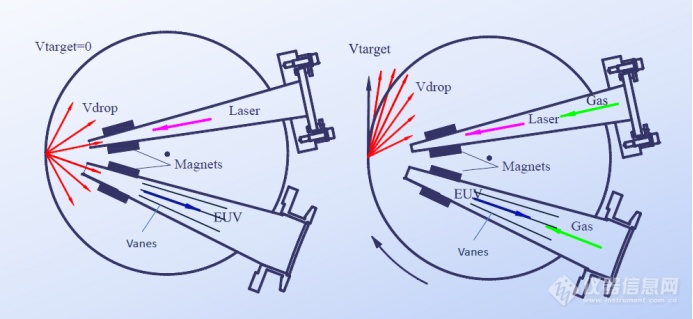
主要参数
100W | 200W | 400W | |||||||
最大脉冲频率 | 25kHZ | 70kHZ | 50kHZ | 135kHZ | 100kHZ | 200kHZ | |||
等离子体尺寸μ m * | ≤60 | ≤40 | ≤60 | ≤40 | ≤60 | ≤45 | |||
可收集的EUV光源立体(S/M) | 0.05sr/0.15sr | ||||||||
(13.5 nm ± 1%) 辐射转换效率 2π· sr | 2% | 1.6% | 2% | 1.6% | 2% | 1.6% | |||
经过碎片抑制系统后进入镜片收集立体角内的光通量@ 带宽 (13.5nm ± 1%)(S/M) | 11mW | 9mW | 22mW | 18mW | 44mW | 40mW | |||
经过碎片抑制系统后的光谱亮度 @ 带宽 (13.5nm ± 1%) W/mm2·sr | ≥80 | ≥140 | ≥160 | ≥280 | ≥310 | 500) W/mm | |||
等离子体稳定性** | 3% RMS | ||||||||
* : 定义为等离子强度分部1/e2的直径
** : 取决于激光稳定性,60发脉冲与脉冲之间的稳定性
系统寿命和维护要求
激光平均功率 | 100W | 200W | 400W |
在不间断运行模式下,不使用特殊的膜滤光片, 收集镜寿命(性能退化10%时) | 8 | 4 | 2 |
在不间断运行模式下,使用特殊的膜滤光片, 收集镜寿命(性能退化10%时) | 18 | 9 | 4 |
维护周期(*天/*月) | 1天/4个月 | 2天/3个月 | 1天/1个月 |
不间断运行模式的正常运行时间* | 4个月 | 3个月 | 1个月 |
目前已有多台 TEUS 系统已交付客户,一些还正在生产中。

主要应用
极紫外光刻空白掩膜版缺陷检测(AMI)
相较于 193nm 的 DUV 光刻机不同,极紫外光刻是使用的反射式光路,因为大多数材料对于 13.5nm 光都有较强的吸收。所以 Mo/Si 多层膜及其变种被大量的使用。掩模是光刻成像系统的重要组成部分。随着芯片制造技术节点的降低,EUV 掩模的结构越来越复杂,对成像质量的影响也逐渐增大。EUV 掩模主要由基底、吸收层与 Mo/Si 多层膜组成。基底对整个 EUV 掩模起支撑作用。EUV 掩模缺陷,尤其是多层膜缺陷,会导致掩模成像质量下降,是影响 EUV 光刻良率的重要问题之一。
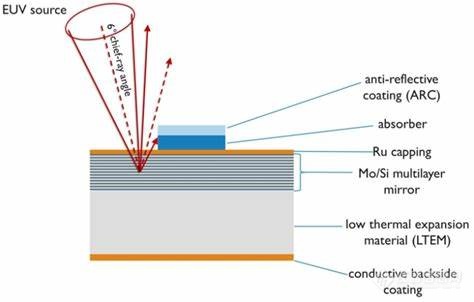
极紫外掩膜版结构示意图
由于非工作波长检测设备在空间分辨和检测的深度的不足,使得工作波长的掩膜显得非常有必要。
目前日本 L 公司已经推出了商业化的工作波长空白掩模检测设备 ABI。如下图6所示,ABI 设备主要包含 EUV 光源,由两个椭球面镜和一个施瓦茨镜子显微照明系统,用于成像的 Schwarzschild 光学镜头,可切换平面和凹球面反射镜及对极紫外 CCD 相机。ABI 设备可在检测模式与复检模式两种模式下运行。
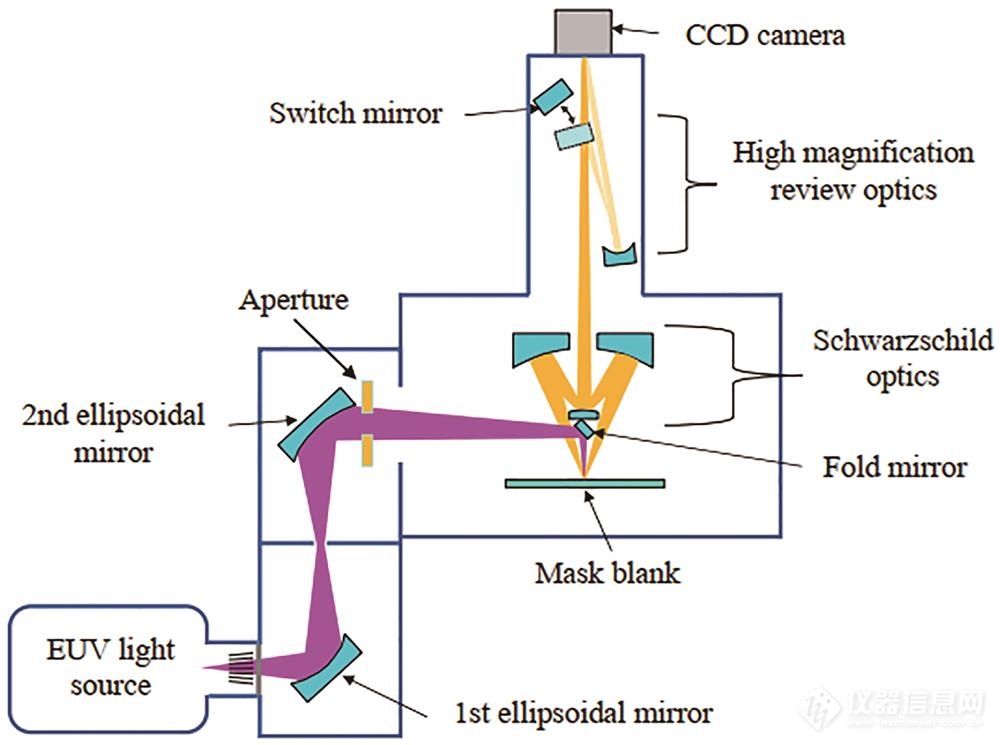
工作波长空白掩模检测设备光路结构
在检测模式下,高放大率复检光学元件部分中的凹球面反射镜不参与成像,EUV 光被椭球面镜收集和反射然后被折叠镜、单色并反射照射到空白掩模上,空白掩模的反射光通过被 Schwarzschild 光学镜头的内 NA 和外 NA(内NA为0.1,外NA为0.27)限制的区域由 CCD 接收。检测模式下成像放大率为26倍。
在复检模式下,若采用暗场成像,则调整可伸缩的平面镜使得光线经凹球面反射镜放大,最终以1200倍(26×46.15)放大率成像得到缺陷位置的高分辨率图像,可获取更精确的缺陷位置与尺寸信息,若采用明场成像,则需另外调整掩模上方的折叠镜使得照射在掩模上的光中心主入射角为 6°,以获取能反映更多缺陷反射信息的 1200 倍放大的明场图像。目前 ABI 已能 100% 检测出高度大于 1 nm,宽度大于 33 nm 的缺陷,已可满足 16 nm hp(half-pitch)节点要求。
同时 TEUS 还可以用于材料科学、晶圆检测和极紫外扫描光刻工艺链中的极紫外光学器件检测、图形化掩膜检测和掩膜空间像检测等。
结论
紧凑型激光驱动等离子体极紫外光源-TEUS 由于其高度高、洁净、能量抖动小等特点适合大规模生产中基于 EUV 显微的掩模版检测等需要高亮度 EUV 光源的应用场景,或者小规模光刻生产与实验等应用方向。同时经过数台 TEUS 的交付,已经验证该光源的性能及稳定性。
ISTEQ
荷兰 ISTEQ 坐落于埃因霍温的高科技园区,在开发和制造各种类型的尖端产品方面拥有广泛的专业技术与丰富的经验。ISTEQ 致力于为各种工业应用尤其是半导体、材料分析和光谱学应用开发广泛的现成解决方案,公司产品包括:激光驱动等离子体白光光源,DPP/LPP EUV光源、用于 X-ray/EUV/VUV 波段的定制化光谱仪及等离子体诊断设备。
北京众星联恒科技有限公司作为荷兰 ISTEQ 公司 TEUS 极紫外光源在中国区的授权总代理商,为中国客户提供所有产品的售前咨询,销售及售后服务。我司始终致力于为广大科研用户提供专业的 EUV、X 射线产品及解决方案。如果您有任何问题,欢迎联系我们进行交流和探讨。
相
关
阅
读
参考文献:
1. 激光与光电子学进展, 2022, 59(9):0922022, 网络出版: 2022-05-10
2. Myers, D. W., Fomenkov, I. V, Hansson, B. A. M., Klene, B. C. & Brandt, D. C. EUV source system development update: advancing along the path to HVM. Emerg. Lithogr. Technol. IX 5751 , 248–259 (2005). https://doi.org/10.1117/ 12.601052 .
3. Stamm, U. et al. EUV source power and lifetime: the most critical issues for EUV lithography. Emerg. Lithogr. Technol. VIII 5374 , 133–144 (2004). https://doi.org/ 10.1117/12.535410 .
4. Yoshioka, M. Xenon DPP source technologies for EUVL exposure tools.Altern. Lithogr. Technol. 7271 , 727109 (2009). https://doi.org/10.1117/12.814100 .
5. Yam ane T, Amano T, Takagi N, et al. Advances in the detection capability on actinic blank inspection[J]. Proceedings of SPIE, 9776, 97761G(2016).
6.Miyai H, Suzuki T, Takehisa K, et al. The capability of high magnification review function for EUV actinic blank inspection tool[J]. Proceedings of SPIE, 8701, 870118(2013).
7. Kamo T, Takai K, Iida N, et al. Evaluation of etched multilayer mask for 0.33 NA EUVL extension[C](2016).
免责声明
此篇文章内容(含图片)部分来源于网络。文章引用部分版权及观点归原作者所有,北京众星联恒科技有限公司发布及转载目的在于传递更多行业资讯与网络分享。若您认为本文存在侵权之处,请联系我们,我们会在第一时间处理。如有任何疑问,欢迎您随时与我们联系。
衍射前沿 新材料纪元|第十五届全国X射线衍射与新材料学术大会暨ICDD研讨会纵览
MiniPIX多功能探测器用于提升基于罗兰圆几何的X射线吸收精细结构谱仪性能
丹佛集结令·X射线科学前沿研讨会|DENVER X-RAY CONFERENCE
变革中成长,探索中前行

相关产品
Greateyes 极紫外、软X射线内真空CCD相机 LOTTE-s系列
Greateyes 极紫外、软X射线内真空CCD相机 LOTTE-i系列
optiXfab 13.5nm 极紫外施瓦茨希尔德(Schwarzschild)
optiXfab 1英寸13.5nm 极紫外多层膜反射镜
optiXfab13.5nm极紫外光源多层膜收集镜
Advacam Timepix3直接探测电子相机
Microworks X射线相衬、暗场成像套件
NTT-AT X射线分辨率测试卡
XOS紧凑型多毛细管微焦点X射线光源Mini-Beam
BrillianSe™ 高分辨率非晶硒X射线探测器
三维扫描透射X射线显微镜 科研级 桌面式X射线相衬微米CT-高能/高灵敏/高分辨
软X射线直读型桌面吸收精细结构谱仪
直读型硬X射线吸收精细结构谱仪
Advacam 光子计数X射线探测器 WidePIX 2(1)x10-MPX3
GDMS增值服务

关注

拨打电话

留言咨询