接触式轮廓仪/粗糙度仪
进口
触针式轮廓仪
Zeta™-388光学轮廓仪
Zeta™-388提供3D量测和成像功能,与集成防震台和晶圆操作系统结合,可实现全自动测量。该系统采用ZDot™ 技术,可同时收集高分辨率3D形貌信息和样品表面真彩色图像。Zeta-388支持研发和生产环境,具有多模光学器件、易于使用的软件、低拥有成本和SECS/GEM通信。

产品描述
Zeta-388光学轮廓仪是一款非接触式三维(3D)表面地貌测量系统。Zeta-388基于Zeta-300的功能,增加了用于全自动测量的机械手臂操作系统。该系统由已获得专利的ZDot技术及多模式光学组件提供支持,可支持各种样品测量:透明和不透明、低至高反射率及各种粗糙程度的纹理,以及从纳米到毫米范围的台阶高度。
Zeta-388光学轮廓仪集成了六种不同的光学量测技术,构建出一款可灵活配置且易于使用的系统。ZDot测量模式同时收集高分辨率的3D扫描信息和样品表面真彩色图像。其他3D测量技术包括白光干涉测量法、诺马斯基光干涉对比显微法和剪切干涉测量法,膜厚测量包含使用ZDot模式测量和光谱反射的测量方法。Zeta-388也是一款高端显微镜,可用于抽样检查或缺陷自动检测。Zeta-388通过提供全面的台阶高度、粗糙度和薄膜厚度测量、缺陷检测功能和机械手臂操作系统来支持研发和生产环境。
特征
采用ZDot及多模式光学技术且便于使用的光学轮廓仪,可应对各种各样的应用程序
用于抽样检查和缺陷检测的高质量显微镜
ZDot:同时收集高分辨率的三维(3D)扫描及真彩色无限聚焦图像
ZXI:采用纵向高分辨率的广域测量白光干涉仪
ZIC:图像对比度增强,可实现亚纳米级粗糙度表面的定量分析
ZSI:纵向高分辨率图像的剪切干涉术
ZFT:通过集成式宽频反射测量法测量薄膜厚度和反射率
AOI:自动光学检测,可量化样本缺陷
生产能力:具有多点量测和图形识别功能的全自动测量
机械手臂操作系统:自动加载直径为50毫米到200毫米的不透明(例如硅)和透明(例如蓝宝石)样品

应用
台阶高度:从纳米到毫米的3D台阶高度
表面:光滑表面到粗糙表面上的粗糙度和波纹度测试
翘曲:2D或3D翘曲
应力:2D或3D薄膜应力
薄膜厚度:透明薄膜厚度从30nm至100µm不等
缺陷检测:捕获大于1µm的缺陷
缺陷审查:KLARF文件可用于寻找缺陷,以确定划痕缺陷位置,测量缺陷3D表面形貌
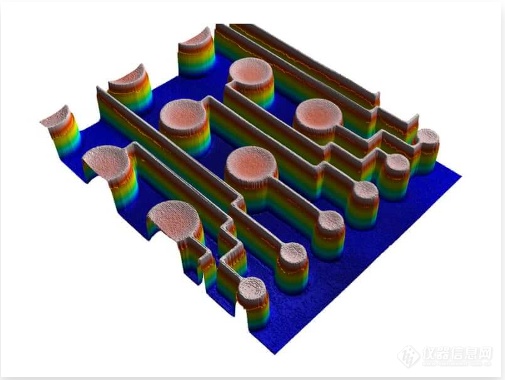
工业
无线通讯器件(SAW/BAW/FBAR)
发光二极管(LED):发光二极管和PSS(图形化的蓝宝石衬底)
半导体和化合物半导体
半导体WLCSP(晶圆级芯片封装)
半导体FOWLP(扇出晶圆级封装)
PCB(印刷电路板)和柔性电路板
MEMS:微机电系统
医疗器械和微流体元件

主要应用
台阶高度
Zeta-388 能够非接触式测量从纳米级到毫米级的3D台阶高度。ZDot和多模式光学组件可提供一系列方法来测量台阶高度。ZDot是主要测量的技术,可以快速测量从几十纳米到毫米级的台阶。ZXI干涉测量可用于在大范围内测量从纳米级到毫米级的台阶。ZSI剪切干涉测量可用于测量不到80nm的台阶。
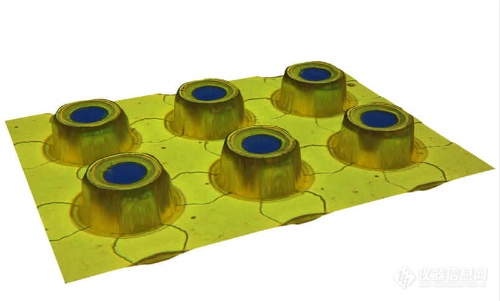
薄膜厚度
Zeta-388 能够使用 ZDot 或 ZFT 测量技术测量透明薄膜的薄膜厚度。ZDot用于测量大于10µm的透明薄膜,例如覆盖在高折射率的衬底上的光刻胶或微流体器件层。ZFT使用集成宽频反射仪测量30nm至100µm的薄膜。这既可以运用于单层,也可以运用于多层薄膜堆叠,用户可以输入薄膜的性质或使用模型来拟合光谱。

纹理:粗糙度和波纹度
Zeta-388 测量3D 纹理、量化样品的粗糙度和波纹度。ZDot可以测量从几十纳米到非常粗糙的表面的粗糙度。ZSI和干涉测量可以测量从埃级到微米级的光滑表面。软件中的过滤器将测量结果分为粗糙度和波纹度两部分,并计算出均方根粗糙度等参数。诺马斯基光干涉对比显微法可以通过揭示斜率的微小变化来可视化非常精细的表面细节。

翘曲:翘曲形状
Zeta-388可以测量表面的2D和3D形状或翘曲。这包括半导体或化合物半导体器件生产过程中层间不匹配导致的晶圆翘曲的测量。Zeta-388 还可以量化结构(例如透镜)的3D 高度和曲率半径。

应力:薄膜应力
Zeta-388 能够测量具有多个工艺层的器件(例如半导体或化合物半导体器件)在生产过程中的应力。精确测量表面的翘曲度需要使用应力载台将样品支撑在中间位置。然后运用Stoney公式的原理根据工艺(诸如薄膜沉积)带来的形貌变化来计算应力。Zeta-388 通过在整个样品直径上以用户定义的间隔测量样品表面的高度,然后把数据合成样品形状的轮廓来测量2D应力。

自动缺陷检测
Zeta-388 能够通过自动光学检测 (AOI) 快速检测样品,区分不同的缺陷类型,并绘制整个样品的缺陷分布图。当与3D 量测功能结合使用时,Zeta-388 可以提供2D检测系统无法提供的缺陷高度信息,从而更快地分析缺陷来源。

缺陷表征
Zeta-388缺陷表征使用检查工具KLARF文件将样品台移动到缺陷位置。用户可以使用Zeta-300检测缺陷或测量缺陷的表面形貌,例如高度、厚度或纹理。这提供了更多无法从2D缺陷检测系统获得的缺陷细节。Zeta-388 还可以使用划线标记缺陷,从而使视场有限的工具(例如SEM)更容易找到缺陷。

LED 图形蓝宝石衬底 (PSS)
Zeta-388 光学轮廓仪支持图形化的蓝宝石衬底的量测和检测。该系统结合ZDot、背光源照明系统和自定义算法,可快速量化PSS圆锥的高度、宽度和间距。Zeta-388 还可用于测量图形化前后的光刻胶,从而使样品在蓝宝石蚀刻之前返工成为可能。PSS衬底的自动缺陷检测能够快速识别关键缺陷,例如PSS圆锥的缺失、圆锥的桥接、撕裂和污染。
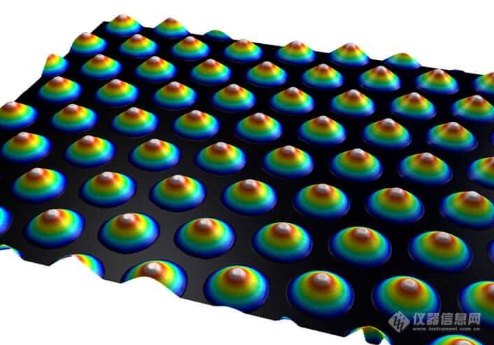
半导体和化合物半导体封装
Zeta-388 支持晶圆级芯片封装 (WLCSP) 和扇出晶圆级封装 (FOWLP) 量测要求。一个主要的赋能技术是在干光刻胶膜完好无损的情况下测量镀铜的高度。这是通过从透明光刻胶到种子层测量铜柱的高度、光刻胶的厚度以及铜和光刻胶的相对高度差来实现的。其他应用包括重布线(RDL)、凸点下金属化(UBM)高度和纹理、光刻胶开口临界尺寸(CD)、光刻胶厚度和聚酰亚胺厚度的测量。还可以测量金属凸点的共面性,以确定凸点高度是否满足最终器件封装连接性要求。

激光烧蚀
Zeta-388可以测量半导体、LED、微流体器件、PCB 等的激光表面处理引起的表面形貌变化。激光已被用于半导体、LED和生物医学设备等行业的精密微观尺度加工和表面处理。对于半导体行业,晶圆ID标记的深度和宽度的测量对于确保它可以在众多加工步骤中成功读取至关重要。

微流体
Zeta-388 能够测量由硅、玻璃和聚合物等材料制成的微流体器件。该系统量化了通道、孔和控制结构的高度、宽度、边缘轮廓和纹理。Zeta-388 可进行折射率补偿,测量用透明顶盖板密封后的最终器件,从而监测腔道的深度。
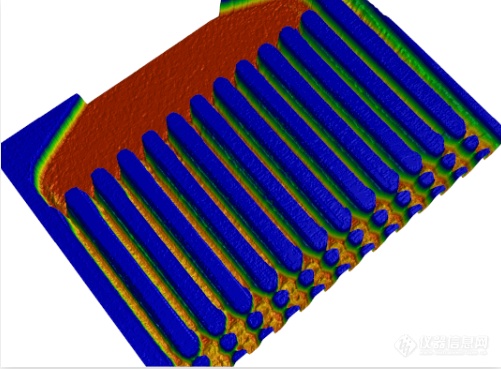
生物技术
Zeta-388 非常适合生物技术应用,可对具有从纳米级到毫米级特征的各种样品表面进行非接触式测量。Zeta-388 可以测量高深宽比台阶,例如生物技术器件的深孔深度。借助高数值孔径物镜和对反射能力极弱的样品的分辨能力,可以测量用于药物输送的微针阵列结构。

30天
1年
安装调试现场免费培训
到货后7天内
24小时内
是
2天内
- 相关仪器
- 相关资料
相关产品




 仪器对比
仪器对比



 关注
关注