推荐厂家
暂无
暂无
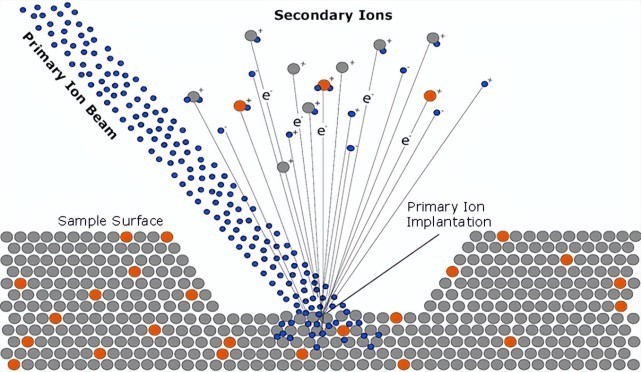





[size=5][b] [/b][/size] 采用脉冲一次离子源(LMIG, Cs, C60,Au,O2+,Ar+)等轰击样品,然后收集从样品表面激发出来的二次离子,采用质谱检测器(飞行时间、四极杆、扇形磁过滤、离子阱等),来收集这些二次离子,并且根据他们的质荷比(m/z)将它们分离,据此来判断分析材料的成分。 二次离子质谱仪分为静态- 二次离子质谱仪(S-SIMS) 和动态二次离子质谱仪(D-SIMS) ,其区分的标准就是根据入射的一次离子的剂量一般10^12atoms/cm2,成为静态二次离子质谱仪,一般采用飞行时间检测器,主要用于生物医药的有机物分析,半导体材料的污染物分析,存储材料分析,可以坚定有机的分子碎片。在分析过程中,材料表面的吸附物质及化学状态,对谱峰影响巨大。这也就是二次离子质谱中的“基体效应”。静态-二次离子质谱是一种无破坏的表面分析方法。最常见的静态- 二次离子质谱仪是飞行时间二次离子质谱仪。飞行时间二次离子质谱仪(TOF-SIMS: Time-of-Flight Secondary Ion Mass Spectrometry)利用一次脉冲离子轰击样品,通过表面激发出的二次离子的飞行时间测量其质量(m/z 100,000),以分析样品的表面组成。 动态-二次离子质谱仪,入射的一次离子的剂量一般10^15atoms/cm2,对表面形成大量的溅射作用,是一种破坏性分析,主要用于地质研究,同位素定年分析,半导体掺杂的深度分析。主要采用的一次离子源为气体等离子源(Ar/O2)或Cs离子源,一般要求样品导电性要好。
1 二次离子质谱学发展简史... 42 SIMS的原理和仪器结构... 52.1 原理... 52.2 质谱分析器(质谱计) 62.2.1 磁质谱计... 72.2.2 四极质谱计... 72.2.3 飞行时间质谱计... 82.2.4 其他质量分析器... 102.3 SIMS仪器类型... 103 SIMS与其它表面分析技术的比较... 113.1 SIMS的主要优缺点... 113.2 与其它微分析技术比较... 134 SIMS的研究和应用... 144.1 元素及同位素分析... 144.2 颗粒物微分析研究... 164.3 团簇、聚合物分析及生物医学等方面的研究... 174.4 SIMS在化合物半导体材料分析中的应用... 194.4.1 常规分析... 204.4.2 最低测量极限... 214.4.3 高分辨率SIMS分析... 234.4.4 解剖分析... 245 SIMS的新进展... 256 几种新型号二次离子质谱仪采用的新技术... 26[url=http://bbs.in
二次离子质谱(SIMS)是一种用于分析固体材料表面组分和杂质的分析手段。通过一次离子溅射,SIMS可以对样品进行质谱分析、深度剖析或成二次离子像。SIMS具有很高的元素检测灵敏度以及在表面和纵深两个方向上的高空间分辨本领,所以其应用范围也相当广泛。涉及化学、生物学和物理学等基础研究领域及微电子、催化、新材料开发等各个领域。 二次离子质谱法对于大部分元素都有很高的探测灵敏度,其检测下限可达百亿分之几的数量级。对痕量组分能进行深度剖析,可在微观(µ m级)上观察表面的特征,也可以对同位索进行分析和对低原子序数的元素(如氢、锂、铍等)进行分析。 ①痕量分析二次离子质谱法有极高的分辨率,可以达到十亿分之几的数量级。因此,可以对痕量的物质做出定性分析以确定其在表面的存在。当然进行这种分析要求排除所有可能影响结果的干扰。防止表面吸附物污染被测试表面,测试要在高真空和高纯度的离子束条件下进行。 ②定量分析定量分析采用的是以标样为基础的分析方法。一次离子的种类、能量和电流密度、样品环境、探测器效率以及二次离子分析器的能带通道确定之后,就能使用元素的相对灵敏度系数对样品进行确切的分析。只要二次离子质谱仪的灵敏度足以探测到基体的所有主要成分,所得结果就是这种基体材料成分的原子百分比。 ③深度分析深度分析的一般方法是监控样品中某元素的二次离子信号随溅射时间的变化。对于均匀基体材料,通过适当的标定试验(已知镀层厚度、陷口深度等)就能把时间转换为深度。元素的定量可以由二次离子强度的变化及二次离子强度定量分析方法得到。

 400-611-9236
400-611-9236
 留言咨询
留言咨询

 400-860-0650
400-860-0650
 留言咨询
留言咨询

 400-612-9980
400-612-9980
 留言咨询
留言咨询


