OAI 超过35年的历史按照您的具体规格设计和制造紫外线仪器和曝光系统在世界范围内亨有声誉无论复杂还是简单,OAI都有最聪明的解决方案。OAI 200型光刻机和紫外曝光系统 OAI系统可以处理各种常规和不规则形状的宽范围的基材。 高效光源在各种光谱上提供均匀的紫外线照射。. OAI 200型光刻机和紫外线曝光系统是一种经济高效的高性能工具,采用行业验证的模块化组件进行设计,使OAI成为MEMS,纳米技术和半导体设备行业的领先者。200型是台式机型,需要最小的洁净室空间。它为研发,试验或小批量生产提供了经济的替代方案。利用创新的空气轴承/真空卡盘校平系统,基板被快速和平缓地平整以用于平行光掩模对准和在接触暴露期间在晶片上的均匀接触。该系统具有微米分辨率和对准精度。对准模块具有掩模插入件组和快速更换晶片卡盘,其允许使用各种衬底和掩模,而不需要对机器重新设定。对准模块包含X,Y和θ轴(微米)。200型对准器可以广泛地安装进对准光学仪器,包括背面IR。 IR照明真空吸盘可以被配置用于整个或或部分晶片的对准。 OAI 200型可配置OAI纳米压印模块,使其成为最低成本的NIL工具。 OAI还提供了一个模块,设计用于使用液体光引物进行快速成型或生产微流体器件。 Model 200具有可靠的OAI光源,在近紫外或深紫外线下使用200至2000瓦功率的灯提供准直的紫外光。双传感器,光学反馈回路与恒定强度控制器相关联,以提供在所需强度的±2%内的曝光强度的控制。可以简单快速地改变UV波长。 型号200是一个高度灵活的, 经济的解决方 案,适合任何 入门级掩模对准和紫外线照射应用。 特点:&bull 高效,均匀,曝光系统与强度控制电源&bull 近,中,深紫外线能力可用&bull 亚微米套印和逐层校准&bull 易于互换的掩膜架和掩膜&bull 用户可设置,“基板到掩膜”间的压力&bull 软接触,硬接触,真空接触,接近曝光模式&bull 暴露可用时氮气N2吹扫&bull 超精确的卡盘运动&bull 可变速率电子操纵杆(可选)&bull 红外对准能力(型号200IR)(可选)&bull 顶部侧对齐以及背面对齐选项&bull 系统隔振具有四(4)象限独立调节(可选)&bull 高可靠性和低维护设计与优秀的文件应用MEMSNIL微流体纳米技术II-VI和III-V器件制造多级抗蚀剂处理LCD和FED显示器MCM’S薄膜器件太阳能电池SAW器件 选项提供单或双相机和屏幕(双相机/双屏版本如照片所示)可以安装NIL的Nano Imprint模块可安装微流体模块 OAI 200型台式光刻机和紫外线曝光系统 OAI 200型掩模对准器和UV曝光系统 特征 规格 体积小 基板平台 X, Y TravelZ TravelMicrometerGraduationsRotation ± 10mm 真空吸盘 1,500 microns.001" .0001"or .01mm .001mm± 3.5? 精密对准模块 可互换的面罩架和基板卡盘 掩膜 大小 Up to 14" x 14" 好处 光源 光束尺寸灯功率 Up to 12" square200, 350, 500, 1,000, and2,000 Watt NUV I 需要最小的洁净室空间 500, 1,000 and 2,000 Watt DUV I 对易碎基材材料造成损坏降至最低 快门定时器设施 定时器 0.1 to 99.0 sec. at 0.1second incrementsor 1 to 999 sec. at 1second increments I 精确对准至1微米 I 可轻松容纳各种基材和面罩 电压 110或220 / 400vac(或根据其他国家电源要求) I IR透明晶片的背面掩模对准,精度高达3-5微米 真空 20 - 28” Hg. I 高度准直,均匀的紫外线 空气和氮气 CDA at 60 PSI andN2at 40 PSI 排气 .35“至.5”水 I 快速更改UV光波长 I 曝光控制强度为±2% 尺寸 高度宽度深度运输重量 37” (200mm), 45” (300mm)31” (200mm) , 60” (300mm)25” (200mm), 70” (300mm)250 Lbs. (200mm), 400lbs (300mm) I 可以配置为NIL的Nano Imprint工具
 留言咨询
留言咨询
 留言咨询
留言咨询
 留言咨询
留言咨询
 留言咨询
留言咨询

 400-860-5168转3086
400-860-5168转3086
 留言咨询
留言咨询
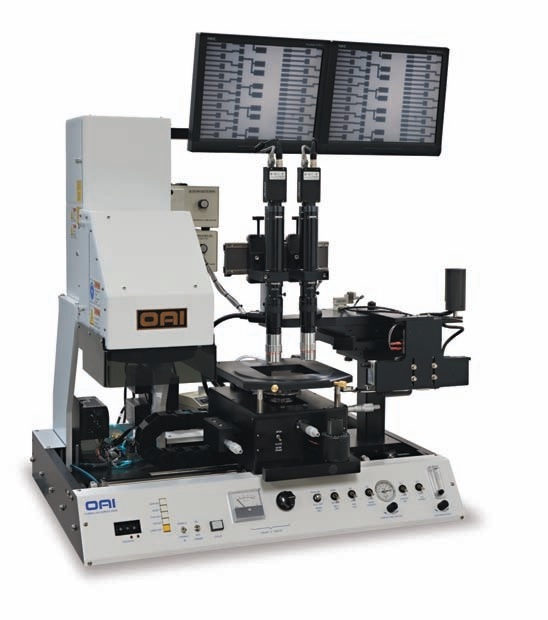
 400-860-5168转3855
400-860-5168转3855
 留言咨询
留言咨询
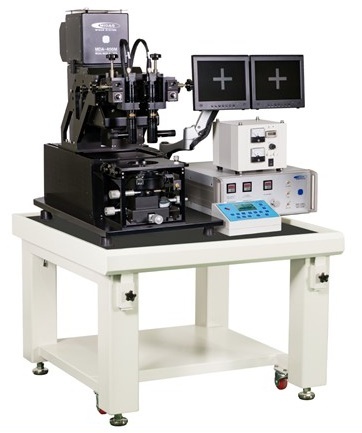
 400-860-5168转3281
400-860-5168转3281
 留言咨询
留言咨询








