推荐厂家
暂无
暂无




 400-622-8982
400-622-8982
 留言咨询
留言咨询

 400-860-5168转0727
400-860-5168转0727
 留言咨询
留言咨询

 400-860-5168转6134
400-860-5168转6134
 留言咨询
留言咨询



[b]特种气体工艺系统一般性要求 [color=#00b0f0] [/color][/b]一般工艺气体都是储存在钢瓶中,钢瓶作为气源相对方便使用。过去无论是在半导体生产车间,抑或是科研单位的实验室,钢瓶总是出现在需要的地方,而没有一个统一的规划布置。随着半导体行业的蓬勃发展,对其配套项目也提出了更高要求。比如在集中供气系统中一般要有专用装置储存钢瓶,在过去十多年中,盖斯帕克没有发明集中供气之前,特种气体供应没有形成有效的系统,钢瓶凌乱,管理混乱,不相容气体混放等问题比较严重,极大的影响到用气安全。彼时,随着半导体、微电子行业的发展壮大,特气系统的工艺要求也越来越规范,本文从宏观方面探讨整个系统设计初期需要注意的问题。特种气体工艺系统的硬件需求:储存、供气的气瓶柜、气瓶架、集装格。气体分配用阀门箱、阀门盘。辅助氮气吹扫系统。尾气处理装置。工艺气体的储存方式比较多样,有槽车、鱼雷管拖挂车、集装格、杜瓦罐、各类储罐等。实验室、科研单位、一般半导体生产厂用的特气多用钢瓶存储。特种气体工艺系统的设计应满足电子产品生产工艺对特气工艺的参数、污染控制、使用安全的要求。不相容的特种气体的排气管道不应该接入同一排气系统。不相容的特种气体的排风管道不应接入同一排风系统。
1 引 言 聚乙二醇二甲醚,系优良的气体净化剂,越来越多地用于合成气及天然气中硫化氢,二氧化碳等杂质的去除。南京化学工业公司于1984年成功地开发了基于该溶剂的气体净化技术,并首先在国内化肥行业大力推广。作为气体净化溶剂,其平均分子量和分布特征是非常重要的质量指标。化学端基分析方法不能得到分布信息因而难以满足工业控制的需要。本文介绍了一种[url=https://insevent.instrument.com.cn/t/Mp]气相色谱[/url](GC)分析方法及其在合成工艺改进中的应用。2 实验部分2.1 仪器和条件 3420[url=https://insevent.instrument.com.cn/t/Mp]气相色谱仪[/url]附FID检测器(北京分析仪器厂),HP3394积分仪(惠普公司),实验室自改装柱上进样器,氢气为载气,进样温度290℃,检测器温度280℃。22 m×0.53 mm ID。交联FFAP大口径FSOT柱,最高使用温度250℃(兰州化学物理研究所)。生产线上直接采样,用微量注射器取0.1 μL直接进样进行GC分析。2.2 定性和定量 利用部分标准和同系物保留规律定性,有效碳数响应规则定量。3 结果与讨论3.1 聚乙二醇的合成 聚乙二醇作为中间合成产物,其平均分子量及分布将决定甲基封端产物的分子分布特征,是保证产品质量的关键。由于物料投放和反应程度控制方面的问题,经常导致平均分子量偏小。我们用耐高温大口径极性毛细管色谱柱实现了高醇的快速分析,20 min内即可得到分析结果,从而为聚乙二醇合成条件的控制提供了直观的依据。3.2 甲醚化封端 甲醚化封端是制备二甲醚产物的第二关键步骤。控制的关键是反应进行的程度。色谱分析表明,甲醚化产物的分布与聚乙二醇的分布特征非常相似。可见GC在此关键步骤也可以有效地对反应程度进行快速及时的检测,得到组成分布,产率等丰富的信息,从而为封端反应的控制提供依据。3.3 产物的精制 精制步骤主要通过真空蒸馏的方法将较轻和较重的组分去掉,进一步改善产品的色泽和分布等指标。色谱分析表明,真空蒸馏对主要产物的分布影响较小,而单甲醚和聚乙二醇的分布变化较明显。是因为,相同聚合单元数时聚乙二醇和单甲醚沸点分别比二甲醚高出约50℃和100℃,高沸点组分在蒸馏中作为残液被部分除去,从而使分布重心向单元数小的方向偏移。有趣的是,有时封端产物经真空蒸馏后出现多的峰,经部分标准品和同系物保留规律证明为冠醚类。这可能是在真空和加热条件下,残留的高醇自身脱水环化形成。而在高醇的封端步骤未检测出冠醚的存在。3.4 工艺的综合优化 对合成过程的监测分析表明,精制在改善产品色泽和去除部分重组分副产物是有作用的,但不能用于明显提高主产物的含量和分布。最终主产物分布和产率主要取决于聚乙二醇的合成和对其甲醇化封端反应程度的控制。通过对封断步骤的有效控制,单甲醚以及高醇的残留均可得到有效的控制,二甲醚的转化率大大提高。
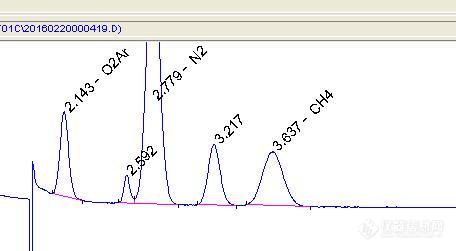
[align=center]工艺气气体分析鬼峰异常处理[/align][align=center]魏 钠 陈安梅 朱凤萍 马伟 王明 周洪涧 张琳 隋微彭涛[/align][b]1、摘要[/b][url=https://insevent.instrument.com.cn/t/Mp]气相色谱[/url]法由于其具有分离效能高、分析速度快、选择性好等优点被应用于各个领域如化工分析、农业农药检测、环境监测 、药物分析等。万华用[url=https://insevent.instrument.com.cn/t/Mp]气相色谱[/url]的分析涉及到原料、中间品、产品等;主要形态有气态、液态、固态。在这里我主要介绍[url=https://insevent.instrument.com.cn/t/Mp]气相色谱[/url]在我们公司气体当中的运用过程中出现异常谱图,解决异常的过程,通过一系列的问题排查,最终解决了谱图异常的问题。工艺气作为造气装置重要的气体,质检对其主要成份:一氧化碳、二氧化碳、氮气、甲烷、氧气、氩气、硫化氢等进行分析。造气装置根据分析的结果来判断水煤浆燃烧过程中炉子的运行情况。在对工艺气的分析结果是比较重要的。[url=https://insevent.instrument.com.cn/t/Mp]气相色谱[/url]的应用中可能出现的异常峰会造成分析员的误判,造成质量事故。[b]2、关键字 [/b]5A分子筛 鬼峰 阀[b]3、仪器以及样品简介涉及仪器:[/b][url=https://insevent.instrument.com.cn/t/Mp]气相色谱[/url]7890A,两个六通阀一个十通阀、两根5A分子筛柱子两个PORAPAK -Q柱[b]涉及样品:[/b]工艺气、氮气置换气等[b]4、异常描述[/b]工艺气体分析中时常出现鬼峰,主要表现为氧气峰后面和氮气峰后面,检测人员对日常分析过程中可能造成误判,很可能会当成是样品峰,这样可能会对分析结果造成影响。因为这些峰有时候峰面积和样品中的组份所出的面积差不多。如下图1所示。3.217分钟的鬼峰面积和3.637分钟的甲烷峰面积差不多很容易当成甲烷来计算。[align=center][img=,456,251]https://ng1.17img.cn/bbsfiles/images/2019/09/201909161529512412_8160_3389662_3.jpg!w456x251.jpg[/img] [/align][align=center]图1[/align][b]5、故障分析[/b]对出现在氮气前后的两个峰进行分析,为何会出现这两个峰,这两个峰是什么?可能的原因有1、样品中带进来的;2、色谱故障造成的。接下来对这两个可能的原因进行排查。[b]排查是否样品中产生:[/b]煤燃烧生成的工艺气中的成份有:二氧化碳、氧氩(氧气、氩气)、氮气、甲烷、一氧化碳、H2S、SO2等;这台色谱上所能分析的日常分析的气体是二氧化碳、氧氩(氧气、氩气)、氮气、甲烷、一氧化碳;这两个峰也有可能是其他主份。但在几个样品的分析观察后发现这两个峰还是存在;就怀疑不是样品的问题,拿来已知成份的标气进行进样验证后发现这两个峰还是存在。排除了是样品造成的鬼峰。[b]排查色谱故障造成的:[/b]色谱造成鬼峰的可原因比较多,1、色谱进样堵有憋压现象造成二次进样;2、色谱柱污染3、色谱微量漏气但不报警;5.1球胆进样时,定量管出气口的有点小,拆下色谱进样过滤头换上新的过滤头后进样,结果还是在氮气前后有两个峰,排除过滤头堵造成;5.2色谱柱的污染也经常导致出鬼峰,主要是一些不干净的样品进色谱柱后载气无法带出造成的。得通过柱子的高温老化来恢复色谱柱的性能(但不能超过色谱柱的最高使用温度)。对常规气体检测影响的5A分子筛色谱柱进行12小时350℃老化可恢复使用性能。从色谱柱的分离效果以及样品的性质来判断色谱柱的性能是正常的,所以排除了色谱柱污染造成的。5.3确定可能是色谱有漏的地方:[align=center][img=,654,257]https://ng1.17img.cn/bbsfiles/images/2019/09/201909161530302841_9364_3389662_3.jpg!w654x257.jpg[/img][/align][align=center]图2[/align]从图2两个鬼峰的峰面积15.43和53.04来看可能就是氧气和氮气峰,因为空气中氮气和氧气的比就是3比1到4比1之间。这就得研究色谱柱和阀的连接结构了,如下图3。样品通过定量环进样,被通过进样口的载气带到色谱柱进行分离,再到惹到检测器进行检测。[align=center][img=,690,359]https://ng1.17img.cn/bbsfiles/images/2019/09/201909161530464287_3635_3389662_3.jpg!w690x359.jpg[/img][/align][align=center]图3[/align]确定色谱可能有小漏点,就得排查是哪个部位漏。这就得从色谱的结构上来分析了。分析气体的色谱相对比较复杂,涉及到三阀四柱。各个接口比较多,排查起来比较费力。如下图4[align=center][img=,690,320]https://ng1.17img.cn/bbsfiles/images/2019/09/201909161531240835_9512_3389662_3.jpg!w690x320.jpg[/img][/align][align=center]图4[/align]柱温箱内结构复杂,不好排查是哪个接口有漏点,所以只能对接柱温箱内的各个接柱的部位进行再次紧固,进紧固后再用标气进色谱。从图5看紧固色谱柱后可以看出鬼峰面积有点变小,说明色谱柱接口处有点漏气。但进行多次进样后发现鬼峰还是存在,只是面积变小了点,这说明还有别处的小漏点。[align=center][img=,626,218]https://ng1.17img.cn/bbsfiles/images/2019/09/201909161531405621_2789_3389662_3.jpg!w626x218.jpg[/img][/align][align=center]图5[/align]可能在阀连接处还有漏点。打开阀箱阀,看到各气炉路管线交错复杂,不知道该从何处下手。通过检测的谱图看出是常规气体分析中出了鬼峰,可见是5A分子筛柱造成的。把5A分子筛柱两端进行紧固时发现一端和阀链接的接口处有点异常,气管有点磨损。用试漏液试后,在轻微的冒小气泡。[color=red] [/color][align=center][img=,690,399]https://ng1.17img.cn/bbsfiles/images/2019/09/201909161531552656_2878_3389662_3.png!w690x399.jpg[/img][/align][align=center]图6[/align]把气管一端裁掉,重新换上接口紧固后再次进标气验证,发现谱图氮气前后的两个峰消失了。谱图恢复正常。[align=center][img=,690,234]https://ng1.17img.cn/bbsfiles/images/2019/09/201909161532126603_3005_3389662_3.jpg!w690x234.jpg[/img][/align]5.4曲线标定由于仪器的各个接口的排查,维护可能对仪器的整体检测性能有所影响,因为气体进色谱通过色谱柱分离,再通过检测器检测计算。需要谱图上的峰面积进行计算。色谱的微量漏气可能造成分析的不准确,所以需要对色谱的校准曲线进行重新标定。曲线的标定必须要求连续几次进样后,各组分的峰面积差别不大,代表仪器所出数据稳定。这样才能进行标定曲线。进行色谱曲线标定后,色谱恢复正常。再次用样品进样分析,仪器正常。[b]6、总结:[/b]工艺气体分析用的色谱仪器结构复杂,在检测过程中时常会遇到一些问题,针对正常谱图中出现鬼峰的异常可以通过以上途径来解决。对于为什么会漏气的问题。我总结的原因有:1)柱温箱的温度60℃在分析完后有个150℃的后运行。这样的热胀冷缩容易造成螺丝和螺帽之间紧固不严实造成漏气。2)阀箱内的漏气。一是做样过程阀的切换造成接口松动;还有就是气管安装接口时的折弯紧固造成气管磨损。3)针对以上问题平时分析人员多关注,并相互多学习培训,提高类似事件的处理能力。 [b]7、参考文献[/b]安捷伦[url=https://insevent.instrument.com.cn/t/Mp]气相色谱[/url]培训教材,安捷伦科技大学;张玉宝,[url=https://insevent.instrument.com.cn/t/Mp]气相色谱仪[/url]的应用及发展趋势,哈尔滨雪佳氟硅化工有限公司.哈尔滨150050刘长云,[url=http://xueshu.baidu.com/s?wd=paperuri%3A%28893cffd2f88e29480955b3c774ee1db8%29&filter=sc_long_sign&tn=SE_xueshusource_2kduw22v&sc_vurl=http%3A%2F%2Fwww.cnki.com.cn%2FArticle%2FCJFDTotal-SHMQ200703010.htm&ie=utf-8][color=windowtext]高炉煤气中酸性气体分析及应对措施[/color][/url],[url=http://xueshu.baidu.com/s?wd=journaluri%3A%28aa595132c982a6f8%29%20%E3%80%8A%E4%B8%8A%E6%B5%B7%E7%85%A4%E6%B0%94%E3%80%8B&tn=SE_baiduxueshu_c1gjeupa&ie=utf-8&sc_f_para=sc_hilight%3Dpublish&sort=sc_cited][color=windowtext]《上海煤气》[/color][/url], 2007(3):29-31


