推荐厂家
暂无
暂无

 400-860-5168转6117
400-860-5168转6117
 留言咨询
留言咨询
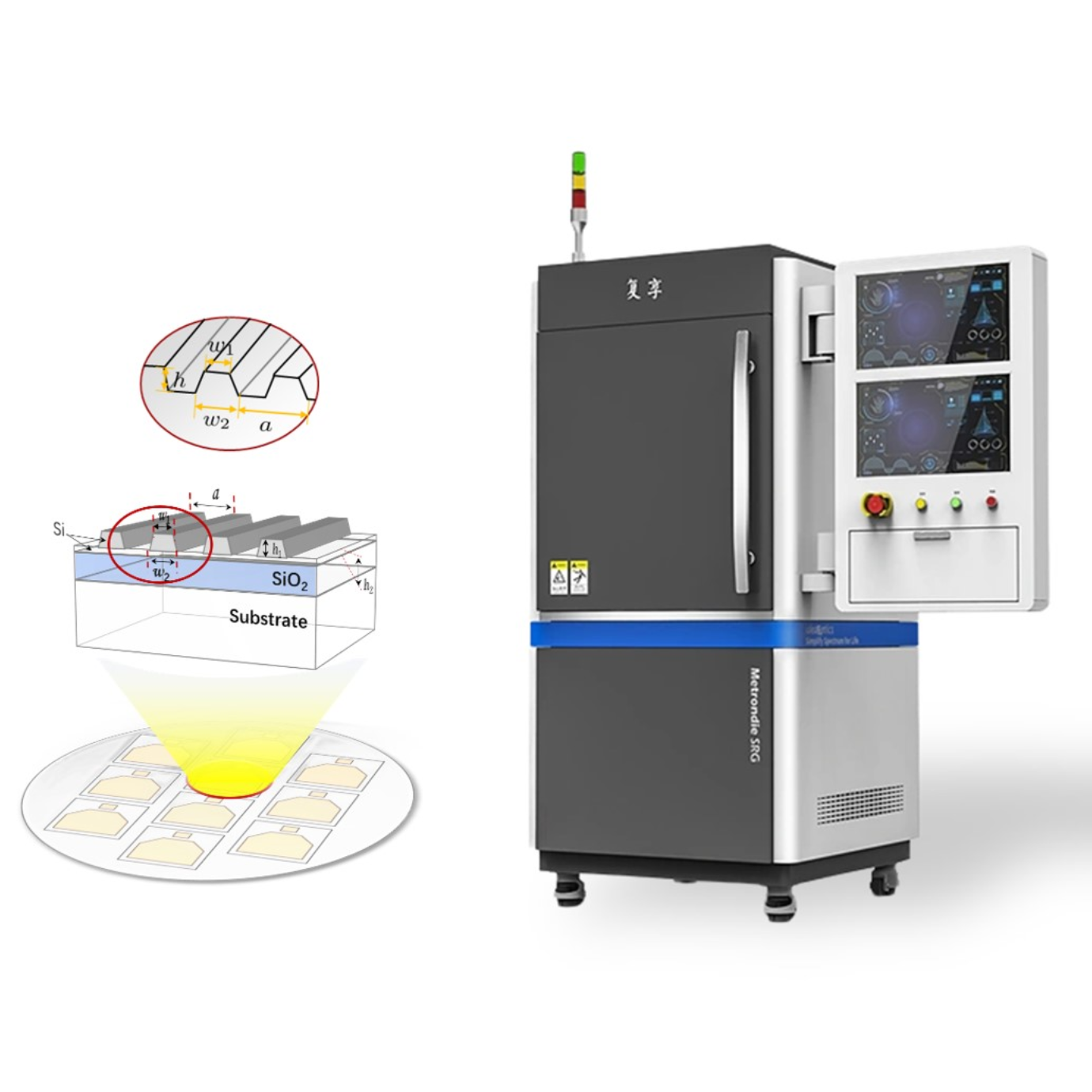
 400-860-5168转2332
400-860-5168转2332
 留言咨询
留言咨询

 400-860-5168转4682
400-860-5168转4682
 留言咨询
留言咨询



北京民居室温检测费 单间价格450元——贵吗??民居室温检测每间价格450元,每增加一间屋子再多掏40元。办公用房室温检测每间价格600元。如果是夜间测温还需要增加40元检测费。
深圳材料表面分析检测中心缺陷分析服务:1、微观形貌观察 2、杂质、残留物成分分析使用设备:1、扫描电子显微镜(SEM) 2、能量色散谱(EDS)价格:1、300元/样(提供5张照片) 2、350元/样电话:0755-25594781 白帆中心网址:http://www.sz863.comMSN:slevin.van@gmail.com
请问大家检测动物源中的农残都是用什么方法净化?用哪种SPE小柱比较好呢?





