方案详情文
智能文字提取功能测试中
一、TiN薄膜应用背景随着现代科学技术的发展,薄膜材料的应用越来越广泛。TiN薄膜是一种优异的表面修饰材料,由于其具有较高的硬度和耐磨性能、化学稳定性和高温稳定性、独特的金黄色、低电阻率以及阻挡扩散层性质,广泛应用于涂层领域、微电子领域、镀膜领域及医疗领域等。二、TiN薄膜的结构与性质Ti和N可以形成多种固溶体和化合物,常见的Ti-N化合物有Ti2N和TiN两种,金属钛(Ti)在间隙相中是以密排六方点阵或面心立方点阵排列,非金属氮(N)原子则填充在Ti晶体中的间隙位置。Ti2N结构中,金属Ti原子以密排六方点阵方式排列,而N原子在它的间隙位置。TiN结构中,金属Ti原子则以面心立方点阵方式排列,N原子在它的八面体间隙位置。TiN薄膜晶体结构如图所示,属于NaCl型的面心立方结构。其中Ti原子占据fcc(面心立方)晶格位置,而N原子则占据fcc晶格的八面体间隙位置。室温下薄膜的晶格常数为a=0.424nm,滑移系为{110}<110>,理论密度值为5.339g/cm3。 TiN薄膜晶体结构示意图三、掠入射X射线衍射(GXRID)技术在TiN薄膜表征中的应用X射线测试技术被广泛用于各种薄膜材料的表征。薄膜材料厚度比较薄,通常需要依附于一定的基底材料之上。而常规XRD测试,X射线的穿透深度一般在几个微米到几十个微米,远远大于薄膜的厚度,导致薄膜的信号会受到基底的影响,来自基底的强大信号会把薄膜的信号掩盖掉。另外,随着衍射角度的增加,X射线在样品上的照射面积逐渐减小,X射线只能辐射到部分样品,无法利用整个样品的体积,衍射信号弱。图(1)四、实验案例本实验采用苏州浪声科学仪器有限公司的FRINGE桌面式X射线衍射仪,对某企业提供的晶圆TiN薄膜样品(60nm TiN/400nm SiO2/Si)进行GIXRD检测。1、样品展示某企业晶圆TiN薄膜样品实物图左图—薄膜处理温度较高,标记1#-TiN film右图—薄膜处理温度较低,标记2#-TiN film2、测试参数设置仪器型号:FRINGE靶材:Cu靶(CuKα)附件:长索拉狭缝、对光片、Z轴样品台管压/管流:30kV/20mA扫描模式:θ-θ扫描测试范围:10-75°步长:0.05°/step积分时间:200ms/step扫描模式:掠射扫描测试范围:10-72°步长:0.05°/step入射角:1°积分时间:500ms/step3、结果与结论图(2)粉末衍射θ-θ扫描模式下薄膜样品1#-TiN film(单晶硅衬底)的衍射图谱图(3)粉末衍射θ-θ扫描模式下薄膜样品1#-TiN film(单晶硅衬底)的衍射图谱上异常峰的解释图(4)薄膜掠射扫描模式下薄膜样品1#-TiN film的衍射图谱及定性结果图(5)薄膜掠射扫描模式下薄膜样品2#-TiN film的衍射图谱及定性结果图(6)薄膜掠射扫描模式下薄膜样品1#及2#-TiN film的叠加衍射图谱表(1)4、分析结果1)采用两种不同的衍射几何对样品进行测试。对于常规对称衍射几何(CXRD),测试过程中,样品固定不动,光管和探测器为θ-θ耦合,即光管转过θ角,光管也转过θ角。对于掠入射非对称衍射几何(GIXRD),测试过程中样品和光管都固定不动,X射线以固定角度(1°)掠入射薄膜并保持角度不变,探测器作2θ扫描大角度范围旋转收集衍射信号(图(1))。2)图(2)展示了在常规粉末衍射θ-θ扫描模式下单晶硅衬底的TiN薄膜的衍射图谱,可以看出单晶硅衬底的400衍射[69.2°(2θ)]成了“3叉峰”,这是因为超强衍射强度导致峰形畸变。图(3)给出了粉末衍射θ-θ扫描模式下薄膜1#-TiN film(单晶硅衬底)的衍射图谱上异常峰的解释。其中33°左右的衍射峰是来自Si(002)晶面。3)图(4)、(5)所示的掠射扫描模式下薄膜1#-TiN film和薄膜2#-TiN film的衍射图谱和定性结果。可以看出,两个不同温度处理的晶圆薄膜的物相均为面心立方结构的氮化钛,PDF卡片号为00-038-1420。另外从卡片匹配情况上来看,可以知道薄膜2#-TiN film存在(200)择优取向。4)图(6)所示的掠射扫描模式下薄膜1#及2#-TiN film的叠加衍射图谱。可以看出处理温度较高的薄膜1#-TiN film的衍射峰比薄膜2#-TiN film更尖锐,说明薄膜1#-TiN film的结晶度更高,使用分峰拟合程序对这两个薄膜的结晶度进行计算,由表1得知薄膜1#-TiN film结晶度为57%,薄膜2#-TiN film结晶度为36%,这一结果与薄膜后处理温度高低相符。五、结论使用苏州浪声的FRINGE桌面式X射线衍射仪,配置薄膜附件可对薄膜样品进行物相分析,结晶度分析,还可进行晶粒尺寸分析,使用GIXRD能够为材料的研发、生产、质量管控等提供强有力的数据支撑,及时调整工艺条件,获得高质量产品。参考文献[1]江超华. 多晶X射线衍射技术与应用. 北京:化学工业出版社,2014:206-208.[2]Qiang S H ,Jie J D ,Xing S , et al.Characteristic of TiN Film Prepared by Multi-Arc Ion Plating[J].Applied Mechanics and Materials,2013,446-447(446-447):254-258.[3]Popovic M ,Novakovic M ,Bibic N .Structural characterization of TiN coatings on Si substrates irradiated with Ar ions[J].Materials Characterization,2009,60(12):1463-1470.
关闭-
1/9

-
2/9

还剩7页未读,是否继续阅读?
继续免费阅读全文苏州浪声科学仪器有限公司为您提供《FRINGE在TiN薄膜的GIXRD应用》,该方案主要用于薄膜材料中无检测,参考标准《暂无》,《FRINGE在TiN薄膜的GIXRD应用》用到的仪器有浪声薄膜衍射仪。
我要纠错
推荐专场
X射线衍射仪(XRD)
更多相关方案




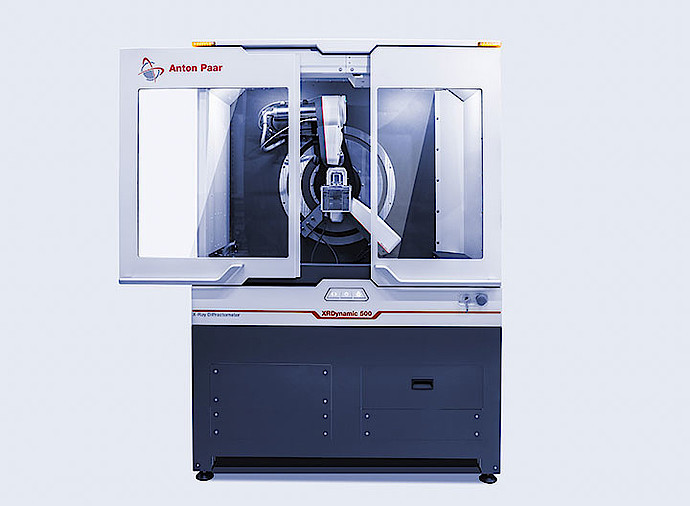

 咨询
咨询




