推荐厂家
暂无
暂无
 留言咨询
留言咨询
 留言咨询
留言咨询
 留言咨询
留言咨询

 400-628-5299
400-628-5299
 留言咨询
留言咨询
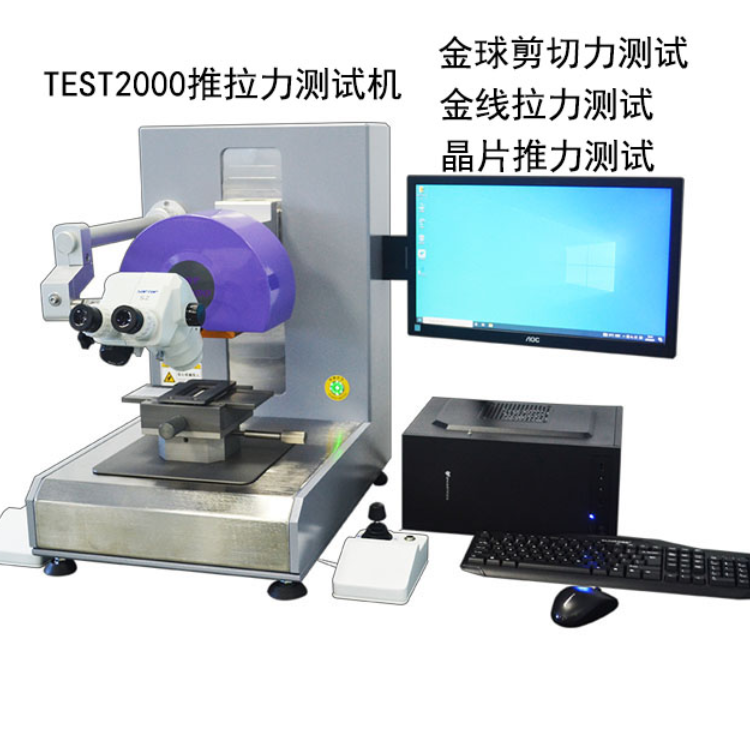
 留言咨询
留言咨询

 400-860-5168转0803
400-860-5168转0803
 留言咨询
留言咨询







芯片推拉力测试仪 IC焊接强度测试仪 IC推拉力测试仪 功能推拉力测试机: 采用了AUTO-RANGE技术和VPM垂直定位技术,测试传感器采用自动量程设计,分辨率高达0.0001克 推拉力测试机(多功能剪切力测试仪)是用于微电子封装和PCBA电子组装制造及其失效分析领域的专用动态测试仪器,是填补国内空白的微电子和电子制造领域的重要仪器设备。该设备测试迅速、准确、适用面广、测试精度高,适用于半导体IC封装测试、LED封装测试、光电子器件封装测试、PCBA电子组装测试、汽车电子、航空航天、军工等等。亦可用于各种电子分析及研究单位失效分析领域以及各类院校教学和研究。该设备无论测试精度、重复可靠性、操控性和外观设计,均达到世界一流的水平。应用包括:wire pull, ball shear, tweezer pul,cold bump pull 和更专业的stud pull 等等。推拉力测试系统适用于半导体各种封装形式测试金铝线黏合力;及COB封装、光电,LED,SMT组装 , 原件与基板黏合测试;推拉力测试机特点: 1、重量:65公斤 2、外观:宽620毫米×长520毫米×高700毫米 3、工作台X方向和Y方向最大行程60毫米;解析度0.25微米;运动时速度2.5毫米/秒;;可承受最大力200公斤;Z方向最大行程70毫米; 解析度1微米;运动时速度10毫米/秒;可承受最大力100公斤 4、测量范围:100克/5000克/10公斤/100公斤 5、测量精度:0.1% 6、测量标准:国家鉴定 标准推拉力测试机功能: 1、可实现多功能推拉力测试;2、任意组合可实现多种功能测试; 3、满足单一测试模组; 4、创新的机械设计模式; 5、强大的数据处理功能; 6、简易的操作模式,方便、有效。推拉力试验机应用: 1、可进行各种推拉力测试: 金球、锡球、芯片、导线、焊接点等 2、最大测试负载力达500kg 3、独立模组可自由添加任意测试模组: 4、强大分析软件进行统计、破断分析、QC报表等功能 5、 X 和 Z 轴可同时移动使拉力角度保持一致 6、程式化自动测试功能拉力测试 ·金/铝线拉力测试 ·非破坏性拉力测试(无损拉克) ·铝带拉力测试 ·非垂直(任何角度)拉力测试 ·夹金/铝线拉力测试 ·夹元件拉力测试 ·薄膜/镀膜/芯片/[color=black
请问现在如果想买LED芯片测试仪的话,哪家的比较好?
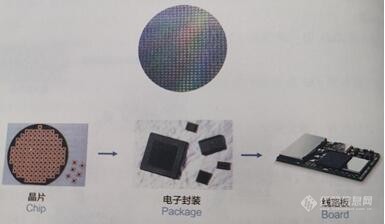
问题描述:半导体集成电路芯片封装指的是什么?解答:[font=宋体][color=black]集成电路封装是半导体开发的最后一个阶段,不仅起着物理包裹、固定、密封、保护芯片和增强电热性能的作用,而且还是芯片内部世界与外部电路沟通的桥梁。封装是将载板技术、芯片封装体、元器件等全部要素按照设备整机的要求进行连接装配,以实现芯片的多方面功能并满足整机和系统的适应性。[/color][/font][align=center][font='Times New Roman','serif'][color=black][img=,386,224]https://ng1.17img.cn/bbsfiles/images/2022/07/202207041430104834_1301_3389662_3.jpg!w385x224.jpg[/img][/color][/font][/align][align=center][font=宋体][color=black]芯片封装示意图[/color][/font][font='Times New Roman','serif'][color=black]*[/color][/font][font=宋体][color=black]引自[/color][/font][font='Times New Roman','serif'][color=black][5] p12[/color][/font][/align]以上内容来自仪器信息网《[url=https://insevent.instrument.com.cn/t/yp][color=#3333ff]ICP-MS[/color][/url]实战宝典》


