技术/销售热线 吴先生
ICP-RIE SI 500 德国Sentech等离子刻蚀机


低损伤刻蚀
由于离子能量低,离子能量分布带宽窄,因此可以用我们的等离子体刻蚀机SI 500进行低损伤刻蚀和纳米结构的刻蚀。
高速刻蚀
对于具有高深宽比的高速硅基MEMS刻蚀,光滑的侧壁可以通过室温下气体切换工艺或低温工艺即可很容易地实现。
自主研发的ICP等离子源
三螺旋平行板天线(PTSA)等离子源是SENTECH高端等离子体工艺设备的独特属性。PTSA源能生成具有高离子密度和低离子能量的均匀等离子体。它具有高耦合效率和非常好的起辉性能,非常适用于加工各种材料和结构。
动态温度控制
在等离子体刻蚀过程中,衬底温度的设定和稳定性对于实现高质量蚀刻起着至关重要的作用。动态温度控制的ICP衬底电极结合氦气背冷和基板背面温度传感,可在-150°C至+400°C的广泛温度范围内提供了优良的工艺条件。
SI 500为研发和生产提供先进的电感耦合等离子体(ICP)工艺设备。它基于ICP等离子体源PTSA,动态温度控制的衬底电极,全自动控制的真空系统,使用远程现场总线技术的先进的SETECH控制软件和用于操作SI 500的用户友好的通用接口。灵活性和模块化是SI 500主要的设计特点。
SI 500 ICP等离子刻蚀机,可以用于加工各种各样的衬底,从直径高达200 mm的晶片到装载在载片器上的零件。单晶片预真空室保证稳定的工艺条件,并且切换工艺非常容易。
SI 500 ICP等离子刻蚀机,通过配置可用于刻蚀不同材料,包括但不仅限于例如三五族化合物半导体(GaAs, InP, GaN, InSb),介质,石英,玻璃,硅和硅化合物(SiC, SiGe),还有金属等。
SENTECH提供用户不同级别的自动化程度,从真空片盒载片到一个工艺腔室到六个工艺模块端口,可用于不同的蚀刻和沉积工艺模块组成多腔系统,目标是高灵活性或高产量。SI 500 ICP等离子刻蚀机也可用作多腔系统中的工艺模块。
SI 500
.png)
ICP等离子刻蚀机
带预真空室
适用于200mm的晶片
衬底温度从-20?°C到300?°C
SI 500 C
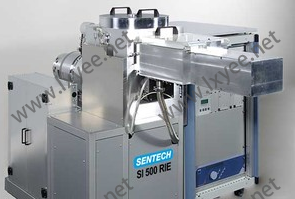
等温ICP等离子刻蚀机
带传送腔和预真空室
衬底温度从-150?°C到400?°C
SI 500 IRE
.png)
SI 500-300
.png)
SI 500为研发和小批量生产应用提供先进的ICP刻蚀工艺,具备高度的灵活性和模块化设计特点,可实现范围广泛的刻蚀工艺。包括刻蚀III-V化合物、II-VI化合物、介质、石英、玻璃、硅和硅化合物等。
SI 500C低温ICP刻蚀机,可在-100℃左右的低温下实现深硅刻蚀。优点是刻蚀后形成非常光滑的侧壁,尤其在光学应用上非常重要。同时低温刻蚀工艺的高刻蚀速率可实现刻穿样片。
SI 591 采用模块化设计、具有高度灵活性,适用于III-V 化合物、聚合物、金属盒硅刻蚀工艺,可配置为单反反应腔系统、或带预真空室或片盒站的多腔系统。特别适用于采用氟基气体的工艺,具有很高的工艺稳定性和重复性。
型号
SI 500 | ICP刻蚀机 | -30~+200℃ |
|
SI 500C | 低温ICP刻蚀机 | -150~+400℃ |
|
SI 500-30 | ICP刻蚀机 | 带预真空室 | 最大12寸晶圆 |
SI 591 | 反应离子刻蚀机 | 带预真空室 |
|
Etchlab200 | 反应离子刻蚀机 | 不带预真空室 |
|
SI500-RIE | 反应离子刻蚀机 | 带预真空室 | 带氦气背冷却系统
|
.png)
.png)
.png)
.png)
.png)
.png)
.png)
.png)
.png)
.png)
.png)
.png)
.png)
.png)
.png)
.png)
.png)
.png)
上海嗨思电子科技有限公司为您提供SENTECH ICP刻蚀机/ RIE离子刻蚀机SI 500SI 500 CS ICP/RIE,nullICP/RIE产地为德国,属于其他,除了SENTECH ICP刻蚀机/ RIE离子刻蚀机SI 500SI 500 CS 的参数、价格、型号、原理等信息外,还可为您提供更多其他,海思科技客服电话,售前、售后均可联系。



