板级封装测试
焊膏—回流焊工艺如图1所示:在PCB板上印刷焊膏,贴装(靠焊膏的粘性)并暂时固定SMD、SMC,然后通过回流焊焊接,最后进行清洗(可根据焊膏的类型及产品的应用范围选择清洗或不清洗)。

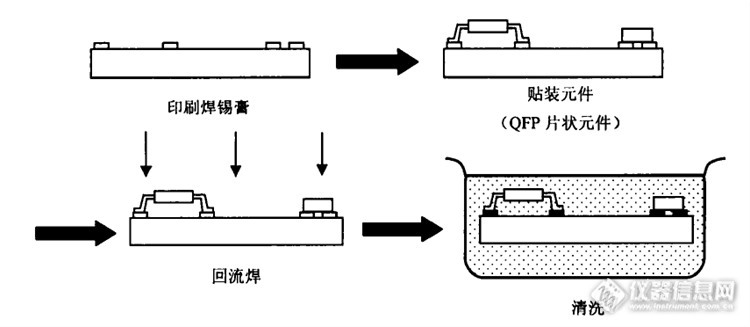
图1 焊膏—回流焊工艺图
本实验进行测试的封装方式有QFP、PGA。QFP封装技术的中文含义是方形扁平是封装技术,该技术实现的芯片引脚之间距离很小,管脚很细。该技术主要适用于SMT表面安装技术在PCB上安装布线。PGA封装技术的中文含义是插针网格阵列封装技术,由这种技术封装的芯片内外有多个方阵形的插针,每个方阵插针沿芯片的四周间隔一定距离排列,根据管脚数目的多少,可以围成2-5圈。
模板印刷过程:1)将模板与PCB精确对准;2)模板上放置焊膏;3)刮刀以一定角度、压力及恒定速率刮过模板;4)将模板与PCB分离,即脱模。印刷图形在室温下放置30分钟,进行焊接。
回流焊过程:在SMT生产流程中,回流炉参数设置的好坏是影响焊接质量的关键,通过温度曲线,可以为回流炉参数的设置提供准确的理论依据。回流温度曲线分为四段。1)预热段,这一段的目的是把室温的电路板尽快加热; 2)保温段,这一段溶剂不断蒸发,同时保证电路板上的全部原件在进入焊接段之前达到相同的温度;3)回流焊阶段,这一段把电路板带入铅锡粉末熔点之上,让铅锡粉末微粒结合成一个锡球并让被焊金属表面充分润湿;4)冷却段,这一段焊膏中的铅锡粉末融化并充分润湿被焊接表面。
板级封装回流焊实验结果
1 QFP回流焊实验结果
SYS305焊膏形成的焊点不能铺展、浸润焊盘,形成润湿不良。见图2a。
SYS305-G焊膏形成焊点铺满焊盘,但有回流现象,没有流平。见图2b。
W焊膏形成焊点没有铺满焊盘,没有回流现象。见图2c。

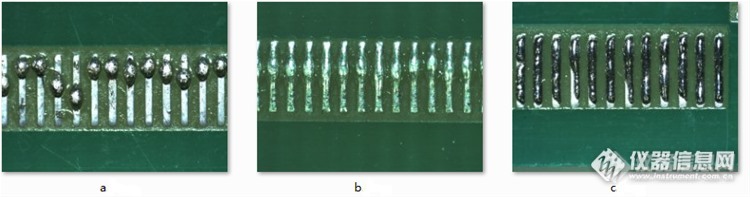
图2 QFP回流焊实验结果(20倍)
(a- SYS305;b-SYS305-G;c-W焊膏)
4.5.2 BGA回流焊实验结果
SYS305焊膏焊后焊点表面不光滑、有凹凸。见图3a。
SYS305-G焊膏焊后焊点表面光滑、无凹凸,铺满整个焊盘。见图3b。
W焊膏焊后焊点表面光滑、无凹凸,没有铺满整个焊盘。见图3c。


图3 BGA回流焊实验结果(20倍)
(a- SYS305;b-SYS305-G;c-W焊膏)